據韓國媒體ETNews透露,三星電子正在研究將非導電膠(NCF)更換為模塑底部填膠(MUF),以提升公司的封裝技術水平。
此前,三星一直利用非導電膠來完成半導體間的垂直連接。盡管NCF能有效避免芯片變形,但其難度較大且生產率低下的缺點使其未受到廣泛認同。
據報道,三星電子擬在硅通孔(through-silicon electrode,TVS)的制造過程中引用MUF材料。TVS可以在晶圓或裸晶表面鉆出許多微小的孔洞,提供垂直連接通道。而MUF則可以填充這些孔洞,減小半導體間的空隙,從而讓各種垂直堆疊的半導體更加穩定。
據悉,三星已從日本引進相關設備,以推進MUF的應用。此外,SK海力士也在第三代HBM(HBM2E)之后改用MUF,尤其是針對MR-MUF進行了調整。
業內人士評價說:“相較于NCF,MR-MUF具有更高的導熱性能,對工藝速度及良品率均有顯著改善。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
三星電子
+關注
關注
34文章
15894瀏覽量
183138 -
TVS
+關注
關注
8文章
977瀏覽量
63569 -
晶圓
+關注
關注
53文章
5416瀏覽量
132337
發布評論請先 登錄
相關推薦
熱點推薦
在芯片封裝保護中,圍壩填充膠工藝具體是如何應用的
圍壩填充膠(Dam&Fill,也稱Dam-and-Fill或圍堰填充)工藝是芯片封裝中一種常見的底部填充(Underfill)或局部保護技術,主要用于對芯片、焊點或敏感區域提供機械支撐

在電子制造的高精度領域中,芯片引腳的處理工藝
互相替代,而是電子制造精密工藝體系中互為補充的關鍵環節。企業應結合自身在產業鏈中的定位(如主營封裝或專注組裝),以及具體工藝瓶頸,合理引入如
發表于 10-30 10:03
半導體封裝工藝流程的主要步驟
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、上焊錫、打碼、外觀檢查、成品測試和包裝出庫,涵蓋了前段(FOL)、中段(EOL)、電鍍(plating)、后段(EOL)以及終測(final test)等多個關鍵環節。

芯片封裝工藝詳解
封裝工藝正從傳統保護功能向系統級集成演進,其核心在于平衡電氣性能、散熱效率與制造成本?。 一、封裝工藝的基本概念 芯片封裝是將半導體芯片通過特定工藝
千億美元打水漂,傳三星取消1.4nm晶圓代工工藝
電子發燒友網綜合報道?據多方消息來源推測,三星電子可能取消原計劃于?2027?年量產的?1.4nm(FS1.4)晶圓代工工藝。三星在?“Sa
千億美元打水漂,傳三星取消1.4nm晶圓代工工藝?
電子發燒友網綜合報道 據多方消息來源推測,三星電子可能取消原計劃于 2027 年量產的 1.4nm(FS1.4)晶圓代工工藝。三星在 “Sa
半導體貼裝工藝大揭秘:精度與效率的雙重飛躍
隨著半導體技術的飛速發展,芯片集成度不斷提高,功能日益復雜,這對半導體貼裝工藝和設備提出了更高的要求。半導體貼裝工藝作為半導體封裝過程中的關鍵環節,直接關系到芯片的性能、可靠性和成本。本文將深入分析半導體貼




 三星電子擬升級工藝,引入模塑底部填膠提升封裝工藝
三星電子擬升級工藝,引入模塑底部填膠提升封裝工藝







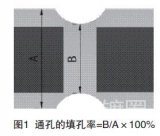



評論