英特爾宣布已實現基于業界領先的半導體封裝解決方案的大規模生產,其中包括英特爾突破性的3D封裝技術Foveros,該技術為多種芯片的組合提供了靈活的選擇,帶來更佳的功耗、性能和成本優化。
這一技術是在英特爾最新完成升級的美國新墨西哥州Fab 9投產的。英特爾公司執行副總裁兼首席全球運營官Keyvan Esfarjani表示:“先進封裝技術讓英特爾脫穎而出,幫助我們的客戶在芯片產品的性能、尺寸,以及設計應用的靈活性方面獲得競爭優勢。”
這一里程碑式的進展還將推動英特爾下一階段的先進封裝技術創新。隨著整個半導體行業進入在單個封裝中集成多個“芯粒”(chiplets)的異構時代,英特爾的Foveros和EMIB(嵌入式多芯片互連橋接)等先進封裝技術提供了速度更快、成本更低的路徑,以實現在單個封裝中集成一萬億個晶體管,并在2030年后繼續推進摩爾定律。
英特爾的3D先進封裝技術Foveros是業界領先的解決方案,在處理器的制造過程中,能夠以垂直而非水平方式堆疊計算模塊。此外,Foveros讓英特爾及其代工客戶能夠集成不同的計算芯片,優化成本和能效。
英特爾將繼續致力于推進技術創新,擴大業務規模,滿足不斷增長的半導體需求。
審核編輯 黃宇
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
英特爾
+關注
關注
61文章
10301瀏覽量
180412 -
3D
+關注
關注
9文章
3011瀏覽量
115001 -
封裝
+關注
關注
128文章
9248瀏覽量
148610
發布評論請先 登錄
相關推薦
熱點推薦
五家大廠盯上,英特爾EMIB成了?
電子發燒友網綜合報道 最近,英特爾EMIB封裝火了,在蘋果、高通、博通的招聘信息中,都指出正在招募熟悉EMIB封裝的工程師。近期還有消息稱,由于臺積電CoWoS 先進
今日看點:加速進化完成新一輪超億元融資;Arm 宣布為 Neoverse 平臺導入英偉達 NVLink Fusion 互聯
CoWoS、EMIB、SoIC和PoP等先進封裝技術經驗。而高通為其數據中心業務部門招聘的產品管理總監職位也要求熟悉英特爾的EMIB技術。
發表于 11-18 10:29
?1063次閱讀
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+半導體芯片產業的前沿技術
MI300,是AMD首款數據中心HPC級的APU
③英特爾數據中心GPU Max系列
3)新粒技術的主要使用場景
4)IP即芯粒
IP即芯粒旨在以芯粒實現特殊功能IP的即插即用,解決
發表于 09-15 14:50
英特爾連通愛爾蘭Fab34與Fab10晶圓廠,加速先進制程芯片生產進程
決定連通愛爾蘭的Fab 34與Fab 10晶圓廠。 ? 目前,英特爾先進制程技術Intel 4/3的主要生產重擔,落在了位于愛爾蘭萊克斯利普的Fab 34晶圓廠肩頭。這一晶圓廠對于
LG電子重兵布局混合鍵合設備研發,鎖定2028年大規模量產目標
近日,LG 電子宣布正式啟動混合鍵合設備的開發項目,目標在 2028 年實現該設備的大規模量產,這一舉措標志著 LG 電子在半導體先進封裝領域邁出了重要一步。混合鍵合
英特爾先進封裝,新突破
在半導體行業的激烈競爭中,先進封裝技術已成為各大廠商角逐的關鍵領域。英特爾作為行業的重要參與者,近日在電子元件技術大會(ECTC)上披露了多
英特爾先進封裝:助力AI芯片高效集成的技術力量
),以靈活性強、能效比高、成本經濟的方式打造系統級芯片(SoC)。因此,越來越多的AI芯片廠商青睞這項技術。 英特爾自本世紀70年代起持續創新,深耕封裝技術,積累了超過50年的豐富經驗

3D封裝與系統級封裝的背景體系解析介紹
的核心技術,正在重塑電子系統的集成范式。3D封裝通過垂直堆疊實現超高的空間利用率,而SiP則專注于多功能異質集成,兩者共同推動著高性能計算、人工智能和物聯網等領域的




 英特爾實現3D先進封裝技術的大規模量產
英特爾實現3D先進封裝技術的大規模量產







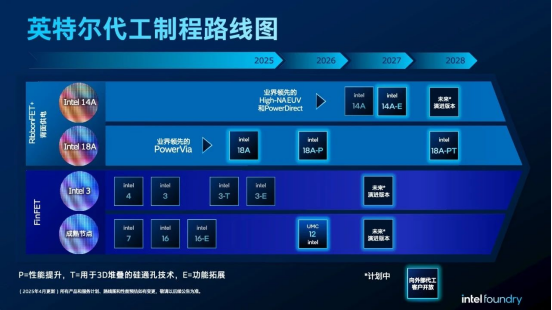



評論