晶圓在加工過(guò)程中的形貌及關(guān)鍵尺寸對(duì)器件的性能有著重要的影響,而形貌和關(guān)鍵尺寸測(cè)量如表面粗糙度、臺(tái)階高度、應(yīng)力及線寬測(cè)量等就成為加工前后的步驟。以下總結(jié)了從宏觀到微觀的不同表面測(cè)量方法:?jiǎn)畏N測(cè)量手段往往都有著自身的局限性,實(shí)際是往往是多種測(cè)量方法配合使用。此外,除表面形貌和臺(tái)階測(cè)量外,在晶圓制程中需要進(jìn)行其他測(cè)量如缺陷量測(cè)、電性量測(cè)和線寬量測(cè)。通過(guò)多種測(cè)量方式的配合,才能保證器件的良率和性能。
以下是幾種晶圓表面形貌及臺(tái)階高度的測(cè)量方法:
1、光學(xué)3D表面輪廓儀
SuperViewW系列光學(xué)3D表面輪廓儀以白光干涉掃描技術(shù)為基礎(chǔ)研制而成,以光學(xué)非接觸的掃描方式對(duì)樣品表面微觀形貌進(jìn)行檢測(cè)。其輪廓尺寸測(cè)量功能支持納米級(jí)別的臺(tái)階高和微米級(jí)別的平面尺寸測(cè)量,包含角度、曲率等參數(shù);可用于半導(dǎo)體減薄片、鍍膜片晶圓IC的粗糙度、微觀輪廓測(cè)量。


針對(duì)半導(dǎo)體領(lǐng)域大尺寸測(cè)量需求,SuperViewW3型號(hào)配備兼容型12英寸真空吸盤,一鍵測(cè)量大尺寸微觀三維形貌。
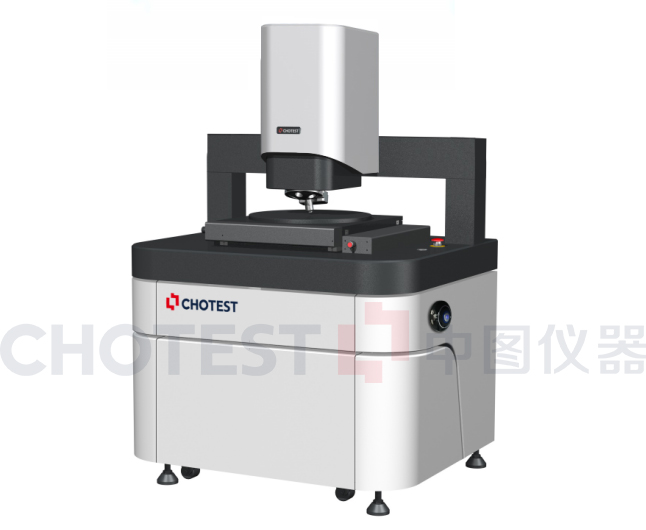 SuperViewW3
SuperViewW3半導(dǎo)體領(lǐng)域?qū)m?xiàng)功能
1.同步支持6、8、12英寸三種規(guī)格的晶圓片測(cè)量,并可一鍵實(shí)現(xiàn)三種規(guī)格的真空吸盤的自動(dòng)切換以適配不同尺寸晶圓;
2.具備研磨工藝后減薄片的粗糙度自動(dòng)測(cè)量功能,能夠一鍵測(cè)量數(shù)十個(gè)小區(qū)域的粗糙度求取均值;
3.具備晶圓制造工藝中鍍膜臺(tái)階高度的測(cè)量,覆蓋從1nm~1mm的測(cè)量范圍,實(shí)現(xiàn)高精度測(cè)量;
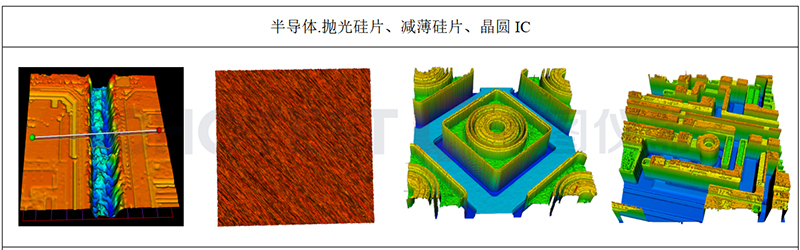
2、共聚焦顯微鏡
VT6000共聚焦顯微鏡以轉(zhuǎn)盤共聚焦光學(xué)系統(tǒng)為基礎(chǔ),是以共聚焦技術(shù)為原理的光學(xué)3D表面形貌檢測(cè)儀。不同的是,SuperViewW系列光學(xué)3D表面輪廓儀擅長(zhǎng)亞納米級(jí)超光滑表面的檢測(cè),追求檢測(cè)數(shù)值的準(zhǔn)確;VT6000共聚焦顯微鏡更擅長(zhǎng)微納級(jí)粗糙輪廓的檢測(cè),能夠提供色彩斑斕的真彩圖像便于觀察。

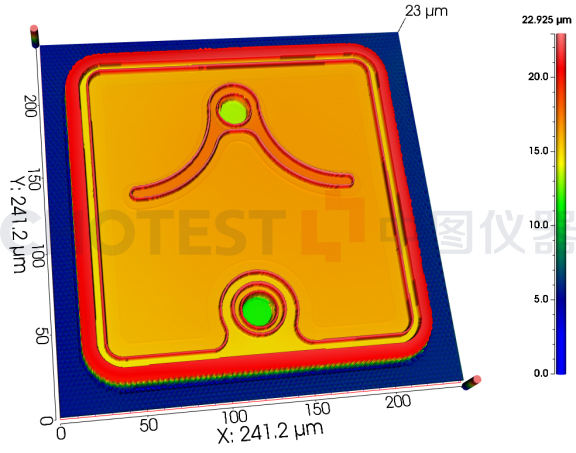 有圖晶圓
有圖晶圓
3、CP系列臺(tái)階儀
CP系列臺(tái)階儀是一款超精密接觸式微觀輪廓測(cè)量?jī)x器。它采用了線性可變差動(dòng)電容傳感器LVDC,具備超微力調(diào)節(jié)的能力和亞埃級(jí)的分辨率,同時(shí),其集成了超低噪聲信號(hào)采集、超精細(xì)運(yùn)動(dòng)控制、標(biāo)定算法等核心技術(shù),使得儀器具備超高的測(cè)量精度和測(cè)量重復(fù)性。


在半導(dǎo)體晶圓制造過(guò)程中,能夠測(cè)量樣品表面的2D形狀或翹曲:因多層沉積層結(jié)構(gòu)中層間不匹配所產(chǎn)生的翹曲或形狀變化,或者類似透鏡在內(nèi)的結(jié)構(gòu)高度和曲率半徑。
4、無(wú)圖晶圓幾何量測(cè)系統(tǒng)
WD4000無(wú)圖晶圓幾何量測(cè)系統(tǒng)采用高精度光譜共焦傳感技術(shù)、光干涉雙向掃描技術(shù),完成非接觸式掃描并建立3D Mapping圖,實(shí)現(xiàn)晶圓厚度、TTV、LTV、Bow、Warp、TIR、SORI、等反應(yīng)表面形貌的參數(shù)。
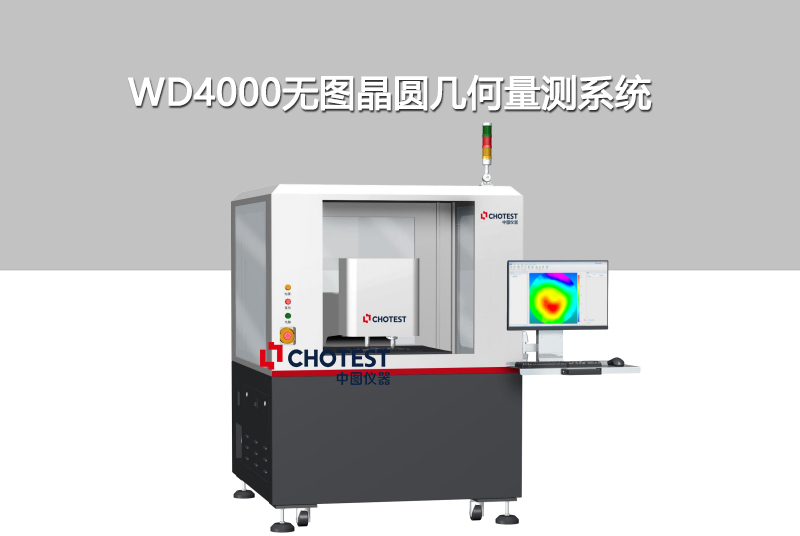
WD4000無(wú)圖晶圓幾何量測(cè)系統(tǒng)采用白光光譜共焦多傳感器和白光干涉顯微測(cè)量雙向掃描技術(shù),完成非接觸式掃描并建立表面3D層析圖像。通過(guò)非接觸測(cè)量,將晶圓的三維形貌進(jìn)行重建,強(qiáng)大的測(cè)量分析軟件穩(wěn)定計(jì)算晶圓厚度,TTV,BOW、WARP、在高效測(cè)量測(cè)同時(shí)有效防止晶圓產(chǎn)生劃痕缺陷,實(shí)現(xiàn)Wafer厚度、翹曲度、平面度、線粗糙度、總體厚度變化(TTV)及分析反映表面質(zhì)量的2D、3D參數(shù)。
 無(wú)圖晶圓厚度、翹曲度的測(cè)量
無(wú)圖晶圓厚度、翹曲度的測(cè)量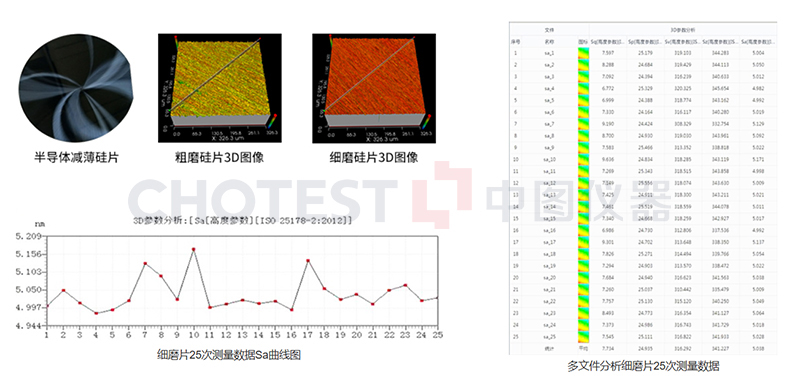 無(wú)圖晶圓粗糙度測(cè)量
無(wú)圖晶圓粗糙度測(cè)量單種測(cè)量手段往往都有著自身的局限性,實(shí)際是往往是多種測(cè)量方法配合使用。除表面形貌和臺(tái)階測(cè)量外,在晶圓制程中需要進(jìn)行其他測(cè)量如缺陷量測(cè)、電性量測(cè)和線寬量測(cè)。通過(guò)多種測(cè)量方式的配合,才能保證器件的良率和性能。
在半導(dǎo)體制造過(guò)程中,晶圓的制備和加工是一個(gè)復(fù)雜的過(guò)程,其中很多參數(shù)和條件都會(huì)對(duì)晶圓的表面形貌產(chǎn)生影響。通過(guò)合理運(yùn)用專業(yè)檢測(cè)設(shè)備對(duì)晶圓表面形貌進(jìn)行測(cè)量,可以了解到這些參數(shù)和條件的變化對(duì)晶圓的影響程度,從而優(yōu)化制造過(guò)程,提高晶圓制備的穩(wěn)定性和一致性,減少晶圓的不良品率。
-
3D
+關(guān)注
關(guān)注
9文章
3011瀏覽量
115015 -
晶圓
+關(guān)注
關(guān)注
53文章
5408瀏覽量
132280 -
測(cè)量
+關(guān)注
關(guān)注
10文章
5632瀏覽量
116718 -
表面輪廓儀
+關(guān)注
關(guān)注
0文章
81瀏覽量
1217
發(fā)布評(píng)論請(qǐng)先 登錄
臺(tái)階儀在ZnO/Au復(fù)合薄膜表征中的應(yīng)用:膜厚精確測(cè)量與表面形貌分析

脈沖激光加工后,表面形貌與粗糙度如何測(cè)量?

臺(tái)階儀在PET復(fù)合膜中的應(yīng)用:非晶ZnO膜厚測(cè)量與界面效應(yīng)表征

臺(tái)階儀的原理及常見(jiàn)問(wèn)題解答

NIST研究院:表面粗糙度與臺(tái)階高度校準(zhǔn)規(guī)范

臺(tái)階儀表面輪廓測(cè)量國(guó)際標(biāo)準(zhǔn):ISO21920與ISO4287的差異解析

臺(tái)階儀在表面計(jì)量學(xué)的應(yīng)用:基于表面紋理最大高度S±3σ的表征研究

衍射光學(xué)元件DOE:臺(tái)階高度與位置誤差的測(cè)量

臺(tái)階儀在大面積硬質(zhì)涂層的應(yīng)用:精準(zhǔn)表征形貌與蝕刻 / 沉積結(jié)構(gòu)參數(shù)

臺(tái)階儀在半導(dǎo)體制造中的應(yīng)用 | 精準(zhǔn)監(jiān)測(cè)溝槽刻蝕工藝的臺(tái)階高度

觸針式輪廓儀 | 臺(tái)階儀 | 納米級(jí)多臺(tái)階高度的精準(zhǔn)測(cè)量

晶圓邊緣 TTV 測(cè)量的意義和影響

wafer晶圓幾何形貌測(cè)量系統(tǒng):厚度(THK)翹曲度(Warp)彎曲度(Bow)等數(shù)據(jù)測(cè)量
wafer晶圓幾何形貌測(cè)量系統(tǒng):厚度(THK)翹曲度(Warp)彎曲度(Bow)等數(shù)據(jù)測(cè)量




 晶圓表面形貌及臺(tái)階高度測(cè)量方法
晶圓表面形貌及臺(tái)階高度測(cè)量方法





評(píng)論