我們知道,SiC MOSFET現(xiàn)階段最“頭疼”的問(wèn)題就是柵氧可靠性引發(fā)的導(dǎo)通電阻和閾值電壓等問(wèn)題,最近,日本東北大學(xué)提出了一項(xiàng)新的外延生長(zhǎng)技術(shù),據(jù)說(shuō)可以將柵氧界面的缺陷降低99.5%,溝道電阻可以降低85.71%,整體SiC MOSFET損耗可以降低30%。
9月28日,東北大學(xué)和CUSIC在“ICSCRM2023”會(huì)議上宣布,他們針對(duì)SiC MOSFET開(kāi)發(fā)一種“同步橫向外延生長(zhǎng)法(SLE法)”,目的是通過(guò)在4C-SiC外延層上再生長(zhǎng)3C-SiC層,來(lái)解決高溫柵氧導(dǎo)致的可靠性問(wèn)題。
為什么需要怎么做?傳統(tǒng)4C-SiC柵氧層制備最大的問(wèn)題是溫度太高(約1300℃),這會(huì)導(dǎo)致SiO2/SiC界面出現(xiàn)碳?xì)埩?/strong>,導(dǎo)致溝道遷移率低,以及可靠性和閾值電壓等缺陷。
如果通過(guò)3C-SiC來(lái)制備柵氧層,工藝問(wèn)題可以低于900℃,可以完美解決這個(gè)問(wèn)題。根據(jù)“行家說(shuō)三代半”之前的報(bào)道,3C-SiC MOSFET的n溝道遷移率范圍為100-370 cm2/V·s。而4H-SiC MOSFET通常為20-40cm2/V·s,溝槽器件為6-90 cm2/V·s,京都大學(xué)的技術(shù)可以做到131 cm2/V·s,但也比3C-SiC MOSFET低3倍左右。

東北大學(xué)根據(jù)這思路制備了一種CHESS-MOSFET,即在4C-SiC疊加3C-SiC層,如下圖:
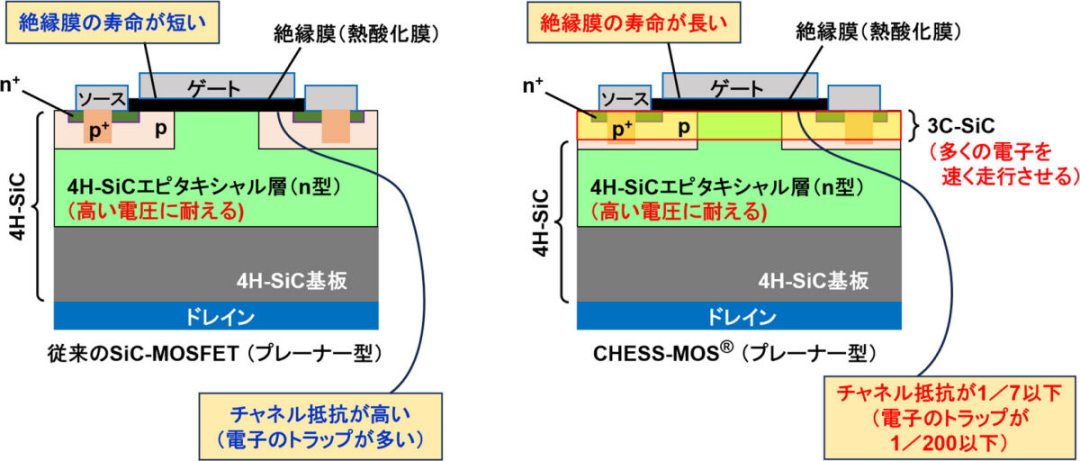
采用4H-SiC外延層的MOSFET(左),CHESS-MOS(右)
該研究團(tuán)隊(duì)表示,CUSIC 設(shè)計(jì)的“CHESS-MOS”能夠同時(shí)降低功率損耗并確保長(zhǎng)期可靠性。
該器件的特點(diǎn)是采用了混合外延層,既利用了3C-SiC的高遷移率,也利用了4H-SiC層的高耐壓。
然而,要實(shí)現(xiàn)這一目標(biāo)需要開(kāi)發(fā)新的外延和晶體生長(zhǎng)技術(shù),以無(wú)縫堆疊兩種不同晶格SiC層。因此,該研究團(tuán)隊(duì)開(kāi)發(fā)了SLE方法。
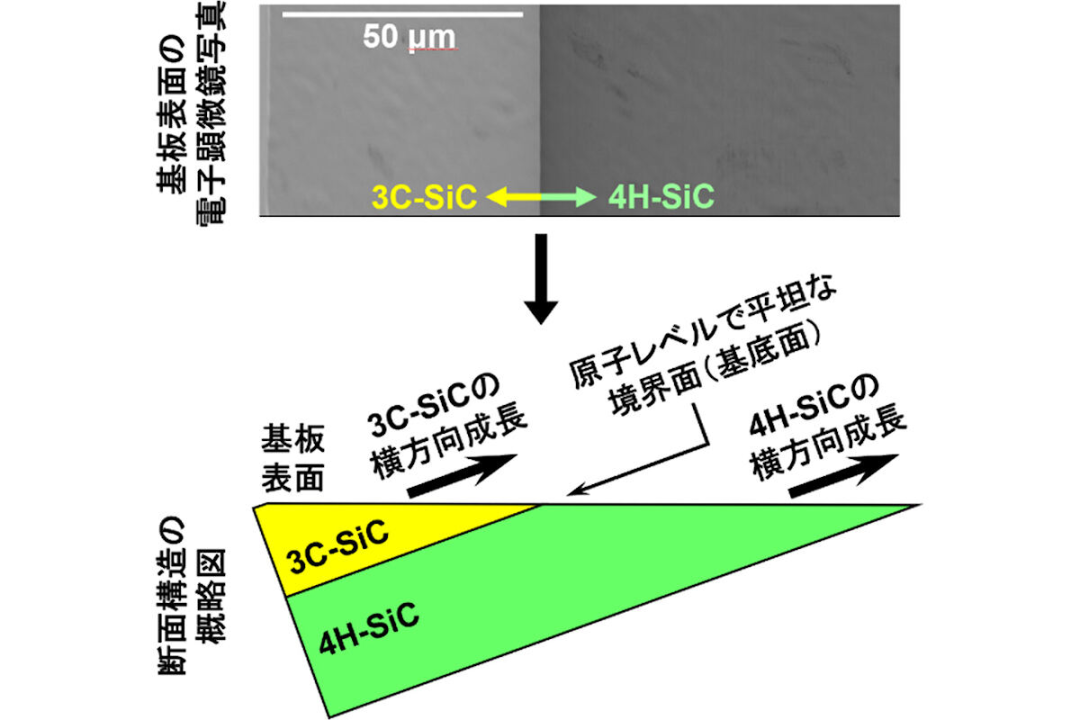
簡(jiǎn)單來(lái)說(shuō),SLE方法是在4H-SiC的延伸基面上生長(zhǎng)3C-SiC層,3C-SiC也沿著4H-SiC基面延伸,這樣使得3C-SiC層與4H-SiC層之間的界面非常平坦,沒(méi)有原子偏差。
掃描非線性介電常數(shù)顯微鏡測(cè)量結(jié)果顯示,3C-SiC表面的缺陷密度僅為4H-SiC的1/200,表明SLE方法可以大幅降低界面缺陷密度,預(yù)測(cè)CHESS-MOS可將損耗降低30%以上。
而且,由于基于3C-SiC的CHESS-MOS還可以極大地降低絕緣膜漏電流密度,消除絕緣膜在短時(shí)間內(nèi)劣化的風(fēng)險(xiǎn),提高器件的長(zhǎng)期可靠性。
在實(shí)驗(yàn)中,該團(tuán)隊(duì)還發(fā)現(xiàn),使用SLE法可以形成3C-SiC/4H-SiC/3C-SiC/4H-SiC等雙量子阱結(jié)構(gòu)的現(xiàn)象,那么通過(guò)有意地形成這種堆疊結(jié)構(gòu),可以制造高頻器件,而在以前,SiC半導(dǎo)體器件被認(rèn)為難以實(shí)現(xiàn)。
此外,該團(tuán)隊(duì)還有另一個(gè)新發(fā)現(xiàn),他們通過(guò)使用SLE方法在半絕緣4H-SiC襯底上生長(zhǎng)3C-SiC層,可避免由于與襯底電容耦合而導(dǎo)致的高頻信號(hào)衰減問(wèn)題,這將有望為高頻集成電路的大規(guī)模生產(chǎn)鋪平道路。
最為重要的是,SLE方法能夠直接在SiC外延層表面的一部分引入不同的晶體結(jié)構(gòu),而無(wú)需大幅改變現(xiàn)有的SiC MOSFET器件形狀或制造工藝,預(yù)計(jì)該技術(shù)很快可以導(dǎo)入器件生產(chǎn)線。
審核編輯:劉清
-
MOSFET
+關(guān)注
關(guān)注
151文章
9670瀏覽量
233497 -
SiC
+關(guān)注
關(guān)注
32文章
3721瀏覽量
69390 -
SLE
+關(guān)注
關(guān)注
0文章
14瀏覽量
8883 -
漏電流
+關(guān)注
關(guān)注
1文章
280瀏覽量
17934 -
閾值電壓
+關(guān)注
關(guān)注
0文章
98瀏覽量
52588
原文標(biāo)題:SiC MOS新技術(shù):溝道電阻可降85%
文章出處:【微信號(hào):SiC_GaN,微信公眾號(hào):行家說(shuō)三代半】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
HC6N10成熟穩(wěn)定量大加濕器專用MOS管 6N10 100V6A 皮實(shí)耐抗惠海
選擇N-MOS還是P-MOS?
如何用雙脈沖測(cè)試更好的表征SiC MOS動(dòng)態(tài)能力?

合科泰TO-252封裝N溝道MOS管HKTD100N03的核心優(yōu)勢(shì)

Vishay SiC32309熱插拔電子保險(xiǎn)絲開(kāi)關(guān)深度技術(shù)解析
ZK40P80T:P溝道MOS管中的高功率性能擔(dān)當(dāng)

SiC-MOS與IGBT抗短路能力對(duì)比

FS8205 20V N 溝道增強(qiáng)型MOS場(chǎng)效應(yīng)管技術(shù)手冊(cè)
100V200V250V MOS管詳解 -HCK450N25L
方正微電子SiC MOS功率模塊FA120P002AA簡(jiǎn)介

深愛(ài)半導(dǎo)體 代理 SIC213XBER / SIC214XBER 高性能單相IPM模塊
無(wú)刷直流電機(jī)電流檢測(cè)新技術(shù)
MOS管的工作原理:N溝道與P溝道的區(qū)別




 淺析SiC MOS新技術(shù):溝道電阻可降85%
淺析SiC MOS新技術(shù):溝道電阻可降85%




評(píng)論