華為技術有限公司日前公開了一項名為“具有改進的熱性能的倒裝芯片封裝”專利,申請公布號為CN116601748A。
該專利實施例提供了一種倒裝芯片封裝、一種裝備有應用封裝結構的電路的裝置以及一種組裝封裝的方法。
更直觀來說,就是一種提供芯片與散熱器之間的接觸方式,能幫助改善散熱性能。可應用于CPU、GPU、FPGA(現場可編程門陣列)、ASIC(專用集成電路)等芯片類型,設備可以是智能手機、平板電腦、可穿戴移動設備、PC、工作站、服務器等。
專利提到,近來,半導體封裝在處理性能方面的進步對熱性能提出了更高的要求,以確保穩定操作。就此而言,倒裝芯片封裝在熱性能方面具有優勢,因其結構特征是芯片通過其下方凸塊與基板連接,能夠將散熱器定位在芯片的頂表面上。
一般來說,為提高冷卻性能,會將熱潤滑脂等熱界面材料(TIM)涂抹到芯片的頂表面,并夾在芯片和散熱器的至少一部分之間。從降低TIM中的熱阻以改善封裝的熱性能的角度來看,使TIM的厚度更小。
相較此前難以精細控制TIM厚度的散熱方案,華為這項專利中的熱界面材料的厚度由模制構件中的壁狀結構的高度限定。由于能在模制過程中輕松控制由模具化合物組成的壁狀結構的高度,因此可以將熱界面材料的厚度調節到所需的小厚度,從而實現改進的熱性能。
倒裝芯片封裝技術將有望促使電子設備的設計更加靈活多樣。由于倒裝封裝可以使芯片更加緊湊地布置在電路板上,產品的尺寸可以進一步減小,從而為手機、平板電腦、智能穿戴設備等帶來更輕薄的外觀。同時,也將極大改善手機設備的散熱問題。
但這種封裝技術也存在很多的技術限制,比如倒裝封裝要求在芯片背面進行復雜的布線和連接,這對制造工藝的要求較高,可能會增加生產成本。其次是可靠性問題。由于倒裝封裝將芯片直接暴露在外,容易受到外界環境的影響,需要更強的保護措施來確保芯片的穩定運行。
由于該技術目前還處在專利階段,何時真正能夠應用尚未可知。一般來說,一項專利技術從技術驗證階段到最終商用會有一定的周期,也有一些技術本身就是作為技術儲備,有可能也會永遠得不到應用。
按照華為當前的現狀,芯片封裝這類技術很有可能在商用量產上會有更大的難度。
在消費市場,宇凡微也公布了最新的射頻芯片合封技術,專利號CN 218677151 U,本實用新型屬于半導體封裝技術領域,提供了一種集成MCU和射頻芯片的封裝體,即可同時實現微控制芯片(MCU)和射頻芯片的功能。
主要由2.4g芯片或433m芯片,加上mcu合封而成,該射頻合封芯片,一經推出在遙控市場受到廣泛的歡迎,超高性價比在消費市場是制勝的法寶,能幫助商家減少各方面的成本。具體請訪問宇凡微官網。
審核編輯:湯梓紅
-
芯片
+關注
關注
463文章
54007瀏覽量
465952 -
cpu
+關注
關注
68文章
11277瀏覽量
224955 -
華為
+關注
關注
218文章
36003瀏覽量
262084 -
封裝技術
+關注
關注
12文章
599瀏覽量
69303
發布評論請先 登錄
華為Pura80發布,一項卡脖子傳感器技術獲突破,一項傳感器技術仍被卡脖子!
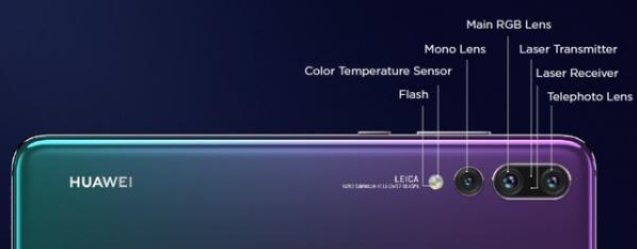



 華為公布一項倒裝芯片封裝技術:能大幅改善CPU散熱
華為公布一項倒裝芯片封裝技術:能大幅改善CPU散熱













評論