1 后摩爾時代,先進(jìn)封裝成為提升芯片性能重要解法
1.1 摩爾定律放緩,先進(jìn)封裝日益成為提升芯片性能重要手段
隨著摩爾定律放緩,芯片特征尺寸接近物理極限,先進(jìn)封裝成為提升芯片性 能,延續(xù)摩爾定律的重要手段。先進(jìn)封裝是指處于前沿的封裝形式和技術(shù),通過 優(yōu)化連接、在同一個封裝內(nèi)集成不同材料、線寬的半導(dǎo)體集成電路和器件等方式, 提升集成電路的連接密度和集成度。當(dāng)前全球芯片制程工藝已進(jìn)入 3-5nm 區(qū)間, 接近物理極限,先進(jìn)制程工藝芯片的設(shè)計難度、工藝復(fù)雜度和開發(fā)成本大幅增加, 摩爾定律逐漸失效,半導(dǎo)體行業(yè)進(jìn)入“后摩爾時代”。前道制程工藝發(fā)展受限,但 隨著 AI 等新興應(yīng)用場景快速發(fā)展,芯片性能要求日益提高,越來越多集成電路 企業(yè)轉(zhuǎn)向后道封裝工藝尋求先進(jìn)技術(shù)方案,以確保產(chǎn)品性能的持續(xù)提升。先進(jìn)封 裝技術(shù)應(yīng)運(yùn)而生,在“后摩爾時代”逐步發(fā)展為推動芯片性能提升的主要研發(fā)方向。先進(jìn)封裝有多種分類標(biāo)準(zhǔn),是否有焊線或光刻工序是其中一種區(qū)分方式。傳 統(tǒng)封裝不涉及光刻工序,切割后的晶圓通過焊線工藝實現(xiàn)芯片與引線框架的電性 連接,從而完成芯片內(nèi)外部的連通。先進(jìn)封裝主要利用光刻工序?qū)崿F(xiàn)線路重排 (RDL)、凸塊制作(Bumping)及三維硅通孔(TSV)等工藝技術(shù),涉及涂膠、曝 光、顯影、電鍍、去膠、蝕刻等工序。
1.2 先進(jìn)封裝份額占比提升,2.5D/3D 封裝增速領(lǐng)先先進(jìn)封裝
AI 帶動先進(jìn)封裝需求。TrendForce 報告指出,聊天機(jī)器人等生成式 AI 應(yīng)用 爆發(fā)式增長,帶動 2023 年 AI 服務(wù)器開發(fā)大幅擴(kuò)張。這種對高端 AI 服務(wù)器的依 賴,需要使用高端 AI 芯片,這不僅將拉動 2023~2024 年 HBM 的需求,而且預(yù)計 還將在 2024 年帶動先進(jìn)封裝產(chǎn)能增長 30~40%。先進(jìn)封裝增速高于整體封裝,2.5D/3D 封裝增速居先進(jìn)封裝之首。根據(jù) Yole, 2021 年,先進(jìn)封裝市場規(guī)模約 375 億美元,占整體封裝市場規(guī)模的 44%,預(yù)計到 2027 年將提升至占比 53%,約 650 億美元,CAGR21-27為 9.6%,高于整體封裝市場 規(guī)模 CAGR21-27 6.3%。先進(jìn)封裝中的 2.5D/3D 封裝多應(yīng)用于(x)PU, ASIC, FPGA, 3D NAND, HBM, CIS 等,受數(shù)據(jù)中心、高性能計算、自動駕駛等應(yīng)用的驅(qū)動,2.5D/3D 封裝市場收入規(guī)模 CAGR21-27高達(dá) 14%,在先進(jìn)封裝多個細(xì)分領(lǐng)域中位列第一。
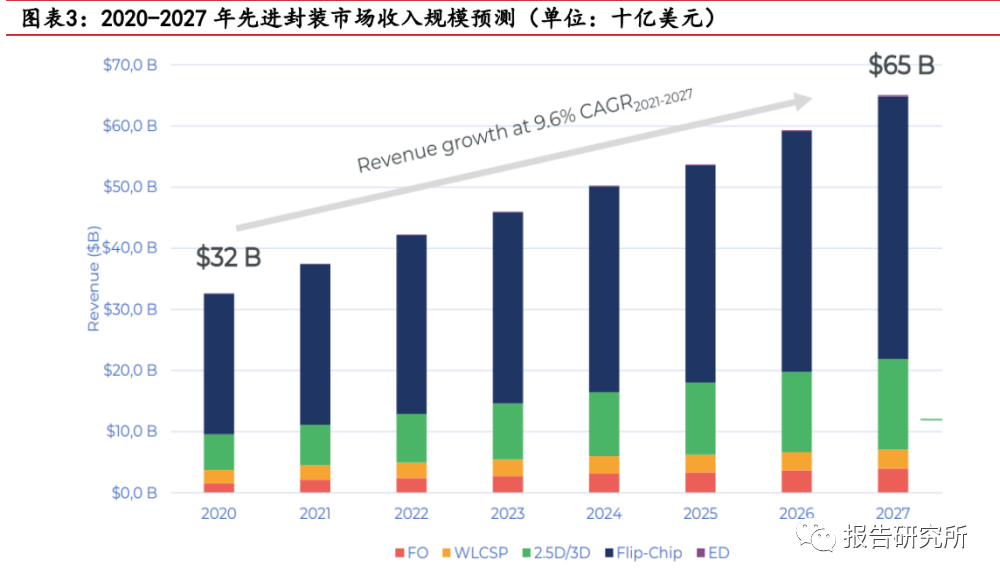
1.3 先進(jìn)封裝處于晶圓制造與封測的交叉區(qū)域
先進(jìn)封裝處于晶圓制造與封測制程中的交叉區(qū)域,涉及 IDM、晶圓代工、封 測廠商。先進(jìn)封裝要求在晶圓劃片前融入封裝工藝步驟,具體包括應(yīng)用晶圓研磨 薄化、重布線(RDL)、凸塊制作(Bumping)及硅通孔(TSV)等工藝技術(shù),涉及 與晶圓制造相似的光刻、顯影、刻蝕、剝離等工序步驟,從而使得晶圓制造與封 測前后道制程中出現(xiàn)中道交叉區(qū)域。前后道大廠爭先布局先進(jìn)封裝,競爭格局較為集中。后摩爾時代,先進(jìn)制程 成本快速提升,一些晶圓代工大廠發(fā)展重心正在從過去追求更先進(jìn)納米制程,轉(zhuǎn) 向封裝技術(shù)的創(chuàng)新。諸如臺積電、英特爾、三星、聯(lián)電等芯片制造廠商紛紛跨足 封裝領(lǐng)域。先進(jìn)封裝競爭格局較為集中,全球主要的 6 家廠商,包括 2 家 IDM 廠 商(英特爾、三星),一家代工廠商(臺積電),以及全球排名前三的封測廠商(日 月光、Amkor、JCET),共處理了超過 80%的先進(jìn)封裝晶圓。
2 TSV:硅通孔,先進(jìn)封裝關(guān)鍵技術(shù)
2.1 TSV:硅通孔技術(shù),芯片垂直堆疊互連的關(guān)鍵技術(shù)
TSV(Through Silicon Via),硅通孔技術(shù),是通過硅通道垂直穿過組成堆 棧的不同芯片或不同層實現(xiàn)不同功能芯片集成的先進(jìn)封裝技術(shù)。TSV 主要通過銅 等導(dǎo)電物質(zhì)的填充完成硅通孔的垂直電氣互連,減小信號延遲,降低電容、電感, 實現(xiàn)芯片的低功耗、高速通信,增加帶寬和實現(xiàn)器件集成的小型化需求。此前,芯片之間的大多數(shù)連接都是水平的,TSV 的誕生讓垂直堆疊多個芯片 成為可能。Wire bonding(引線鍵合)和 Flip-Chip(倒裝焊)的 Bumping(凸 點(diǎn))提供了芯片對外部的電互連,RDL(再布線)提供了芯片內(nèi)部水平方向的電互 連,TSV 則提供了硅片內(nèi)部垂直方向的電互連。
2.2 TSV 三種主要應(yīng)用方向:背面連接、2.5D 封裝、3D 封裝
TSV 有多種用途,可大致分為 3 種:(a) 垂直的背面連接,無芯片堆疊,如“簡單的背面連接”。TSV 位于有源晶 粒(active die)中,用于連接至晶圓背面的焊盤(bond pad);(b) 2.5D 封裝。晶粒(die)連接至硅中介層(interposer),TSV 在中介層 中;(c) 3D 封裝。TSV 位于有源晶粒中,用于實現(xiàn)芯片堆疊。
(a)TSV 作為簡單背面連接:用于 CIS 和鍺化硅(SiGe)功率放大器
TSV 三種主要應(yīng)用方式中,簡單的背面連接結(jié)構(gòu)是技術(shù)難度最低的,也是 TSV 技術(shù)首次大規(guī)模投入生產(chǎn)時的應(yīng)用方向,如 CMOS 圖像傳感器(CIS)、SiGe 功率 放大器兩個產(chǎn)品就應(yīng)用了 TSV 技術(shù)。將 TSV 用于 CMOS 圖像傳感器有許多優(yōu)點(diǎn):1)使用 TSV 代替引線鍵合可以減小相機(jī)模組的尺寸。2)簡化了圖像傳感器的晶圓級封裝(WLP)。WLP 工藝的第一步 是將玻璃晶圓附著到圖像傳感器的正面,防止光刻膠(抗蝕劑)微透鏡在組裝過程 中受到損壞和污染,然而安裝好玻璃晶圓后會使從晶圓正面到焊盤的連接途徑受 阻,TSV 通過簡化晶圓級封裝,對此問題提供了簡易的解決方法。
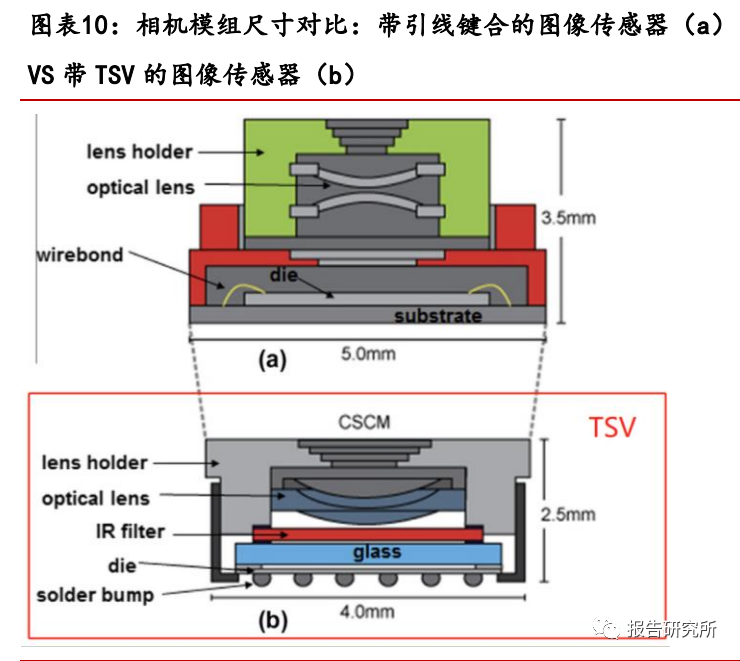
(b)TSV 應(yīng)用于 2.5D 封裝:FPGA
與簡單的背面連接相比,2.5D 先進(jìn)封裝的硅中介層需要更小的 TSV 間距 (≤50 μm),因此需要更先進(jìn)的 TSV 工藝。現(xiàn)場可編程門陣列(Field Programmable Gate Array,F(xiàn)PGA)器件是最早 使用硅中介層的產(chǎn)品之一:硅中間層可以使芯片間密切連接,整合后的結(jié)構(gòu)看起 來像單個大尺寸的 FPGA 芯片,解決了早期直接構(gòu)建單個大尺寸 FPGA 芯片的技術(shù) 難題。
(c)TSV 應(yīng)用于 3D 封裝:存儲器堆疊
儲器堆疊是首批應(yīng)用 3D 堆疊 TSV 結(jié)構(gòu)的產(chǎn)品之一,和 2.5D 封裝中硅中階層 對 TSV 間距的需求相似,但實際應(yīng)用中難度更高,例如寬 I/O DRAM 設(shè)備。使用寬 I/O DRAM 和芯片堆疊的優(yōu)勢包括封裝高度降低40%,功耗降低50%, 帶寬增加 6 倍。
2.3 國內(nèi)封測廠 TSV 布局情況:多家頭部廠商已有布局
內(nèi)資封測廠商向 TSV 等先進(jìn)封裝領(lǐng)域突破。全球半導(dǎo)體產(chǎn)業(yè)經(jīng)歷二次產(chǎn)業(yè)轉(zhuǎn) 移,目前處于第三次產(chǎn)業(yè)轉(zhuǎn)移的進(jìn)程之中,作為半導(dǎo)體領(lǐng)域壁壘相對較低的領(lǐng)域, 封測產(chǎn)業(yè)目前主要轉(zhuǎn)移至亞洲區(qū)域,主要包括中國大陸、中國臺灣、東南亞等。封測是中國大陸集成電路發(fā)展最為完善的板塊,技術(shù)能力與國際先進(jìn)水平比較接 近,我國封測市場已形成內(nèi)資企業(yè)為主的競爭格局。中國大陸封測市場目前主要 以傳統(tǒng)封裝業(yè)務(wù)為主,經(jīng)過多年的技術(shù)創(chuàng)新和市場積累,內(nèi)資企業(yè)產(chǎn)品已由 DIP、 SOP、SOT、QFP 等產(chǎn)品向 QFN/DFN、BGA、CSP、FC、TSV、LGA、WLP 等技術(shù)更先進(jìn) 的產(chǎn)品發(fā)展,并且在 WLCSP、FC、BGA 和 TSV 等技術(shù)上取得較為明顯的突破,產(chǎn) 量與規(guī)模不斷提升,逐步縮小與外資廠商之間的技術(shù)差距,極大地帶動我國封裝 測試行業(yè)的發(fā)展。
我國頭部封測企業(yè),如長電科技、通富微電、華天科技、晶方科技已有采用 TSV技術(shù)封裝的產(chǎn)品批量出貨。2.5D/3D封裝所需的晶圓內(nèi)部的加工如TSV加工, 硅轉(zhuǎn)接板加工等工序?qū)儆诰A廠擅長制程,而晶圓,裸芯片(Die)之間的高密度 互聯(lián)和堆疊,以及和基板,接點(diǎn)的互聯(lián)技術(shù)屬于芯片后道成品制造環(huán)節(jié)的優(yōu)勢。應(yīng)用于 CoWoS 等 2.5D/3D 先進(jìn)封裝中的 TSV 技術(shù)對深寬比等有更高要求,需要用 到諸多前道設(shè)備,仍多由晶圓廠來完成。國內(nèi)封測廠則在先進(jìn)封裝平臺、CIS 封 裝等領(lǐng)域?qū)?TSV 技術(shù)有所布局。長電科技的 XDFOI技術(shù)平臺有 TSV less 和 TSV 方案。通富微電 2021 年在高性能計算領(lǐng)域建成了 2.5D/3D 封裝平臺(VISionS) 及超大尺寸 FCBGA 研發(fā)平臺,并完成高層數(shù)再布線技術(shù)開發(fā),可為客戶提供晶圓 級和基板級 Chiplet 封測解決方案;在存儲器領(lǐng)域,多層堆疊 NAND Flash 及 LPDDR 封裝實現(xiàn)穩(wěn)定量產(chǎn),并在國內(nèi)首家完成基于 TSV 技術(shù)的 3DS DRAM 封裝開 發(fā)。華天科技工業(yè)級 12 吋 TSV-CIS 產(chǎn)品已實現(xiàn)量產(chǎn)。晶方科技應(yīng)用晶圓級硅通 孔(TSV)封裝技術(shù),聚焦以影像傳感芯片為代表的智能傳感器市場,封裝的產(chǎn)品 主要包括 CIS 芯片、TOF 芯片、生物身份識別芯片、MEMS 芯片等,應(yīng)用于智能手 機(jī)、安防監(jiān)控數(shù)碼、汽車電子等市場領(lǐng)域。
3 TSV 制造流程及所需設(shè)備
3.1 TSV 制造流程
-
芯片
+關(guān)注
關(guān)注
463文章
54010瀏覽量
466058 -
摩爾定律
+關(guān)注
關(guān)注
4文章
640瀏覽量
80905 -
封裝
+關(guān)注
關(guān)注
128文章
9249瀏覽量
148624 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
533瀏覽量
1027
原文標(biāo)題:電子行業(yè)TSV研究框架:先進(jìn)封裝關(guān)鍵技術(shù)
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
華宇電子分享在先進(jìn)封裝技術(shù)領(lǐng)域的最新成果
硅通孔電鍍材料在先進(jìn)封裝中的應(yīng)用

TSV制造工藝概述

TGV技術(shù):推動半導(dǎo)體封裝創(chuàng)新的關(guān)鍵技術(shù)

TSV技術(shù)的關(guān)鍵工藝和應(yīng)用領(lǐng)域

DPC陶瓷覆銅板:高性能電子封裝的關(guān)鍵技術(shù)
突破!華為先進(jìn)封裝技術(shù)揭開神秘面紗
英特爾先進(jìn)封裝,新突破
射頻系統(tǒng)先進(jìn)封裝技術(shù)研究進(jìn)展
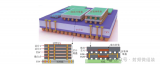
電機(jī)系統(tǒng)節(jié)能關(guān)鍵技術(shù)及展望
TSV以及博世工藝介紹

先進(jìn)碳化硅功率半導(dǎo)體封裝:技術(shù)突破與行業(yè)變革

揭秘激光錫絲焊接機(jī)在電子制造業(yè)中的關(guān)鍵技術(shù)




 電子行業(yè)TSV研究框架:先進(jìn)封裝關(guān)鍵技術(shù)
電子行業(yè)TSV研究框架:先進(jìn)封裝關(guān)鍵技術(shù)






評論