近兩年新能源汽車和光伏儲能市場的火熱,讓半導體供應上升到了很多公司戰略層面的考慮因素。特別是SiC的供應更加緊俏。最近幾年用戶對SiC的使用更有經驗,逐漸發揮出了其高效率高功率密度的優點,正在SiC使用量增大的階段,卻面臨了整個市場的缺貨的狀態。碳化硅功率器件缺貨有很多因素,目前前道是最大的瓶頸,特別是前道的“最前端” ,SiC襯底片和外延片是目前缺貨最嚴重的材料。
面對這種問題,作為功率半導體的領頭羊英飛凌又有哪些舉措呢?一方面,英飛凌與多家晶圓廠簽訂長期供貨協議推動其碳化硅(SiC)供應商體系多元化,保證晶圓供應。就在本月,英飛凌與中國碳化硅供應商北京天科合達半導體股份有限公司和山東天岳先進科技股份有限公司分別簽訂了長期協議,以確保獲得更多而且具有競爭力的碳化硅材料供應。協議將為英飛凌供應高質量并且有競爭力的150毫米碳化硅晶圓和晶錠,以及助力英飛凌向200毫米直徑碳化硅晶圓的過渡。其供應量預計將占到英飛凌長期需求量的兩位數份額。另一方面,英飛凌繼續在歐洲和亞洲擴產,增加碳化硅產能。
除此之外,英飛凌還有一個增加晶圓利用率的獨門黑科技:冷切割(cold split)技術。幾年前英飛凌收購了一家名為SILTECTRA的科技公司,其核心技術“冷切割”,是一種高效的晶體材料加工工藝,能夠將材料損失降到最低。英飛凌目前已經開始將這項技術用于SiC晶錠的切割上,從而讓單個晶錠可出產的芯片數量翻番。在未來,這項技術還可以用于晶圓制作過程中的切割,進一步提高芯片產量。
傳統的芯片制作過程包括晶圓切片,外延生長,芯片正面工藝和背部減薄等。其中晶錠的切片和背部減薄工序對SiC材料的“浪費”最多,幾乎可以達到四分之三。
晶圓切割工藝包括鋸切割和研磨,其中鋸切割通常采用金剛石線切割碳化硅的晶錠,效率低而且碳化硅晶錠和金剛石線的損耗也很高。不僅如此,鋸切割的晶圓片切割面平整度比較差,這對后續SiC芯片的制作良率也造成一定的障礙。研磨除了在晶圓處理過程中需要使用之外,在芯片最后的背部減薄工藝中也經常會用到,這一步對于原材料的損耗也很大。針對傳統的處理方式,冷切割技術則可以大大的提高晶圓利用率,并改進切面的平整度和良率。
那么冷切割技術又是如何進行的呢?首先在碳化硅晶錠切片過程中,采用低溫和激光技術切出晶圓片Wafer,這一步相比于鋸切割對于材料的損耗幾乎可以忽略不計。
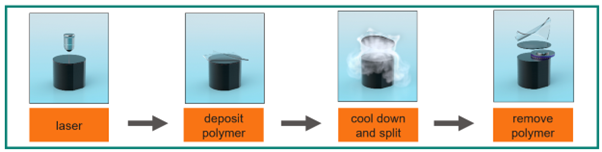
在芯片工藝的最后,冷切割技術又可以替代背部減薄工藝,將本來需要磨掉的材料切下完整的一片晶圓片。更重要的是,這一片晶圓還可以再次利用,回到之前的工藝繼續生產芯片。
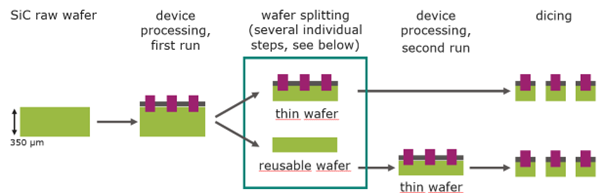
通過晶錠的切片和背部減薄的切割方法,冷切割技術理論上可以達到傳統晶圓處理方法4倍的利用率。不僅如此,冷切割技術還可以用于GaN晶錠的生產過程中。英飛凌目前已經在晶錠的切片過程中開始試產冷切割技術,未來兩年會繼續把冷切割技術用到背部減薄工藝中去。
英飛凌正著力提升碳化硅產能,以實現在2030年之前占據全球30%市場份額的目標。預計到2027年,英飛凌的碳化硅產能將增長10倍。英飛凌位于馬來西亞居林的新工廠計劃于2024年投產,屆時將補充奧地利菲拉赫工廠的產能。迄今為止,英飛凌已向全球3,600多家汽車和工業客戶提供碳化硅半導體產品。
-
英飛凌
+關注
關注
68文章
2518瀏覽量
142886 -
硅晶
+關注
關注
0文章
11瀏覽量
7769
發布評論請先 登錄
Wolfspeed成功制造出單晶300mm碳化硅晶圓
破局300mm!Wolfspeed碳化硅晶圓取得關鍵突破
重大突破!12 英寸碳化硅晶圓剝離成功,打破國外壟斷!
如何利用 AI 算法優化碳化硅襯底 TTV 厚度測量數據處理

激光干涉法在碳化硅襯底 TTV 厚度測量中的精度提升策略

【新啟航】如何解決碳化硅襯底 TTV 厚度測量中的各向異性干擾問題

碳化硅襯底切割自動對刀系統與進給參數的協同優化模型

基于機器視覺的碳化硅襯底切割自動對刀系統設計與厚度均勻性控制

自動對刀技術對碳化硅襯底切割起始位置精度的提升及厚度均勻性優化

碳化硅襯底切割進給量與磨粒磨損狀態的協同調控模型

基于進給量梯度調節的碳化硅襯底切割厚度均勻性提升技術

切割進給量與碳化硅襯底厚度均勻性的量化關系及工藝優化

碳化硅何以英飛凌?—— SiC MOSFET性能評價的真相




 英飛凌碳化硅晶圓處理黑科技——冷切割
英飛凌碳化硅晶圓處理黑科技——冷切割






評論