隨著半導(dǎo)體微納制造技術(shù)的不斷發(fā)展,尤其是集成電路(Integrated Circuit,IC)的設(shè)計(jì)線(xiàn)寬即將進(jìn)入亞納米級(jí),各個(gè)單元和互連線(xiàn)不斷細(xì)化,器件內(nèi)部的電路縱橫交錯(cuò),隔離電路中的缺陷、查明隱藏在大量晶體管和金屬線(xiàn)中的問(wèn)題的能力是產(chǎn)品快速量產(chǎn)的關(guān)鍵。分析師很難在不知道異常在哪里的情況下深入研究,而足智多謀的分析師有許多工具和技術(shù)來(lái)幫助檢測(cè)集成電路上的缺陷,比如,液晶(Liquid Crystal,LC)熱點(diǎn)檢測(cè)技術(shù),最適合用于發(fā)現(xiàn)產(chǎn)生大量熱量的短路。然而,這些技術(shù)通常是不夠的,分析人員必須找到一種方法來(lái)表征,創(chuàng)建一個(gè)基準(zhǔn)來(lái)對(duì)比一個(gè)故障單元,以檢測(cè)電子元件故障根源的缺陷。在這些情況下,EMMI提供了建立分析的完美平臺(tái)。
微光顯微鏡(Emission Microscope, EMMI)是利用高增益相機(jī)/探測(cè)器來(lái)檢測(cè)由某些半導(dǎo)體器件缺陷/失效發(fā)出的微量光子的一種設(shè)備。
當(dāng)對(duì)樣品施加適當(dāng)電壓時(shí),其失效點(diǎn)會(huì)因加速載流子散射或電子-空穴對(duì)的復(fù)合而釋放特定波長(zhǎng)的光子。這些光子經(jīng)過(guò)收集和圖像處理后,就可以得到一張信號(hào)圖。撤去樣品施加的電壓后,再收集一張背景圖,把信號(hào)圖和背景圖疊加之后,就可以確定發(fā)光點(diǎn)的位置,從而實(shí)現(xiàn)對(duì)失效點(diǎn)的定位。
InGaAs EMMI和傳統(tǒng)EMMI具有相同的原理和功能。兩種探測(cè)光子都是由電子-空穴復(fù)合和熱載流子觸發(fā)的。它們的不同之處在于InGaAs具有更高的靈敏度,并且可以檢測(cè)更長(zhǎng)的波長(zhǎng)范圍900-1700 nm(相對(duì)于 350-1100 nm 的傳統(tǒng)EMMI),這與 IR(紅外) 的光譜波長(zhǎng)相同。
EMMI是發(fā)現(xiàn)許多不同半導(dǎo)體失效的一種強(qiáng)大工具,是指引失效分析進(jìn)一步深入的一盞指路明燈。然而,就其本身而言,它只是收集數(shù)據(jù)的一種方式。就像一個(gè)沒(méi)有經(jīng)驗(yàn)的航行者盡管查閱了最好的海圖、星圖,但可能仍然會(huì)發(fā)現(xiàn)他們的船擱淺了一樣,一個(gè)注重細(xì)節(jié)、技術(shù)熟練的分析團(tuán)隊(duì)是必要的,他們能利用來(lái)自EMMI的數(shù)據(jù),進(jìn)一步闡明問(wèn)題并成功確定失效的根本原因。
金鑒實(shí)驗(yàn)室是一家專(zhuān)注于第三代半導(dǎo)體氮化鎵和碳化硅芯片和器件失效分析的新業(yè)態(tài)的科研檢測(cè)機(jī)構(gòu),具備國(guó)家認(rèn)可及授權(quán)的CMA/CNAS資質(zhì),并是工信部認(rèn)定的“國(guó)家中小企業(yè)公共服務(wù)示范平臺(tái)”,廣東省工信廳認(rèn)定的“LED失效分析公共服務(wù)示范平臺(tái)”,廣州市中級(jí)人民法院司法鑒定專(zhuān)業(yè)委托機(jī)構(gòu)。
金鑒實(shí)驗(yàn)室擁有一支由國(guó)家級(jí)人才工程入選者和行業(yè)資深管理和技術(shù)專(zhuān)家組成的團(tuán)隊(duì),博士、研究生、本科生以上學(xué)歷人員占比超過(guò)90%,專(zhuān)業(yè)涵蓋光電、電子、化學(xué)、材料等各個(gè)方向,大部分有三代半導(dǎo)體材料和器件工廠(chǎng)工作經(jīng)歷。團(tuán)隊(duì)每月積累數(shù)百個(gè)行業(yè)案例分析經(jīng)驗(yàn),在半導(dǎo)體芯片和器件材料檢測(cè)與失效分析領(lǐng)域已達(dá)到了世界領(lǐng)先水平。
金鑒實(shí)驗(yàn)室擁有自主研發(fā)的EMMI,如下圖所示。
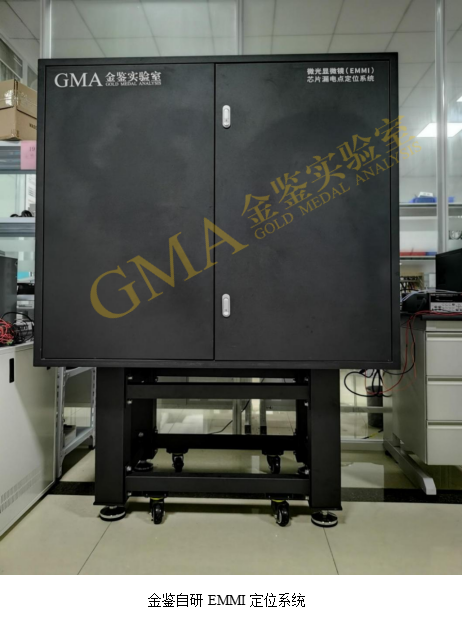
儀器特點(diǎn):
①I(mǎi)nGaAs采集相機(jī),在近紅外區(qū)域具備高靈敏度;
②分辨率高;
③多倍率圖像采集:5X~100X;
④超低溫電制冷降低暗電流帶來(lái)的信噪;
⑤電制冷/空氣冷卻自由轉(zhuǎn)換。
應(yīng)用范圍:
①LED故障分析
②太陽(yáng)能電池評(píng)估
③半導(dǎo)體失效分析
④EL/PL圖像采集
⑤光通信設(shè)備分析
檢測(cè)到亮點(diǎn)的情況:
引起熱點(diǎn)的缺陷:會(huì)產(chǎn)生亮點(diǎn)的缺陷-漏電結(jié);接觸毛刺;熱電子效應(yīng);閂鎖效應(yīng);氧化層漏電;多晶硅晶須;襯底損傷;物理?yè)p傷等。
原本存在的亮點(diǎn):飽和/有源雙極晶體管、飽和MOS/動(dòng)態(tài)CMOS、正向偏置二極管/反向偏置二極管(擊穿)。
無(wú)法檢測(cè)到亮點(diǎn)的情況:無(wú)光點(diǎn)的缺陷、歐姆接觸、金屬互聯(lián)短路、表面反型層和硅導(dǎo)電通路等。
案例分析
1、客戶(hù)送樣漏電LED藍(lán)光芯片,通過(guò)InGaAs EMMI測(cè)試在芯片正極電極位置檢測(cè)到異常點(diǎn)。

2、客戶(hù)送樣漏電LED藍(lán)光倒裝芯片,通過(guò)InGaAs EMMI測(cè)試在芯片位置可檢測(cè)到異常點(diǎn),并觀(guān)察到擊穿形貌。
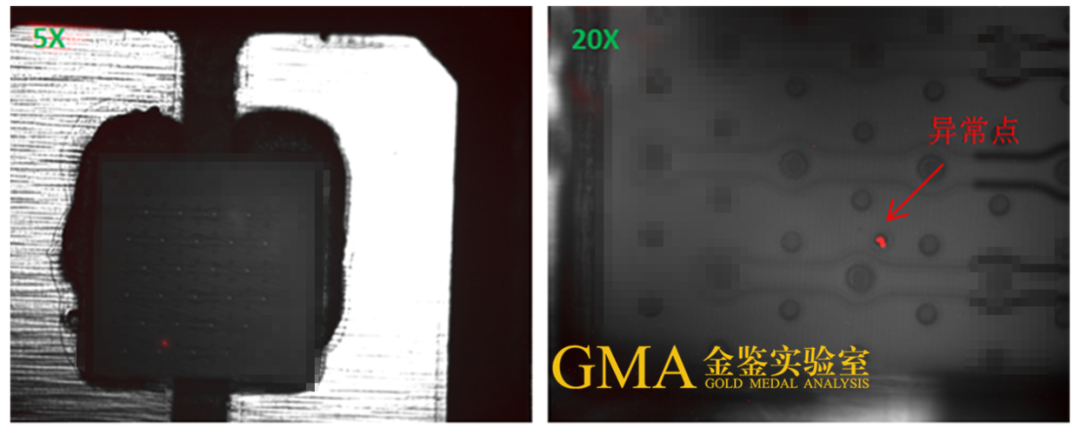
3、客戶(hù)送樣漏電LED紅光垂直芯片,通過(guò)InGaAs EMMI測(cè)試在芯片位置可檢測(cè)到異常點(diǎn)。

4、客戶(hù)送樣硅基芯片,通過(guò)InGaAs EMMI測(cè)試在芯片位置可檢測(cè)到異常點(diǎn)。

有了EMMI這盞指路明燈指引著我們進(jìn)行進(jìn)一步的失效分析,配合FIB(聚焦離子束系統(tǒng))為進(jìn)一步的失效分析提供了更強(qiáng)大制樣和分析的手段。
-
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30737瀏覽量
264163
發(fā)布評(píng)論請(qǐng)先 登錄
芯片失效故障定位技術(shù)中的EMMI和OBIRCH是什么?
一文了解什么是功率半導(dǎo)體器件產(chǎn)品的失效

LED失效分析方法與應(yīng)用實(shí)踐

半導(dǎo)體“聚焦離子束(FIB)”分析技術(shù)的詳解;

半導(dǎo)體“基礎(chǔ)FMEA和家族?FMEA”分析的詳解;

半導(dǎo)體“金(Au)絲引線(xiàn)鍵合”失效機(jī)理分析、預(yù)防及改善的詳解;

晶背暴露的MOS管漏電怎么查?熱紅外顯微鏡Thermal EMMI 熱點(diǎn)分析案例

是德科技Keysight B1500A 半導(dǎo)體器件參數(shù)分析儀/半導(dǎo)體表征系統(tǒng)主機(jī)
半導(dǎo)體器件的靜電放電(ESD)失效機(jī)理與防護(hù)設(shè)計(jì)

探秘鍵合點(diǎn)失效:推拉力測(cè)試機(jī)在半導(dǎo)體失效分析中的核心應(yīng)用

BW-4022A半導(dǎo)體分立器件綜合測(cè)試平臺(tái)---精準(zhǔn)洞察,卓越測(cè)量
熱發(fā)射顯微鏡下芯片失效分析案例:IGBT 模組在 55V 就暴露的問(wèn)題!

如何用FIB截面分析技術(shù)做失效分析?
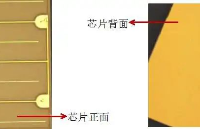



 半導(dǎo)體失效分析的指路明燈-EMMI
半導(dǎo)體失效分析的指路明燈-EMMI





評(píng)論