鍺硅(SiGe)外延(p-MOS源漏)
自 32 nm節點以來,CMOS 器件結構已從多晶硅柵(如硅氧化/多晶硅結構)和非應變源漏結構演變到利用高k柵介質/金屬柵 (high-k/ Metal-Gate, HKMG)和應變硅源漏,如圖所示。
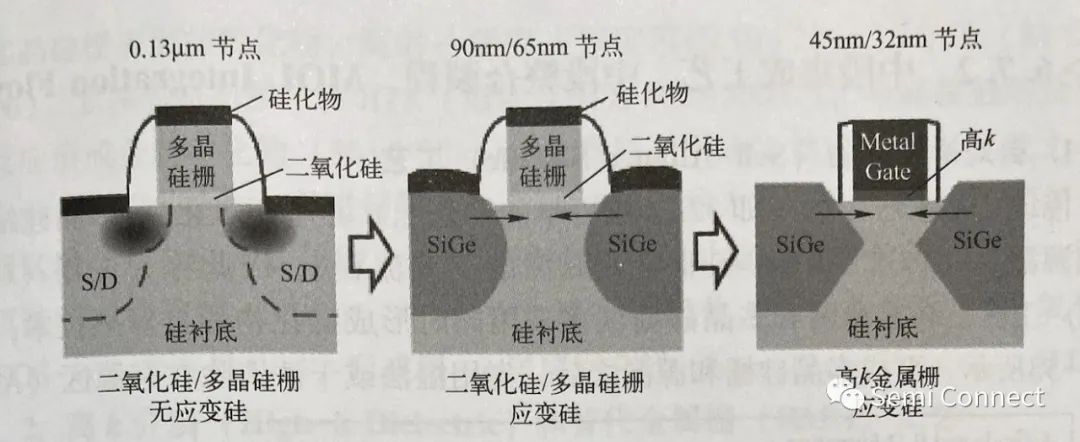
其制造工藝流程如下:首先形成補償側墻(Offset Spacer),經n+/p+輕摻雜源漏后,選擇性地進行圖形化,在p型源漏區先進行干法刻蝕,使其凹陷適當的深度(30~100nm);然后采用濕法各向異性刻蝕形成“鉆石”形腔(Diamond Cavity,又稱“∑”形狀);接著外延鍺硅(SiGe)形成p-MOS 的源漏,p型摻雜可由原位硼摻雜或硼離子注入和快速熱退火(RTA) 來形成。p型源漏的鉆石形鍺硅面向溝道的鄰近尖點(DiamondTip),可有效地增強沿溝道方向的壓應力,因此也增強了溝道空穴遷移率。
審核編輯 :李倩
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
CMOS
+關注
關注
58文章
6217瀏覽量
242841 -
晶硅
+關注
關注
1文章
57瀏覽量
23434
原文標題:前段集成工藝(FEOL)- 6
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
熱點推薦
集成電路制造中薄膜生長工藝的發展歷程和分類
薄膜生長是集成電路制造的核心技術,涵蓋PVD、CVD、ALD及外延等路徑。隨技術節點演進,工藝持續提升薄膜均勻性、純度與覆蓋能力,支撐銅互連、高k柵介質及應變器件發展。未來將聚焦低溫沉積、三維結構適配與新材料集成,實現性能與可靠

集成電路制造中常用濕法清洗和腐蝕工藝介紹
集成電路濕法工藝是指在集成電路制造過程中,通過化學藥液對硅片表面進行處理的一類關鍵技術,主要包括濕法清洗、化學機械拋光、無應力拋光和電鍍四大類。這些工藝貫穿于芯片制造的多個關鍵環節,直

燕東微北電集成12英寸生產線工藝設備順利搬入
歲末冬安,圓夢芯成。2025年12月10日,北京燕東微電子股份有限公司(688172.SH)旗下北京電控集成電路制造有限責任公司12英寸集成電路生產線項目(以下簡稱“燕東微北電集成項目”)迎來
集成電路制造中薄膜刻蝕的概念和工藝流程
薄膜刻蝕與薄膜淀積是集成電路制造中功能相反的核心工藝:若將薄膜淀積視為 “加法工藝”(通過材料堆積形成薄膜),則薄膜刻蝕可稱為 “減法工藝”(通過材料去除實現圖形化)。通過這一 “減”

半導體外延工藝在哪個階段進行的
半導體外延工藝主要在集成電路制造的前端工藝(FEOL)階段進行。以下是具體說明:所屬環節定位:作為核心步驟之一,外延屬于前端制造流程中的關鍵環節,其目的是在單晶襯底上有序沉積單晶材料以
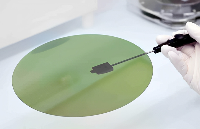
半導體分層工藝的簡單介紹
在指甲蓋大小的硅片上建造包含數百億晶體管的“納米城市”,需要極其精密的工程規劃。分層制造工藝如同建造摩天大樓:先打地基(晶體管層),再逐層搭建電路網絡(金屬互連),最后封頂防護(封裝層)。這種將芯片分為FEOL(前道工序) 與 BEOL(后道工序) 的智慧,正是半導體工業
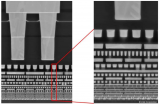
半導體封裝工藝流程的主要步驟
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、上焊錫、打碼、外觀檢查、成品測試和包裝出庫,涵蓋了前段(FOL)、中段(EOL)、電鍍(plating)、后段(EOL)以及終測(final test)等多個關鍵環節。

概倫電子集成電路工藝與設計驗證評估平臺ME-Pro介紹
ME-Pro是概倫電子自主研發的用于聯動集成電路工藝與設計的創新性驗證評估平臺,為集成電路設計、CAD、工藝開發、SPICE模型和PDK專業從業人員提供了一個共用平臺。




 前段集成工藝(FEOL)
前段集成工藝(FEOL)


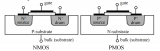








評論