濕法刻蝕也稱腐蝕。硅的濕法刻蝕是 MEMS 加工中常用的技術。其中,各向同性 (Isotropic)濕法刻蝕常用的腐蝕劑是由氫氟酸(HF)、硝酸( HNO3)和乙酸(CH3COOH)組成的混合物(也稱為 HNA 腐蝕劑);對硅的刻蝕速率和對掩模材料的刻蝕選擇性可通過各組分比例的不同來調節。目前,各向同性濕法刻蝕的實際應用較少。
硅的各向異性(Anisotropic)濕法刻蝕技術已成功用于多種 MEMS 產品中,如硅壓力傳感器、加速度計、MEMS 傳聲器等。硅的各向異性腐蝕主要是利用各個硅晶體面腐蝕速率不同而實現的。利用這種特性,可以在硅襯底上加工出多種多樣的結構,如凹槽(可應用于壓力傳感器的腔體等)、金字塔結構(可應用手原子力顯微鏡探針等)或懸浮結構(可應用于加速度計的懸臂梁等)等。
在各向異性濕法刻蝕中,隨著腐蝕時間的推移,快速腐蝕面將消失,僅留下低速腐蝕面,此時腐蝕腔體的形狀幾乎不再變化,但其尺寸會隨著慢速腐蝕面的腐蝕而略有增大,這時獲得的腔體稱為自限制圖形。
對于 「100」 硅襯底,預測任-意掩模圖案的自限制圖形腐蝕窗口的方法為:1.確定掩模圖案上沿《110》晶向的上下左右4個方向上的最上點、最下點、最左點和最右點; 2.過這4個點做平行于《110》晶向的4 條直線; 3.這4條直線圍成的區域即為自穩定圖形的窗口形貌;4.腐蝕的深度由硅片厚度,有無自停止層和窗口尺寸共同決定。
在某些加工中,往往需要避免出現凸角刻蝕。例如,當需要的一個矩形凸臺時,凸角腐蝕將導致矩形的4個角嚴重失真。此時,就需要利用凸角補償方法來完成腐蝕。常見的凸角補償主要是在掩模版設計時,在凸角處增加圖形,完成對凸角的保護,補償圖形的尺寸與形狀隨腐蝕深度與腐蝕液種類的不同而調節,通過控制補償圖形,可以得到非常理想的凸角結構。
-
傳感器
+關注
關注
2576文章
55028瀏覽量
791243 -
mems
+關注
關注
129文章
4475瀏覽量
198784 -
硅晶體
+關注
關注
0文章
10瀏覽量
3752
原文標題:濕法蝕刻(Wet Etching)
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
濕法刻蝕工作臺工藝流程
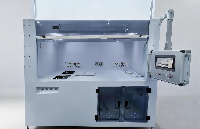
濕法蝕刻的最佳刻蝕條件是什么
晶圓濕法刻蝕技術有哪些優點

半導體濕法腐蝕工藝中,如何選擇合適的掩模圖形來控制腐蝕區域?
白光干涉儀在晶圓濕法刻蝕工藝后的 3D 輪廓測量

濕法刻蝕的工藝指標有哪些
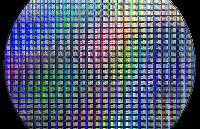
濕法刻蝕sc2工藝應用是什么

濕法刻蝕的主要影響因素一覽
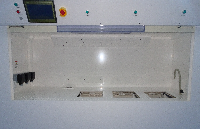
VirtualLab Fusion:分層介質元件
一文詳解濕法刻蝕工藝




 常見的各向同性濕法刻蝕的實際應用
常見的各向同性濕法刻蝕的實際應用





評論