介紹
隨著半導體器件的小型化和超大規模集成(VLSI)電路的圖案密度的增加,單個光致抗蝕劑掩模不再適用于細線圖案化和接觸圖案化。 盡管單光刻膠掩模工藝被認為是器件制造中的簡單工藝,但在接觸氧化物期間,它對光刻膠掩模層的氧化物蝕刻選擇性低光刻從365納米I-線和248納米KrF變為193納米ArF和13.56納米遠紫外(EUV),為了增加光致抗蝕劑的透射率,光致抗蝕劑材料的主鏈結構必須從硬的芳族結構變為軟的脂族結構,其具有較低的光吸收,并且這種軟結構進一步降低了氧化物的蝕刻選擇性為了抵抗,由于其柔軟性,圖案化的光致抗蝕劑在長時間暴露于等離子體的過程中容易變形,產生諸如扭曲和缺口的問題。
在反應離子蝕刻器中使用氧等離子體氧等離子體中存在的自由基傾向于引起圖案化ACL的不希望的側壁蝕刻,這導致弓形蝕刻輪廓和增加的頂部圖案開口。
在本研究中,引入COS作為一種新的氧氣添加氣體,在刻蝕ACL的過程中形成有效的側壁鈍化層,而不會顯著改變ACL的刻蝕速率。已經研究了通過向氧等離子體中引入COS作為添加氣體,ACL硬掩模蝕刻輪廓和蝕刻機理的變化,并且還研究了由于改進的50納米尺寸ACL接觸硬掩模,HARC二氧化硅的蝕刻特性。
結果和討論
數字1 顯示了僅使用O2而不使用任何添加氣體蝕刻的ACL的(a)孔輪廓和(b)頂部孔形狀的SEM照片。工藝條件是900 W 60 MHz rf功率、20毫托O2 (200 sccm)和300 K。當僅使用O2蝕刻ACL時,獲得具有寬頂部孔尺寸和窄底部孔尺寸的錐形無定形碳孔蝕刻輪廓。此外,在頂部孔區域附近,還觀察到弓形無定形碳孔輪廓。在反應離子蝕刻期間,由于在襯底附近形成的鞘電勢,氧離子被垂直吸引到晶片表面,并且它們各向異性地蝕刻ACL。然而,氧等離子體中的氧自由基和被SiON掩模散射的氧離子傾向于增強頂部接觸區域附近的側壁蝕刻,導致通過ACL的各向同性蝕刻的弓形和錐形無定形碳孔蝕刻輪廓,其隨著蝕刻深度的增加而減小。并且,如圖2所示。1(b)隨著蝕刻時間增加到(b) 50%過蝕刻和(c) 100%過蝕刻,其中過蝕刻百分比定義為總蝕刻時間/剛好蝕刻
時間為0.5 lm厚的ACL)×100%,孔洞最終通過孔頂側的過度開口合并。隨著蝕刻深度和無定形碳孔的縱橫比的增加,在圖2中觀察到的錐形和弓形。1(a),變得更加嚴重,如圖。1(b)隨著蝕刻時間的增加,蝕刻量增加。然后,由于孔頂側的過度開口,孔最終合并。
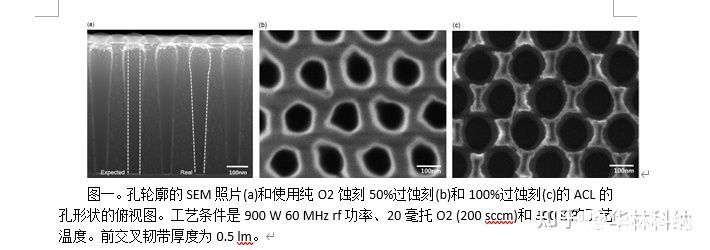

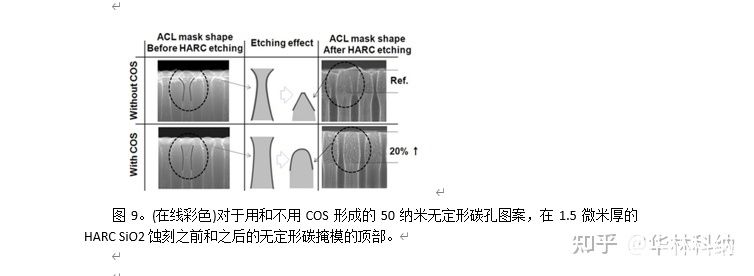
在50納米HARC二氧化硅的蝕刻中,使用具有和不具有COS的O2等離子體形成的無定形碳孔圖案被用作蝕刻掩模。使用與蝕刻不同的反應離子蝕刻器來蝕刻HARC二氧化硅
實驗蝕刻中使用的條件。在1.5 lm厚的HARC二氧化硅蝕刻之前和之后,無定形碳掩模的頂部顯示在圖1中。9 對于50納米有和沒有COS形成的無定形碳孔圖案。當蝕刻HARC二氧化硅時,由于弓形和錐形側壁蝕刻,無定形碳掩模具有窄的瓶頸狀輪廓(圖2中的圖片)。9 左上或圖。1左)比添加COS后形成的具有改進輪廓的掩模蝕刻得更快。9左下方或圖。7底部)是因為通過傾斜的物理轟擊增強了掩模層的去除角度。在蝕刻1.5 lm厚的HARC二氧化硅之后對于用COS形成的非晶碳掩模,剩余的非晶碳層較厚,并且該厚層將SiO2蝕刻選擇性(掩模層的蝕刻速率/SiO 2層的蝕刻速率之比)提高了約20%,這是通過對于沒有COS的非晶碳掩模層的剩余非晶碳層實現的。此外,由于添加COS改善了無定形碳底部開口,SiO2接觸輪廓的開口率(頂部孔尺寸/底部孔尺寸的比率)改善了約5%。
.結論
為了改善ACL用作HARC二氧化硅刻蝕掩膜的刻蝕特性,在O2等離子體中加入一種新的添加氣體COS,研究了它對無定形碳孔刻蝕特性的影響。當在反應離子蝕刻器中使用沒有COS的氧等離子體蝕刻覆蓋有50 nm SiON掩模的ACL時,獲得了無定形碳孔的弓形蝕刻輪廓和錐形蝕刻輪廓。此外,還觀察到無定形碳孔形狀的扭曲。然而,當向O2等離子體中添加5% COS時,即使ACL的蝕刻速率略微降低了約8%,無定形碳的蝕刻輪廓也顯示出改善;也就是說,添加5%的COS,側壁彎曲寬度減少約10%,底孔開口增加約20%,因此提高37%
由于在蝕刻的無定形碳孔的側壁上沉積了硫化碳相關的鈍化層,可以獲得總蝕刻輪廓比率(頂部孔尺寸/底部孔尺寸的比率)。由于硫化碳相關層在無定形碳孔側壁上的均勻沉積,無定形碳孔的變形也可能改善了約6%。當使用在具有COS的O2等離子體中形成的無定形碳掩模蝕刻HARC SiO2時,由于無定形碳掩模輪廓的改善,與使用在純氧等離子體中形成的無定形碳掩模蝕刻相比,可以觀察到相對于掩模層的SiO2蝕刻選擇性提高了約20%,以及頂部SiO2接觸輪廓的開口改善。使用含COS的氧等離子體蝕刻ACL的特性比使用含HBr的氧等離子體蝕刻ACL的特性更好,HBr通常用作無定形碳孔蝕刻中側壁鈍化的添加氣體。因此,認為COS可廣泛用作無定形碳掩模圖案化的添加氣體,其可應用于例如下一代深亞微米器件加工領域中的高縱橫比和高密度圖案的蝕刻。
審核編輯:符乾江
-
半導體
+關注
關注
339文章
30737瀏覽量
264129 -
刻蝕
+關注
關注
2文章
220瀏覽量
13779
發布評論請先 登錄
晶圓刻蝕清洗過濾:原子級潔凈的半導體工藝核心
晶圓濕法刻蝕技術有哪些優點

白光干涉儀在晶圓濕法刻蝕工藝后的 3D 輪廓測量

TSV制造技術里的通孔刻蝕與絕緣層
芯片刻蝕原理是什么
半導體boe刻蝕技術介紹
半導體制造關鍵工藝:濕法刻蝕設備技術解析

晶科能源碳管理系統獲萊茵符合性認證




 非晶碳層的刻蝕特性研究
非晶碳層的刻蝕特性研究








評論