熱風回流焊是整個BGA返修工藝的關鍵。其中有幾個問題比較重要:
1、芯片返修回流焊的曲線應當與芯片的原始焊接曲線接近,熱風回流焊曲線可分成四個區間:預熱區,加熱區,回流區,冷卻區,四個區間的溫度、時間參數可以分別設定,通過與計算機連接,可以將這些程序存儲和隨時調用。
2、在回流焊過程中要正確選擇各區的加熱溫度和時間,同時應注意升溫速度。一般在100℃以前,最大升溫速度不超過6 ℃/s,100℃以后最大升溫速度不超過3℃ /s,在冷卻區,最大冷卻速度不超過6℃/s。因為過高的升溫速度和降溫速度都可能損壞PCB和芯片,這種損壞有時是肉眼不能觀察到的。不同的芯片,不同的焊錫膏,應選擇不同的加熱溫度和時間。如CBGA芯片的回流溫度應高于PBGA的回流溫度,90Pb/10Sn應較63Sn/37Pb焊錫膏選用更高的回流溫度。對免洗焊膏,其活性低于非免洗焊膏,因此,焊接溫度不宜過高,焊接時間不宜過長,以防止焊錫顆粒的氧化。
3、熱風回流焊中,PCB板的底部必須能夠加熱。加熱有兩個目的:避免由于PCB板單面受熱而產生翹曲和變形;使焊錫膏溶化時間縮短。對大尺寸板返修BGA,底部加熱尤其重要。BGA-3592-G返修設備的底部加熱方式有兩種,一種是熱風加熱,一種是紅外加熱。熱風加熱的優點是加熱均勻,一般返修工藝建議采用這種加熱。紅外加熱的缺點是PCB受熱不均勻。
4、要選擇好的熱風回流噴嘴。熱風回流噴嘴屬于非接觸式加熱,加熱時依靠高溫空氣流使BGA芯片上各焊點的焊錫同時溶化。美國OK集團首先發明這種噴嘴,它將BGA元件密封,保證在整個回流過程中有穩定的溫度環境,同時可保護相鄰元件不被對流熱空氣加熱損壞。
在電子產品尤其是電腦與通信類電子產品的生產領域,半導體器件向微小型化、多功能化、綠色化發展,各種封裝技術不斷涌現,BGA/CSP是當今封裝技術的主流。其優勢在于進一步縮小半導體器件的封裝尺寸,因而提高了高密度貼裝技術水平,十分適合電子產品輕、薄、短、小及功能多樣化的發展方向。
編輯:hfy
-
pcb
+關注
關注
4404文章
23877瀏覽量
424233 -
BGA
+關注
關注
5文章
584瀏覽量
51526 -
回流焊
+關注
關注
14文章
540瀏覽量
18559
發布評論請先 登錄


氣體質量流量計和微量氧傳感器在真空回流焊爐中的應用
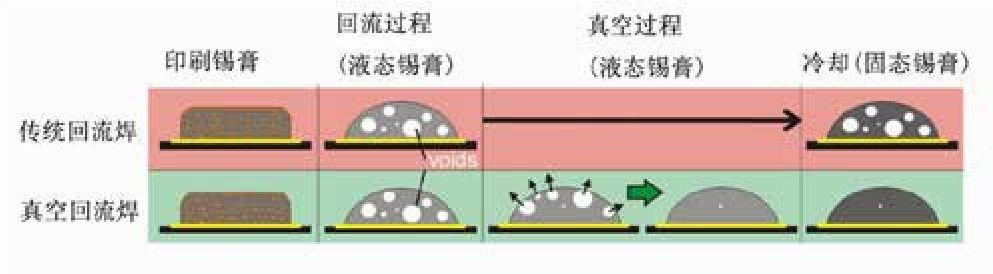
晉力達小型回流焊的優勢

淺談回流焊接技術的工藝流程
激光錫焊工藝能否替代傳統回流焊

什么是回流焊,大型雙導軌回流焊的優勢有哪些

回流焊問題導致SMT產線直通率下降,使用我司回流焊后改善的案例
淺談藍牙模塊貼片加工中的二次回流焊接
3分鐘看懂錫膏在回流焊的正確打開方式




 淺談BGA返修工藝的關鍵:熱風回流焊
淺談BGA返修工藝的關鍵:熱風回流焊


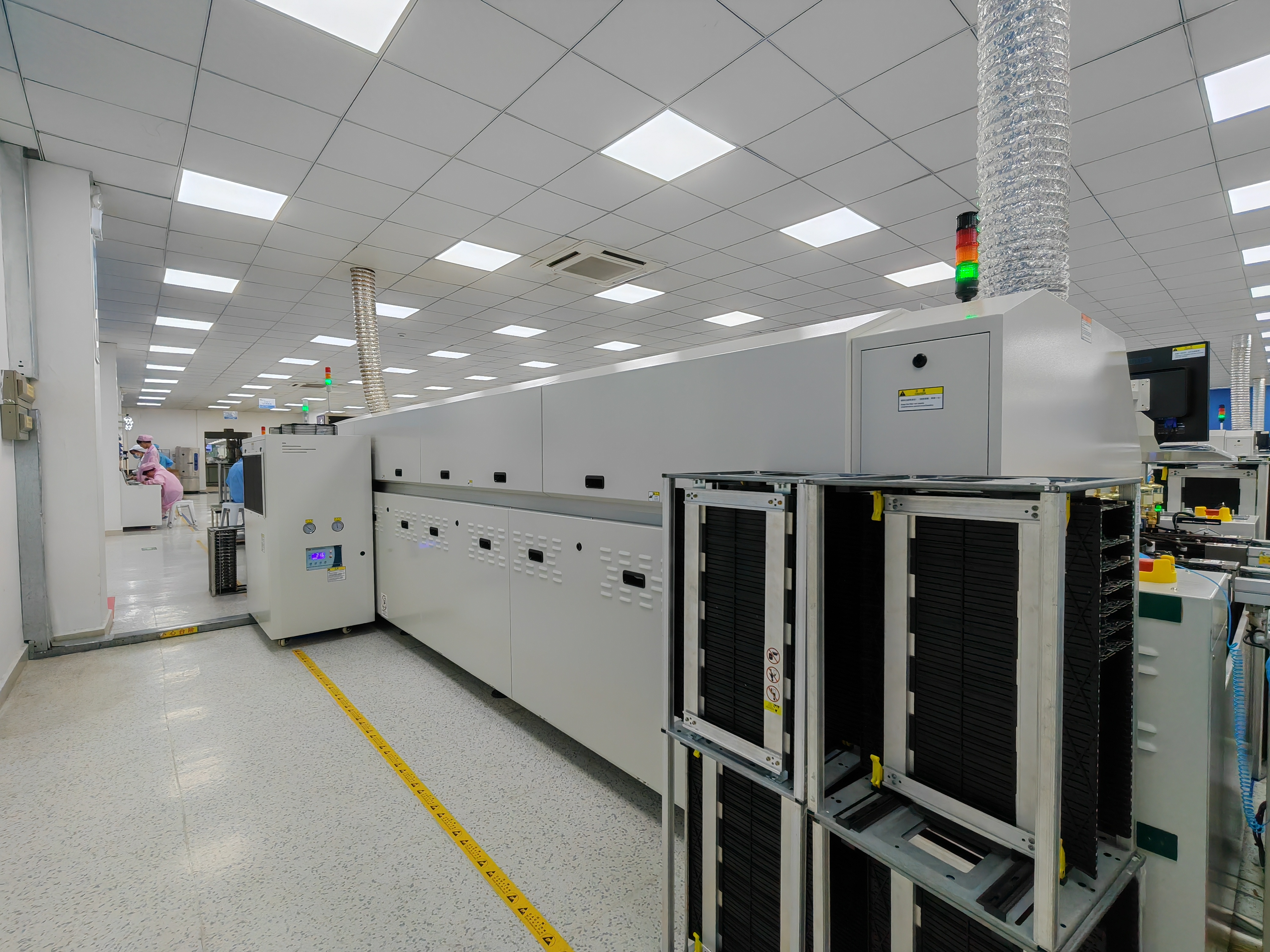



評論