在半導體科學技術的發展中,氣相外延發揮了重要作用,該技術已廣泛用于Si半導體器件和集成電路的工業化生產。
硅的外延生長
一個含有硅原子的氣體以適當的方式通過襯底,自反應劑分子釋放出的原子在襯底上運動直到它們到達適當的位置,并成為生長源的一部分,在適當的條件下就得到單一的晶向。所得到的外延層精確地為單晶襯底的延續。
它是在一定條件下,在經過切、磨、拋等仔細加工的單晶襯底上,生長一層合乎要求的單晶層的方法。
硅外延生長其意義是在具有一定晶向的硅單晶襯底上生長一層具有和襯底相同晶向的電阻率與厚度不同的晶格結構完整性好的晶體。
半導體分立元器件和集成電路制造工藝需要外延生長技術,因半導體其中所含的雜質有N型和P型,通過不同類型的組合,使半導體器件和集成電路具有各種各樣的功能,應用外延生長技術就能容易地實現。
硅外延生長方法,又可分為氣相外延、液相外延、固相外延。目前國際上廣泛的采用化學氣相沉積生長方法滿足晶體的完整性、器件結構的多樣化,裝置可控簡便,批量生產、純度的保證、均勻性要求。
外延生長的特點:
(1)低(高)阻襯底上外延生長高(低)阻外延層;
(2)P(N)型襯底上外延生長N(P)型外延層;
(3)與掩膜技術結合,在指定的區域進行選擇外延生長;
(4)外延生長過程中根據需要改變摻雜的種類及濃度;
(5)生長異質,多層,多組分化合物且組分可變的超薄層;
(6)實現原子級尺寸厚度的控制;
(7)生長不能拉制單晶的材料;
氣相外延生長
氣相硅外延生長是在高溫下使揮發性強的硅源與氫氣發生反應或熱解,生成的硅原子淀積在硅襯底上長成外延層。
通常使用的硅源是SiH4、SiH2Cl2、SiHCl3和SiCL4。SiHCl3和SiCl4常溫下是液體,外延生長溫度高,但生長速度快,易提純,使用安全,所以它們是較通用的硅源。早期多使用SiCl4,近來使用SiHCl3和SiH2Cl2逐漸增多。
SiH2Cl2在常溫下是氣體,使用方便并且反應溫度低,是近年來逐漸擴大使用的硅源。SiH4也是氣體,硅烷外延的特點是反應溫度低,無腐蝕性氣體,可得到雜質分布陡峭的外延層,
缺點:
1、要求生長系統具有良好的氣密性,否則會因漏氣而產生大量的外延缺陷。
2、SiH4在高溫和高濃度下易發生氣相分解而生成粉末狀硅使外延無法進行。
對襯底的要求
在硅外延中使用的硅襯底是經過切、磨、拋等工藝仔細加工而成的,外延生長前又經過嚴格的清洗、烘干,但表面上仍殘存有損傷、污染物及氧化物等。
為了提高外延層的完整性,在外延生長前應在反應室中進行原位化學腐蝕拋光,以獲得潔凈的硅表面。常用的化學腐蝕劑為干燥的HCl或HBr,在使SiH4外延生長時,由于SF6具有無毒和非選擇、低溫腐蝕特點,所以可用它做腐蝕拋光劑。為了控制外延層的電特性,通常使用液相或氣相摻雜法。作為N型摻雜劑的有PCl3,PH3和AsCl3,而作為P型摻雜劑的有BCl3、BBr3和B2H6等。
氣相外延生長過程包括:
(1)反應劑(SiCl4或SiHCl3+H2)氣體混合物質量轉移到襯底表面;
(2)吸收反應劑分子在表面上(反應物分子穿過附面層向襯底表面遷移);
(3)在表面上進行反應或一系列反應;
(4)釋放出副產物分子;
(5)副產物分子向主氣流質量轉移;(排外)
(6)原子加接到生長階梯上。
外延設備及所用的氣體
化學氣相外延生長使用的設備裝置通常稱謂外延生長反應爐。一般主要由氣相控制系統、電子控制系統、反應爐主體、排氣系統四部分組成。
根據反應室的結構,硅外延生長系統有水平式和立式兩種,前者已很少使用,后者又分為平板式和桶式。立式外延爐,外延生長時基座不斷轉動,故均勻性好、生產量大。
由于SiCl4等硅源的氫還原及SiH4的熱分解反應的△H為正值,即提高溫度有利于硅的淀積,因此反應器需要加熱,加熱方式主要有高頻感應加熱和紅外輻射加熱。通常在石英或不銹鋼反應室內放有高純石墨制的安放硅襯底的基座,為了保證硅外延層質量,石墨基座表面包覆著SiC或沉積多晶硅膜。
反應爐爐體它是在高純石英鐘罩中懸掛著一個多邊錐狀桶式經過特殊處理的高純石墨基座。基座上放置硅片,利用紅外燈快速均勻加熱。九段溫控、中心軸可以旋轉,進行嚴格雙密封的耐熱防爆結構。
電源系統:獨立電源線、3相4線、50Hz、350A
氣體控制系統:高精度的質量流量計、傳動器氣動閥控制,無泄露、耐腐蝕的EP管、氫(H2)檢漏、報警系統
冷卻系統:足夠的水冷循環系統和風冷循環系統
控制系統:微機程序控制、聯鎖方法,安全可靠
爐體:石英鐘罩、石英環、石英吊桿、護套、雙密封泵、高純石墨基座
溫度控制系統:獨特的紅外燈輻射加熱、9段溫控,均勻快速加熱,可調
氣相外延爐
硅外延生長基本工藝
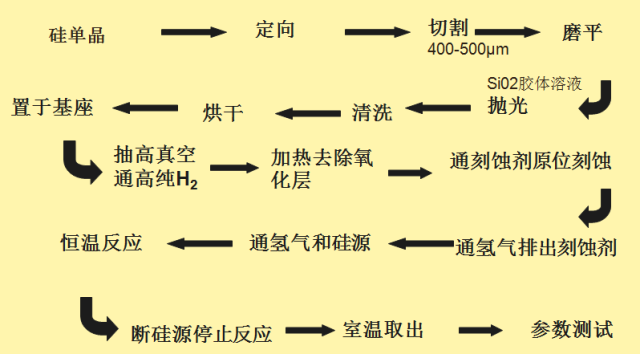
工藝流程
?單晶定向后,用內(外)圓/線切割機切成厚度為400~550 mm的薄片;
?磨片機上用金剛砂磨平(倒角)后,再用SiO2膠體溶液拋光成鏡面,制成襯底;?清洗甩(烘)干后,放在基座上;
?封閉反應室通高純H2排除反應室中的空氣;
?
啟動加熱系統,調整溫度到所需溫度。?
反應所需的氫氣經凈化器提純, 一路通反應室,另一路通硅源容器, 攜帶硅源入反應室。
?生長前用干燥的HCl或Br(HBr)在高溫下對襯底進行氣相拋光處理;
?調整反應室溫度至生長溫度,按需要通入硅源和氫氣進行硅外延生長;
?按實驗求得的生長速率和所需要的外延層厚度來確定生長時間;
?生長結束時,停止通硅源,但繼續通氫氣并降溫至室溫,取出外延片進行參數測試。

硅外延生長的基本原理和影響因素
以SiCl4源介紹其生長原理及影響因素。
SiCl4氫還原的基本反應方程:
SiCl4+2H2 = Si+4HCl
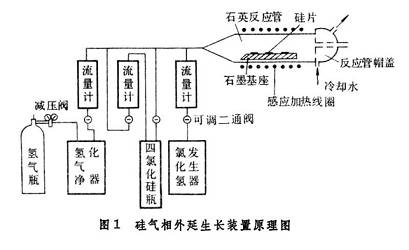
影響因素
1.SiCl4濃度對生長率的影響
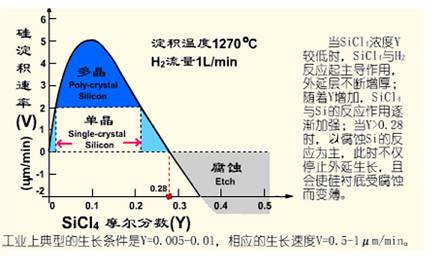
2.溫度對生長速率的影響
溫度較低時,生長速率隨溫度升高呈指數規律上升
較高溫度區,生長速率隨溫度變化較平緩。
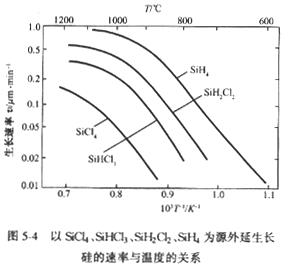
3.氣流速度對生長速率的影響
反應物濃度和生長溫度一定時,水平式反應器中的生長速率與總氫氣流速的平方根成正比。
立式反應器,流速較低時生長速度與總氫氣流速平方根成比例;
流速超過一定值后,生長速率達到穩定的極限值而不再增加。

4.襯底晶向的影響
常壓外延生長條件下(SiCl4+H2源,生長溫度T=1280℃,SiCl4濃度0.1%)
| 晶向 | 〈100〉 | 〈110〉 | 〈111〉 |
| 生長速度μm/min | 1.65 | 1.52 | 1.39 |
注意:偏離〈111〉晶向不同角度的襯底相應有一個最大允許生長速率(臨界生長速度),超過此速率生長外延層時會出現缺陷。
硅外延層電阻率的控制
不同器件對外延層的電參數要求不同。
1 外延層中的雜質及摻雜
1.1外延層中雜質來源
外延層中總的載流子濃度N總可表示為
N總=N襯底±N氣±N鄰片±N擴散±N基座±N系統
正負號由雜質類型決定,與襯底中雜質同類型取正號,與襯底中雜質反型取負號。
雜質不是來源于襯底片稱為外摻雜。
如:N氣、N基座、N系統
雜質來源于襯底片,稱為自摻雜。
如:N擴散、N襯底、N鄰片
結論:盡管外延層中的雜質來源于各方面,但決定外延層電阻率的主要原因還是人為控制的摻雜劑的多少;即N氣起主導作用。
1.2外延生長的摻雜
N型摻雜劑:PCl3、AsCl3、SbCl3和AsH3;
P型摻雜劑:BCl3、BBr3、B2H6。
SiCl4為源,鹵化物作摻雜劑,使用兩個SiCl4揮發器。
調節揮發器的氫氣流量和溫度,控制外延片的電阻率。
AsH3、B2H6等氫化物摻雜劑,純H2將它們稀釋后裝鋼瓶,控制它和通過SiCl4揮發器的H2流量調整外延層的電阻率。
SiH4為源, 摻雜劑使用AsH3、B2H6。
高阻P型外延層,常用低阻P型襯底自摻雜效應實現摻雜。
2 外延中雜質的再分布
希望外延層和襯底界面處的摻雜濃度很陡;
襯底中的雜質會擴散進入外延層,致使外延層和襯底之間界面處的雜質濃度梯度變平。
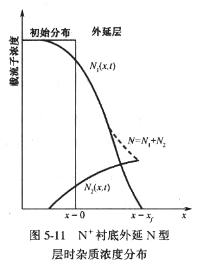
N1(x,t):重摻雜襯底擴散造成的雜質濃度分布;
N2(x,t):外部摻入的雜質濃度分布曲線。
總的雜質濃度
N(x,t)=N1(x,t)±N2(x,t)
3外延層生長中的自摻雜
自摻雜效應:襯底中的雜質進入氣相中再摻入外延層。
自摻雜造成的影響:
外延層電阻率的控制受到干擾;
襯底外延層界面處雜質分布變緩;
器件特性偏離,可靠性降低;
妨礙雙極型集成電路提高速度和微波器件提高頻率。
抑制自摻雜的方法:
1.盡量減少雜質由襯底逸出。
(1)使用蒸發速度較小的雜質做襯底和埋層中的雜質。
(2)外延生長前高溫加熱襯底。
(3)背面封閉技術。
(4)采用低溫外延技術和不含有鹵原子的硅源。
(5)二段外延生長技術。
2. 減壓生長技術, 使已蒸發到氣相中的雜質盡量不再進入外延層。
4外延層的夾層
外延層的夾層:外延層和襯底界面附近出現高阻層或反型層。
兩種類型:
(1)導電類型混亂,擊穿圖形異常,用磨角染色法觀察,界面不清晰;
(2)導電類型異常,染色觀察會看到一條清晰的帶。
夾層產生的原因:
(1)P型雜質沾污,造成N型外延層被高度補償;
(2)襯底中基硼的含量大于3×1016cm-3時,外延層容易出現夾層。
防止夾層出現的方法:
(1)提高重摻單晶質量,絕不能用復拉料或反型料拉重摻單晶;
(2)工藝中防止引入P型雜質,降低單晶中B的含量,
(3)外延生長時先長一層N型低阻層(如0.1W×cm)作為過渡層,可控制夾層。
由于硅單晶質量和外延生長技術水平的提高,夾層已很少出現。
硅外延層的缺陷
外延片中的缺陷分兩類:
(1)表面缺陷(宏觀缺陷)。如云霧、劃道、亮點、塌邊、角錐、滑移線等。
(2)內部結構缺陷(微觀缺陷)。如:層錯、位錯等。
1外延片的表面缺陷
1.1云霧狀表面
表面呈乳白色條紋,肉眼即可看到。
起因:氫氣純度低,H2O過多或氣相拋光濃度過大,生長溫度太低。

霧狀表面缺陷①霧圈②白霧③殘跡④花霧
1.2角錐體(三角錐或乳突)
形狀象沙丘,用肉眼可看見。
防止角錐體產生采取的措施:
①選擇與(111)面朝〈110〉偏離3~4°的晶向切片,提高臨界生長速度;
②降低生長速度;
③防止塵埃及碳化物沾污,注意清潔等。
角錐體
1.3亮點
外形為烏黑發亮的小圓點。40~60倍顯微鏡下呈發亮的小突起。
大者為多晶點,可因系統沾污,反應室硅粉,SiO2粒脫落,氣相拋光不當或襯底裝入反應室前表面有飄落的灰塵等引起。
細小的亮點多半由襯底拋光不充分或清洗不干凈造成。
1.4塌邊(取向平面)
外延生長后片子邊緣部分比中間部分低,形成一圈或一部分寬1~2mm左右的斜平面,是無缺陷的完整的(111)面。
形成塌邊的原因:襯底加工時造成片邊磨損而偏離襯底片晶向。
如傾斜面為(111)面,在外延時它會擴展而長成(111)取向小平面。
1.5劃痕
一般由機械損傷引起,用鉻酸腐蝕液腐蝕時會在其兩旁出現成行排列的層錯。
1.6星形線(滑移線)
外延層表面出現平行的或順〈110〉方向伸展的線條,高低不平肉眼可見。
鉻酸腐蝕液腐蝕后在線的一側出現位錯排。
起因:與硅片在加熱過程中受到的熱應力有關,采用襯底邊緣倒角的辦法來消除。
2外延層的內部缺陷
2.1層錯
硅外延生長時,外延層常常含有大量的層錯。

外延層層錯形貌分為單線、開口、正三角形、套疊三角形和其他組態。
2.2位錯
處理好的襯底上用正常方法生長的外延層中,位錯密度大致與襯底的位錯密度相近或稍少一些。
基座上溫度分布不好,片子直徑又大,片子內將形成一個溫度梯度,摻雜或異質外延時引入位錯。
3微缺陷
微缺陷:硅外延層經鉻酸腐蝕液腐蝕后呈現淺三角坑或丘狀物的缺陷,宏觀看是一種“霧狀”或“漬狀”。
起因:多種雜質沾污引起,Fe、Ni等影響最大。
Fe的濃度達到1015cm-3時,明顯地產生這種云霧狀缺陷。
消除方法:工藝中注意基座及工具的清潔處理,應用“吸雜技術”。
氣相外延提高了硅材料的完美性和高集成度,減少儲存單元的漏電流,提高了電路的速度,改變電路的功率特性以及頻率特性,解決CMOS電路的鎖定,實現各種材質的多種薄膜外延。
-
半導體
+關注
關注
339文章
31036瀏覽量
265590 -
冷卻系統
+關注
關注
5文章
138瀏覽量
18598
原文標題:半導體工藝之氣相外延
文章出處:【微信號:WW_CGQJS,微信公眾號:傳感器技術】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
橢偏儀在半導體的應用|不同厚度c-AlN外延薄膜的結構和光學性質

奧松半導體入選重慶市首批概念驗證中心建設名單
半導體“襯底”和“外延”區別的詳解;

機器視覺在半導體行業的重要性(以51camera晶圓隱裂檢測系統為例)
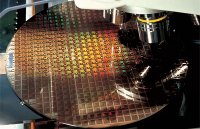
半導體外延和薄膜沉積有什么不同

半導體外延工藝在哪個階段進行的
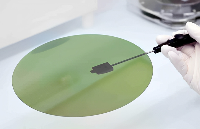
臺階儀應用 | 半導體GaAs/Si異質外延層表面粗糙度優化

功率半導體器件——理論及應用
小華半導體榮獲2024年度汽車電子科學技術獎突出創新產品獎
從原理到應用,一文讀懂半導體溫控技術的奧秘
電鏡技術在第三代半導體中的關鍵應用
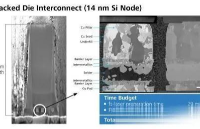
一文詳解外延生長技術
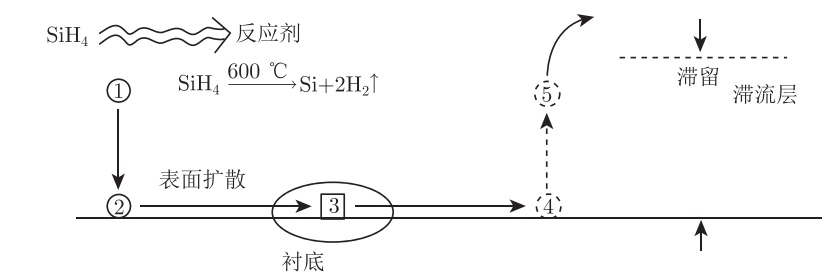



 半導體科學技術中氣相外延的重要作用
半導體科學技術中氣相外延的重要作用

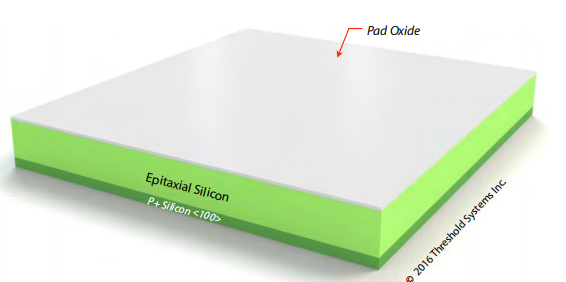



評論