去年的CES 2019大展上,Intel正式公布了Foveros 3D立體封裝技術,首款產品代號Lakefield。
該工藝的最大的特點是,改變了將不同IP模塊使用同一工藝、放置在同一2D平面上的做法,改為3D立體式堆棧,而且不同IP模塊可以靈活選擇最適合自己的工藝制程。
獲得的好處是,在全新封裝技術的支撐下,Lakefield可歸為全新的芯片種類——不但可以裝入不同的計算內核實現混合計算,還能按需裝入其它模塊,并且能在極小的封裝尺寸內實現性能、能效的優化平衡。
今日,Intel官方曬出出了Lakefield的芯片本體,并介紹了內部的架構。真的小到只能用指尖才能輕輕捏住,需要用放大鏡才能看清。
因為有了Foveros 3D堆疊技術的加持,Lakefield芯片和英特爾過去所有的產品都不同——采用混合CPU設計,1個大核搭配4個小核的組合。
大核使用傾向于性能的微架構,比如10nm的Sunny Cove,小核則使用低功耗的微架構,比如新一代的Tremont。
Tremont指令集架構、微架構、安全性、電量管理等方面均有所提升此外,它還可以根據設計需求,除了CPU外再封裝進多個功能模塊,包括最新的顯示芯片以及I/O功能。
這么多的CPU核心和功能模塊,通過Foveros 3D結合后,總體的速度和能耗都超出預期,這是傳統芯片難以想象的。
Lakefield平臺的這些特點,意味著能夠帶來諸多優勢。
首先是體積小,小到猶如指甲蓋的12mm x 12mm,其主板也如手指般大小。然后是組合靈活,基于Foveros 3D的芯片可以結合不同工藝、不同架構、不同功能的模塊,實現無縫結合。最后是混合計算的模式,平時使用更為節能的內核,最大程度提升電池續航時間,需要時才使用高性能內核,性能和節能可以做到同時兼顧。
體積小、功能模塊組合靈活、混合計算,這些優勢結合在一起,就足以為產品設計打開革命性的空間。
在Foveros 3D之前,CPU芯片是以2D的方式展開的,這就意味著功能模塊的增加會增大芯片的面積,意味著會犧牲一定的性能并消耗更多電量。而且,在晶體管密度越來越高的今天,這種形式幾乎已經達到極限。
而Foveros 3D的神奇之處在于,它可以把邏輯芯片模塊像蓋房子那樣一層一層地堆疊起來,而且可以做到2D變3D后,性能不會受到損失,電量消耗也不會顯著增加。
這對Soc芯片來說,是天大的利好,因為Soc的功能復雜,集成的模塊也很多,使用Foveros 3D之后,不同IP的模塊可以有機地結合在一起,不但芯片設計的靈活性大幅提升,芯片面積、功耗都會有優秀表現,特別適合新時代移動設備的需求。
據悉,Lakefield將用于微軟Surface Duo雙屏本、ThinkPad X1 Fold、三星Galaxy Book S筆記本之中。
-
英特爾
+關注
關注
61文章
10301瀏覽量
180428 -
cpu
+關注
關注
68文章
11277瀏覽量
224955
發布評論請先 登錄
XS5018C:高性能2D/3D降噪ISP-TX 2K芯片電路圖資料
2D、2.5D與3D封裝技術的區別與應用解析

探索TLE493D-P3XX-MS2GO 3D 2Go套件:開啟3D磁傳感器評估之旅
Vitrox的v510i系列的3D AOI光學檢測設備
淺談2D封裝,2.5D封裝,3D封裝各有什么區別?
LMI Gocator 6300系列智能3D線激光輪廓傳感器介紹

玩轉 KiCad 3D模型的使用

TMAG5170D-Q1 3D線性霍爾效應傳感器技術解析與應用指南
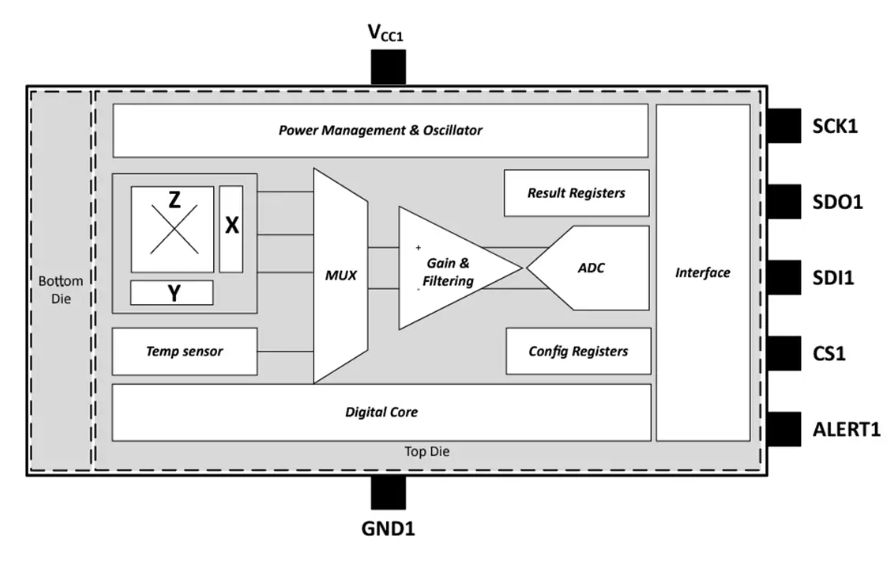
iTOF技術,多樣化的3D視覺應用
如何提高3D成像設備的部署和設計優勢

TechWiz LCD 3D應用:局部液晶配向
HT 可視化監控頁面的 2D 與 3D 連線效果




 Intel展出Lakefield芯片本體,CPU 2D變3D
Intel展出Lakefield芯片本體,CPU 2D變3D





評論