在CES 2020展會(huì)上,CPU處理器也是Intel主題演講的重點(diǎn),這次展會(huì)上官方正式發(fā)布了Tiger Lake處理器,它是第二款10nm處理器,CPU及GPU架構(gòu)也全面升級(jí),亮點(diǎn)多多。
此外,Intel還聯(lián)合多家合作伙伴展示了一些全新的PC產(chǎn)品,比如折疊屏筆記本ThinkPad X1 Fold,它使用的是Lakefield處理器,是Intel首款3D封裝芯片,同時(shí)封裝10nm芯片和22nm IO的多種模塊。
Tiger Lake、Lakefield兩款處理器是2020年的重點(diǎn)產(chǎn)品之一,它們也同時(shí)是Intel六大技術(shù)支柱戰(zhàn)略中的代表產(chǎn)品,從制程到封裝,再到架構(gòu)都極具創(chuàng)新性。
何為六大技術(shù)支柱?Intel的核心競爭力都在這里了
在2018年底的Intel架構(gòu)日活動(dòng)上,Intel官方首次提出了六大技術(shù)戰(zhàn)略,這也就是大家常說的六大支柱,聽上去很像是六個(gè)柱子支撐著Intel,實(shí)際上Intel官方的描述是6個(gè)圓環(huán),層層相扣,意義更準(zhǔn)確一些。
具體來說,這六大支柱就是制程和封裝、架構(gòu)、內(nèi)存和存儲(chǔ)、互連、安全、軟件。Intel的目標(biāo)是借助這六大技術(shù)支柱,實(shí)現(xiàn)指數(shù)級(jí)的增長。
在當(dāng)時(shí)的會(huì)議上,英特爾高級(jí)副總裁、首席架構(gòu)師以及架構(gòu)、圖形與軟件部門總經(jīng)理Raja Koduri提到,“我們現(xiàn)在正把這個(gè)模式(六大戰(zhàn)略支柱)運(yùn)用于我們的整個(gè)工程部門,落實(shí)在我們將在明年和未來推出的全新創(chuàng)新產(chǎn)品與技術(shù)規(guī)劃。不管是通過 “Foveros” 邏輯堆疊實(shí)現(xiàn)的先進(jìn)封裝創(chuàng)新,還是面向軟件開發(fā)者的 “One API” 方案,我們正在采取行動(dòng),推動(dòng)可持續(xù)的新一輪創(chuàng)新。”
以往一提到計(jì)算能力,大家想到的往往就是摩爾定律推動(dòng)下的晶體管密度,但是如今的計(jì)算格局正在發(fā)生深刻變化,數(shù)據(jù)洪流時(shí)代考驗(yàn)的不只是單一的CPU、GPU那么簡單,推動(dòng)摩爾定律發(fā)展的也不只是晶體管規(guī)模,而是“包括晶體管、架構(gòu)研究、連接性提升、更快速的內(nèi)存系統(tǒng)和軟件的結(jié)合”,這也是Intel六大技術(shù)支柱戰(zhàn)略的意義所在。
Tiger Lake:10nm+工藝、Willow Cove及Xe架構(gòu)落地
在六大技術(shù)支柱中,制程/封裝、架構(gòu)依然是最底層也是最重要的部分,2019年Intel首次落地了10nm工藝及Sunny Cove架構(gòu),2020年的CES展會(huì)上Intel又正式宣布了Tiger Lake處理器,它使用的是10nm+工藝以及新的Willow Cove微內(nèi)核、Xe圖形架構(gòu)GPU,同時(shí)還帶來了新一代的IO接口(這部分我們單獨(dú)再說)。
在Tiger Lake處理器上,Intel已經(jīng)在使用改進(jìn)版的10nm工藝——10nm+。此前很多人都聽過10nm工藝延期的消息,但是大部分并不了解Intel的10nm工藝,認(rèn)為別的廠商7nm工藝超越Intel了,實(shí)際上并沒有。
Intel的10nm工藝是近年來升級(jí)幅度最明顯的一代工藝,摩爾定律下大部分工藝升級(jí)是2x晶體管密度,而從14nm到10nm工藝,Intel做到了2.7x晶體管密度提升,10nm節(jié)點(diǎn)就實(shí)現(xiàn)了100MTr/mm2,一平方毫米內(nèi)就集成了1億個(gè)晶體管,相當(dāng)于其他廠商的7nm晶體管密度水平。
在10nm+工藝之外,Tiger Lake處理器還會(huì)用上全新的CPU內(nèi)核——Willow Cove,這是去年Ice Lake處理器的Sunny Cove核心的繼任者,后者的IPC性能提升了18%,最多可達(dá)40%,Willow Cove核心的性能會(huì)進(jìn)一步提升。
根據(jù)官方的說法,Willow Cove內(nèi)核的主要改進(jìn)是在緩存系統(tǒng)上,更大容量的多級(jí)緩存,再輔以合理的層級(jí)結(jié)構(gòu)、高速度、低延遲,帶來的性能提升絕對(duì)會(huì)是非常顯著的,無論日常應(yīng)用還是游戲都能獲益匪淺,Intel官方表示CPU性能提升至少是雙位數(shù),也就是超過10%的。
Lakefield處理器2020年問世 Foveros 3D封裝成真
在CES展會(huì)上,Intel及其合作伙伴還探索了PC產(chǎn)品的全新形態(tài),聯(lián)想在發(fā)布會(huì)上現(xiàn)場展示了ThinkPad X1 Fold折疊屏筆記本,夢(mèng)幻般的外形及全新的操作體驗(yàn)驚艷了全場。
折疊屏、雙屏等全新形態(tài)的PC同時(shí)也對(duì)處理器提出了更高的要求,性能、功耗、尺寸等關(guān)鍵指標(biāo)的要求都不一樣了,趨勢(shì)就是功耗更低、體積更小、集成度更高,所以這些產(chǎn)品使用的處理器也不同,目前主要是Intel的Lakefield處理器,也會(huì)在2020年開賣,去年發(fā)布微軟雙屏Surface Neo、三星筆記本Galaxy Book S也是如此,都會(huì)在今年正式上市。
Lakefield處理器的特殊之處在于它的封裝,這就要涉及到Intel六大技術(shù)支柱中的封裝技術(shù)了,Lakefield首發(fā)了Intel的Foveros 3D立體封裝技術(shù),2019年的CES展會(huì)上正式宣布,它可以將多個(gè)硅片堆疊在一起,縮小整體面積,但提高內(nèi)部互連通信效率,并且可以靈活控制不同模塊,滿足不同需求,還可以采用不同工藝。
具體到Lakefield處理器上,其內(nèi)部集成了10nm工藝的計(jì)算Die、22nm工藝的基礎(chǔ)Die兩個(gè)硅片,前者包含一個(gè)高性能的Sunny Cove/Ice Lake CPU核心、四個(gè)高能效的Tremont CPU核心,整體尺寸僅為12×12毫米,比一枚硬幣還小。
在CPU核心之外,F(xiàn)overos 3D封裝還可以加入10nm GPU核心、DRAM內(nèi)存等核心,最新消息顯示它甚至可能集成聯(lián)發(fā)科的5G基帶。
總之,憑借Foveros 3D封裝的靈活性,Intel可以按需整合各種不同的IP核心,這種超高集成度也使得Lakefield處理器厚度減少了40%,核心面積減少了40%,GPU性能提升50%,待機(jī)功耗只有原來的1/10。
2020年成六大技術(shù)支持落地的關(guān)鍵點(diǎn) 架構(gòu)、工藝、封裝合體
2019年Intel推出Ice Lake處理器之后,新的10nmnm工藝及Sunny Cove架構(gòu)意味著六大技術(shù)支柱正式拉開了帷幕,首次在架構(gòu)及工藝上同步升級(jí)。
2020年Intel的六大技術(shù)支柱就更重要了,可以說這次會(huì)遍地開花了,Tiger Lake及Lakefield處理器不僅帶來了10nm+工藝、全新的Willow Cove核心、Xe圖形架構(gòu)GPU核心,也首次將3D封裝Foveros技術(shù)變成了現(xiàn)實(shí)。
在未來的芯片發(fā)展中,F(xiàn)overos 3D為代表的新一代封裝技術(shù)也會(huì)占據(jù)越來越多的份額,其高集成度及靈活搭配不同工藝的特性賦予未來的PC更高的創(chuàng)新性,從外觀形態(tài)到操作體驗(yàn)都有全新的體驗(yàn)。
此外,Intel還聯(lián)合多家合作伙伴展示了一些全新的PC產(chǎn)品,比如折疊屏筆記本ThinkPad X1 Fold,它使用的是Lakefield處理器,是Intel首款3D封裝芯片,同時(shí)封裝10nm芯片和22nm IO的多種模塊。
Tiger Lake、Lakefield兩款處理器是2020年的重點(diǎn)產(chǎn)品之一,它們也同時(shí)是Intel六大技術(shù)支柱戰(zhàn)略中的代表產(chǎn)品,從制程到封裝,再到架構(gòu)都極具創(chuàng)新性。
何為六大技術(shù)支柱?Intel的核心競爭力都在這里了
在2018年底的Intel架構(gòu)日活動(dòng)上,Intel官方首次提出了六大技術(shù)戰(zhàn)略,這也就是大家常說的六大支柱,聽上去很像是六個(gè)柱子支撐著Intel,實(shí)際上Intel官方的描述是6個(gè)圓環(huán),層層相扣,意義更準(zhǔn)確一些。
具體來說,這六大支柱就是制程和封裝、架構(gòu)、內(nèi)存和存儲(chǔ)、互連、安全、軟件。Intel的目標(biāo)是借助這六大技術(shù)支柱,實(shí)現(xiàn)指數(shù)級(jí)的增長。
在當(dāng)時(shí)的會(huì)議上,英特爾高級(jí)副總裁、首席架構(gòu)師以及架構(gòu)、圖形與軟件部門總經(jīng)理Raja Koduri提到,“我們現(xiàn)在正把這個(gè)模式(六大戰(zhàn)略支柱)運(yùn)用于我們的整個(gè)工程部門,落實(shí)在我們將在明年和未來推出的全新創(chuàng)新產(chǎn)品與技術(shù)規(guī)劃。不管是通過 “Foveros” 邏輯堆疊實(shí)現(xiàn)的先進(jìn)封裝創(chuàng)新,還是面向軟件開發(fā)者的 “One API” 方案,我們正在采取行動(dòng),推動(dòng)可持續(xù)的新一輪創(chuàng)新。”
以往一提到計(jì)算能力,大家想到的往往就是摩爾定律推動(dòng)下的晶體管密度,但是如今的計(jì)算格局正在發(fā)生深刻變化,數(shù)據(jù)洪流時(shí)代考驗(yàn)的不只是單一的CPU、GPU那么簡單,推動(dòng)摩爾定律發(fā)展的也不只是晶體管規(guī)模,而是“包括晶體管、架構(gòu)研究、連接性提升、更快速的內(nèi)存系統(tǒng)和軟件的結(jié)合”,這也是Intel六大技術(shù)支柱戰(zhàn)略的意義所在。
Tiger Lake:10nm+工藝、Willow Cove及Xe架構(gòu)落地
在六大技術(shù)支柱中,制程/封裝、架構(gòu)依然是最底層也是最重要的部分,2019年Intel首次落地了10nm工藝及Sunny Cove架構(gòu),2020年的CES展會(huì)上Intel又正式宣布了Tiger Lake處理器,它使用的是10nm+工藝以及新的Willow Cove微內(nèi)核、Xe圖形架構(gòu)GPU,同時(shí)還帶來了新一代的IO接口(這部分我們單獨(dú)再說)。
在Tiger Lake處理器上,Intel已經(jīng)在使用改進(jìn)版的10nm工藝——10nm+。此前很多人都聽過10nm工藝延期的消息,但是大部分并不了解Intel的10nm工藝,認(rèn)為別的廠商7nm工藝超越Intel了,實(shí)際上并沒有。
Intel的10nm工藝是近年來升級(jí)幅度最明顯的一代工藝,摩爾定律下大部分工藝升級(jí)是2x晶體管密度,而從14nm到10nm工藝,Intel做到了2.7x晶體管密度提升,10nm節(jié)點(diǎn)就實(shí)現(xiàn)了100MTr/mm2,一平方毫米內(nèi)就集成了1億個(gè)晶體管,相當(dāng)于其他廠商的7nm晶體管密度水平。
在10nm+工藝之外,Tiger Lake處理器還會(huì)用上全新的CPU內(nèi)核——Willow Cove,這是去年Ice Lake處理器的Sunny Cove核心的繼任者,后者的IPC性能提升了18%,最多可達(dá)40%,Willow Cove核心的性能會(huì)進(jìn)一步提升。
根據(jù)官方的說法,Willow Cove內(nèi)核的主要改進(jìn)是在緩存系統(tǒng)上,更大容量的多級(jí)緩存,再輔以合理的層級(jí)結(jié)構(gòu)、高速度、低延遲,帶來的性能提升絕對(duì)會(huì)是非常顯著的,無論日常應(yīng)用還是游戲都能獲益匪淺,Intel官方表示CPU性能提升至少是雙位數(shù),也就是超過10%的。
Lakefield處理器2020年問世 Foveros 3D封裝成真
在CES展會(huì)上,Intel及其合作伙伴還探索了PC產(chǎn)品的全新形態(tài),聯(lián)想在發(fā)布會(huì)上現(xiàn)場展示了ThinkPad X1 Fold折疊屏筆記本,夢(mèng)幻般的外形及全新的操作體驗(yàn)驚艷了全場。
折疊屏、雙屏等全新形態(tài)的PC同時(shí)也對(duì)處理器提出了更高的要求,性能、功耗、尺寸等關(guān)鍵指標(biāo)的要求都不一樣了,趨勢(shì)就是功耗更低、體積更小、集成度更高,所以這些產(chǎn)品使用的處理器也不同,目前主要是Intel的Lakefield處理器,也會(huì)在2020年開賣,去年發(fā)布微軟雙屏Surface Neo、三星筆記本Galaxy Book S也是如此,都會(huì)在今年正式上市。
Lakefield處理器的特殊之處在于它的封裝,這就要涉及到Intel六大技術(shù)支柱中的封裝技術(shù)了,Lakefield首發(fā)了Intel的Foveros 3D立體封裝技術(shù),2019年的CES展會(huì)上正式宣布,它可以將多個(gè)硅片堆疊在一起,縮小整體面積,但提高內(nèi)部互連通信效率,并且可以靈活控制不同模塊,滿足不同需求,還可以采用不同工藝。
具體到Lakefield處理器上,其內(nèi)部集成了10nm工藝的計(jì)算Die、22nm工藝的基礎(chǔ)Die兩個(gè)硅片,前者包含一個(gè)高性能的Sunny Cove/Ice Lake CPU核心、四個(gè)高能效的Tremont CPU核心,整體尺寸僅為12×12毫米,比一枚硬幣還小。
在CPU核心之外,F(xiàn)overos 3D封裝還可以加入10nm GPU核心、DRAM內(nèi)存等核心,最新消息顯示它甚至可能集成聯(lián)發(fā)科的5G基帶。
總之,憑借Foveros 3D封裝的靈活性,Intel可以按需整合各種不同的IP核心,這種超高集成度也使得Lakefield處理器厚度減少了40%,核心面積減少了40%,GPU性能提升50%,待機(jī)功耗只有原來的1/10。
2020年成六大技術(shù)支持落地的關(guān)鍵點(diǎn) 架構(gòu)、工藝、封裝合體
2019年Intel推出Ice Lake處理器之后,新的10nmnm工藝及Sunny Cove架構(gòu)意味著六大技術(shù)支柱正式拉開了帷幕,首次在架構(gòu)及工藝上同步升級(jí)。
2020年Intel的六大技術(shù)支柱就更重要了,可以說這次會(huì)遍地開花了,Tiger Lake及Lakefield處理器不僅帶來了10nm+工藝、全新的Willow Cove核心、Xe圖形架構(gòu)GPU核心,也首次將3D封裝Foveros技術(shù)變成了現(xiàn)實(shí)。
在未來的芯片發(fā)展中,F(xiàn)overos 3D為代表的新一代封裝技術(shù)也會(huì)占據(jù)越來越多的份額,其高集成度及靈活搭配不同工藝的特性賦予未來的PC更高的創(chuàng)新性,從外觀形態(tài)到操作體驗(yàn)都有全新的體驗(yàn)。
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請(qǐng)聯(lián)系本站處理。
舉報(bào)投訴
-
英特爾
+關(guān)注
關(guān)注
61文章
10301瀏覽量
180412
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
熱點(diǎn)推薦
新能源汽車爆發(fā)期,LED廠商如何借 AEC-Q102 認(rèn)證搶占百億市場?
系統(tǒng)的核心器件,市場需求隨之呈現(xiàn)指數(shù)級(jí)增長。據(jù)測算,2025年全球車用LED市場規(guī)模將突破800億元。新能源汽車對(duì)LED升級(jí):場景與性能雙重挑戰(zhàn)1.應(yīng)用場景持續(xù)擴(kuò)

為什么銅纜是企業(yè)無線技術(shù)的支柱?
成為企業(yè)無線技術(shù)的支柱。 銅纜的基本特性及其優(yōu)勢(shì) 銅纜是一種以銅作為主要傳輸介質(zhì)的線纜,常見的形式包括雙絞線(如Cat5e、Cat6、Cat6a)和同軸電纜。銅纜具有以下顯著優(yōu)勢(shì): 高
立訊精密2025年MSCI ESG評(píng)級(jí)獲評(píng)A級(jí)
近日,國際資本市場權(quán)威指數(shù)機(jī)構(gòu)MSCI(明晟)公布最新ESG評(píng)級(jí)結(jié)果,立訊精密評(píng)級(jí)從BB級(jí)躍升2級(jí),直達(dá)A級(jí),超過78%全球同業(yè)。這標(biāo)志著立
我國 IPv6 發(fā)展實(shí)現(xiàn)跨越式突破,2025 年活躍用戶達(dá) 8.65 億
;的跨越式轉(zhuǎn)變,網(wǎng)絡(luò)規(guī)模、用戶規(guī)模、流量規(guī)模均位居世界首位,為"十五五"時(shí)期支撐經(jīng)濟(jì)社會(huì)高質(zhì)量發(fā)展、加快建設(shè)網(wǎng)絡(luò)強(qiáng)國奠定堅(jiān)實(shí)基礎(chǔ)。關(guān)鍵指標(biāo)呈爆發(fā)式增長截至2025年9月,我國IPv6活

AR眼鏡定制_2025年消費(fèi)級(jí)/工業(yè)級(jí)AR智能眼鏡主板硬件方案開發(fā)
的核心驅(qū)動(dòng)力。MTK8781的技術(shù)核心:三大技術(shù)支柱,異構(gòu)計(jì)算架構(gòu):算力與能效的平衡,MTK8781采用先進(jìn)的“2+6”八核異構(gòu)設(shè)計(jì)。

借助新思科技MACsec安全模塊的以太網(wǎng)解決方案
隨著接入云端的器件數(shù)量呈指數(shù)級(jí)增長,加之傳感器、應(yīng)用與服務(wù)的種類不斷豐富,數(shù)據(jù)流量迎來爆發(fā)式增長,帶寬需求也因此水漲船高。
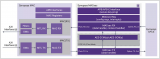
2025嵌入式行業(yè)現(xiàn)狀如何?
2025嵌入式行業(yè)現(xiàn)狀如何? 一、市場規(guī)模與增長趨勢(shì)1.1 全球市場概況總體規(guī)模:2025年全球嵌入式系統(tǒng)市場規(guī)模預(yù)計(jì)突破1.2萬億美元,相當(dāng)于每天誕生3個(gè)“光谷”級(jí)產(chǎn)業(yè)集群。 驅(qū)動(dòng)因素:物聯(lián)網(wǎng)
發(fā)表于 08-25 11:34
AI技術(shù)和國產(chǎn)芯片加持,養(yǎng)老機(jī)器人迎爆發(fā)式增長
機(jī)器人市場迎來了爆發(fā)式增長。2024 年,該市場規(guī)模突破 300 億元,預(yù)計(jì) 2025 年將達(dá)到 500 億元,年復(fù)合
寵物攝像頭爆發(fā)式增長背后的技術(shù)密碼
報(bào)告》顯示,2023年中國寵物經(jīng)濟(jì)產(chǎn)業(yè)規(guī)模達(dá)5,928億元,同比增長20.1%;2028年市場規(guī)模更是有望攀升至11,500億元。

什么是晶圓級(jí)扇出封裝技術(shù)
晶圓級(jí)扇出封裝(FO-WLP)通過環(huán)氧樹脂模塑料(EMC)擴(kuò)展芯片有效面積,突破了扇入型封裝的I/O密度限制,但其技術(shù)復(fù)雜度呈指數(shù)級(jí)增長。

AI驅(qū)動(dòng)半導(dǎo)體產(chǎn)業(yè)爆發(fā)式增長 2030年全球產(chǎn)值或突破萬億美元大關(guān)
,全球半導(dǎo)體行業(yè)總產(chǎn)值有望達(dá)到1萬億美元規(guī)模,其中AI相關(guān)應(yīng)用將貢獻(xiàn)近半壁江山。2024年被業(yè)界普遍視為"AI元年",生成式AI技術(shù)的爆發(fā)性發(fā)展對(duì)半導(dǎo)體產(chǎn)業(yè)產(chǎn)生了深遠(yuǎn)

格科高性能CIS封裝技術(shù)實(shí)現(xiàn)新突破
AI眼鏡正從“極客玩具”走向消費(fèi)級(jí)產(chǎn)品,市場數(shù)據(jù)印證了這一趨勢(shì)的爆發(fā)力。據(jù)維深信息Wellsenn XR數(shù)據(jù)報(bào)告[1],2024年全球AI眼鏡銷量為152萬臺(tái),2025年將激增至350
鴻道Intewell操作系統(tǒng)助力工業(yè)機(jī)器人控制系統(tǒng)自主可控
工業(yè)機(jī)器人與人形機(jī)器人的爆發(fā)式增長,正成為東土科技鴻道Intewell系統(tǒng)實(shí)現(xiàn)跨越式發(fā)展的核心引擎。從技術(shù)適配到生態(tài)重構(gòu),東土科技的三大核心能力與兩大機(jī)器人賽道形成深度共振,其市場空間
Intel-Altera FPGA:通信行業(yè)的加速引擎,開啟高速互聯(lián)新時(shí)代
與戰(zhàn)略調(diào)整收購背景:2015年,英特爾斥資167億美元收購Altera,意圖通過FPGA技術(shù)強(qiáng)化AI、邊緣計(jì)算等新興領(lǐng)域布局,但收購后未能實(shí)現(xiàn)預(yù)期協(xié)同效應(yīng)。戰(zhàn)略調(diào)整:2025年,英特爾
發(fā)表于 04-25 10:19
PLP面板級(jí)封裝,靜待爆發(fā)
電子發(fā)燒友綜合報(bào)道? 面板級(jí)封裝(Panel-Level Packaging,PLP)已經(jīng)存在一段時(shí)間,但未被大規(guī)模應(yīng)用。Yole Group近期預(yù)測,2024年,PLP市場總收入達(dá)到約1.6億美元
發(fā)表于 04-09 00:09
?3608次閱讀



 Intel這6大技術(shù)支柱2020年爆發(fā),有望實(shí)現(xiàn)指數(shù)級(jí)增長
Intel這6大技術(shù)支柱2020年爆發(fā),有望實(shí)現(xiàn)指數(shù)級(jí)增長




評(píng)論