填充先進封裝允許您設計裸芯片組件放置在層疊PCBs芯片上或多芯片模塊,以最大限度地減輕。看看這個快速演示。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
463文章
54010瀏覽量
466138 -
pcb
+關注
關注
4405文章
23878瀏覽量
424355 -
設計
+關注
關注
4文章
826瀏覽量
71325
發布評論請先 登錄
相關推薦
熱點推薦
先進封裝時代,芯片測試面臨哪些新挑戰?
架構;封裝前需確保芯粒為 KGD 以避免高價值封裝體報廢,推高測試成本;高密度封裝使測試時散熱困難,易引發誤判。先進封裝要求測試工程師兼具多
當芯片變“系統”:先進封裝如何重寫測試與燒錄規則
先進封裝推動芯片向“片上系統”轉變,重構測試與燒錄規則。傳統方案難適用于異構集成系統,面臨互聯互操作性、功耗管理、系統級燒錄等挑戰。解決方案需升級為系統驗證思維,包括高密度互連檢測、系統級功能測試
【熱管理產品系列】高導熱封裝石墨膜組件
解決了裸石墨片易掉粉、易碎裂和不耐磨的缺點,同時消除了其導電特性可能引發的電路風險,為客戶提供了高可靠且絕緣性能卓越的均溫導熱解決方案。核心優勢高導熱封裝石墨膜組件

適用于先進3D IC封裝完整的裸片到系統熱管理解決方案
摘要半導體行業向復雜的2.5D和3DIC封裝快速發展,帶來了極嚴峻的熱管理挑戰,這需要從裸片層級到系統層級分析的復雜解決方案。西門子通過一套集成工具和方法來應對這些多方面的挑戰,這些工具和方法結合了

突破!華為先進封裝技術揭開神秘面紗
在半導體行業,芯片制造工藝的發展逐漸逼近物理極限,摩爾定律的推進愈發艱難。在此背景下,先進封裝技術成為提升芯片性能、實現系統集成的關鍵路徑,成為全球科技企業角逐的新戰場。近期,華為的

先進封裝工藝面臨的挑戰
在先進制程遭遇微縮瓶頸的背景下,先進封裝朝著 3D 異質整合方向發展,成為延續摩爾定律的關鍵路徑。3D 先進封裝技術作為未來的發展趨勢,使
裸板電源是什么
裸板電源(Open Frame Power Supply)指的是沒有外殼封裝、裸露 PCB(印刷電路板)及電子元件的電源模塊。裸板電源通常用于嵌入式設備、工業控制、電源適配器、LED 驅動等應用場
發表于 03-20 16:37



 先進封裝的裸芯片組件的設計
先進封裝的裸芯片組件的設計

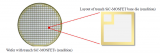








評論