輸入阻抗、驅(qū)動(dòng)電路簡(jiǎn)單、開關(guān)損耗小等優(yōu)點(diǎn)在MOSFET和BJT的基礎(chǔ)上有效降低了n漂移區(qū)的電阻率,大大提高了器件的電流能力。目前IGBT已經(jīng)能夠覆蓋從600V—6500V的電壓范圍。 我國(guó)擁有最大的功率半導(dǎo)體市場(chǎng),目前IGBT等高端器件的研發(fā)與國(guó)際大公司相比有
2021-09-25 06:52:00 5778
5778 搞電力電子的應(yīng)該都知道IGBT和MOSFET屬于全控型電力電子器件,在應(yīng)用的時(shí)候把它當(dāng)作一個(gè)開關(guān)就可以了,但估計(jì)很少人能夠說(shuō)出IGBT和MOSFET工作區(qū)的命名和區(qū)別,同時(shí)由于不同參考書對(duì)工作區(qū)的命名又有很多種,很容易讓人混淆。
2021-01-01 17:34:00 25187
25187 
電力MOSFET都是通過(guò)增加N-漂移區(qū)的厚度來(lái)提高工作電壓,但由此也帶來(lái)通態(tài)電阻的增大,當(dāng)電流比較大時(shí),管壓降和損耗會(huì)明顯加大,因此MOSFET特別適合高頻低壓場(chǎng)合,低壓MOS管不必增加或加厚N-漂移區(qū),通態(tài)電阻可以做到非常小,接近1毫歐水平。
2022-10-20 09:32:57 4198
4198 IGBT的結(jié)構(gòu)中絕大部分區(qū)域是低摻雜濃度的N型漂移區(qū),其濃度遠(yuǎn)遠(yuǎn)低于P型區(qū),當(dāng)IGBT柵極施加正向電壓使得器件開啟后
2023-11-28 16:48:01 3071
3071 
上一章我們對(duì)IGBT穩(wěn)態(tài)的分析中,在IGBT的大注入條件下,電子和空穴的運(yùn)動(dòng)相互影響,這個(gè)影響關(guān)系需要用雙極性擴(kuò)散系數(shù)來(lái)描述。
2023-12-01 10:33:51 1506
1506 
在《IGBT的物理結(jié)構(gòu)模型》中,我們將IGBT內(nèi)部PIN結(jié)切分成了PIN1和PIN2(見上一節(jié)插圖), 因?yàn)镻IN1與溝槽所構(gòu)成的MOS串聯(lián)
2023-12-01 10:43:06 1589
1589 
IGBT吸收電路的模型。在分析中均假定:所有二極管的通態(tài)電壓降為零,開關(guān)器件T的拖尾電流為零,開關(guān)器件T的通態(tài)電壓降為零。
2025-05-21 09:45:30 1052
1052 
區(qū),它是IGBT 特有的功能區(qū),與漏區(qū)和亞溝道區(qū)一起形成PNP 雙極晶體管,起發(fā)射極的作用,向漏極注入空穴,進(jìn)行導(dǎo)電調(diào)制,以降低器件的通態(tài)電壓。附于漏注入區(qū)上的電極稱為漏極。 IGBT的開關(guān)作用
2012-07-25 09:49:08
本帖最后由 eehome 于 2013-1-5 10:09 編輯
IGBT保護(hù)分析
2012-07-24 23:08:06
IGBT正常工作時(shí),p-base表面會(huì)形成導(dǎo)通溝道,電子從發(fā)射極經(jīng)n型漂移區(qū)流向集電極,而空穴將不斷地從集電極注入到n型漂移區(qū)。此時(shí)IGBT的外部表現(xiàn)為:存在負(fù)載電流,IGBT處于導(dǎo)通狀態(tài)。由于該區(qū)
2023-02-10 15:36:04
的壓降比等效(IC 和速度相同) PT 器件的壓降高的原因。正向阻斷當(dāng)柵極和發(fā)射極短接并在集電極端子施加一個(gè)正電壓時(shí),P/N J3結(jié)受反向電壓控制。此時(shí),仍然是由N漂移區(qū)中的耗盡層承受外部施加的電壓。閂
2012-07-09 14:14:57
IGBT 特有的功能區(qū),與漏區(qū)和亞溝道區(qū)一起形成PNP 雙極晶體管,起發(fā)射極的作用,向漏極注入空穴,進(jìn)行導(dǎo)電調(diào)制,以降低器件的通態(tài)電壓。附于漏注入區(qū)上的電極稱為漏極。 IGBT 的開關(guān)作用是通過(guò)加正向
2012-07-09 10:01:42
IGBT 特有的功能區(qū),與漏區(qū)和亞溝道區(qū)一起形成PNP 雙極晶體管,起發(fā)射極的作用,向漏極注入空穴,進(jìn)行導(dǎo)電調(diào)制,以降低器件的通態(tài)電壓。附于漏注入區(qū)上的電極稱為漏極。 IGBT 的開關(guān)作用是通過(guò)加正向
2012-07-09 11:53:47
大電流。對(duì)于 Mosfet來(lái)說(shuō),僅由多子承擔(dān)的電荷運(yùn)輸沒(méi)有任何存儲(chǔ)效應(yīng),因此,很容易實(shí)現(xiàn)極短的開關(guān)時(shí)間。但是,和 Mosfet 有所不同,IGBT器件中少子也參與了導(dǎo)電。所以 IGB 結(jié)構(gòu)雖然使導(dǎo)通壓降
2022-09-16 10:21:27
使用的具有自關(guān)斷能力的器件,開關(guān)頻率高,廣泛應(yīng)用于各類固態(tài)電源中。但如果控制不當(dāng),它很容易損壞。一般認(rèn)為 IGBT 損壞的主要原因有兩種:一是 IGBT 退出飽和區(qū)而進(jìn)入了放大區(qū)使得開關(guān)損耗增大;二是
2019-12-25 17:41:38
失效問(wèn)題。 IGBT失效場(chǎng)合:來(lái)自系統(tǒng)內(nèi)部,如電力系統(tǒng)分布的雜散電感、電機(jī)感應(yīng)電動(dòng)勢(shì)、負(fù)載突變都會(huì)引起過(guò)電壓和過(guò)電流;來(lái)自系統(tǒng)外部,如電網(wǎng)波動(dòng)、電力線感應(yīng)、浪涌等。歸根結(jié)底,IGBT失效主要是由集電極
2020-09-29 17:08:58
IGBT并聯(lián)技術(shù)分析胡永宏博士(艾克思科技)通過(guò)電力電子器件串聯(lián)或并聯(lián)兩種基本方法,均可增大電力電子裝置的功率等級(jí)。采用這兩種方法設(shè)計(jì)的大功變流器,結(jié)構(gòu)相對(duì)簡(jiǎn)單,加之控制策略與小功率變流器相兼容
2015-03-11 13:18:21
使用的具有自關(guān)斷能力的器件,開關(guān)頻率高,廣泛應(yīng)用于各類固態(tài)電源中。但如果控制不當(dāng),它很容易損壞。一般認(rèn)為 IGBT 損壞的主要原因有兩種:一是 IGBT 退出飽和區(qū)而進(jìn)入了放大區(qū)使得開關(guān)損耗增大;二是
2019-12-27 08:30:00
的二極管V的個(gè)數(shù),如圖2(a)所示,使這些二極管的通態(tài)壓降之和等于或略大于驅(qū)動(dòng)模塊過(guò)流保護(hù)動(dòng)作電壓與IGBT模塊散熱器的通態(tài)飽和壓降Uce之差。 混合驅(qū)動(dòng)模塊與IGBT模塊散熱器過(guò)流保護(hù)的配合 上述用
2012-06-19 11:26:00
和結(jié)構(gòu)函數(shù)分析進(jìn)行模塊內(nèi)部結(jié)構(gòu)的缺陷辨識(shí)和失效機(jī)理分析,并利用仿真的方式對(duì)于不同邊界條件的動(dòng)態(tài)熱傳導(dǎo)過(guò)程進(jìn)行有限元仿真,更直觀地觀察到模塊的熱傳導(dǎo)的過(guò)程,同時(shí)驗(yàn)證了實(shí)驗(yàn)方法的準(zhǔn)確性。 他們發(fā)現(xiàn)在溫度波動(dòng)
2020-12-10 15:06:03
滿足漂移區(qū)電流與漂移區(qū)電阻乘積超過(guò)0.7V,才能使得P+襯底與N-drift的PN結(jié)正向?qū)ǎ@樣才可以work,否則溝道開啟也不能work的。 最后給大家吹吹牛吧,大家經(jīng)常會(huì)聽到第一代IGBT一直
2018-10-17 16:56:39
注入到N 一層的空穴(少子),對(duì)N 一層進(jìn)行電導(dǎo)調(diào)制,減小N一層的電阻,使IGBT 在高電壓時(shí),也具有低的通態(tài)電。IGBT 的工作特性包括靜態(tài)和動(dòng)態(tài)兩類:1 .靜態(tài)特性:IGBT 的靜態(tài)特性主要有伏安
2018-10-18 10:53:03
”,長(zhǎng)期以來(lái),該產(chǎn)品(包括芯片)還是被壟斷在少數(shù)IDM手上(FairChild、Infineon、TOSHIBA),位居“十二五”期間國(guó)家16個(gè)重大技術(shù)突破專項(xiàng)中的第二位(簡(jiǎn)稱 “02專項(xiàng)”)。究竟IGBT是何方神圣?讓我們一起來(lái)學(xué)習(xí)它的理論吧。IGBT的設(shè)計(jì)與仿真 PPT
2020-08-09 08:00:14
Source端,它則需要一個(gè)長(zhǎng)長(zhǎng)的漂移區(qū)來(lái)作為漏極串聯(lián)電阻分壓,使得電壓都降在漂移區(qū)上就可以了。2) 大電流:一般的MOSFET的溝道長(zhǎng)度有Poly CD決定,而功率MOSFET的溝道是靠?jī)纱螖U(kuò)散的結(jié)深差
2020-08-09 07:53:55
IGBT驅(qū)動(dòng)電路分析
2015-03-27 16:09:18
1.引入分布式電源前后的網(wǎng)損模型的建立。2.仿真分析DG接入對(duì)變壓器運(yùn)行臺(tái)數(shù)及網(wǎng)損的影響;變壓器電阻對(duì)網(wǎng)損的影響。3.仿真分析DG接入位置對(duì)網(wǎng)損的影響;DG容量對(duì)網(wǎng)損的影響;DG運(yùn)行方式對(duì)網(wǎng)損的影響。
2015-04-19 10:24:25
DAP仿真器 BURNER
2023-03-28 13:06:20
邊界下會(huì)沿著橫向擴(kuò)散更遠(yuǎn)(圖中P阱),形成一個(gè)有濃度梯度的溝道,它的溝道長(zhǎng)度由這兩次橫向擴(kuò)散的距離之差決定。為了增加擊穿電壓,在有源區(qū)和漏 區(qū)之間有一個(gè)漂移區(qū)。LDMOS中的漂移區(qū)是該類器件設(shè)計(jì)的關(guān)鍵
2020-05-24 01:19:16
建模,通過(guò)內(nèi)部基準(zhǔn)電壓和反饋電阻演示蒙特卡羅和高斯分布技術(shù)。然后,將得出的仿真結(jié)果與最差情況分析仿真結(jié)果進(jìn)行比較。其中包括4個(gè)附錄。附錄A提供了有關(guān)微調(diào)基準(zhǔn)電壓源分布的見解。附錄B提供了LTspice
2022-03-25 10:52:10
。 3.2 電壓測(cè)量 IGBT 開通和關(guān)斷過(guò)程中電壓的完整觀測(cè)可以直接使用示波器探頭, 但對(duì)于開通時(shí)IGBT 電壓拖尾過(guò)程和通態(tài)飽和壓降的測(cè)量, 則需要使用箝位電路( 見圖5) 。原因在于此時(shí)示波器的Y
2018-10-12 17:07:13
(Voltage snapback)現(xiàn)象(如圖3所示),反向恢復(fù)性能差和漂移區(qū)電流分布不均勻等。這些問(wèn)題是RC-IGBT產(chǎn)品廣泛應(yīng)用的障礙。圖3 電壓折回輸出曲線示意圖這次我們先為大家介紹幾種為
2019-09-26 13:57:29
-氧化物-半導(dǎo)體結(jié)構(gòu),作為門極;漂移區(qū)普遍采用N型摻雜的半導(dǎo)體來(lái)承受阻斷電壓;門極施加正壓(高于器件閾值電壓)時(shí),器件導(dǎo)通,通態(tài)電流在漂移區(qū)縱向流動(dòng)。區(qū)別主要在于IGBT在漂移區(qū)背面有P+注入作為集電極
2019-04-22 02:17:17
的N-MOSFET是一樣的。當(dāng)VGE>0V,VCE>0V時(shí),IGBT表面同樣會(huì)形成溝道,電子從n區(qū)出發(fā)、流經(jīng)溝道區(qū)、注入n漂移區(qū),n漂移區(qū)就類似于N-MOSFET的漏極。藍(lán)色虛線部分同理于
2019-07-18 14:14:01
原因我們以今天的主角IGBT為例,通過(guò)分析IGBT在關(guān)斷過(guò)程中載流子的移動(dòng)和分布來(lái)解釋以上這點(diǎn)。當(dāng)IGBT正常工作時(shí),p-base表面會(huì)形成導(dǎo)通溝道,電子從發(fā)射極經(jīng)n型漂移區(qū)流向集電極,而空穴將不
2019-06-28 11:10:16
IGBT在matlab仿真中柵極怎么連接?為什么我畫的IGBT的柵極和電源、PWM連接不上?
2018-11-15 13:26:27
proteus 仿真中的IGBT如何驅(qū)動(dòng)啊 用單片機(jī)直接加高低電平行嗎
2016-05-27 10:01:27
于,它使用低摻雜的N-襯底作為起始層,先在N-漂移區(qū)的正面做成MOS結(jié)構(gòu),然后用研磨減薄工藝從背面減薄到 IGBT 電壓規(guī)格需要的厚度,再?gòu)谋趁嬗秒x子注入工藝形成P+ collector。在截止時(shí)電場(chǎng)
2021-05-26 10:19:23
什么少數(shù)載流子電子能穿過(guò)集電結(jié)形成電流Ib??從外部看:集電結(jié)正偏時(shí),電位Ub>Uc,集電結(jié)的內(nèi)電場(chǎng)變窄,有利于多子的擴(kuò)散運(yùn)動(dòng),不利于少子的漂移運(yùn)動(dòng),而少子電子還是能形成電流Ib??這是不是和我們說(shuō)的PN結(jié)不同?那位大俠能給我從內(nèi)部結(jié)構(gòu)來(lái)詳細(xì)說(shuō)明一下。。。`
2012-12-21 11:56:02
同樣會(huì)形成溝道,電子從n區(qū)出發(fā)、流經(jīng)溝道區(qū)、注入n漂移區(qū),n漂移區(qū)就類似于N-MOSFET的漏極。藍(lán)色虛線部分同理于BJT結(jié)構(gòu),流入n漂移區(qū)的電子為PNP晶體管的n區(qū)持續(xù)提供電子,這就保證了PNP晶體管
2023-02-10 15:33:01
當(dāng)MDD二極管兩端外加電壓發(fā)生變化時(shí),一方面PN結(jié)寬窄變化,勢(shì)壘區(qū)內(nèi)的施主陰離子和受主陽(yáng)離子數(shù)量會(huì)改變;另一方面擴(kuò)散的多子和漂移的少子數(shù)量也會(huì)因電壓變化而改變。這種情況與電容的作用類似,分別用勢(shì)壘
2021-06-15 17:08:31
輸入阻抗特性。當(dāng)MOSFET 的溝道形成后,從P+ 基極注入到N 一層的空穴(少子),對(duì)N 一層進(jìn)行電導(dǎo)調(diào)制,減小N 一層的電阻,使IGBT 在高電壓時(shí),也具有低的通態(tài)電壓。文章來(lái)源:中國(guó)電力電子產(chǎn)業(yè)網(wǎng)-IGBTIGBT模塊散熱器 區(qū)熔單晶 陶瓷覆銅板`
2012-06-19 11:36:58
什么是萊斯 (Rician) 分布當(dāng)接收機(jī)與發(fā)射機(jī)距離很近時(shí),或固定接收時(shí),接收信號(hào)中也會(huì)出現(xiàn)發(fā)射信號(hào)的直達(dá)波,增強(qiáng)了接收信號(hào)的平均電平,符合了 Rice 分析的正弦波加窄帶高斯噪聲情況,這時(shí)把接收
2008-05-30 13:15:33
電流密度(P區(qū))J=enD/L其中n是P區(qū)邊緣處平衡態(tài)時(shí)的少子濃度。D是擴(kuò)散系數(shù),L是擴(kuò)散長(zhǎng)度。參雜濃度越大,n應(yīng)該越小。N區(qū)的多子電子擴(kuò)散到P區(qū)就是少子了,在那邊P區(qū)不還是要進(jìn)行少子擴(kuò)散么?我說(shuō)
2010-12-02 19:09:24
碰撞電離率模型進(jìn)行化簡(jiǎn)計(jì)算。(3)應(yīng)用準(zhǔn)確的Chynoweth碰撞電離率模型,基于已有的Miller公式,對(duì)不同漂移區(qū)摻雜濃度下的S參數(shù)進(jìn)行了確定,提出了參數(shù)S與漂移區(qū)摻雜濃度N的擬合公式,并驗(yàn)證了其
2019-10-30 13:22:00
導(dǎo)電性外加正向電壓(正偏):在外電場(chǎng)作用下,多子將向PN結(jié)移動(dòng),結(jié)果使空間電荷區(qū)變窄,內(nèi)電場(chǎng)被削弱,有利于多子的擴(kuò)散而不利于少子的漂移,擴(kuò)散運(yùn)動(dòng)起主要 作用。結(jié)果,P區(qū)的多子空穴將源源不斷的流向N區(qū),而N
2015-03-26 20:32:03
電路中的參數(shù)。 1 柵極電阻和分布參數(shù)分析 IGBT在全橋電路工作時(shí)的模型如圖1所示。 RG+Rg是IGBT的柵極電阻, L01、L02、L03是雜散電感(分布電感), Cgc、Cge、Cce
2011-09-08 10:12:26
在做時(shí)序仿真的時(shí)候,發(fā)現(xiàn)一個(gè)問(wèn)題,代碼如下:assign gateway_out1 = gateway_in10 * gateway_in11 結(jié)果發(fā)現(xiàn) 輸出帶有高阻態(tài),波形如圖。 在做功能仿真的時(shí)候沒(méi)有問(wèn)題,做時(shí)序仿真就出現(xiàn)問(wèn)題了。 請(qǐng)問(wèn)這是什麼原因造成的。
2017-07-27 09:09:53
有意者加q:1534120811.引入分布式電源前后的網(wǎng)損模型的建立。2.仿真分析DG接入對(duì)變壓器運(yùn)行臺(tái)數(shù)及網(wǎng)損的影響;變壓器電阻對(duì)網(wǎng)損的影響。3.仿真分析DG接入位置對(duì)網(wǎng)損的影響;DG容量對(duì)網(wǎng)損的影響;DG運(yùn)行方式對(duì)網(wǎng)損的影響。
2015-04-19 19:24:29
本帖最后由 eehome 于 2013-1-5 10:08 編輯
IGBT失效分析大概有下面幾個(gè)方面:1、IGBT過(guò)壓失效,Vge和Vce、二極管反向電壓失效等。2、IGBT過(guò)流,一定程度
2012-12-19 20:00:59
1.2kV,可作為IGBT的續(xù)流二極管,顯著減小IGBT的開通功耗,并抑制開關(guān)噪聲。 如圖2c所示,SFD結(jié)構(gòu)是通過(guò)用A1-Si替代A1電極在p區(qū)之間的n-漂移區(qū)表面形成一個(gè)極薄的p-區(qū),以控制淺
2019-02-12 15:38:27
。 當(dāng)柵極和發(fā)射極短接并在集電極端子施加一個(gè)正電壓時(shí),P/N J3結(jié)受反向電壓控制,此時(shí),仍然是由N漂移區(qū)中的耗盡層承受外部施加的電壓。 IGBT在集電極與發(fā)射極之間有一個(gè)寄生PNPN晶閘管(如圖1
2019-03-05 06:00:00
區(qū)。 (3)通態(tài)電壓Von:圖1-12:IGBT通態(tài)電壓和MOSFET比較所謂通態(tài)電壓,是指IGBT進(jìn)入導(dǎo)通狀態(tài)的管壓降VDS,這個(gè)電壓隨VGS上升而下降。由上圖可以看到,IGBT
2009-05-12 20:44:23
。在這里我們主要討論N-基區(qū)內(nèi)的載流子分布,因?yàn)?b class="flag-6" style="color: red">IGBT的開關(guān)特性主要受N-基區(qū)載流子影響。通態(tài)下,N-基區(qū)充滿了電子和空穴,因此該區(qū)域也可以稱為載流子存儲(chǔ)區(qū)(Carrier Storage Region
2023-02-13 16:11:34
另一側(cè)的P+ 區(qū)稱為漏注入區(qū)( Drain injector ),它是IGBT 特有的功能區(qū),與漏區(qū)和亞溝道區(qū)一起形成PNP 雙極晶體管,起發(fā)射極的作用,向漏極注入空穴,進(jìn)行導(dǎo)電調(diào)制,以降低器件的通態(tài)
2012-03-23 11:13:52
本人本科時(shí)學(xué)過(guò)一點(diǎn)模電,對(duì)微電子理解不深。請(qǐng)教幾個(gè)IGBT領(lǐng)域的問(wèn)題:1、場(chǎng)截止層是如何起作用的:為什么加入場(chǎng)截止層之后需要的漂移區(qū)的厚度變薄而且還可以提高耐壓?摻雜濃度較高的場(chǎng)截止層不是變相提升
2020-02-20 14:26:40
,IGBT應(yīng)該不會(huì)導(dǎo)通,圖2中信號(hào)3似乎表明IGBT有通斷。然后又想會(huì)不會(huì)因?yàn)?b class="flag-6" style="color: red">IGBT中的續(xù)流二極管的影響,于是我做了以下仿真,如圖3,圖4.圖3 圖4圖4為電流傳感器的波形,電流很小,應(yīng)該不是續(xù)流二極管
2016-01-09 12:10:23
的縱向NPT-IGBT基本相同,其有源區(qū)在正面,包括多晶硅柵極、n+發(fā)射區(qū)和p基區(qū),然后有源區(qū)的下面是n-漂移區(qū),最后是集電極。當(dāng)集射極之間加正電壓時(shí),由p-基區(qū)和n-漂移區(qū)形成的反偏PN結(jié)來(lái)承擔(dān)外部
2020-12-11 16:54:35
INTEWORK-VBA(Vehicle Bus Analyzer) 車輛總線監(jiān)控分析及仿真工具,是由經(jīng)緯恒潤(rùn)自主研發(fā)的一款專業(yè)、易用的車載
2021-03-05 10:42:54
陜西天士立科技有限公司/ST-FBSOA/IGBT/MOS正向偏置安全工作區(qū)測(cè)試系統(tǒng),可以測(cè)試Si,SiC,GaN,材料的器件級(jí)和模塊級(jí)的IGBT,MOSFET的FBSOA
2024-08-01 13:50:58
從安全工作區(qū)探討IGBT的失效機(jī)理
1、? 引言
半導(dǎo)體功率器件失效的原因多種多樣。換效后進(jìn)行換效分析也是十分困難和復(fù)雜的。其中失效的主要原因之
2010-02-22 09:32:42 3714
3714 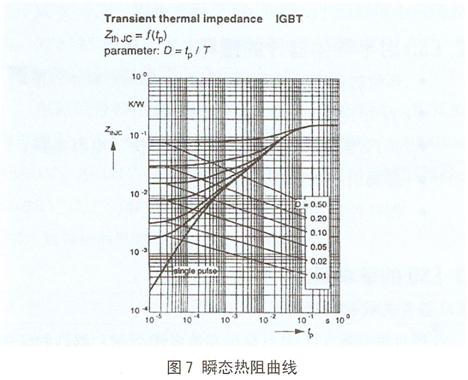
介紹了用Multisim仿真軟件分析三態(tài)門工作過(guò)程的方法,目的是探索三態(tài)門工作波形的仿真實(shí)驗(yàn)技術(shù),即用Multisim仿真軟件中的字組產(chǎn)生器產(chǎn)生三態(tài)門的控制信號(hào)及輸入信號(hào),用Multisim中示
2011-05-06 15:59:38 0
0 基于混沌、均勻分布的真隨機(jī)數(shù)發(fā)生器的工作電路和精度要求較高的電壓參考電路的溫度漂移進(jìn)行分析,給出了仿真得到的溫度曲線;分析了工藝中可能存在的問(wèn)題和溫度的影響與運(yùn)放的
2011-06-10 15:53:22 26
26 利用silvaco軟件對(duì)PT-IGBT的I-V特性進(jìn)行了仿真,在同一電流密度下提取了不同柵極寬度IGBT的通態(tài)壓降,得到了通態(tài)壓降隨柵極寬度變化的曲線,該仿真結(jié)果與理論分析一致。對(duì)于相同的元
2011-12-05 15:28:54 31
31 N+緩沖層設(shè)計(jì)對(duì)PT-IGBT器件特性的影響至關(guān)重要。文中利用Silvaco軟件對(duì)PT-IGBT的I-V特性進(jìn)行仿真。提取相同電流密度下,不同N+緩沖層摻雜濃度PT-IGBT的通態(tài)壓降,得到了通態(tài)壓降隨N+緩沖層
2013-05-06 18:17:06 45
45 從偶極子天線的完整場(chǎng)分布出發(fā),結(jié)合近區(qū)場(chǎng)和遠(yuǎn)區(qū)場(chǎng)的特點(diǎn),在保證誤差精度為1dB的前提下,經(jīng)理論分析計(jì)算及MATLAB擬合對(duì)比,得到了偶極子天線近區(qū)、過(guò)渡區(qū)、遠(yuǎn)區(qū)的范圍,并給出
2013-06-25 16:26:13 13
13 功率MOSFET的工作原理 截止:漏源極間加正電源,柵源極間電壓為零。P基區(qū)與N漂移區(qū)之間形成的PN結(jié)J1反偏,漏源極之間無(wú)電流流過(guò)。 導(dǎo)電:在柵源極間加正電壓UGS,柵極是絕緣的,所以不會(huì)有柵極
2017-09-29 16:53:28 18
18 壓接型IGBT器件內(nèi)部各組件直接堆疊在一起,通過(guò)外部壓力使得各組件間保持良好的機(jī)械與電氣接觸,進(jìn)而引入一定比例的接觸電阻和接觸熱阻,所以器件內(nèi)部的壓力分布不僅影響器件內(nèi)部的電流分布和溫度分布,還將
2018-02-27 11:22:10 2
2 《微電網(wǎng)分析與仿真理論》——分布式發(fā)電系統(tǒng)模型pdf資料下載
2018-04-08 11:03:22 0
0 近年來(lái)電力電子技術(shù)的迅猛發(fā)展促進(jìn)了半導(dǎo)體功率器件的發(fā)展,計(jì)算機(jī)仿真技術(shù)的不斷進(jìn)步大大降低了電力電子技術(shù)的研發(fā)成本,提高了效率。計(jì)算機(jī)仿真的關(guān)鍵為器件的建模。IGBT為新型電力電子器件,通用仿真軟件中(如Pspice)沒(méi)有它的仿真模型,所以建立Pspice仿真模型對(duì)于電路仿真具有重要的實(shí)際意義。
2019-12-26 14:33:26 16
16 。 MOSFET和IGBT技術(shù) 由于不存在少數(shù)載流子傳輸,因此可以在更高的頻率下開關(guān)MOSFET。對(duì)此的限制由兩個(gè)因素強(qiáng)加:電子在漂移區(qū)中的傳播時(shí)間以及對(duì)輸入柵極和米勒電容進(jìn)行充電和放電所需的時(shí)間
2021-05-26 17:04:02 4024
4024 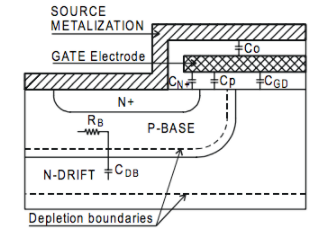
MOSFET的阻斷電壓已經(jīng)可以做到10 kV,但作為一種缺乏電導(dǎo)調(diào)制的單極性器件,進(jìn)一步提高阻斷電壓將會(huì)面臨通態(tài)電阻升高的問(wèn)題。理論計(jì)算表明,20 kV的碳化硅功率MOSFET需要制備厚度超過(guò)172 μm的漂移區(qū),則其通態(tài)特征電阻將會(huì)顯著增大,可超過(guò)245 mΩ·cm2。因此實(shí)現(xiàn)高壓大電流功率器件
2021-04-07 14:09:25 1006
1006 
多子與少子器件傳統(tǒng)的功率器件根據(jù)主要導(dǎo)電載流子一般分為多子和少子器件,少子器件主要包括二極管,BJT,晶閘管,GTO等,這些器件導(dǎo)通的時(shí)候電流至少經(jīng)過(guò)一個(gè)PN節(jié),并且電子和空穴同時(shí)導(dǎo)電,其都是進(jìn)入對(duì)應(yīng)的PN區(qū)的少數(shù)載流子,最終形成電流。
2021-04-08 10:12:51 6943
6943 
MOS器件第一個(gè)深溝槽(Deep Trench)作為“體內(nèi)場(chǎng)板”在反向電壓下平衡漂移區(qū)電荷,這樣可以降低漂移區(qū)的電阻率,從而降低器件的比導(dǎo)通電阻(RSP)和柵極電荷(Qg)。
2021-05-08 17:47:21 28747
28747 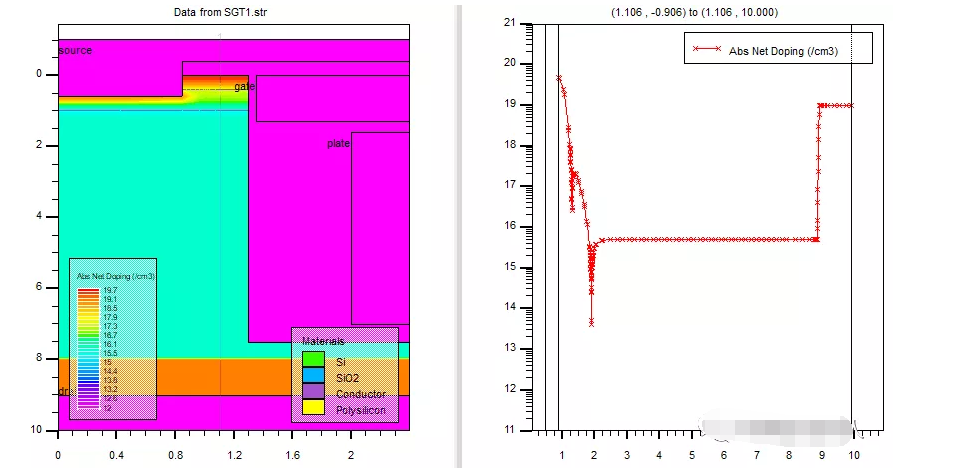
廣泛應(yīng)用。 IGBT憑借其高輸入阻抗、驅(qū)動(dòng)電路簡(jiǎn)單、開關(guān)損耗小等優(yōu)點(diǎn)在MOSFET和BJT的基礎(chǔ)上有效降低了n漂移區(qū)的電阻率,大大提高了器件的電流能力。目前IGBT已經(jīng)能夠覆蓋從600V—6500V的電壓范圍。 我國(guó)擁有最大的功率半導(dǎo)體市場(chǎng),目前IGBT等高
2021-10-12 10:18:45 4372
4372 通過(guò)此系列文章,目前我們學(xué)習(xí)了過(guò)程能力分析的意義,基于Minitab的正態(tài)/非正態(tài)數(shù)據(jù)過(guò)程能力分析的思路和方法,其中在非正態(tài)數(shù)據(jù)能力分析中,我們講了兩種方法——轉(zhuǎn)換方法和擬合其他分布方法。文章發(fā)布后
2022-05-17 16:35:59 1814
1814 
IGBT的驅(qū)動(dòng)方法和MOSFET基本相同,只需控制輸入極N一溝道MOSFET,所以具有高輸入阻抗特性。當(dāng)MOSFET的溝道形成后,從P+基極注入到N一層的空穴(少子),對(duì)N一層進(jìn)行電導(dǎo)調(diào)制,減小N一層的電阻,使IGBT在高電壓時(shí),也具有低的通態(tài)電壓。
2022-08-18 16:37:46 5731
5731 絕緣柵雙極型晶體管(IGBT) 是雙極型晶體管(BJT) 和場(chǎng)效應(yīng)晶體管(MOSFET) 的復(fù)合器件,IGBT將BJT的電導(dǎo)調(diào)制效應(yīng)引入到
VDMOS 的高阻漂移區(qū), 大大改善了器件的導(dǎo)通特性
2023-02-22 14:57:54 6
6 缺乏電導(dǎo)調(diào)制的單極性器件,進(jìn)一步提高阻斷電壓
將會(huì)面臨通態(tài)電阻升高的問(wèn)題。理論計(jì)算表明,20 kV的碳化硅功率MOSFET需要制備厚度超過(guò)172 μm的漂移區(qū),則其通態(tài)特
征電阻將會(huì)顯著增大,可超過(guò)245 mΩ·cm2。因此實(shí)現(xiàn)高壓大電流功率器件(>7kV,>100A)的希望寄托
2023-02-24 10:33:51 0
0 今天,本文就和大家嘮一嘮IGBT的安全工作區(qū),英文全稱safe operating area,簡(jiǎn)稱SOA。顧名思義,也就是說(shuō)只要使用的條件(電壓、電流、結(jié)溫等)不
超出SOA圈定的邊界,IGBT
2023-02-24 09:35:20 13
13 小川給大家介紹的是直流工作點(diǎn)的溫度漂移的Multisim仿真及分析。希望大家能夠多多支持。
2023-03-01 11:48:27 2526
2526 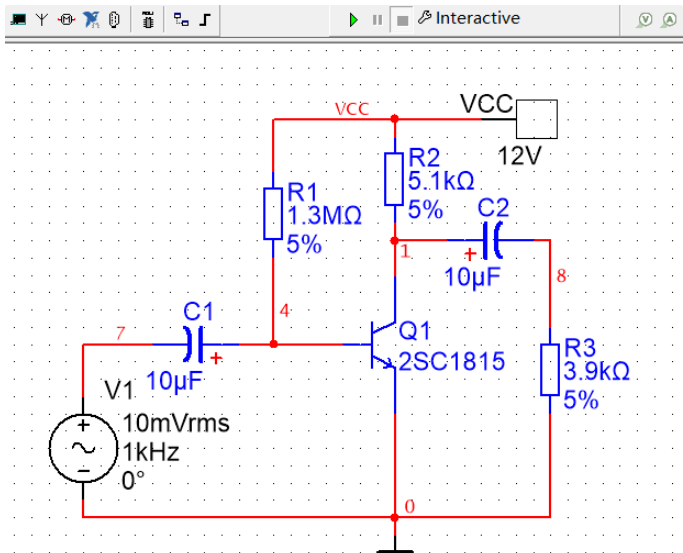
理想比導(dǎo)通電阻的一個(gè)關(guān)系式,其中WD是滿足所需擊穿電壓BV的漂移區(qū)的厚度,q是電子電荷,ND是漂移區(qū)的摻雜濃度,μn是電子遷移率,εn是半導(dǎo)體介電常數(shù),EC是所需耐壓的臨界電場(chǎng)值。
2023-05-23 09:26:11 2253
2253 
絕緣柵雙極型晶體管(IGBT) 是雙極型晶體管(BJT) 和場(chǎng)效應(yīng)晶體管(MOSFET) 的復(fù)合器件,IGBT將BJT的電導(dǎo)調(diào)制效應(yīng)引入到VDMOS 的高阻漂移區(qū), 大大改善了器件的導(dǎo)通特性
2023-05-25 17:11:50 6445
6445 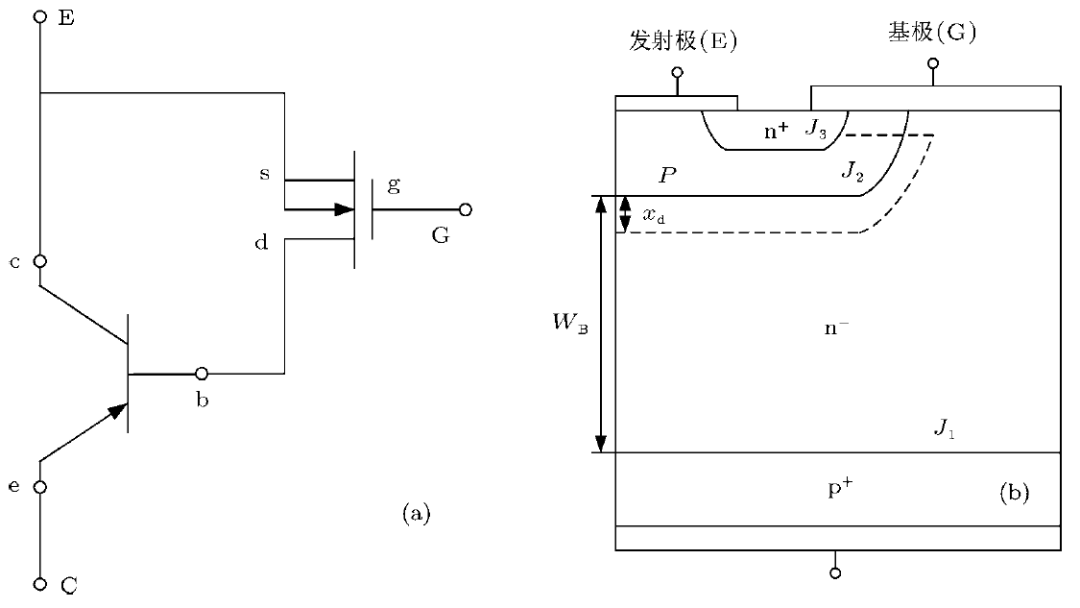
10.2.1垂直漂移區(qū)10.2單極型器件漂移區(qū)的優(yōu)化設(shè)計(jì)第10章功率器件的優(yōu)化和比較《碳化硅技術(shù)基本原理——生長(zhǎng)、表征、器件和應(yīng)用》代理產(chǎn)品線:1、國(guó)產(chǎn)AGMCPLD、FPGAPtP替代Altera
2022-04-09 09:38:19 656
656 
10.2.2橫向漂移區(qū)10.2單極型器件漂移區(qū)的優(yōu)化設(shè)計(jì)第10章功率器件的優(yōu)化和比較《碳化硅技術(shù)基本原理——生長(zhǎng)、表征、器件和應(yīng)用》代理產(chǎn)品線:1、國(guó)產(chǎn)AGMCPLD、FPGAPtP替代Altera
2022-04-11 15:15:45 701
701 
在IGBT開關(guān)過(guò)程中通常用開通延遲td(on)、關(guān)斷延遲td(off)、上升時(shí)間tr和下降時(shí)間tf來(lái)進(jìn)行描述。圖5是IGBT整個(gè)開關(guān)過(guò)程的波形。
2023-07-12 11:07:38 1220
1220 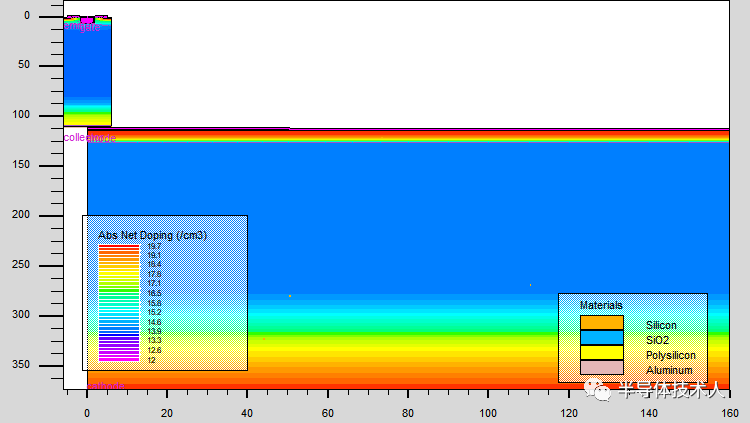
摘要: 為提升高壓 IGBT 的抗短路能力,進(jìn)一步改善短路與通態(tài)壓降的矛盾關(guān)系,研究了
IGBT 背面工藝對(duì)抗短路能力的影響。通過(guò) TCAD 仿真,在 IGBT 處于負(fù)載短路工作期間,針對(duì)場(chǎng)
2023-08-08 10:14:47 2
2 igbt為什么要反并聯(lián)二極管 IGBT是一種功率器件,它是一種膜材料型結(jié)構(gòu),它采用P型部分、N型部分、漂移區(qū)、隔離氧化層、金屬控制電極和保護(hù)結(jié)構(gòu)等元件組成,為集成化的功率MOSFET和雙極性晶體管
2023-08-29 10:25:59 6721
6721 逆變器IGBT模塊的應(yīng)用分析(1)根據(jù)負(fù)載的工作電壓和額定電流,以及使用頻率,選擇合適規(guī)格的模塊。使用模塊前,請(qǐng)?jiān)敿?xì)閱讀模塊參數(shù)數(shù)據(jù)表,了解模塊的各項(xiàng)技術(shù)指標(biāo);根據(jù)模塊的技術(shù)參數(shù)確定使用方案,計(jì)算
2023-09-20 17:49:52 2996
2996 
海量分布式光伏接入主動(dòng)配電網(wǎng)臺(tái)區(qū),將引起含分布式光伏接入的配電網(wǎng)臺(tái)區(qū)功率因數(shù)異常,臺(tái)區(qū)用戶電能質(zhì)量問(wèn)題日益突出,而用戶側(cè)功率因數(shù)較低將引起電網(wǎng)考核。鑒于此,利用分布式光伏逆變器無(wú)功輸出能力,提升
2023-09-28 14:06:44 4122
4122 
電子發(fā)燒友網(wǎng)站提供《柵極寬度對(duì)IGBT通態(tài)壓降的影響.pdf》資料免費(fèi)下載
2023-10-25 10:45:41 0
0 Q A 問(wèn): IGBT 的安全工作區(qū) 在 ? IGBT ? 的規(guī)格書中,可能會(huì)看到安全工作區(qū)(SOA, Safe Operating Area),例如 ? ROHM
2023-12-13 20:15:02 3750
3750 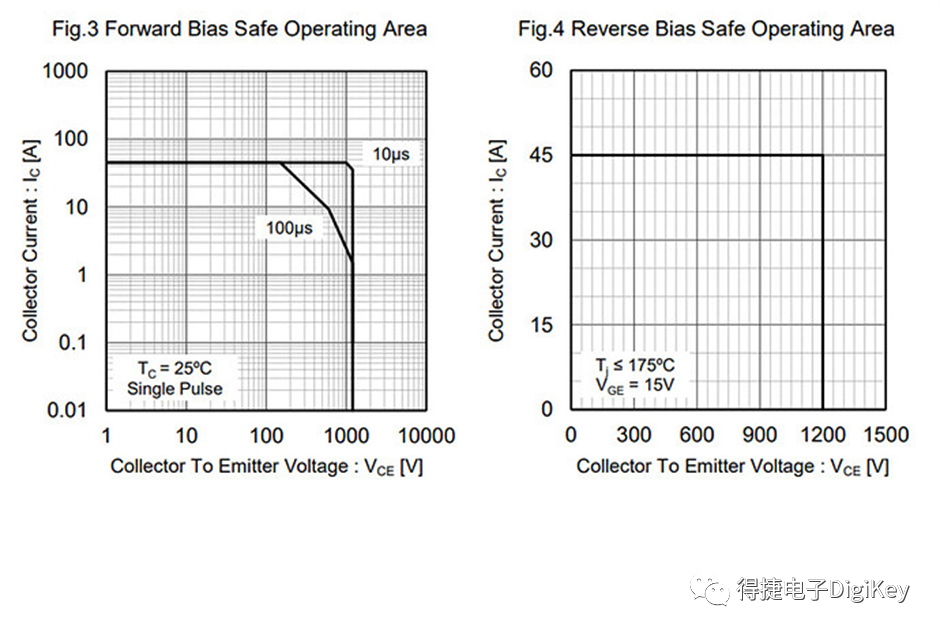
領(lǐng)域。盡管它們有一些相似之處,但在結(jié)構(gòu)、特性和應(yīng)用方面存在顯著的差異。 首先,讓我們來(lái)看一下IGBT的基本結(jié)構(gòu)。IGBT是一種三極管型器件,結(jié)合了MOSFET的驅(qū)動(dòng)能力和雙極型晶體管的低導(dǎo)通壓降特性。它由一個(gè)P型襯底、一個(gè)N型集電極、一個(gè)P型獨(dú)立柵控極和一個(gè)N型漂移區(qū)組成。IGBT的工作原理
2023-12-19 09:56:33 3799
3799 IGBT和MOSFET在對(duì)飽和區(qū)的定義差別? IGBT和MOSFET是傳輸電力和控制電流的重要電子器件。它們?cè)谠S多電力電子應(yīng)用中起著關(guān)鍵的作用。飽和區(qū)是IGBT和MOSFET工作的一個(gè)重要區(qū)域,但是
2024-02-18 14:35:35 4111
4111 IGBT(絕緣柵雙極型晶體管)的工作區(qū)主要涉及其在不同工作狀態(tài)下的安全運(yùn)行區(qū)域,這些區(qū)域定義了IGBT在特定條件下的電壓、電流及功率限制,以確保其穩(wěn)定運(yùn)行并防止損壞。
2024-07-24 10:52:00 4308
4308 新潔能650V Gen.7系列IGBT產(chǎn)品,基于微溝槽場(chǎng)截止技術(shù),可大幅提高器件的元胞結(jié)構(gòu)密度。采用載流子存儲(chǔ)設(shè)計(jì)、多梯度緩沖層設(shè)計(jì)、超薄漂移區(qū)設(shè)計(jì),大幅度提升器件的電流密度。同時(shí)優(yōu)化了器件的開關(guān)特性,為系統(tǒng)設(shè)計(jì)提供更大的余量。
2024-08-15 16:34:22 1808
1808 
(MOSFET)?結(jié)合而成。其核心價(jià)值在于兼具M(jìn)OSFET的高輸入阻抗(驅(qū)動(dòng)功率小)與BJT的低導(dǎo)通壓降特性,實(shí)現(xiàn)了電能高效轉(zhuǎn)換與精準(zhǔn)控制。 ?核心特性? ?結(jié)構(gòu)特性? 采用?PNPN垂直疊層結(jié)構(gòu)?,包含發(fā)射區(qū)(P+)、集電區(qū)(N-)、漂移區(qū)(N+)和柵極區(qū)(P)。 電流流動(dòng)方向垂直于晶片表面,有助于提
2025-05-14 14:45:54 2652
2652
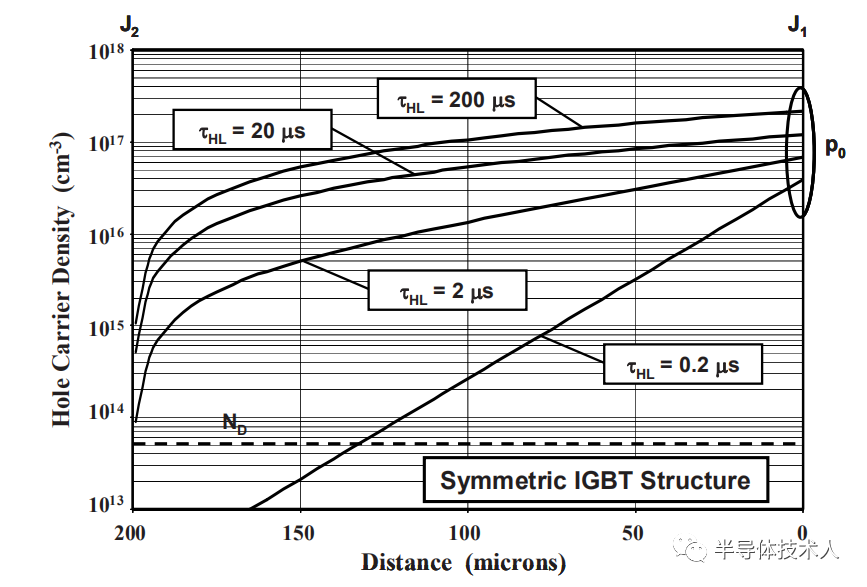
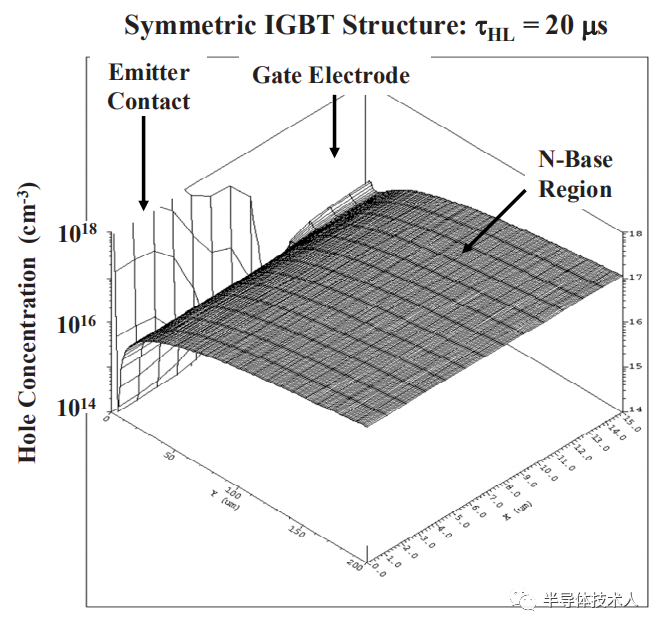
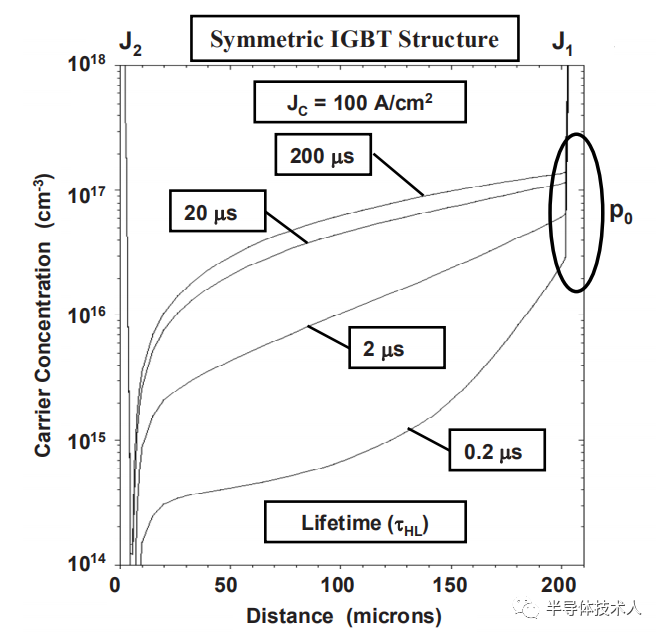
 電子發(fā)燒友App
電子發(fā)燒友App














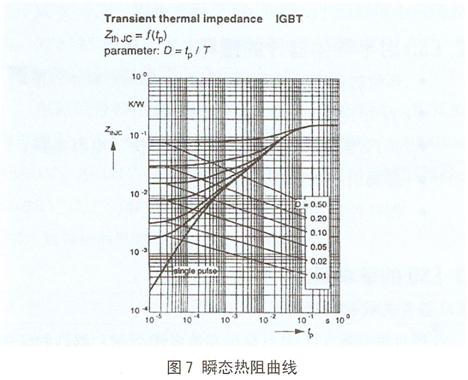

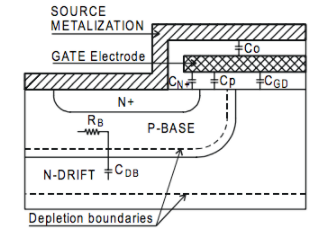


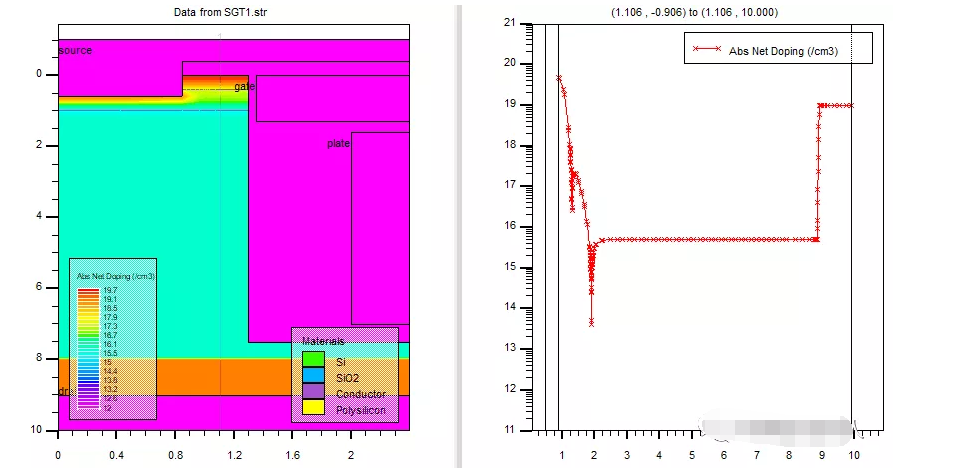

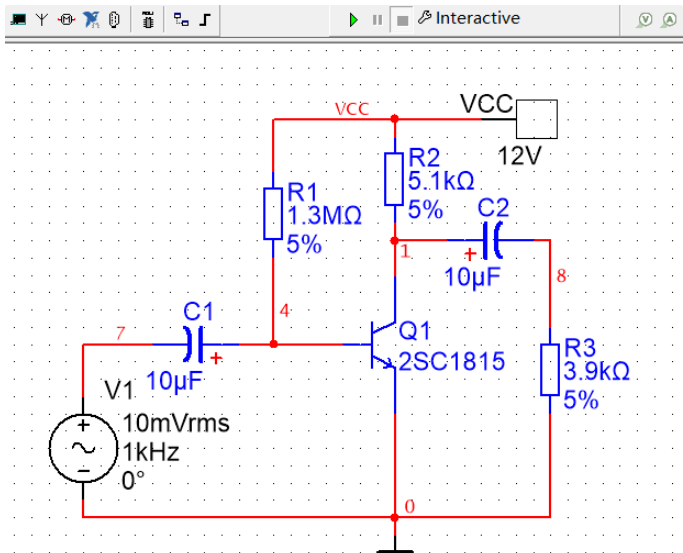

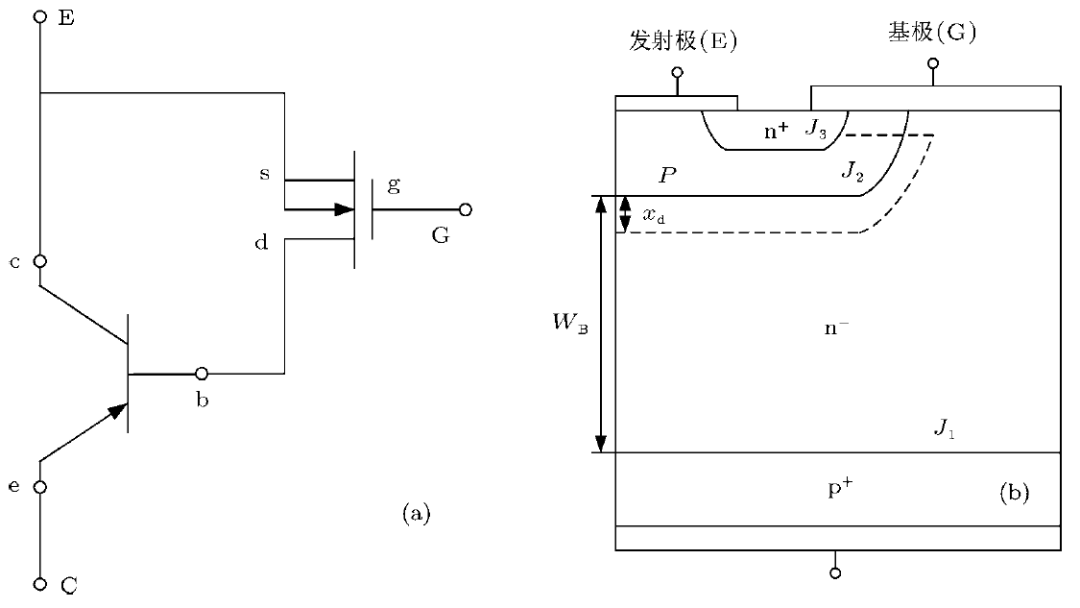

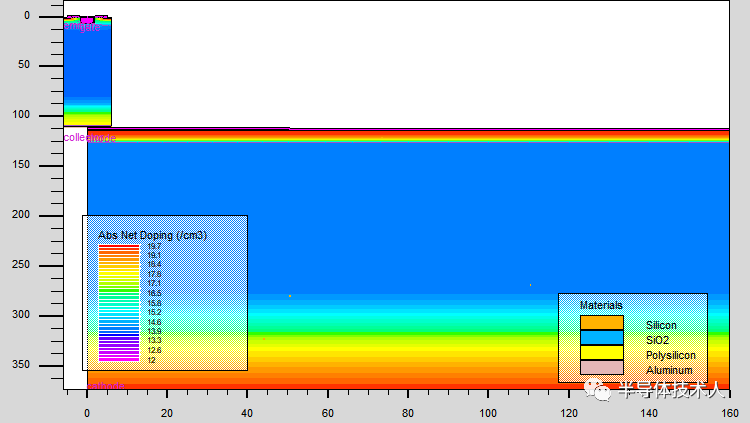


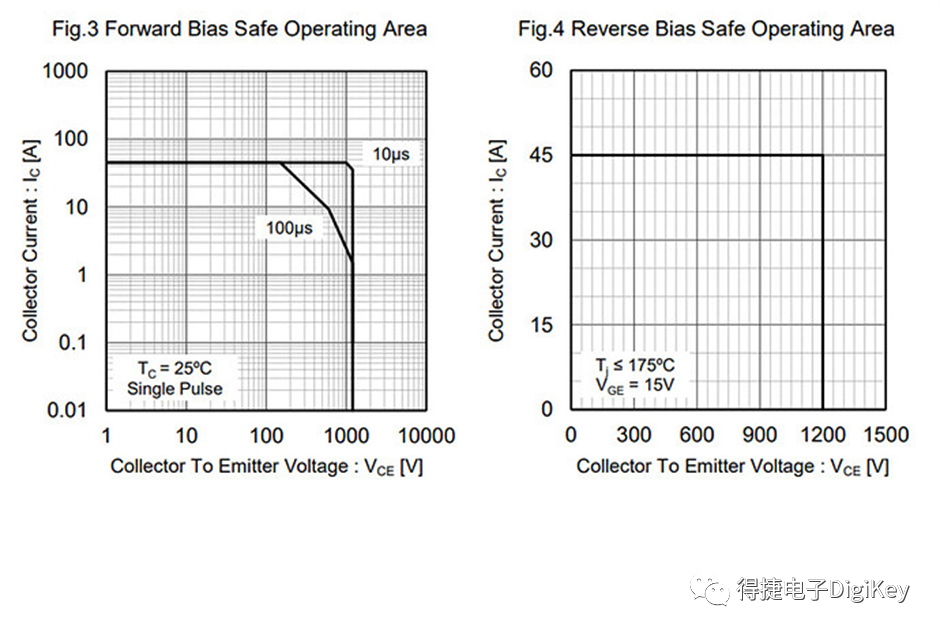




評(píng)論