隨著2D平面半導體技術漸入瓶頸,2.5D、3D立體封裝普遍被視為未來大趨勢,AMDFiji/Vega GPU核心與HBM顯存、Intel Foveros全新封裝、3D NAND閃存等等莫不如此。
但隨著堆疊元器件的增多,集中的熱量如何有效散出去也成了大問題,AMD就悄然申請了一項非常巧妙的專利設計。
AMD Fiji GPU與HBM顯存
Intel Foveros立體封裝
根據專利描述,AMD計劃在3D堆棧的內存或邏輯芯片中間插入一個熱電效應散熱模塊(TEC),原理是利用帕爾貼效應(Peltier Effect)。
它也被稱作熱電第二效應、溫差電效應。由N型、P型半導體材料組成一對熱電偶,通入直流電流后,因電流方向不同,電偶結點處將產生吸熱和放熱現象。
按照AMD的描述,利用帕爾貼效應,位于熱電偶上方和下方的上下內存/邏輯芯片,不管哪一個溫度更高,都可以利用熱電偶將熱量吸走,轉向溫度更低的一側,進而排走。

不過也有不少問題AMD沒有解釋清楚,比如會不會導致上下的元器件溫度都比較高?熱電偶本身也會耗電發熱又如何處理?
但總的來說,AMD的這個思路非常新奇巧妙,未來或許會有很光明的前景。
-
芯片
+關注
關注
463文章
54010瀏覽量
466082 -
amd
+關注
關注
25文章
5684瀏覽量
139971 -
半導體
+關注
關注
339文章
30737瀏覽量
264149
原文標題:動態 | AMD新專利思路清奇,芯片散熱還能這么玩
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
英偉達Rubin GPU采用鉆石銅散熱,解決芯片散熱難題
奇捷科技EasyAI ECO Suite即將發布
沒有專利的opencv-python 版本
亞馬遜:調用跨境物流API追蹤國際包裹清關狀態,優化時效

浮思特|NMB散熱風扇是什么品牌?為什么會被廣泛使用?

兩種散熱路徑的工藝與應用解析
清鶴科技與龍芯中科簽署戰略合作協議
三防漆與散熱的關系:涂層會不會影響設備散熱?

看點:AMD服務器CPU市場份額追上英特爾 華為Mate80主動散熱專利曝光

蘋果發布的主動散熱專利,或將開啟移動電影攝影的未來

【智能控溫,性能全開!】峰岹科技推出FT3207手機主動散熱芯片,降溫效率提升15%




 AMD新專利思路清奇 芯片散熱還能這么玩
AMD新專利思路清奇 芯片散熱還能這么玩


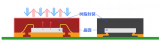



評論