文章來源:學習那些事
原文作者:小陳婆婆
本文介紹了硅片表面細拋光與最終拋光。
1.1硅片表面細拋光
硅片表面細拋光作為實現超精密加工的關鍵工序,其核心在于通過精準調控拋光布材質、拋光液成分及工藝參數,在5-8μm的加工量范圍內實現局部平整度≤10nm、表面粗糙度≤0.2nm的極致控制,同時進一步降低金屬離子污染。

該工序對環境潔凈度要求嚴苛——300mm硅片加工區域需達到1000級以上,通過高效空氣過濾系統與正壓控制確保微粒污染最小化,避免加工過程中引入二次缺陷。

為滿足IC芯片線寬從130nm向7nm及以下演進的需求,細拋光工藝正朝著更高精度、更低損傷的方向突破。雙面拋光技術通過同步加工硅片兩側,顯著提升了加工效率與厚度均勻性,成為200mm與300mm大直徑硅片的主流選擇。美國Rodel公司等供應商通過深入研究拋光布硬度、結構與表面粗糙度的關聯性,開發出系列化產品——如低硬度聚氨酯發泡墊配合納米級SiO?拋光液,可實現表面劃痕缺陷密度降低30%以上;而高密度絨毛結構拋光布則通過增強拋光液承載能力,提升了加工一致性。
近年來,智能化與環保化成為細拋光技術的重要發展方向。基于機器視覺與傳感器的實時監測系統可動態調整拋光壓力、轉速及拋光液供給量,實現加工參數的自適應優化,將局部平整度控制精度提升至亞納米級。環保型低腐蝕性拋光液通過優化硅溶膠粒徑分布與pH緩沖體系,在保持高效拋光性能的同時減少了廢液處理成本與環境負擔。此外,納米級氧化鈰復合拋光液的開發,通過化學機械協同作用的增強,實現了對超細線寬硅片的無損傷加工。
1.2硅片表面最終拋光
硅片表面最終拋光作為滿足超細線寬IC芯片(線寬<28nm)對表面納米形貌及雜質污染極致要求的關鍵工序,其技術路徑正呈現傳統化學機械拋光與新興干化學平坦化技術并行的演進態勢。
傳統堿性膠體二氧化硅化學機械拋光通過化學腐蝕與機械摩擦的協同作用實現表面精修——硅片與NaOH反應生成可溶性硅酸鹽,配合50-70nm SiO?膠粒的吸附作用及拋光布的機械摩擦,在約1μm的加工量范圍內完成損傷層去除與鏡面化,需精準調控拋光液粒度、pH值、拋光布材質(如Rodel IC1000多孔聚氨酯墊)及工藝參數(壓力、轉速、溫度),以控制總厚度偏差(TTV)、局部平整度(STIR/SFQR)等核心指標,確保表面無凹坑、橘皮、波紋及熱氧化堆垛層錯(OISF)等微缺陷。

與此同時,數字控制干化學平坦化等離子體技術(D.C.P)作為前沿突破方向,通過SF?等離子體電離產生的氟原子與硅反應(Si+4F→SiF?),實現無接觸、高精度加工。該技術憑借計算機實時控制等離子體腐蝕時間與掃描速度,可精準去除表面凸起,達成GBIR≤0.50μm、SBIR<0.13μm、SFQR<0.10μm的極致精度,同時將邊緣扣除距離從3mm縮減至1mm,使IC芯片有效面積增加約2.7%,單片加工成本降至約2.4美元。盡管D.C.P設備投資較高且面臨等離子體源穩定性、掃描系統精度、表面損傷控制等技術挑戰,但其在450mm以上超大直徑硅片及7nm以下超細線寬工藝中的潛力顯著,正通過優化等離子體工藝參數、提升三維掃描控制精度等研究逐步推進產業化。
當前,300mm硅片最終拋光仍多采用傳統堿性膠體二氧化硅單面拋光工藝,因其技術成熟且成本可控,但D.C.P技術作為未來方向,正通過材料科學、等離子體物理與智能控制技術的交叉創新,持續突破加工精度與成本瓶頸。
最終拋光的工藝優化需系統考量拋光液成分(如納米級SiO?溶膠)、拋光布結構(如絨毛層與發泡層復合設計)、工藝參數(壓力梯度、pH緩沖體系)的協同匹配,以實現表面粗糙度≤0.2nm、局部平整度≤10nm的極致控制,滿足先進半導體制造對硅片表面質量與幾何尺寸的嚴苛要求。
-
芯片制造
+關注
關注
11文章
734瀏覽量
30519 -
硅片
+關注
關注
13文章
416瀏覽量
35790
原文標題:芯片制造——硅片表面細拋光與最終拋光
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄



 芯片制造中的硅片表面細拋光與最終拋光加工工藝介紹
芯片制造中的硅片表面細拋光與最終拋光加工工藝介紹

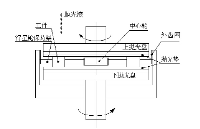










評論