文章來(lái)源:學(xué)習(xí)那些事
原文作者:小陳婆婆
本文介紹了電子封裝中焊接材料的焊錫種類(lèi)、錫膏和助焊劑。
焊接材料作為芯片封裝中的核心連接媒介,其性能與工藝適配性直接影響電路的可靠性及使用壽命。
焊錫的種類(lèi)
焊錫的歷史可追溯至羅馬帝國(guó)時(shí)期,鉛-錫合金因其低熔點(diǎn)(共晶點(diǎn)約183℃)與優(yōu)異的潤(rùn)濕性,長(zhǎng)期占據(jù)電子封裝主導(dǎo)地位,尤其在表面貼裝技術(shù)(SMT)興起后,共晶鉛-錫合金(如63Sn-37Pb)成為引腳插入式元件焊接的標(biāo)準(zhǔn)材料。然而,鉛的毒性及環(huán)保法規(guī)推動(dòng)下,無(wú)鉛焊料如Sn-Ag-Cu(SAC)合金逐步替代傳統(tǒng)鉛-錫體系,其中SAC305(96.5Sn-3.0Ag-0.5Cu)因優(yōu)異的機(jī)械強(qiáng)度、抗疲勞性及與基板的熱膨脹系數(shù)匹配性,成為綠色封裝的主流選擇,其熔點(diǎn)約217-220℃,需通過(guò)添加微量元素如Ni、Co、Mn等進(jìn)一步優(yōu)化潤(rùn)濕性及抑制金屬間化合物生長(zhǎng)。
鉛-錫合金體系中,高鉛含量焊錫(如90Pb-10Sn)因高溫穩(wěn)定性適用于分段式焊接,而高錫焊錫(如96.5Sn-3.5Ag)則憑借高強(qiáng)度用于特殊接點(diǎn)需求。

銀、銻、銦等元素的添加可提升焊錫機(jī)械強(qiáng)度與潤(rùn)濕性,但過(guò)量會(huì)導(dǎo)致金屬間化合物(如Ag?Sn、SbSn)生成,引發(fā)脆性風(fēng)險(xiǎn)。雜質(zhì)元素如鋁、鉍、鎘、銅、金、鐵、鎳、磷、鋅等需嚴(yán)格控制含量,以避免浮渣、粒狀焊點(diǎn)或腐蝕問(wèn)題,例如銅在波焊中易熔入錫槽形成金屬間化合物,需限制其含量于0.3%以下。
錫膏
錫膏作為電子封裝中的關(guān)鍵焊接材料,其發(fā)展歷程與工藝革新緊密關(guān)聯(lián)。早期錫膏由鉛粉、氧化鋅及礦油脂蠟混合而成,主要用于傳統(tǒng)焊接場(chǎng)景;隨著電子工業(yè)對(duì)精密工藝的需求提升,錫膏逐步演變?yōu)橛?~15種復(fù)雜成分構(gòu)成的復(fù)合體系,鉛錫比例靈活調(diào)整以適應(yīng)不同應(yīng)用場(chǎng)景。

現(xiàn)代錫膏的核心在于金屬粉粒的制備——通過(guò)氣相微粒化或旋轉(zhuǎn)散布技術(shù)將焊錫合金熔體轉(zhuǎn)化為直徑5~150μm的均勻粉粒,經(jīng)振動(dòng)或氣流篩選確保粒徑分布符合標(biāo)準(zhǔn),粉粒表面需光滑無(wú)氧化,否則氧化現(xiàn)象將導(dǎo)致焊接點(diǎn)品質(zhì)下降。印刷工藝方面,網(wǎng)印與蓋印(Stencil Printing)是主流技術(shù),網(wǎng)目與粉粒直徑比值需大于2以保障均勻性,鏤板間隙與粉粒直徑比值則需超過(guò)42,而蓋印因無(wú)網(wǎng)線(xiàn)阻礙,可實(shí)現(xiàn)更一致的印刷效果,尤其適用于高精度要求場(chǎng)景。
當(dāng)前,錫膏技術(shù)正朝著綠色化與高性能化方向發(fā)展:無(wú)鉛錫膏如Sn-Ag-Cu(SAC)合金因符合RoHS法規(guī),在消費(fèi)電子、汽車(chē)電子中廣泛應(yīng)用,其通過(guò)添加微量元素如Ni、Co優(yōu)化潤(rùn)濕性與抗疲勞性;環(huán)保型助焊劑如水溶性、無(wú)鹵素配方逐步替代傳統(tǒng)松香基產(chǎn)品,減少環(huán)境污染;數(shù)字化印刷技術(shù)如噴墨打印與錫膏結(jié)合,實(shí)現(xiàn)亞微米級(jí)精度控制,提升焊接可靠性;納米級(jí)錫膏通過(guò)減小粉粒尺寸至納米級(jí),增強(qiáng)潤(rùn)濕性與機(jī)械強(qiáng)度,適用于微型傳感器、柔性電子等前沿領(lǐng)域。這些進(jìn)展不僅鞏固了錫膏在傳統(tǒng)封裝中的地位,更推動(dòng)了其在5G通信、新能源汽車(chē)及生物芯片等新興領(lǐng)域的創(chuàng)新應(yīng)用。
焊劑
助焊劑作為焊接工藝中的關(guān)鍵輔助材料,其核心功能在于清潔金屬表面氧化層、降低熔融焊料表面張力以提升潤(rùn)濕性,同時(shí)協(xié)調(diào)腐蝕性、發(fā)泡性、揮發(fā)性與粘貼性以適配不同焊接場(chǎng)景。其成分體系由活化劑、載劑、溶劑及功能添加物構(gòu)成:活化劑依據(jù)活性等級(jí)分為高、中、低三類(lèi),高活性如鹽酸、溴酸、胺氫鹵化物適用于氣密性封裝,中低活性如羧酸、脂肪酸則多用于對(duì)腐蝕敏感的軍用或通信電子;載劑涵蓋天然松脂、合成樹(shù)脂及水溶性有機(jī)體系,其中天然松脂載劑因低腐蝕性常用于無(wú)需清潔工藝,而水溶性載劑如乙二醇、聚乙二醇混合物可通過(guò)水洗快速去除殘留,減少環(huán)境污染;溶劑則需匹配涂布工藝,如乙醇、松油烴用于發(fā)泡式涂布以形成均勻薄層,高沸點(diǎn)溶劑則適用于固體助焊劑以避免焊錫濺射。
涂布工藝方面,發(fā)泡式通過(guò)壓縮空氣形成泡沫涂層,尤其適用于電鍍導(dǎo)孔的精細(xì)涂布;波式與噴灑式則分別適配大規(guī)模波峰焊與高精度噴墨打印場(chǎng)景,其中噴灑式通過(guò)噴嘴精準(zhǔn)控制涂布量,減少助焊劑浪費(fèi)。選擇助焊劑時(shí)需綜合考量產(chǎn)品功能、焊接工藝設(shè)計(jì)、清潔步驟及環(huán)保法規(guī)——例如軍用電子嚴(yán)格限制高活性助焊劑以避免長(zhǎng)期腐蝕風(fēng)險(xiǎn),通信電子傾向低腐蝕性配方以保障信號(hào)穩(wěn)定性,而無(wú)鉛、無(wú)鹵素助焊劑則響應(yīng)RoHS等環(huán)保要求,減少鉛、鹵素對(duì)環(huán)境與健康的危害。
-
焊接
+關(guān)注
關(guān)注
38文章
3575瀏覽量
63368 -
芯片封裝
+關(guān)注
關(guān)注
13文章
619瀏覽量
32359
原文標(biāo)題:電子封裝——焊接材料
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
影響焊錫質(zhì)量的因素
關(guān)于“無(wú)鉛焊接”選擇材料及方法
轉(zhuǎn): 關(guān)于“無(wú)鉛焊接”選擇材料及方法
PCB板焊錫機(jī)自動(dòng)焊接的方式
線(xiàn)路板焊接的原理和條件
線(xiàn)路板焊接資料
路板焊接基礎(chǔ)知識(shí)
焊錫絲的種類(lèi)與作用
焊錫和錫在應(yīng)用上存在哪些差別
漆包線(xiàn)焊錫選激光,一種高效的焊接方法

激光焊錫技術(shù):為數(shù)碼電子產(chǎn)品微型化和高性能化提供焊接解決方案
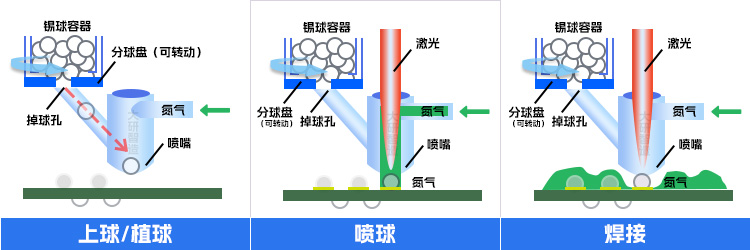
激光焊錫:智能家電制造中的高精度焊接解決方案
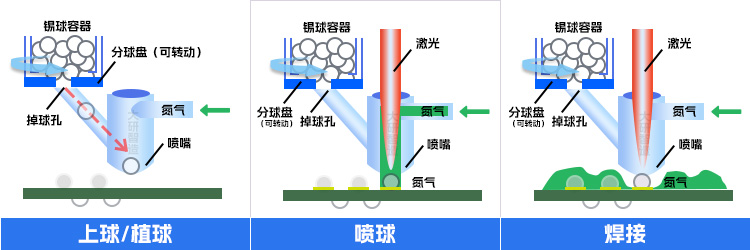
激光焊錫和激光焊接的原理區(qū)別
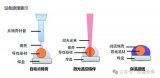



 電子封裝中焊接材料的焊錫種類(lèi)
電子封裝中焊接材料的焊錫種類(lèi)






評(píng)論