突破輕薄設備的性能邊界
解析三星移動SoC先進封裝技術
推出全新封裝架構,提升移動應用處理器的熱管理效率
在當今競爭高度激烈的半導體市場中,移動應用處理器(AP)被要求在愈發受限的裝配空間內持續實現性能提升。隨著智能手機形態不斷向輕薄化演進、高性能計算需求的增長以及端側AI應用的普及,使得更高的功耗被壓縮在更小的體積之中,進而導致功率密度上升、發熱問題加劇。同時,消費者對更長續航以及更輕薄機身的期待不斷提高。由此,移動AP的開發已不再局限于性能的漸進式提升,而是需通過結構層面的演進,實現對有限內部空間的更高效利用。
在上述背景下,移動AP封裝正逐步突破傳統“芯片保護”的單一角色,演進為一項在系統層面高效散熱與熱管理、并提升空間利用率的關鍵技術。通過封裝架構設計與散熱路徑優化,移動AP封裝在保障性能與可靠性的同時,支持更輕薄的產品設計,并為更大容量電池釋放寶貴空間,其在移動AP中的重要性正持續提升。
當通過提高功耗來換取性能提升時,AP的工作溫度也會隨之上升;而為抑制溫升又必須降低功耗,這將直接限制芯片性能的充分發揮。因此,熱阻管理已成為移動AP設計中確保性能穩定性的關鍵因素。在傳統移動封裝中,業界通常通過采用高導熱材料或增加硅片厚度來改善散熱性能。然而,在整體持續小型化的發展趨勢下,僅依賴材料性能提升或芯片加厚,在從根本上解決散熱問題方面已存在明顯局限。
傳統PoP(PackageonPackage)設計的局限性
對于旗艦級AP與SoC,業界通常采用PoP(Pack-ageonPackage)結構,即將DRAM直接堆疊在AP芯片之上,以提升整體性能。然而,受移動終端對厚度的嚴格限制影響,封裝整體厚度在代際演進中持續減薄。隨著封裝變薄,AP裸片厚度也隨之降低,芯片內部產生的熱量向外傳導的擴散路徑被進一步壓縮,散熱效率受限,導致芯片溫度快速上升并觸及熱限制,從而直接制約持續性能輸出。
在AP工作過程中,封裝內硅片產生的熱量需要被迅速傳導至封裝外部,以降低芯片溫度。熱阻越低,散熱效率越高,越有助于在高負載場景下維持穩定性能。為此,終端廠商通常通過熱擴散片、均熱板等散熱組件,將AP產生的熱量傳導至外部散熱結構。然而,在傳統POP架構中,DRAM封裝位于AP芯片上方,阻斷了AP與散熱組件之間的直接傳熱路徑。這一結構特性降低了整體傳熱效率,成為在封裝層級與系統層級上制約性能進一步提升的根本性限制因素。
三星HPB封裝技術:滿足移動AP對持續性能提升的關鍵需求
三星通過在AP芯片上方引l入熱傳導塊(HeatPath BlocK,HPB),顯著提升了熱管理能力。該結構實現了HPB在扇出型晶圓級封裝(FoWLP)中的行業首次應用,有效降低了封裝內部熱阻,使移動AP即使在高負載工況下也能保持穩定性能。
在此基礎上,三星開發出一種全新的封裝類型,用以更高效地將AP裸片產生的熱量傳導至手機整機的散熱組件。與傳統PoP結構中DRAM封裝位于AP上方、阻礙散熱不同,該新結構對DRAM位置進行了重新布局,使其不再覆蓋主要發熱區域;同時,將具備高效導熱能力的HPB直接布置在熱源上方,從而構建更直接、更高效的散熱路徑。
HPB的核心優勢
三星在開發HPB時確立了一個明確目標:高效導出AP裸片產生的熱量,確保性能長期穩定釋放。為在引入HPB的同時保持封裝結構的可靠性,三星同步采用了全新的導熱界面材料(Thermal Interface Material,TIM),該材料兼具高導熱性能與優異的界面粘結可靠性,從而在提升散熱效率的同時,確保封裝整體的結構穩定性與可靠性。
在傳統POP結構中,位于下層的AP裸片若要將熱量向上導出,必須經過中間的DRAM封裝。其傳熱路徑依次穿過DRAM封裝底部的焊球、基板、DRAM裸片以及環氧模封材料(EMC")。在這一過程中,具有相對較高導熱性能的焊球僅分布在有限區域,而基板中的介電層2)、用于芯片貼裝的DAF3以及EMC均屬于低導熱材料,導致熱量在DRAM封裝內部的傳導效率先天受限,從而難以高效傳遞至均熱板等移動終端散熱組件。
相比之下,應用于Exynos2600的HPB采用金屬材料制造(銅,導熱系數約400W/m·K),其導熱性能較基板、DAF或EMC等聚合物材料高出約500-1.000倍。借此,AP裸片產生的熱量可被迅速導出封裝之外,有效抑制熱源處的溫升,為實現穩定、可持續的性能輸出提供了有利條件。
從挑戰到突破:塑造三星移動封裝未來的研發之路
在新封裝的開發過程中,設計團隊針對AP裸片向HPB方向的熱傳導路徑進行了優化,相較于傳統PoP結構顯著提升了散熱效率。具體做法包括將DRAM封裝面積縮減至約一半,并對整體封裝高度與AP封裝厚度進行協同優化。這些結構調整旨在增強熱傳導路徑,同時盡量避免整體封裝尺寸增加。
由于DRAM的非對稱布局,AP-DRAM接口也進行了重新設計,并對芯片及封裝整體架構進行了改造,以兼顧性能與可靠性。此外,HPB結構的降溫效果在開發階段已通過多視角模擬進行預驗證,并結合材料、工藝和產品各階段的根因分析與選代優化,實現了目標性能的穩定達成。這一過程依托相關部門的緊密協作,形成了高效的跨職能開發體系。
隨著移動處理器在嚴格厚度約束下對性能的持續提升需求,封裝層級的熱阻設計將成為保障AP持續性能的關鍵因素。基于HPB的封裝架構展示了通過優化熱傳導路徑的結構性改進,如何有效突破傳統封裝的限制。
通過HPB的研發,三星電子積累了寶貴的技術經驗、驗證方法論及強有力的跨部門協作框架。基于此,三星將在未來移動平臺上持續推進AP封裝技術,實現性能、熱穩定性與空間效率的協同提升。
1)環氧模封材料(EMC):用于半導體封裝中封裝芯片的模塑材料。
2)介電層(DielectricLayer):封裝基板中用于電路互連之間的絕緣層。
3)芯片貼裝膜(DAF,DieAttachFilm):用于將硅片粘接到基板上的薄膜型粘合劑。
-
移動SoC
+關注
關注
0文章
5瀏覽量
7901 -
三星
+關注
關注
1文章
1772瀏覽量
34347 -
先進封裝
+關注
關注
2文章
551瀏覽量
1047
原文標題:科技之心|從SoC封裝開始的性能升級
文章出處:【微信號:sdschina_2021,微信公眾號:三星半導體和顯示官方】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
三星發布Exynos 2600,全球首款2nm SoC,NPU性能提升113%

三星貼片電容封裝尺寸對布局密度的影響

三星電子正式發布Galaxy Z TriFold
三星Galaxy Z Fold7搭載高通驍龍8至尊版移動平臺
全能快充移動電源核心:深度解析IP5353高集成SOC
三星貼片電容的疊層陶瓷技術(MLCC)詳解
深度解析:SM5401S/SM5401/SM5402移動電源SOC如何優化效率與安全?
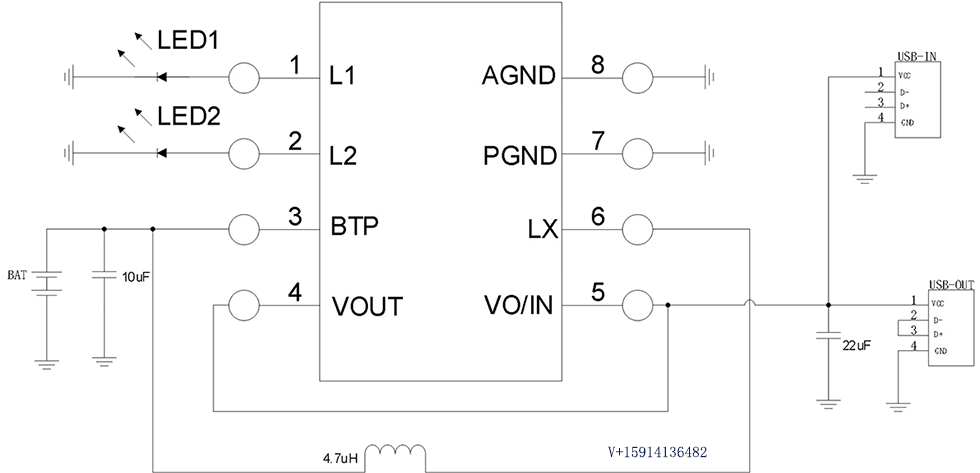
三星MLCC電容的微型化技術,如何推動電子產品輕薄化?

智能駕駛核心器件:三星ADAS SoC高性能MLCC解決方案

回收三星S21指紋排線 適用于三星系列指紋模組
詳細解讀三星的先進封裝技術
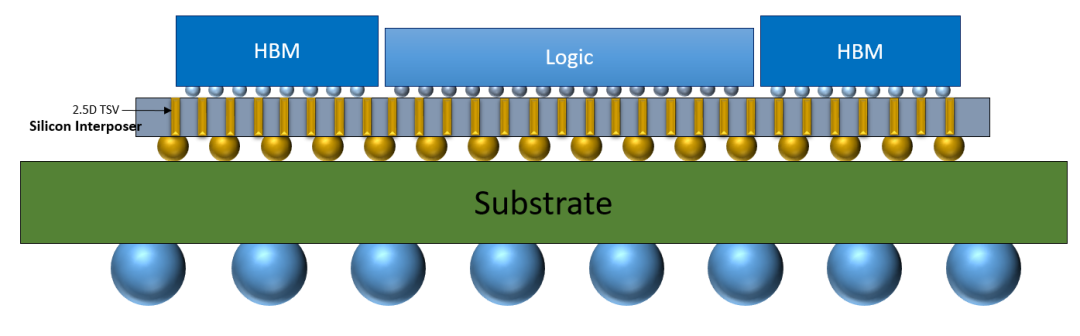
三星在4nm邏輯芯片上實現40%以上的測試良率
深度解析:如何選擇靠譜的三星車規電容代理商?

三星貼片電容批次號查看指南




 深度解析三星移動SoC先進封裝技術
深度解析三星移動SoC先進封裝技術




評論