1 、引言
芯片晶片作為半導(dǎo)體器件的核心基材,其表面粗糙度直接影響光刻、蝕刻、薄膜沉積等后續(xù)工藝的穩(wěn)定性與器件最終性能。尤其是在先進(jìn)制程中,低于0.3 nm的超光滑表面要求成為關(guān)鍵技術(shù)瓶頸——表面微小凸起或凹陷會導(dǎo)致光刻膠涂覆不均、薄膜附著力下降,進(jìn)而引發(fā)器件漏電、良率降低等問題。傳統(tǒng)表面粗糙度測量方法受限于分辨率或測量模式,難以實現(xiàn)低于0.3 nm精度的非接觸全域檢測。3D白光干涉儀憑借亞納米級垂直分辨率、非接觸測量特性及全域三維形貌表征能力,成為芯片晶片超低表面粗糙度測量的核心技術(shù)手段。本文重點探討3D白光干涉儀在芯片晶片低于0.3 nm表面粗糙度測量中的應(yīng)用。
2 、3D白光干涉儀測量原理
3D白光干涉儀以寬光譜白光為光源,經(jīng)分束器分為參考光與物光兩路。參考光射向高精度固定參考鏡反射,物光照射至待測芯片晶片表面后反射,兩束反射光匯交產(chǎn)生干涉條紋。由于白光相干長度極短(僅數(shù)微米),僅在光程差接近零時形成清晰干涉條紋。通過壓電陶瓷驅(qū)動裝置帶動參考鏡進(jìn)行納米級精密掃描,高靈敏度探測器同步采集干涉條紋強度變化,形成干涉信號包絡(luò)曲線,曲線峰值位置精準(zhǔn)對應(yīng)晶片表面高度坐標(biāo)。結(jié)合像素級高度計算與全域二維拼接技術(shù),可快速重建晶片表面三維輪廓,通過專業(yè)粗糙度分析算法精準(zhǔn)計算Ra(算術(shù)平均偏差)等核心參數(shù),其垂直分辨率可達(dá)0.01 nm,完全適配芯片晶片低于0.3 nm的超光滑表面檢測需求。
3 、3D白光干涉儀在芯片晶片超低粗糙度測量中的應(yīng)用
3.1 低于0.3nm粗糙度精準(zhǔn)量化
針對芯片晶片低于0.3 nm的粗糙度檢測要求,3D白光干涉儀可通過優(yōu)化測量參數(shù)實現(xiàn)精準(zhǔn)量化。測量時,選取低噪聲測量模式,搭配高數(shù)值孔徑物鏡,對晶片光學(xué)功能區(qū)進(jìn)行全域掃描,通過三維輪廓重建獲取全表面高度數(shù)據(jù)。系統(tǒng)內(nèi)置的粗糙度分析模塊可自動剔除測量噪聲,精準(zhǔn)計算Ra值,且支持不同區(qū)域的參數(shù)對比分析。實驗數(shù)據(jù)表明,其測量結(jié)果與原子力顯微鏡(AFM)比對誤差≤0.02 nm,可有效捕捉拋光工藝中磨料粒徑、拋光壓力變化導(dǎo)致的0.05 nm級粗糙度波動,為先進(jìn)制程晶片拋光工藝參數(shù)優(yōu)化提供精準(zhǔn)量化依據(jù)。同時,采用二維拼接技術(shù)可實現(xiàn)8英寸、12英寸大尺寸晶片的全表面覆蓋測量,避免局部測量的片面性。
3.2 表面微缺陷同步識別
芯片晶片表面的納米級微劃痕、殘留顆粒、微小凹陷等缺陷,即使尺寸僅數(shù)十納米,也會嚴(yán)重影響后續(xù)工藝及器件性能,且與表面粗糙度密切相關(guān)。3D白光干涉儀在實現(xiàn)低于0.3 nm粗糙度測量的同時,可通過三維輪廓重建同步識別此類微缺陷。當(dāng)檢測到深度超過0.5 nm、長度超過200 nm的微劃痕,或直徑超過50 nm的殘留顆粒/凹陷時,可判定為不合格產(chǎn)品。通過缺陷的尺寸、位置量化分析,可追溯拋光、清洗等制備環(huán)節(jié)的問題。例如,當(dāng)表面出現(xiàn)密集微小殘留顆粒時,可反饋調(diào)整清洗工藝的超聲功率、清洗劑配比等參數(shù),提升晶片表面潔凈度與光滑度。
4 、測量優(yōu)勢與應(yīng)用價值
相較于傳統(tǒng)觸針式粗糙度儀,3D白光干涉儀的非接觸測量模式可避免劃傷芯片晶片的超光滑表面,保障樣品完整性;相較于原子力顯微鏡(AFM)的點掃描局限,其具備更快的全域掃描速度(12英寸晶片全表面測量時間≤15 s),可滿足半導(dǎo)體產(chǎn)業(yè)批量生產(chǎn)檢測需求。通過為芯片晶片低于0.3 nm表面粗糙度測量提供精準(zhǔn)、全面的量化數(shù)據(jù)及微缺陷檢測結(jié)果,3D白光干涉儀可助力構(gòu)建先進(jìn)制程晶片的嚴(yán)格質(zhì)量管控體系,提升芯片制備良率,為半導(dǎo)體產(chǎn)業(yè)向更高精度制程發(fā)展提供關(guān)鍵技術(shù)支撐。
大視野 3D 白光干涉儀:納米級測量全域解決方案?
突破傳統(tǒng)局限,定義測量新范式!大視野 3D 白光干涉儀憑借創(chuàng)新技術(shù),一機解鎖納米級全場景測量,重新詮釋精密測量的高效精密。

三大核心技術(shù)革新?
1)智能操作革命:告別傳統(tǒng)白光干涉儀復(fù)雜操作流程,一鍵智能聚焦掃描功能,輕松實現(xiàn)亞納米精度測量,且重復(fù)性表現(xiàn)卓越,讓精密測量觸手可及。?
2)超大視野 + 超高精度:搭載 0.6 倍鏡頭,擁有 15mm 單幅超大視野,結(jié)合 0.1nm 級測量精度,既能滿足納米級微觀結(jié)構(gòu)的精細(xì)檢測,又能無縫完成 8 寸晶圓 FULL MAPPING 掃描,實現(xiàn)大視野與高精度的完美融合。?
3)動態(tài)測量新維度:可集成多普勒激光測振系統(tǒng),打破靜態(tài)測量邊界,實現(xiàn) “動態(tài)” 3D 輪廓測量,為復(fù)雜工況下的測量需求提供全新解決方案。?
實測驗證硬核實力?
1)硅片表面粗糙度檢測:憑借優(yōu)于 1nm 的超高分辨率,精準(zhǔn)捕捉硅片表面微觀起伏,實測粗糙度 Ra 值低至 0.7nm,為半導(dǎo)體制造品質(zhì)把控提供可靠數(shù)據(jù)支撐。?

(以上數(shù)據(jù)為新啟航實測結(jié)果)
有機油膜厚度掃描:毫米級超大視野,輕松覆蓋 5nm 級有機油膜,實現(xiàn)全區(qū)域高精度厚度檢測,助力潤滑材料研發(fā)與質(zhì)量檢測。?

高深寬比結(jié)構(gòu)測量:面對深蝕刻工藝形成的深槽結(jié)構(gòu),展現(xiàn)強大測量能力,精準(zhǔn)獲取槽深、槽寬數(shù)據(jù),解決行業(yè)測量難題。?
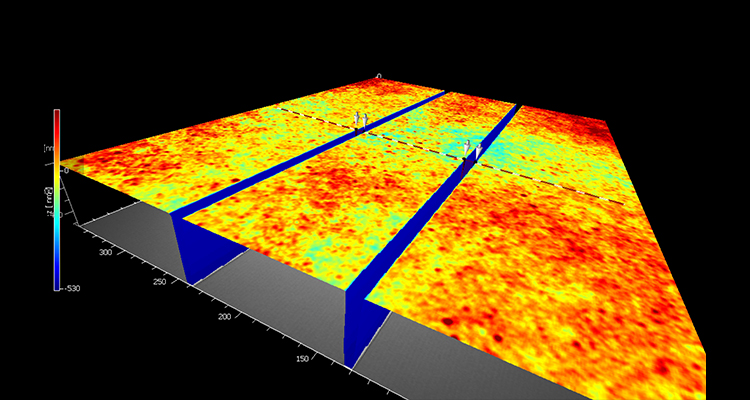
分層膜厚無損檢測:采用非接觸、非破壞測量方式,對多層薄膜進(jìn)行 3D 形貌重構(gòu),精準(zhǔn)分析各層膜厚分布,為薄膜材料研究提供無損檢測新方案。?
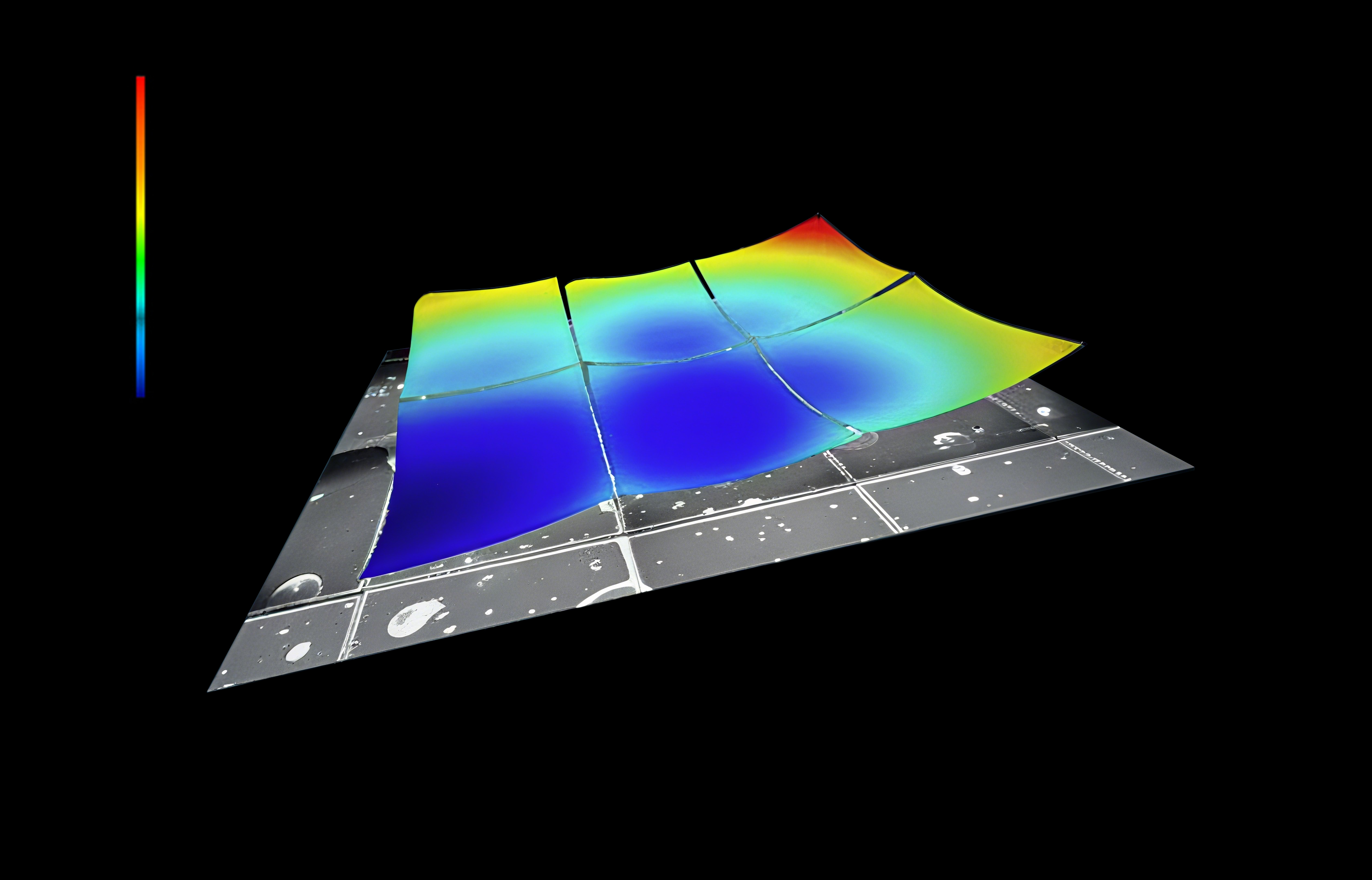
新啟航半導(dǎo)體,專業(yè)提供綜合光學(xué)3D測量解決方案!
審核編輯 黃宇
-
芯片
+關(guān)注
關(guān)注
463文章
53949瀏覽量
465200 -
晶片
+關(guān)注
關(guān)注
1文章
413瀏覽量
32873
發(fā)布評論請先 登錄
PLC平面光波導(dǎo)的圖形凹槽深度測量-3D白光干涉儀應(yīng)用

脈沖激光加工后,表面形貌與粗糙度如何測量?

納米壓印的光柵圖形形貌3D測量-3D白光干涉儀應(yīng)用

白光干涉儀在晶圓深腐蝕溝槽的 3D 輪廓測量

白光干涉儀在肖特基二極管晶圓的深溝槽 3D 輪廓測量

白光干涉儀與激光干涉儀的區(qū)別及應(yīng)用解析
白光干涉儀與原子力顯微鏡測試粗糙度的區(qū)別解析

白光干涉儀可以測量什么?精準(zhǔn)測量粗糙度、臺階高度、形貌、平面度、膜厚、PV、曲率#優(yōu)可測 #優(yōu)可測白光干涉儀
增材制造工藝參數(shù)對表面粗糙度的影響及3D顯微鏡測量技術(shù)研究

臺階儀在3D打印中的應(yīng)用:精確測量物體表面粗糙度

優(yōu)可測白光干涉儀AM系列:量化管控納米級粗糙度,位移傳感器關(guān)鍵零件壽命提升50%

FRED應(yīng)用:天文光干涉儀
白光干涉儀:表面形貌分析,如何區(qū)分波紋度與粗糙度?




 芯片晶片低于0.3nm的表面粗糙度測量-3D白光干涉儀應(yīng)用
芯片晶片低于0.3nm的表面粗糙度測量-3D白光干涉儀應(yīng)用






評論