在導電金屬材料體系中,銅(Cu)以卓越導電性及遠低于金、銀的成本優勢,成為電子漿料、催化等領域貴金屬替代潛力材料。但納米銅表面活性高,易氧化形成絕緣層,嚴重限制實際應用。因此,行業多通過合金化改性銅材料,利用組分協同效應賦予其優于單一金屬的獨特性能。本研究聚焦CuC合金,采用碳熱還原法合成,借助Xfilm埃利的四探針技術系統測試導電性能,為開發高性能低成本銅基導電材料提供數據支撐。
本研究采用碳熱還原法制備CuC合金。在惰性氣氛保護下,將特定的銅源與碳源前驅體進行高溫燒結還原,成功合成出目標材料。為準確評估其導電性能,并對比其與商用銅粉的差異,選用四探針電阻率測試法作為核心表征手段。
四探針電阻測試原理

Xfilm埃利四探針方阻儀
導電性能是評估導電漿料及薄膜的關鍵指標,本研究采用四探針電阻測試儀對燒結后的導電薄膜進行電阻率表征。該測試系統主要由計算機、測試臺與四探針探頭構成,具有測量速度快、范圍廣、精度高等優點。其基本原理是:將兩個電流探針接觸樣品并輸入恒定電流,同時在另外兩個電壓探針間檢測產生的電壓降,最終根據歐姆定律計算得到材料的電阻或電導率。
碳含量與材料結構對導電性的影響
/Xfilm
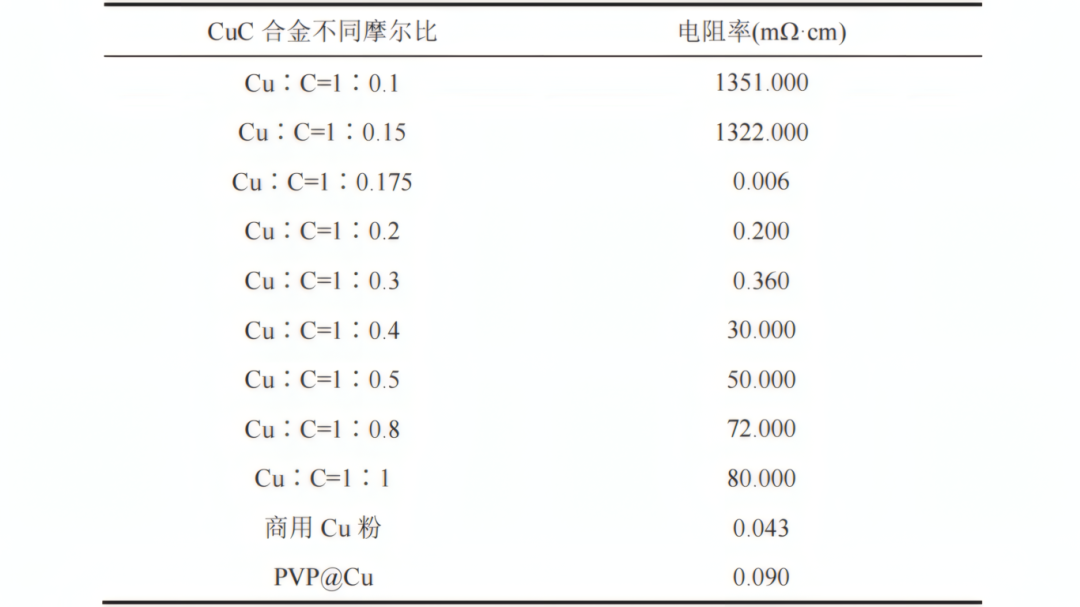
不同碳含量的CuC 合金與銅基材料的導電性
為探究碳含量及材料結構對導電性的影響,將不同配比合成的CuC合金粉體及對比樣品通過壓片法制成薄片,并使用四探針測試儀系統測量了其薄層電阻率。
1. 碳含量對CuC合金導電性能的影響
測試數據清晰表明,碳含量對CuC合金的導電性有決定性影響。隨著碳源比例增加,薄層電阻呈現上升趨勢。當碳源摩爾比超過0.3時,電阻急劇增大。這是因為過量的碳會沉積在銅顆粒表面,形成核殼結構,表面的碳層阻礙了電子傳輸,導致電阻升高。反之,當碳源摩爾比低于或等于0.15時,電阻也出現異常升高。這是由于還原劑不足,未能將銅前驅體完全還原,樣品中殘留了大量導電性差的氧化銅。因此,實驗發現,當銅源與碳源的摩爾比控制在10.3之間時,CuC合金能獲得最優異的導電性能。
2.材料結構對導電性能的影響
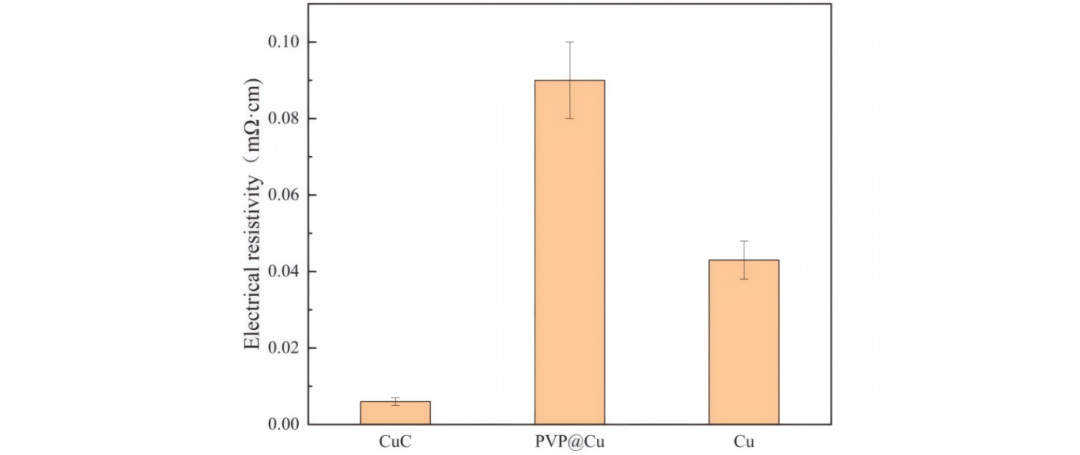 不同結構的銅粒子的導電性能,CuC 為合金結構,PVP@Cu 為核殼結構
不同結構的銅粒子的導電性能,CuC 為合金結構,PVP@Cu 為核殼結構
研究進一步對比不同結構材料的導電性,結果顯示,具有合金結構的CuC薄片電阻率僅為商用銅粉薄片的約1/7,展現出顯著的導電優勢。而另一種核殼結構的PVP@Cu材料,其電阻率(0.09 mΩ·cm)則高于商用銅。
這種性能差異主要源于微觀形貌:本研究合成的合金結構樣品呈塊狀,顆粒間接觸面積大,電子更易傳輸;而核殼結構多為球形,顆粒間為點接觸,導電通道受限,導致電阻增高。這證明,通過合金化構建合適的微觀結構,是大幅提升銅基材料導電性的有效途徑。
本研究通過碳熱還原法成功制備CuC合金,并利用四探針測試揭示了碳含量與材料結構對導電性的影響規律。實驗表明,在銅碳摩爾比為1:0.175~0.3時,材料導電性最優;塊狀合金結構的CuC導電性能顯著優于商用銅粉與核殼結構樣品,得益于優化的成分有效抑制氧化,且塊狀形貌可構建更佳的導電通路。
Xfilm埃利四探針方阻儀
/Xfilm

Xfilm埃利四探針方阻儀用于測量薄層電阻(方阻)或電阻率,可以對最大230mm 樣品進行快速、自動的掃描, 獲得樣品不同位置的方阻/電阻率分布信息。
- 超高測量范圍,測量1mΩ~100MΩ
- 高精密測量,動態重復性可達0.2%
- 全自動多點掃描,多種預設方案亦可自定義調節
- 快速材料表征,可自動執行校正因子計算
基于四探針法的Xfilm埃利四探針方阻儀,憑借智能化與高精度的電阻測量優勢,可助力評估電阻,推動多領域的材料檢測技術升級。
-
材料
+關注
關注
3文章
1559瀏覽量
28682 -
導電
+關注
關注
0文章
252瀏覽量
22276 -
電阻測試
+關注
關注
1文章
21瀏覽量
7648
發布評論請先 登錄
使用兩探針及四探針方法測得的電阻率差異
電阻率越大導電性能越好還是越差
標準電阻器的導電性能有要求嗎
如何提升漆包線的導電性能
四探針法 | 測量射頻(RF)技術制備的SnO2:F薄膜的表面電阻

基于四探針法的碳膜電阻率檢測




 基于四探針電阻測試的CuC 合金的導電性能研究
基于四探針電阻測試的CuC 合金的導電性能研究










評論