超級AI芯片時代,電子元器件的進化方向
千瓦功耗的AI芯片正將電子元器件推向一場前所未有的技術革命。
隨著單顆AI芯片功耗突破1000瓦大關,電子元器件行業正經歷從“被動支撐”到“主動賦能”的角色轉變。傳統電子元件已無法滿足超級AI算力對能效、密度與可靠性的嚴苛要求,一場圍繞材料、架構和集成工藝的創新浪潮正在全球展開。
芯片制造商正在通過3D堆疊、CoWoS先進封裝等技術突破單芯片性能極限,而電子元器件則向著小型化、高頻化和高可靠性方向演進。
01 材料革命:第三代半導體與新型元件
AI芯片功耗飆升直接推動電子元器件材料的革新。?第三代半導體材料碳化硅(SiC)和氮化鎵(GaN)憑借其高擊穿電壓、高導熱性和高開關頻率的特性,正在快速取代傳統硅基元件。
Wolfspeed、意法半導體和英飛凌等企業正擴大SiC和GaN元件產能,這些材料能夠將最終產品的排放量降低高達30%?。
在被動元件領域,村田制作所推出的創新“埋容”方案將電容集成到PCB內部,實現了垂直供電和更短的供電距離,降低了封裝內損耗。
面對AI芯片核心電壓已降至1V甚至更低的趨勢,村田開發出厚度僅220微米的超薄電容,在05035尺寸實現22μF大容量,滿足AI加速卡對高容量密度元件的需求。
02 架構革新:從平面到3D集成
為克服摩爾定律物理極限,電子元器件架構正從平面布局向三維堆疊轉變。臺積電的CoWoS封裝技術通過將芯片垂直堆疊在基板上,顯著提升了算力密度,已成為AI服務器芯片的主流封裝方案。
三維集成不僅提高了計算性能,還大幅降低了功耗。
?Chiplet技術將不同工藝、不同功能的芯片模塊化集成,實現了“性能提升+成本降低”的雙重目標。這一技術路徑通過異構集成不同工藝芯片,大幅提高了設計靈活性和良品率。
2025年SEMICON Taiwan展會上,臺積電推出的COUPE硅光平臺集成了先進封裝和硅光技術,預計2026年底問世,將首先應用于數據中心內部的交換機和AI服務器的光學互聯模塊。
03 系統協同:應對AI算力的全鏈條創新
超級AI芯片時代,電子元器件的創新不再是單點突破,而是全鏈條協同創新。從材料到制造再到封裝,各環節必須緊密配合才能滿足AI算力需求。
AI服務器對MLCC的需求量比傳統服務器增長約100%?,AIPC和AI手機分別增長40%-60%和20%,且對功率、頻率、散熱等性能要求更高。
在供電系統方面,AI芯片對電源穩定性的要求極為苛刻,電壓波動容忍度從10%收緊至5%甚至更小。這促使村田等企業開發出小尺寸大容量的陶瓷電容方案和聚合物鋁電容方案,其中MLCC產品最大容量可達330μF。
連接器與傳感器也在同步進化。高速連接器需滿足AI服務器、800G光模塊需求,而MEMS傳感器在壓力、慣性領域市占率大幅提升。這些元件共同保障了AI系統在高速運算下的穩定運行。
未來五年,電子元器件將呈現高端化、智能化、綠色化三大趨勢。國內企業在高性能芯片、高端傳感器等領域逐步縮小與國際先進企業的差距。到2030年,AI領域用MLCC及芯片電感年均增速預計將超過30%?。
電子元器件行業正在從“基礎支撐”轉向“價值核心”,成為全球科技革命的核心引擎。只有那些在材料科學、制造工藝和系統集成上持續創新的企業,才能在超級AI芯片時代保持領先地位。
-
電子元器件
+關注
關注
134文章
3894瀏覽量
113921 -
AI芯片
+關注
關注
17文章
2126瀏覽量
36770
發布評論請先 登錄
電子元器件供應鏈升級!34萬㎡超級平臺全面賦能

老年份的電子元器件是否可買
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+AI芯片的需求和挑戰
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+可期之變:從AI硬件到AI濕件
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+內容總覽
AI優化設計能否革新磁性元器件設計方案?
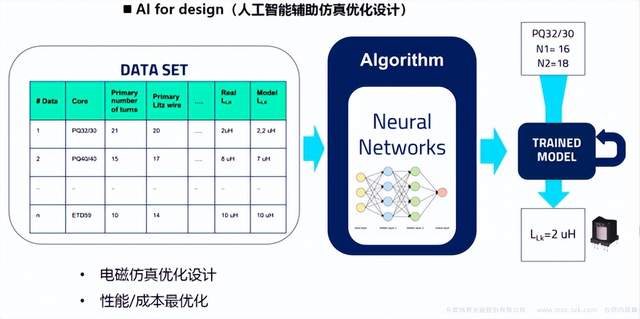
【書籍評測活動NO.64】AI芯片,從過去走向未來:《AI芯片:科技探索與AGI愿景》
AI平臺能否終結磁性元器件“經驗主義”設計




 超級AI芯片時代,電子元器件的進化方向
超級AI芯片時代,電子元器件的進化方向







評論