半導體器件是經過以下步驟制造出來的
一、從ingot(硅錠)到制造出晶圓的過程
二、前道制程:在晶圓上形成半導體芯片的過程:
三,后道制程:將半導體芯片封裝為 IC的過程。
在每一步驟,Nanoscope Systems都可以為三維形貌檢測技術提供快速精確可靠的測試方案。
一、【Si晶圓的制造工程】 :從圓柱形的硅錠切出圓盤狀的晶圓,并將其表面拋光,如同鏡面一樣。
第一步、從硅單結晶晶柱切出品圓狀的品圓(切成薄片:Slicing)
將圓柱狀的 Si單結晶晶柱貼在支撐臺上,再使帶有鉆石粒的內圓周刀刃旋轉,就可切出圓盤狀的晶圓。
第二步、Si晶圓的表面拋光(研磨-精磨:Polishing)
如果想制造缺陷少的器件,需要將 Si晶圓表面用機械或化學方法加以拋光成鏡面,
以去除表面的缺陷層。在此可使用NS3500對 wafer表面上三維均實現高精度(亞納米)粗糙度測量,用于評定拋光效果;同時對整個 wafer的TTV/Bow/Warp,Flatness進行測量


二、【前道制程】:反復進行黃光微影、蝕刻及雜質擴散的工程,以制造半導體芯片。
第一步、氣相成長
在完成鏡面研磨的晶圓表面(單結晶硅基板)形成氣相沉積層。

第二步、選擇性的摻雜擴散
運用類似照相技術的微影方法,可選擇性地擴散摻雜物而在部分區域制造想要地極性與雜質濃度。通過重復這個過程可制造所需求地半導體器件。
第三步、蒸鍍電極金屬
將鋁、銅等蒸鍍在晶圓表面形成電極及配線

NS3500 可以對3D形貌、高度、角度等進行測量。

三、【后道制程】:從晶圓切割芯片,再用導線與引線連接,然后用塑膜樹脂包裝IC芯片,并進行測試以去除不良品
第一步、切片(dicing)
將制造在晶圓上的半導體器件,用鉆石刀將晶圓切割成各個芯片。

第二步、Wire Bonding引線鍵合
用細金屬線,利用熱、壓力使金屬引線與基板焊盤緊密焊合,實現芯片與基板間的電氣互聯和芯片間的信息互通。

第三步、封裝
為了增加機械強度,將芯片上的接點用導線連接刀封裝外殼的引腳上,將芯片封裝起來。

第四步、測試篩檢
最后用測試表測定并判斷其電氣特性,并除去不良品。
專業術語
前道Front End:
后道Back End:
晶圓 Wafer:
晶粒 Die:
晶片、芯片Chip:
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54335瀏覽量
468598
發布評論請先 登錄

【封裝技術】幾種常用硅光芯片光纖耦合方案
芯片制造的步驟
芯片制造過程中的布線技術

芯片引腳成型與整形:電子制造中不可或缺的兩種精密工藝
晶圓和芯片哪個更難制造一些
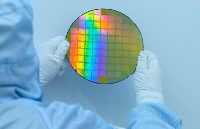

從芯片到主板,科技創新實現高質量發展
硅肖特基二極管芯片 skyworksinc

多晶硅在芯片制造中的作用
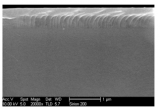



 芯片的制造過程---從硅錠到芯片
芯片的制造過程---從硅錠到芯片




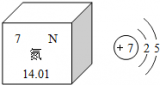




評論