以下文章來源于半導體先進技術與仿真,作者CAE工程師筆記Tony
隨著能源效率成為全球關注的焦點,半導體行業(yè)迎來了技術革新的浪潮。金屬氧化物半導體場效應晶體管(MOSFET)便是這一背景下的產(chǎn)物,其通過電場效應調(diào)控導電通道,顯著降低了驅(qū)動所需的能量。這種設計帶來了快速的開關響應和高效率的能量轉(zhuǎn)換,使MOSFET在中小功率場景中廣泛應用。不過,當面對高壓需求時,MOSFET的性能會受到限制,因為提升耐壓能力往往伴隨著電阻的增加,從而削弱其效率。為了應對高壓高功率場景下的挑戰(zhàn),絕緣姍雙極型晶體管(Insulated Gate Bipolar Transistor,IGBT)應時而生間。這種器件巧妙結(jié)合了電場控制與載流子傳輸?shù)膬?yōu)勢,既能在高電壓下保持較低的能量損耗,又能處理較大的電流負載。憑借這一特性,IGBT迅速成為現(xiàn)代工業(yè)領域不可或缺的支柱,在電機驅(qū)動、可再生能源系統(tǒng)等領域中扮演著關鍵角色。
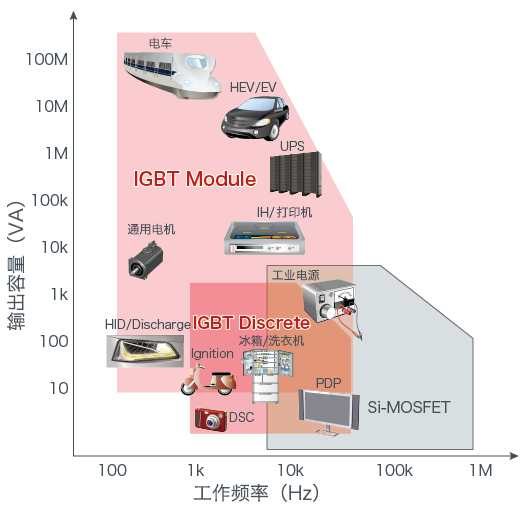
自20世紀80年代IGBT問世以來,其制造工藝經(jīng)歷了多次革新。在IGBT器件的早期設計中,研究人員選用了高摻雜濃度的P型襯底作為基礎,并通過在該襯底上淀積兩次N型外延層,成功構(gòu)建了最初始的穿通型(Punch Through,PT)IGBT結(jié)構(gòu)。為了降低制造成本并提升耐壓性能,研究人推出了采用區(qū)熔單晶片工藝制作的非穿通(NonPunchThrough,NPT)型IGBT結(jié)構(gòu)。在NPTIGBT的發(fā)展初期,由于背面工藝中存在諸多如N-buffer層的制備、退火處理等技術難題,導致器件的耐壓能力受到限制,僅能達到600V至1200V的范圍。通過綜合比較PT-IGBT和NPT-IGBT的優(yōu)缺點,在前人的研究基礎上研究人員進一步優(yōu)化設計,提出了場截止(FieldStop,FS)型IGBT器件結(jié)構(gòu)。
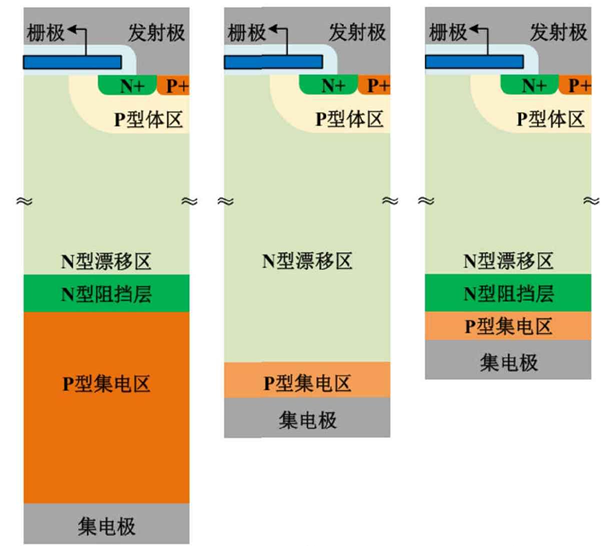
FS-IGBT作為當今主流的IGBT器件結(jié)構(gòu),通過在襯底中引入FS層,當實現(xiàn)了在維持額定電壓不變的前提下對器件性能的顯著優(yōu)化。FS層的應用是IGBT襯底技術發(fā)展的重要里程碑,體現(xiàn)了研究人員在器件設計上的持續(xù)創(chuàng)新與改進。隨著技術的不斷發(fā)展,F(xiàn)S-IGBT產(chǎn)品的耐壓水平也逐漸提高到了6500V。
近年來,出現(xiàn)的輕穿通(Light Punch-Through, LPT)IGBT結(jié)構(gòu),通過減薄器件厚度實現(xiàn)了導通損耗與關斷損耗的優(yōu)化平衡。然而,芯片體積的縮減導致短路耐受能力顯著降低,這種在傳統(tǒng)厚晶圓IGBT中未曾出現(xiàn)的失效模式表現(xiàn)為:短路期間的自發(fā)熱引發(fā)泄漏電流,在短路切斷后持續(xù)放大,最終導致熱失控。
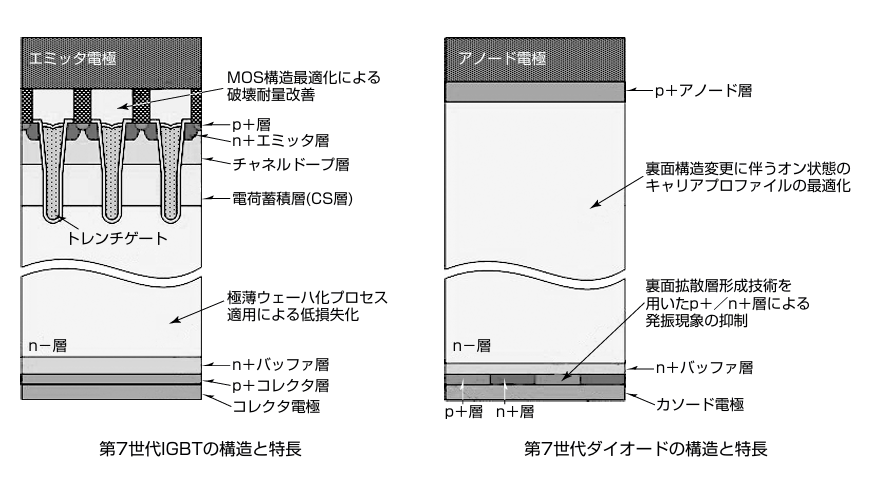
為實現(xiàn)性能提升與短路耐受能力保障的雙重目標,研究表明,通過IGBT表面增加輔助電極提升熱容,或減薄背面焊料層增強散熱,均可改善短路耐受能力。此外,為優(yōu)化IGBT損耗特性,溝槽柵結(jié)構(gòu)與微縮化設計成為主流趨勢,但這也導致單位面積溝道密度增加,進而增大短路電流、降低耐受能力。

為平衡這一矛盾,采用部分虛擬陪柵結(jié)構(gòu)連接發(fā)射極電位的結(jié)構(gòu)方案被證明可同時改善導通特性與短路耐受能力。本CASE重點針對虛擬陪柵結(jié)構(gòu)IGBT,通過實驗與仿真驗證表面發(fā)射極層布局對短路耐受能力的作用機制。
下圖展示了用于短路耐受能力對比的兩種1200V FS-IGBT表面結(jié)構(gòu)。器件采用數(shù)微米厚鋁膜作為表面電極,未設置特殊散熱層。表面結(jié)構(gòu)包含一個主動柵溝槽和兩個連接發(fā)射極的虛擬陪柵,通過沿溝槽縱向交替排列n+發(fā)射極與防閂鎖p+層,實現(xiàn)飽和電流控制與反向偏置安全工作區(qū)保障。
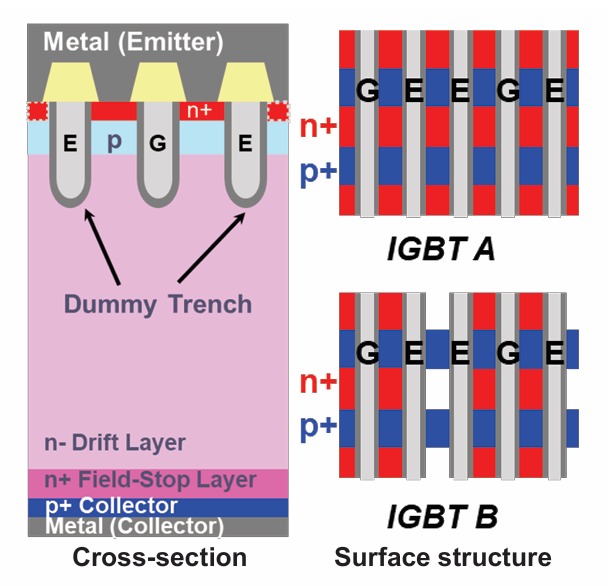
實驗設計中,IGBT A采用全表面條紋狀排列的n+/p+層,而IGBT B則去除虛擬陪柵之間的n+發(fā)射極區(qū)域。兩種結(jié)構(gòu)的有效溝道面積保持一致,因此如下圖所示,IGBT B與IGBT A的I-V特性曲線與開關損耗基本一致。
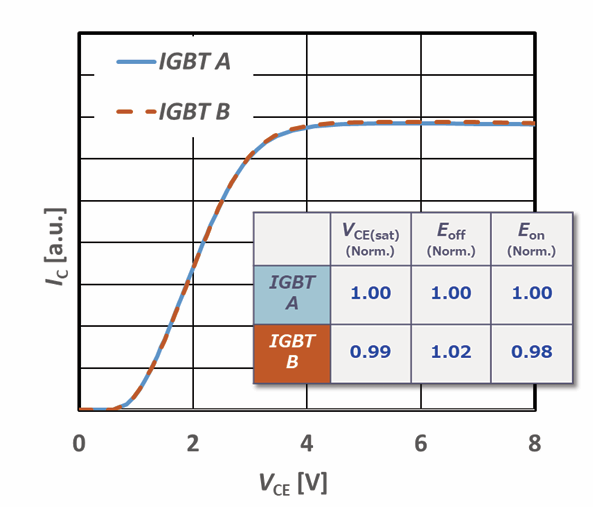
短路測試樣本制備如下圖所示:芯片焊接于數(shù)毫米厚銅基板,銅基板連接集電極電源,表面發(fā)射極與柵極通過鋁線鍵合分別連接至發(fā)射極電源與柵壓源。表面涂覆硅凝膠實現(xiàn)電氣絕緣,其散熱條件可視為近似絕熱狀態(tài),與實際功率模塊工況一致。測試時將銅基板固定于175°C熱臺,施加800V集電極-發(fā)射極電壓后,給柵極施加+15V電壓脈沖以觸發(fā)短路。
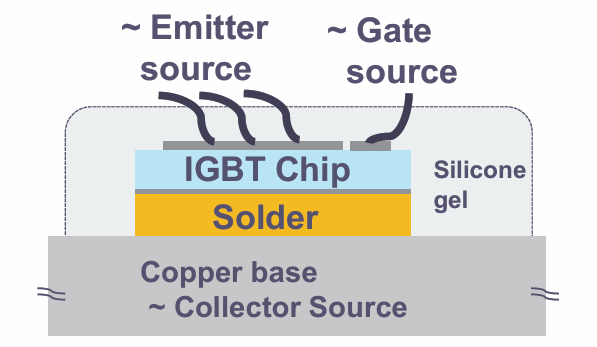
測試采用階梯式延時法:若短路開始至中斷后1毫秒內(nèi)未失效,則逐步延長短路時間重復測試。以短路能量損耗(Esc)作為耐受能力評價指標。下圖展示了典型短路波形,可見相同設置下兩器件波形基本重合,但IGBT A在短路電流關斷270微秒后發(fā)生熱失控失效,而IGBT B未出現(xiàn)該現(xiàn)象。實測數(shù)據(jù)顯示IGBT B的Esc值較IGBT A提升8%。
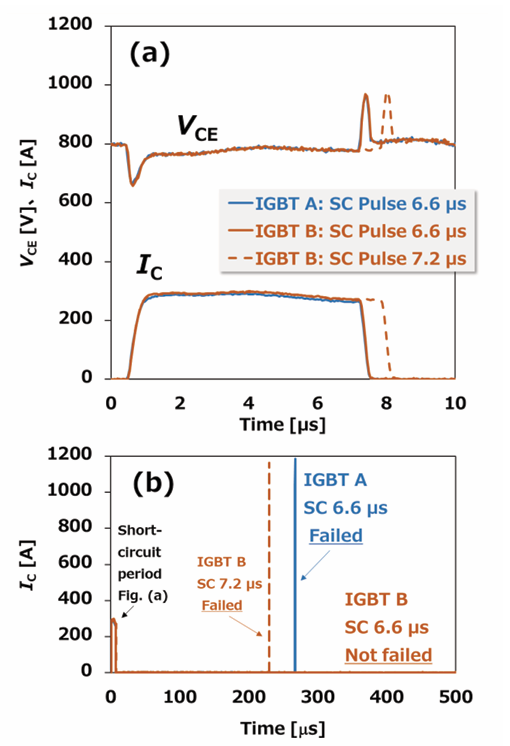
為揭示IGBT B抑制熱失控的物理機制,建立了精確的三維仿真模型。模型復現(xiàn)實際器件的結(jié)構(gòu)參數(shù),包括表面鋁電極、背面焊料層與銅基板。為簡化計算采用單胞模型,銅基板面積與IGBT胞元一致。銅基板背面設定為175°C恒溫并賦予高導熱系數(shù),鋁電極表面按凝膠密封條件設為絕熱邊界。
仿真中模擬實際測試條件:在VCE=800V時施加柵壓脈沖產(chǎn)生短路,重點分析短路關斷后泄漏電流演變規(guī)律。下圖仿真波形顯示(a.顯示短路發(fā)生的時間段,b.顯示完整波形),相同短路時間下僅IGBT A模型出現(xiàn)關斷后電流驟升。其泄漏電流隨時間持續(xù)增長,自發(fā)熱效應導致熱失控,而IGBT B模型在相同時段內(nèi)保持穩(wěn)定,Esc提升約8%,與實驗高度吻合。
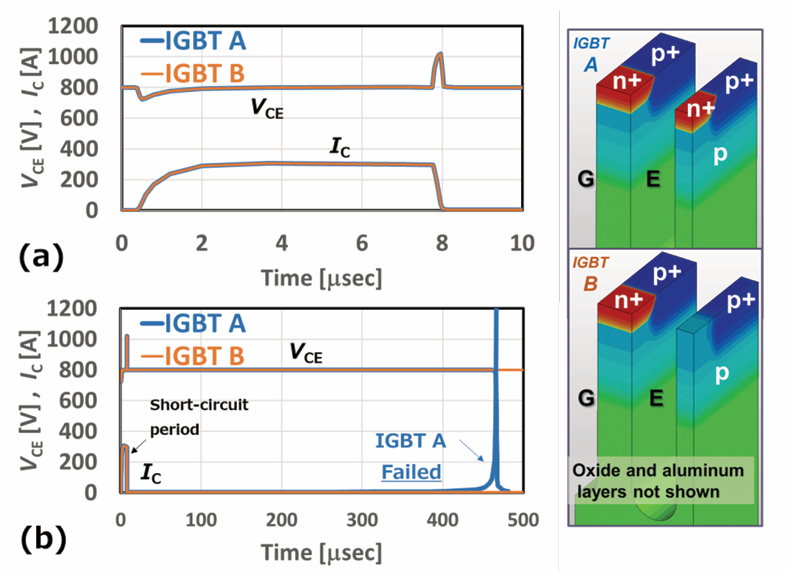
通過下圖的瞬態(tài)過程分析可明確機理差異,短路初始時刻:兩結(jié)構(gòu)溫度分布與電子電流分布一致,發(fā)熱峰值位于柵溝槽下方的漂移層。短路后80微秒:熱量沿厚度方向擴散,表面溫度升高引發(fā)n+發(fā)射極電子泄漏電流增大。關鍵發(fā)現(xiàn)是,IGBT A中所有n+發(fā)射極區(qū)(無論鄰近柵溝槽或虛設溝槽)均產(chǎn)生泄漏電流,而IGBT B因去除虛設溝槽旁n+區(qū),總泄漏電流顯著降低。短路后310微秒:泄漏電子經(jīng)電場加速抵達p+集電極,引發(fā)空穴注入的電流放大效應。IGBT A因初始泄漏電流較大,放大效應更顯著,形成發(fā)熱-電流增長的正反饋循環(huán),最終導致熱失控。
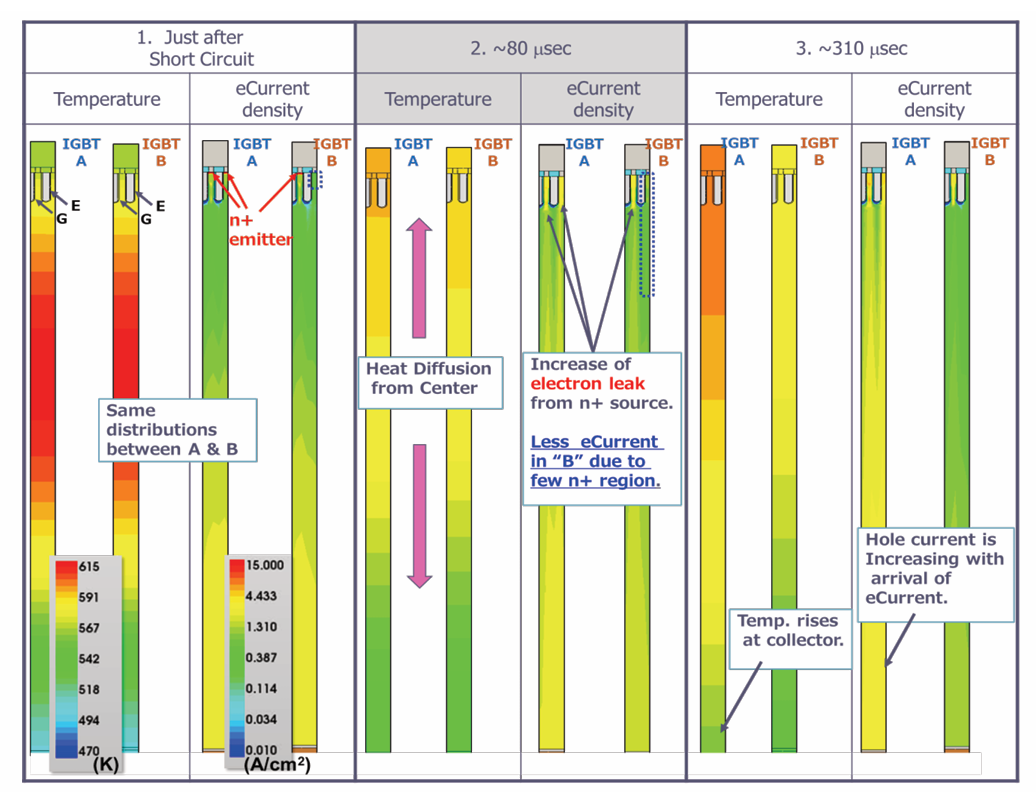
為驗證該機制,下圖進一步展示了n+發(fā)射極面積比與Esc的關聯(lián)性實驗數(shù)據(jù)。隨著n+發(fā)射極比例減小,Esc呈現(xiàn)單調(diào)上升趨勢,有力支持了上述分析結(jié)論。
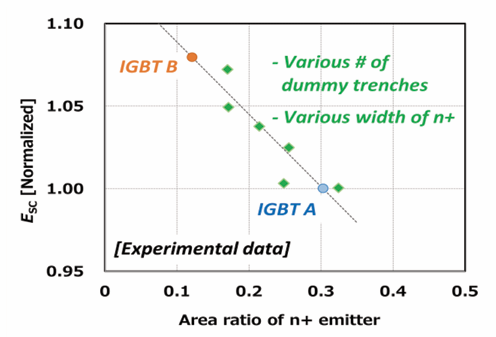
綜上所述,本CASE通過實驗與仿真相結(jié)合的方法,系統(tǒng)揭示了FS-IGBT的短路失效物理機制。研究證實n+發(fā)射極面積比例直接影響短路關斷后的泄漏電流特性,進而決定耐受能力。針對現(xiàn)代虛擬陪柵結(jié)構(gòu)IGBT,通過優(yōu)化n+發(fā)射極布局方案,可在不犧牲電氣性能的前提下顯著提升短路耐受能力,為高性能高可靠性IGBT設計提供重要理論依據(jù)與實踐指導。
-
MOSFET
+關注
關注
150文章
9484瀏覽量
230169 -
IGBT
+關注
關注
1288文章
4275瀏覽量
260855 -
晶體管
+關注
關注
78文章
10303瀏覽量
146648
原文標題:功率半導體(Power Semiconductor)-2 FS-IGBT 短路耐受能力提升
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
工業(yè)電機驅(qū)動中的IGBT過流和短路保護
【案例分享】工業(yè)電機驅(qū)動中的IGBT過流和短路保護
如何設計600V FS結(jié)構(gòu)的IGBT
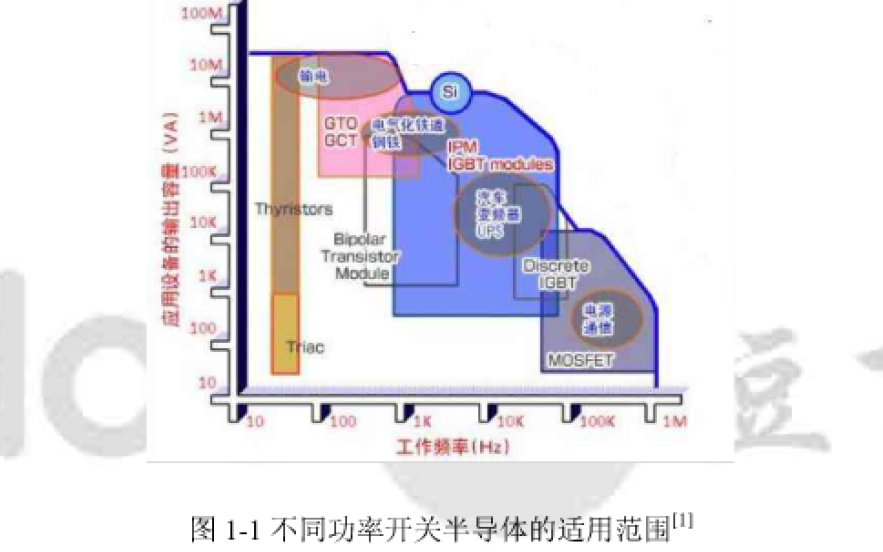
關于英飛凌CoolSiC MOSFET的抗短路能力
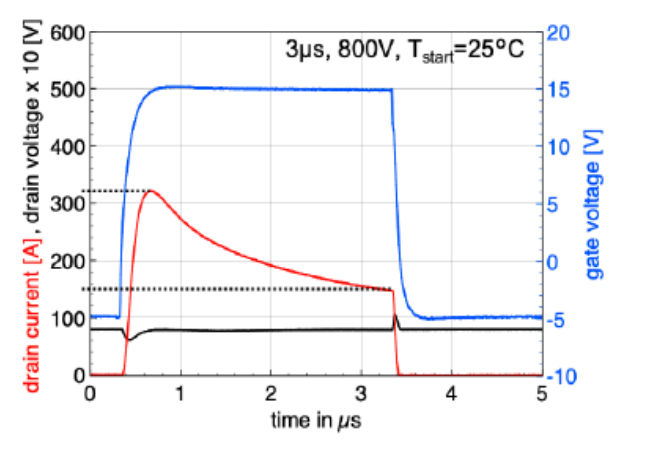
IGBT的短路耐受時間
IGBT短路時的損耗

高壓IGBT短路分析和性能改進
IGBT中的短路耐受時間是什么
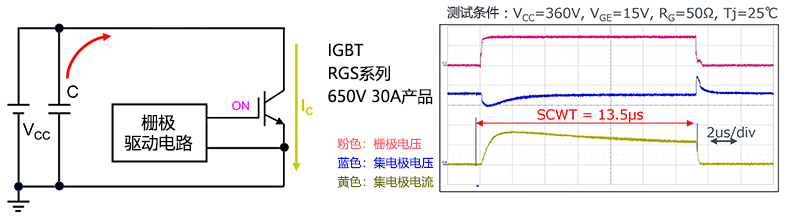
為什么IGBT的短路耐受時間只有10us?10us又是如何得來的?
IGBT短路耐受時間的重要性
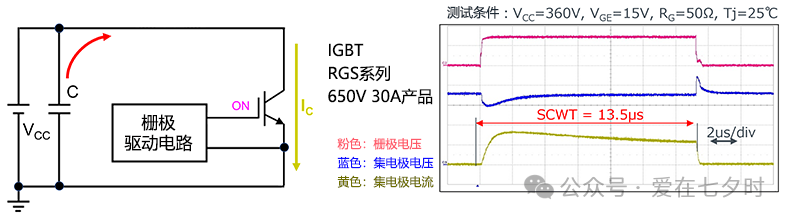
淺談SiC MOSFET器件的短路耐受能力






 FS-IGBT短路耐受能力提升方法
FS-IGBT短路耐受能力提升方法











評論