【博主簡介】本人“愛在七夕時”,系一名半導體行業質量管理從業者,旨在業余時間不定期的分享半導體行業中的:產品質量、失效分析、可靠性分析和產品基礎應用等相關知識。常言:真知不問出處,所分享的內容如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習!
隨著半導體材料技術的突破,對功率器件電壓和頻率提出了更高的要求。更高電壓和更快開關頻率導致器件在工作過程中產生大量的熱量,熱量作為副產物影響了封裝材料的絕緣性能。所以,在電子元器件制造過程中,灌封膠是必不可少的材料之一。而在市面上,最常見的灌封膠就是有機硅灌封膠和環氧灌封膠了。
有機硅凝膠材料因其具有優良的耐溫、防水和電氣絕緣性能等,成為電子器件必不可少的封裝絕緣材料。目前,硅基IGBT模塊灌封常用的有機硅凝膠是一種雙組份加成型室溫或加溫硫化有機硅凝膠。
有機硅具有極強的適應性和耐用性,可承受極端溫度、機械應變和刺激性化學品,提供可靠的粘合、密封和熱穩定性。硅凝膠作為一種特殊的電子灌封材料,除具備有機硅類灌封膠獨特的耐候和耐老化性能、優異的耐高/低溫性能、良好的疏水性和電絕緣性能之外,還具有內應力小、抗沖擊性好、粘附力強的優點,是IGBT模塊灌封的首選材料。
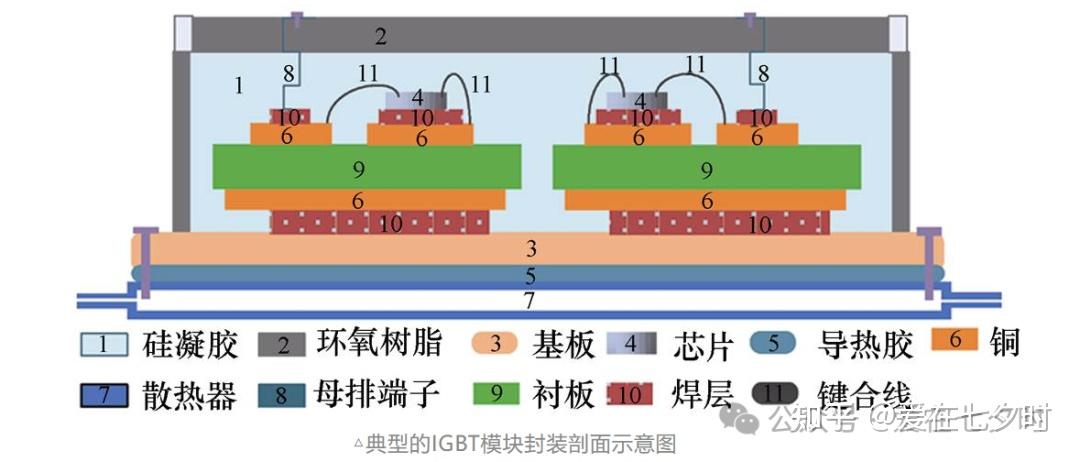
IGBT(Insulated Gate Bipolar Transistor),中文名字叫“絕緣柵雙極型晶體管”。目前主要應用在IGBT模塊灌封的是有環氧膠和有機硅凝膠兩個。主流的大功率模塊都是選用的硅凝膠和環氧膠配合使用,既能給模塊提供很好的電氣絕緣保護(有機硅凝膠),又能給模塊給予很好的機械強度保護(環氧膠)。
一、IGBT模塊灌封膠的介紹
灌封膠是一種特殊的有機高分子復合材料,廣泛應用于電子元器件的制造過程中。常見的灌封膠類型包括環氧樹脂灌封膠、有機硅灌封膠(硅酮灌封膠)、聚氨酯灌封膠以及丙烯酸酯灌封膠等。
環氧灌封膠是由環氧樹脂、固化劑、填充劑等組成。環氧樹脂是環氧灌封膠的主要成分,它的優點是具有優異的物理性能,如高強度、高硬度、高耐熱性等。
環氧灌封膠有以下優異性能:
1、優異的機械保護:環氧灌封膠在固化后形成堅硬的外殼,能夠有效保護內部電子元件不受物理沖擊、振動和壓力的損害。
2、卓越的化學和環境抵抗力:環氧灌封膠具有很強的抗化學腐蝕性,能夠抵抗多種化學物質的侵蝕。同時,它還能防止濕氣、塵埃和其他環境因素對電子組件造成的損害。
3、高度電氣絕緣性:環氧灌封膠具有很好的電絕緣特性,可以有效防止電氣短路和電氣干擾,保證電子設備的安全穩定運行。
4、熱穩定性和熱管理:環氧灌封膠能夠承受較寬的溫度范圍,提供良好的熱穩定性,幫助電子設備在不同的工作環境下維持性能。它還能在一定程度上幫助散熱,防止設備過熱。
5、防止氧化和腐蝕:環氧灌封膠可以封閉電子元件,防止空氣中的氧氣與電路接觸,從而減少氧化和腐蝕的可能性。
6、提高組件的長期穩定性和可靠性:通過封裝,環氧灌封膠能夠延長電子組件的使用壽命,減少維護需求和更換頻率,從而提高整體的經濟效益。
7、多功能和可定制性:環氧灌封膠可根據不同的應用需求調整配方,如改變硬度、粘度、固化時間和顏色等,滿足特定工業應用的需求。
8、強粘接力:環氧灌封膠與多種材料(如金屬、塑料、陶瓷等)都能形成牢固的粘接,確保封裝結構的完整性和耐久性。
二、IGBT模塊對灌封膠的要求
基于目前工藝制備的有機硅凝膠灌封于IGBT模塊中時,當器件內部溫度升高到125℃時,有機硅凝膠內部將產生氣泡,并且隨著溫度升高,硅凝膠內的氣泡呈體積增大,數量增多的趨勢。絕緣材料中的氣泡將嚴重影響材料的絕緣性能。于是高壓大功率IGBT模塊對灌封膠提出的新要求有:
1、灌封膠材料絕緣強度高,足以保障芯片終端鈍化層及器件內部三結合點處等電場集中位置的絕緣;
2、灌封膠材料制備無副產物;
3、灌封膠材料具有一定的耐熱、防水、耐機械性能等。大功率IGBT模塊在運行過程中會產生極高的溫度,雖然底部的氮化鋁底襯起到一定的導熱作用,但模塊內部溫度可能會達到180℃甚至200℃;另外IGBT模塊在使用過程中可能會遭受外界濕熱、外力沖擊、強烈機械振動等不利因素影響,因此要求新一代大功率IGBT模塊封裝材料具有極佳的耐高溫性能,以保證IGBT芯片的運行可靠性;
大功率IGBT用高耐溫環氧灌封膠具有很好的耐化學腐蝕性能和很高的剪切強度,能夠長期暴露在超過200℃高溫環境中,短期甚至能承受高達250℃的高溫。
硅凝膠供應商針對IGBT模塊提出的新要求,紛紛推出了低應力、十分柔軟的IGBT硅凝膠,灌封到IGBT模組上后,硅凝膠的低應力及柔軟性,能夠達到比較理想的抗沖擊、減震效果,同時,凝膠表面的粘性,粘接在IGBT模組上,也能很好的達到防水防潮的保護效果。不僅如此,IGBT硅凝膠優異的電氣絕緣性能,如高介電強度和體積電阻率,也能夠保護IGBT模塊。
三、環氧灌封膠在IGBT模塊封裝中的應用
IGBT模塊按封裝形式的不同可分為壓接式和焊接式。環氧膠灌封主要應用于焊接式,不僅能提高IGBT模塊的絕緣能力,還能提升IGBT模塊的可靠性,延長其使用壽命。環氧樹脂由于具有極好的電氣絕緣性能和操作工藝性,被廣泛應用于電子封裝領域,采用環氧樹脂進行灌封保護的電子元器件具有極好的整體性和尺寸穩定性,能有效延長電子芯片2~3倍的使用壽命。
同時,溫度變化所導致的環氧灌封膠體開裂、與外殼的脫離或應力過大導致外殼開裂等問題會對封裝結果有直接影響,因此環氧灌封膠的溫度性能對其在IGBT模塊中的應用影響較大。
目前主要應用在IGBT模塊灌封的是環氧膠和有機硅凝膠兩個。主流的大功率模塊都是選用的硅凝膠和環氧膠配合使用,既能給模塊提供很好的電氣絕緣保護(有機硅凝膠),又能給模塊給予很好的機械強度保護(環氧膠)。
并且,灌封用環氧膠一般是在完成硅凝膠灌封后再進行灌封,經固化后在硅凝膠上層形成一層密度大質地堅硬的保護層,能夠起保護和強化模塊整體性的作用,對提高模塊的抗機械沖擊性具有一定的實際意義,這種封裝結構方式在軌道交通用IGBT模塊上應用較多。
IGBT模塊灌封用環氧膠主要采用雙組分的形式,是由特種環氧樹脂、無機填料和助劑等制備而成,其固化物具有很高的阻燃性和較低的CTE值,可以有效隔離外部不利環境的影響。
但環氧灌封膠固化收縮率較大,且固化后CTE值相對芯片、襯板、綁定線等差異較大,環氧灌封的IGBT模塊在溫度沖擊實驗后易開裂、脫離和形變,導致封裝失效,因此環氧灌封膠在IGBT模塊封裝中的應用研究需要重點關注。
研究人員分別對 1# 和 2# 環氧灌封膠進行了灌封實驗。下圖為兩種環氧灌封膠灌封前后的IGBT模塊照片。采用 Econo PACK 封裝形式的模塊,灌封尺寸約為110.0 mm×57.5 mm×17.0 mm。

下表 4 為經過高溫存儲、低溫存儲和溫度循環后兩種環氧灌封膠在 IGBT 功率模塊中的應用情況。從下表 4 可以發現,1# 灌封的模塊在高溫存儲、低溫存儲以及溫度循環后并未出現膠開裂,膠體與 IGBT 塑料外殼之間也并未出現由于收縮引起的縫隙和脫離現象,能滿足IGBT模塊的灌封要求;2# 能完全通過高溫存儲測試,但由于 CTE 值偏大,模塊低溫存儲以及溫度循環后膠體與外殼間脫離,封裝失效,在耐溫性能方面還存在缺陷,可能還需在環氧膠樹脂應用、填料種類及含量等方面進行調整和優化。

四、IGBT模塊灌封膠設備
針對IGBT硅凝膠的特點,為實現對IGBT模塊產品無氣泡灌封的自動化作業,最大限度地滿足產品真空灌膠的需求,設備廠商也推出了真空灌膠機,將雙組份膠水按照預先設定好的比例和出膠重量,自動配比后自動混合均勻,在預先實現真空的環境里均勻的灌注到每個產品里面,實現高精度注膠以及快速量產。
五、環氧灌封膠在IGBT功率模塊封裝中應用的實驗
為評估國產環氧灌封膠在絕緣柵雙極晶體管(IGBT)功率模塊封裝中的應用情況,選取了兩種國產環氧灌封膠進行了綜合對比:包括對兩種環氧灌封膠固化前黏度、比重和凝膠時間,固化后力學性能、熱性能、絕緣性能等的橫向對比。分析出兩種環氧灌封膠的差異,并利用其分別封裝了IGBT功率模塊,對所封裝的IGBT模塊進行了高溫存儲、低溫存儲及溫度循環等環境測試。對比測試結果表明:兩種環氧灌封膠不同的增韌機理、混合比例、固化溫度、機械強度和Tg值對封裝存在一定影響,但CTE值是影響環氧灌封膠在IGBT模塊封裝應用的重要參數。
功率半導體模塊主要應用于電能轉換和電能控制,是電能轉換與電能控制的關鍵器件,被譽為電能處理的"CPU",是節能減排的基礎器件和核心技術之一,被廣泛應用在先進軌道交通、輸配電、電動汽車、新能源、智能家電以及軍工等領域。功率模塊封裝技術是集材料性能研究和應用研究于一體的綜合性學科,所涉封裝材料由于功率模塊的封裝形式多樣而不同。從材料的種類可以劃分為有機材料和無機材料,其中無機封裝材料如玻璃、水凝膠陶瓷等由于燒結溫度過高或熱膨脹系數(CTE)匹配度的問題導致應用較少;而有機封裝材料主要是有機硅、環氧樹脂和聚酰亞胺等高分子材料,在功率模塊中應用范圍較廣,相關的研究報道也相對較多。
絕緣柵雙極晶體管(IGBT)具有易驅動、控制速度快、導通電壓低、通態電流大、尺寸小等優點,是一種重要的功率半導體器件。IGBT 模塊按封裝形式的不同可分為壓接式和焊接式。壓接式采用的有機材料較少,本文不討論;焊接式主要采用的是有機硅凝膠和環氧膠灌封,不僅能提高 IGBT 模塊的絕緣能力,還能提升IGBT模塊的可靠性,延長其使用壽命。環氧樹脂由于其良好的絕緣性和工藝性而應用廣泛,但環氧灌封膠固化收縮率較大,且固化后CTE值相對芯片、襯板、綁定線等差異較大,環氧灌封的IGBT 模塊在溫度沖擊實驗后易開裂、脫離和形變,導致封裝失效,因此環氧灌封膠在IGBT模塊封裝中的應用研究需要重點關注。以下是對兩種國產 IGBT模塊封裝用環氧灌封膠的基本性能、熱性能和絕緣性能進行對比測試,并結合材料的基本性能研究兩種環氧灌封膠在模塊中的應用情況,為國產環氧灌封膠在 IGBT模塊中的應用提供一定的參考。
1、原材料及使用工藝
選取兩種國產環氧灌封膠作為研究對象,分別標記為1#環氧灌封膠和2#環氧灌封膠,兩種環氧灌封膠的關鍵參數下見表1。

2、測試儀器及方法
黏度采用上海高致精密儀器有限公司NDJ-5S型黏度計進行測試,測試標準為 GB/T 10247— 2008;體積電阻率采用日本HIOKI公司SM7120型高阻計進行測試,測試標準為 GB/T 1410—2006;電氣強度采用桂林電器科學研究院有限公司ZHT-10/ 50型電氣擊穿測試儀進行測試,測試標準為GB/T 1408.1—2006;力學性能采用德國ZWICK公司Z010型萬能拉力機進行測試,測試標準為 GB/T 2567—2008;導熱系數采用湘潭湘儀儀器有限公DRPL-II型導熱測試儀進行測試,測試標準為 GB/T 10295—2008;熱失重分析采用梅特勒TGA1(SF)型熱重分析儀進行測試,空氣氛圍,溫度從25℃升溫到 700℃,升溫速率為 5℃/min;玻璃化轉變溫度采用梅特勒 DSC1 型差示掃描量熱儀進行測試,測試標準為 GB/T 19466.2—2004;熱膨脹系數采用美國 TA公司TMA Q400型熱機械分析儀進行測試,測試標準為GB/T 36800.2—2018;阻燃性采用江都市天璨試驗機械廠CZF-5型水平垂直燃燒測試儀進行測試,測試標準為GB/T 2408—2008,樣品厚度為6 mm。
3、結果與討論
(1)環氧灌封膠固化前物理性能對比
環氧灌封膠固化前物理性能主要指膠的黏度、密度、凝膠時間等基本技術參數,如表 1所示。表 1 中的參數決定了環氧灌封膠的使用工藝條件及對灌膠設備的要求,也是環氧灌封膠選型中重要的技術工藝參數。
由于供應商對環氧灌封膠配方設計思路的差異,兩種環氧灌封膠固化前特性差異較大。對表 1 數據對比分析可以發現,兩種膠的設計思路差別為:1# 為雙組分熱固化型環氧灌封膠,A、B組分密度和黏度相差較小,采用質量比為 1∶1的比例混合有利于稱量和混合施膠。但該膠在常溫下混合黏度較大,超過 20 000 mPa·s,室溫下難以完成模塊灌封,需要將膠加熱至40~50℃以獲得更合適的操作黏度和滲透性;2# 也為雙組分熱固化型環氧灌封膠,但 A、B 組分密度和黏度相差大,采用質量比為 4∶1 的比例混合。此外該環氧灌封膠在常溫下的混合黏度為 5 540 mPa·s,具有較低操作黏度和滲透性,可無需加熱直接完成模塊的灌封。但該膠 A 組分填料含量高、黏度大,增加了填料沉降風險,也不利于 A、B 組分混合。綜上所述,1# 和 2# 環氧灌封膠固化前性能差異較大,對于儲存條件、工藝條件及灌膠設備等要求都會有所不同,需要結合存儲條件、灌膠設備、現場工藝條件等實際情況考慮選用。
(2)環氧灌封膠固化后物理性能
a.環氧灌封膠的基本性能
IGBT模塊在運行過程中可能會遭受機械振動、沖擊和高潮濕等不利影響因素,要求環氧灌封膠具有較大的硬度、抗沖擊性、較低的吸水率以保證模塊的可靠性。兩種環氧灌封膠固化后的基本性能如下表2所示。從下表2可以看出,盡管兩種環氧灌封膠固化前后的基本性能差異較大,但固化后都體現出較好的機械強度、較低的吸水率和優異的阻燃性。其中1#環氧灌封膠的導熱系數明顯大于2#環氧灌封膠,可能是所采用的填料種類及添加量的差異所致。

b. 環氧灌封膠的熱性能
熱(高溫)失效一直是導致IGBT失效的重要原因,因此對IGBT封裝材料的熱性能需要重點關注。首先對兩種環氧灌封膠的熱穩定性進行測試,再對其玻璃化轉變溫度(Tg)及 CTE值等熱性能進行討論,以期對環氧灌封膠在高溫條件下的封裝失效原因進行分析。
環氧樹脂及固化劑的分子量、固化物的交聯密度以及填料含量都可能阻礙分子鏈段的運動,從而對灌封膠的熱穩定性造成一定的影響。下圖1為兩種環氧灌封膠的熱失重分析(TGA)曲線。通過TGA曲線的起始分解溫度和不同溫度下的殘留率對比兩種環氧灌封膠的耐熱性能。從下圖1可以看出,1# 和 2# 環氧灌封膠的填料含量分別約為50%和42%,起始熱分解溫度分別為279.7℃和 298.5℃,2#環氧灌封膠具有較好的耐熱性。

兩種環氧灌封膠固化物的DSC 曲線如圖2所示。樣品測試先從室溫開始,然后以20℃/min的速率升溫至200℃,再以20℃/min的速率降至室溫,最后以20℃/min的速率升溫至200℃。


從上圖 3(a)可以看出,TMA測得兩種環氧灌封膠的 Tg分別為 101.3℃和95.5℃,與DSC法測試結果并不相同;從圖 3(b)可以看出,1#環氧灌封膠的 CTE 值要低于2#,說明1#環氧灌封膠的熱性能更為優異。
兩種環氧膠灌封膠的技術資料顯示,1#環氧灌封膠選用的樹脂類型為雙酚A型環氧樹脂、鄰甲酚醛環氧樹脂、納米殼核增韌劑以及氧化鋁等,采用的固化劑為含剛性分子結構的改性酸酐;2#環氧灌封膠樹脂類型為低黏度脂環族環氧樹脂、酚醛樹脂、改性增韌劑、二氧化硅以及氧化鋁等,固化劑為甲基六氫苯酐和一定量的促進劑。TMA測試結果表明,由于1#環氧灌封膠中鄰甲基酚醛具有更大的分子鏈結構,與含剛性分子結構的固化劑交聯后能有效地阻礙主鏈的內旋運動,環氧柔性下降,而納米結構的核殼增韌劑對環氧灌封膠的Tg影響較小。而2#環氧灌封膠雖然采用了分子鏈結構較大的酚醛樹脂,但低羥基當量的酚醛樹脂使交聯點減少,低黏度脂環族環氧樹脂與甲基六氫苯酐固化后也無法形成更大的分子結構阻礙主鏈內旋運動,分子柔性較大,導致2# 環氧灌封膠的Tg較低。此外,低黏度脂環族環氧樹脂雖然交聯密度較大,但其固化收縮率較大,通過后期溫度沖擊或者低溫存儲測試,有可能會進一步加劇樹脂內應力釋放和收縮,造成模塊封裝失效。對比 TMA 與 DSC 測得的Tg發現,TMA不僅能得到環氧灌封膠的熱變形溫度,還能了解環氧灌封膠在高溫狀態下的膨脹和變形情況,更直觀且更具有參考價值。
c.環氧灌封膠的絕緣性能

4、結論
對兩種國產環氧灌封膠進行了對比分析,發現 1# 和 2# 環氧灌封膠的混合比例、固化溫度、機械強度、Tg和CTE值并不相同。1# 環氧灌封膠完成IGBT 模塊灌封后模塊能順利通過高溫存儲、低溫存儲和溫度循環測試;由于 2# 環氧灌封膠 CTE 值偏大,所灌封模塊只能通過高溫存儲測試,無法滿足 IGBT 功率模塊的封裝使用要求。因此,CTE值的大小是影響環氧灌封膠在 IGBT模塊封裝應用的最重要參數。此外,對于環氧灌封膠在 IGBT 模塊上的驗證過程需要對材料性能、應用工藝以及后期的灌封驗證綜合考慮,周期較長,如何建立高效的選擇機制和打造高可靠性的實驗驗證平臺將是需要面臨解決的關鍵問題。
寫在最后面的話
總之,使用環氧灌封膠對電子器件進行灌封封裝具有諸多優勢,不僅能提高器件的絕緣性、機械強度和抗化學腐蝕性,還能提供良好的密封性,有效保護內部構件免受外界環境的侵害。這不僅能提高電子產品的可靠性和使用壽命,還能大幅降低故障率,為消費者提供更安全、穩定的產品體驗。
而今,環氧灌封膠又作為IGBT模塊封裝的核心材料,其性能直接決定模塊的可靠性及壽命。當前技術已通過復合改性和工藝優化顯著提升耐熱性與機械強度,但高溫穩定性、環保性及多功能集成仍是未來突破方向。隨著新能源汽車與SiC器件的普及,環氧灌封膠將向高性能化、智能化及綠色化發展,成為支撐下一代功率電子技術的關鍵材料。

免責聲明
【我們尊重原創,也注重分享。文中的文字、圖片版權歸原作者所有,轉載目的在于分享更多信息,不代表本號立場,如有侵犯您的權益請及時私信聯系,我們將第一時間跟蹤核實并作處理,謝謝!】
參考文獻:
[1] 賈揚?巴利加 .IGBT 器件物理、設計與應用[M]. 韓雁,丁扣寶, 張世峰譯.北京:機械工業出版社,2018.
[2] 王善林,陳玉華.電子封裝技術實驗[M].北京:冶金工業出版社, 2019.
[3] 斯蒂芬?林德 .功率半導體器件與應用[M ].肖曦,李虹譯 .北京:機械工業出版社,2019.
[4] KAESSNER S, SCHEIBEL M G, BEHRENDT S, et al. Reliabili‐ ty of novel ceramic encapsulation materials for electronic packag‐ ing[J]. Journal of Microelectronics and Electronic Packaging, 2018,15(3):132-139.
[5] 曾亮,齊放,戴小平,等.高分子絕緣材料在功率模塊封裝中的研究與應用[J].絕緣材料,2021,54(5):1-9.
[6] 安德列亞斯?福爾克,麥克爾?郝康普.IGBT模塊:技術、驅動和應用[M].韓金剛譯.2版.北京:機械工業出版社,2016.
[7] 曾亮,黎超華,李忠良,等 .大功率 IGBT 用耐高溫環氧灌封膠的研制[J].絕緣材料,2016,49(3):24-28.
[8] 曾亮,朱偉,李忠良,等 .大功率 IGBT 用環氧樹脂灌封膠的流變性能研究[J].絕緣材料,2015,48(6):25-29.
[9] 趙慧宇,丁娉,姜其斌,等.IGBT用雙組分加成型有機硅凝膠的國產化研究[J].特種橡膠制品,2013,34(3):31-33.
[10] 丁娉,陳磊,唐毅平,等.新型大功率IGBT用硅凝膠的制備及其應用性研究[J].絕緣材料,2014,47(2):62-65.
審核編輯 黃宇
-
半導體
+關注
關注
339文章
31114瀏覽量
265937 -
封裝
+關注
關注
128文章
9309瀏覽量
148963 -
IGBT
+關注
關注
1290文章
4361瀏覽量
264043
發布評論請先 登錄
灌封膠的常見類型及其特點

高頻點膠掛絲怎么解決?灌封膠觸變性控制技巧 |鉻銳特實業

冬季灌封膠不干?環氧聚氨酯低溫固化五大避坑指南 |鉻銳特實業

高導熱灌封膠如何驗證?詳解導熱系數的精準測試方法與影響因素 | 鉻銳特實業

定制灌封膠_特殊場景灌封膠定制化服務流程與案例




 半導體IGBT模塊封裝中環氧灌封膠應用的詳解;
半導體IGBT模塊封裝中環氧灌封膠應用的詳解;














評論