以下文章來源于汽車工程師漫談;作者Auto Ingenieur
一、ESD和EOS區別
ESD(Electro Static Discharge靜電釋放)與EOS(Electrical Over Stress過度電性應力)都是與電壓過應力有關的概念,但它們之間有明顯的差異。
ESD的電壓很高(>500V),持續時間相對較短(<1us)。
EOS的電壓相對較低(<100V),持續時間更長一些(通常>1us)。
| ESD | EOS | |
| 產生 | ESD屬于EOS的特例,有限的能量,由靜電荷引起 | 典型地,由電源和測試設備產生 |
| 時間 | 事件持續時間在微微秒-毫微秒級 | 事件持續時間在微秒-秒級.也可能是微秒) |
| 現象 | 其可見性不強,損壞位置不易發現 | 損壞的現象包括金屬線熔化、發熱、高功率、門鎖效應 |
| 影響 | 通常導致電晶體級別的損壞 | 短的EOS脈沖損壞看起來像ESD損壞 |
二、失效統計
從失效機理上器件的靜電損傷可分為靜電過電壓導致的場致失效和瞬時放電電流引起的熱致失效。通常,靜電損傷造成的元器件失效的主要模式有:
①端口漏電、擊穿呈阻性甚至短路;②端口特性無明顯變化,功能異常;③重要性能參數退化;④潛在性損傷:靜電電荷放電后元器件內部輕微損傷,放電后元器件的電參數是合格或出現變化,但其抗過電應力削減、壽命縮短,經過一段時間工作完全失效。我們所接觸的靜電失效大部分是潛在性失效的模式。
靜電敏感結構主要失效機理匯總見下表。

據有關數據統計,靜電損傷/過電損傷(ESD/EOS)失效是導致半導體器件失效的主要原因,占50%以上。而在靜電損傷的案例中,受影響最多的是CMOS類集成電路,其次是功放管和微波器件(組件)等。
三、失效特征分析
靜電損傷分為突發失效和潛在失效兩種類型。突發失效是指元器件受到靜電放電損傷后,突然完全或部分喪失其規定的功能。具體表現有:PN結區被擊穿、嚴重漏電;開路:集成電路的金屬化條或鍵合引線的熔斷;電容器介質擊穿短路;CMOS電路和MOS功率管因靜電觸發“閂鎖”燒毀,參數漂移等。
下圖為ESD擊中半導體器件后導致的氧化物穿孔、硅融化。


而潛在失效指靜電放電能量較低,或放電回路有限流電阻,僅造成輕微損傷,器件電參數可能仍然合格或略有變化。主要表現為:柵氧化層損傷、柵氧化物愈合或短路、保護電路受損、電荷陷阱、PN結衰減等。潛在失效同樣對器件產生不利影響:①使用可靠性下降,縮短預期壽命;②電參數逐漸惡化、抗過電應力能力下降。
當持續時間更長的EOS事件發生時,沖擊器件保護單元的能量就會更多,常常超出ESD保護單元的最大沖擊能量承受能力,這樣就會在ESD保護單元中積累太多的熱量,最終導致嚴重的毀壞。通常情況下,芯片中支撐ESD保護單元的其他部分也會連帶著一起受損。
下圖是根據IC管腳損壞開蓋后裸片,發現輸入管腳焊盤區域有開路。
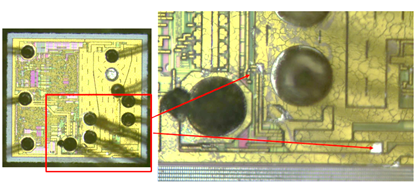
四、EOS、ESD失效的鑒別方法
①失效背景調查
通常靜電損傷發生具有一定的隨機性和持續性,而EOS損傷發生的階段可能具有一定規律性和可重復性。一般來說,EOS/ESD不具有失效器件的批次性特征,而缺陷引起的失效通常具有一定的批次性特征,而且在“合格品”中可能同樣存在潛在缺陷的跡象或趨勢。因此需關注失效發生是否具備批次性特點。另外,需調查失效發生的階段、周圍工作場景等信息,通過失效背景信息區分三種失效是分析的輔助手段。
②參數測試
通常,對失效樣品需要進行參數測試,這些包括:端口I/V測試、靜態電流、功能測試等,同時會利用同批次良品進行對比。對于靜電損傷引起的失效,其參數測試結果往往與良品差異性小,而EOS損傷的測試結果則往往差異較明顯。對于缺陷誘發的失效,則可能在大量良品測試中檢測出潛在缺陷的樣品。另外,懷疑靜電損傷的失效,則應該針對良品開展靜電敏感度等級評價測試,評估是否屬于靜電敏感類型器件,同時通過進一步解剖對比模擬失效的樣品與失效樣品之間的差異。
③顯微形貌觀察和分析
ESD一般在IC的某個端口,有的損傷比較明顯,開封后在金相下很明顯的看出損傷痕跡,比如在保護網絡電力部分;
EOS的碳化面積較大,一般過功率燒毀會出現原始損傷點且由這點有向四周輻射的裂紋,過電壓損傷一般在有源區的邊緣位置,多發生在電源引腳上。
定位損傷點是分析中的難點,通過解剖樣品,并且借助于失效定位手段:如光學顯微觀察、液晶分析法、光發射顯微分析技術(EMMI)以及激光誘導電阻變化技術(OBIRCH)、磁顯微分析以及聚焦離子束剖切(FIB)等方法定位到失效點,然后直接觀察失效的微觀物理形貌特征,是鑒別三種失效類型最直觀的方式,也是最需要經驗的一個環節。通常,從損傷后的物理微觀形貌來看,靜電損傷形貌通常比較輕微,損傷區域小,損傷點尺寸通常為微米級,或者僅有輕微損傷痕跡,相對于EOS損傷來說要輕微一些。
對于CMOS集成電路而言,多數發生在電極或擴散區之間,往往有明顯的指向性。有時也會伴有金屬化損傷,但相對于EOS損傷來說,損傷區域及尺寸小,不會像EOS損傷那樣有較大面積的金屬化熔融和燒毀的特征。而缺陷誘發的失效,往往具有失效部位和類型單一,且“合格品”中也可能存在類似缺陷。總的來說,ESD失效是EOS失效的一部分,二者之間沒有明顯分界,在對失效樣品進行判別分析時,要采用上述三種方法進行綜合分析,才能得到較為準確的判斷。
-
ESD
+關注
關注
50文章
2415瀏覽量
180133 -
EOS
+關注
關注
0文章
133瀏覽量
22194 -
失效模式
+關注
關注
0文章
31瀏覽量
10469
原文標題:ESD和EOS失效模式和判斷依據
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
靜電放電/過度電性應力/閂鎖試驗 (ESD/EOS/Latch-up)
USB端口ESD和EOS防護介紹及方案
芯片IC可靠性測試、ESD測試、FA失效分析
液晶顯示屏的ESD和EOS怎么破?
On chip ESD和EOS保護設計




 ESD和EOS失效模式介紹
ESD和EOS失效模式介紹

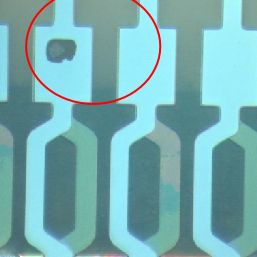








評論