【博主簡介】本人系一名半導體行業質量管理從業者,旨在業余時間不定期的分享半導體行業中的:產品質量、失效分析、可靠性分析和產品基礎應用等相關知識。常言:真知不問出處,所分享的內容如有雷同或是不當之處,還請大家海涵,如有需要可留意文末聯系方式,當前在網絡平臺上均以“愛在七夕時”的昵稱為ID跟大家一起交流學習!
在當今材料學科專業畢業生就業中,會被面試官問及到有關電化學表征技術中的“X射線光電子能譜”技術相關的問題。同時,已在行業中摸爬滾打的有些朋友也會有相關這樣或那樣的疑惑。除此之外,還有在各大高校的課題中,也會遇到關于此類問題,那么今天就集中跟大家分享一下有關于“X射線光電子能譜”技術分析的話題。

講到X射線,相信絕大多數朋友都知道:它的發現是19世紀末20世紀初物理學的三大產物(X射線1896年、放射線1896年、電子1897年)之一,這一發現標志著現代物理學的產生。X射線的發現為諸多科學領域提供了一種行之有效的研究手段。X射線的發現和研究,對20世紀以來的物理學以至整個科學技術的發展產生了巨大而深遠的影響。
而X射線光電子能譜是一種廣泛應用的方法,不僅可以對表面幾納米范圍內的元素(Li到U)進行定性和定量分析,還可以分析決定材料性質的化學鍵狀態。 X射線光電子能譜自 20 世紀 70 年代以來就廣為人知。
X射線光電子能譜采用軟X射線作為激發源,這意味著激發光對樣品的損傷很小,并且絕緣體上的電荷很容易被去除,因此不僅可以測量金屬材料,還可以測量包括聚合物材料在內的許多其他材料。

一、X射線光電子能譜分析技術的介紹
X射線光電子能譜,其英文全稱為:X-ray Photoecectron Spectroscopy,簡稱:XPS,該分析技術是一種通過一束入射到樣品表面3~10nm 深度的光子束,檢測材料表面信息的無損測量技術。XPS分析技術能很好地使樣品保持其原有的結構信息,可用于定性和定量分析材料表面的元素組成和含量,以及分析元素的化學價態、化學鍵 等信息。
XPS分析技術早期也被稱為:ESCA (Electron Spectroscopy for Chemical Analysis),是一種使用電子譜儀測量X-射線光子輻照時樣品表面所發射出的光電子和俄歇電子能量分布的方法。XPS可用于定性分析以及半定量分析, 一般從XPS圖譜的峰位和峰形獲得樣品表面元素成分、化學態和分子結構等信息,從峰強可獲得樣品表面元素含量或濃度。
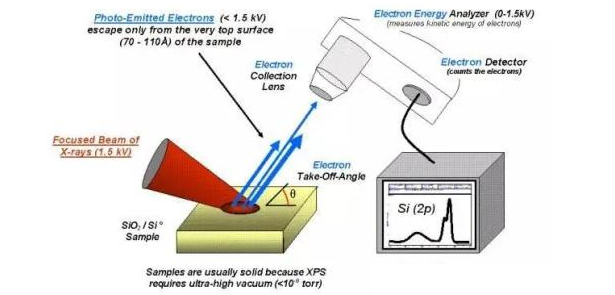
詳細來說,XPS就是用一束X射線激發固體表面,同時測量被分析材料表面1-10nm內發射出電子的動能,而得到XPS譜。光電子譜記錄超過一定動能的電子。光電子譜中出現的譜峰為原子中一定特征能量電子的發射。光電子譜峰的能量和強度可用于定性和定量分析所有表面元素(氫元素除外)。

隨著對高性能材料需求的不斷增長,表面工程隨之顯得越來越重要。只有了解材料層表面處和界面處的物理和化學相互作用,才能解決許多與現代材料相關的問題。 表面化學特性將影響材料的諸多方面,如腐蝕速率、催化活性、粘合性、表面潤濕性、接觸勢壘和失效機理。
材料的表面是材料與外部環境及與其它材料相互作用的位置。所以,在許多應用領域中,用表面修飾改變或改進材料性能和特性。材料經處理(如斷裂、切割或刮削)后,XPS可用于分析其化學特性。從不粘鍋涂層到薄膜電子學和生物活性表面,XPS成為表面材料表征的標準工具。在本章節我就不過多的贅述關于“表面表征”和“X射線光電發射過程”等相關的知識了,有機會再跟大家詳聊。
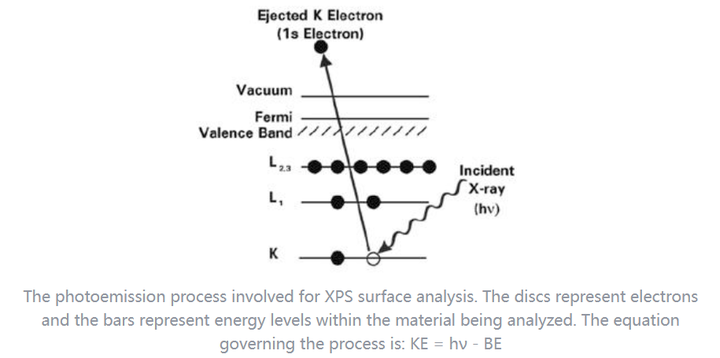
二、X射線光電子能譜(XPS)分析技術的歷史
XPS是由瑞典Kai M.Siegbahn教授領導的研究小組創立的,并于1954年研制出世界上第一臺光電子能譜儀,1981年,研制出高分辨率電子能譜儀。

他在1981年獲得了諾貝爾物理學獎。這種能譜最初是被用來進行化學元素的定性分析,現在已發展為表面元素定性、半定量分析及元素化學價態分析的重要手段。此外,配合離子束剝離技術和變角XPS 技術,還可以進行薄膜材料的深度分析和界面分析。
目前,XPS 方法廣泛應用于化學化工,材料,機械,電子材料等領域。
三、X射線光電子能譜(XPS)分析技術的基本原理
XPS分析技術起源于1887年德國物理學家赫茲發現的光電效應。即一定能量的X射線(常用的射線源是Mg Kα-1253. 6eV 或Al Kα-1486. 6eV) 照射到樣品表面,和待測樣品的表層原子發生作用,當光電子能量大于核外電子的結合能時,可以激發待測物質原子中的電子脫離原子成為自由電子。
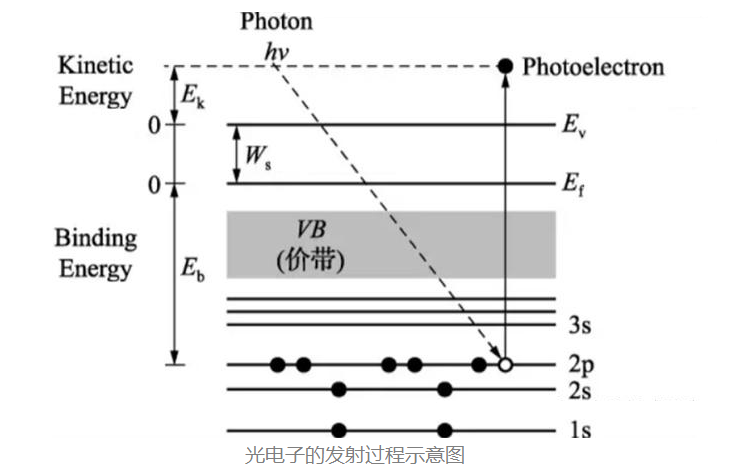
入射的X 射線光子與K層電子相互作用,使它受激發后脫離原子發射出去,該過程可用下式表示:
hν =Ek+Eb+Er (1)
其中,hν 是X射線的能量;Ek是光電子的能量;Eb是電子的結合能;Er是原子的反沖能量,其中Er很小,可以忽略;而根據能量守恒定律可得到下述關系:
Eb=hν-Ek(2)
式中,hν是已知的,Ek可通過電子能量分析器測得,故可確定結合能Eb。由于不同原子中同一層上電子的束縛能Eb不同,因此可用Eb進行元素鑒定。
即:通過測量樣品中各個元素光電子結合能的大小來鑒別樣品表面元素的化學組成、狀態及含量,從而進行定性、定量分析或深度剖析等。

四、X射線光電子能譜(XPS)分析技術基礎知識
關于XPS分析技術譜線中伴峰的來源和俄歇電子(Auger electron)產生的過程等相關知識點,可詳細閱讀以下分享的“X射線光電子能譜(XPS)技術基礎培訓”內容:





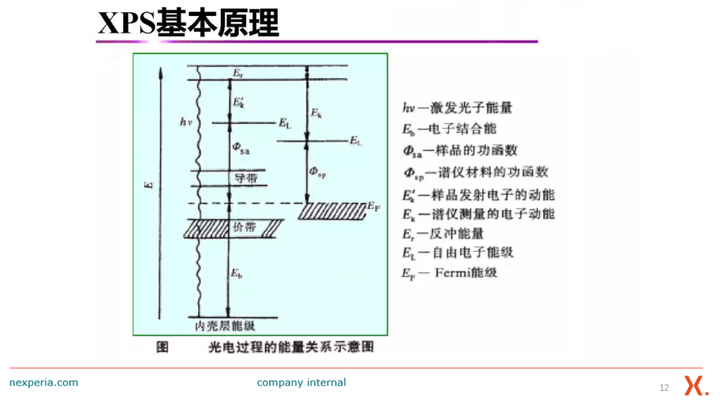

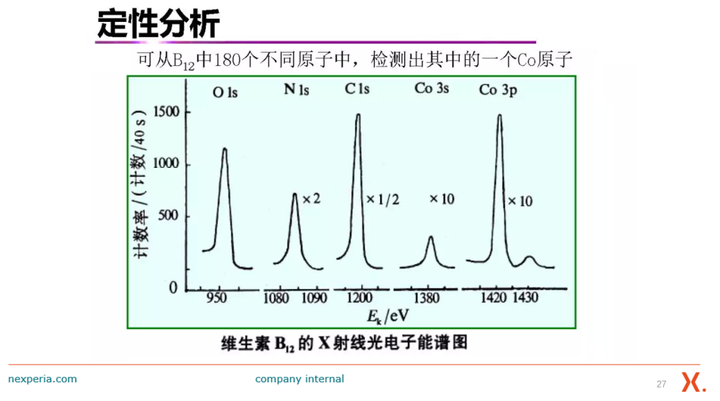
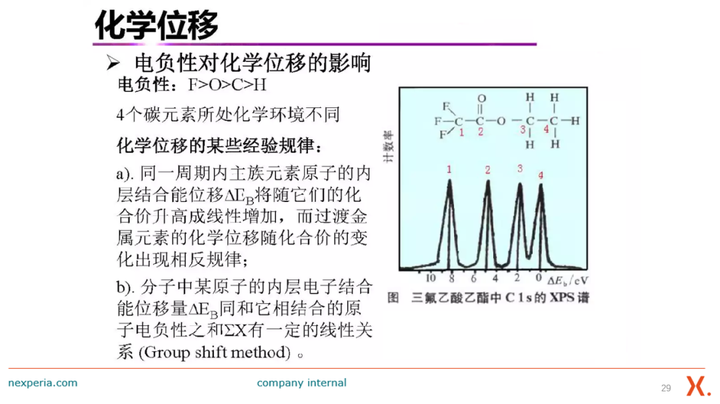
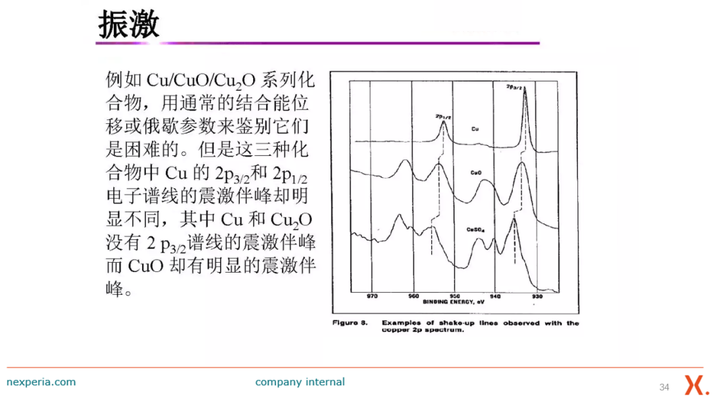



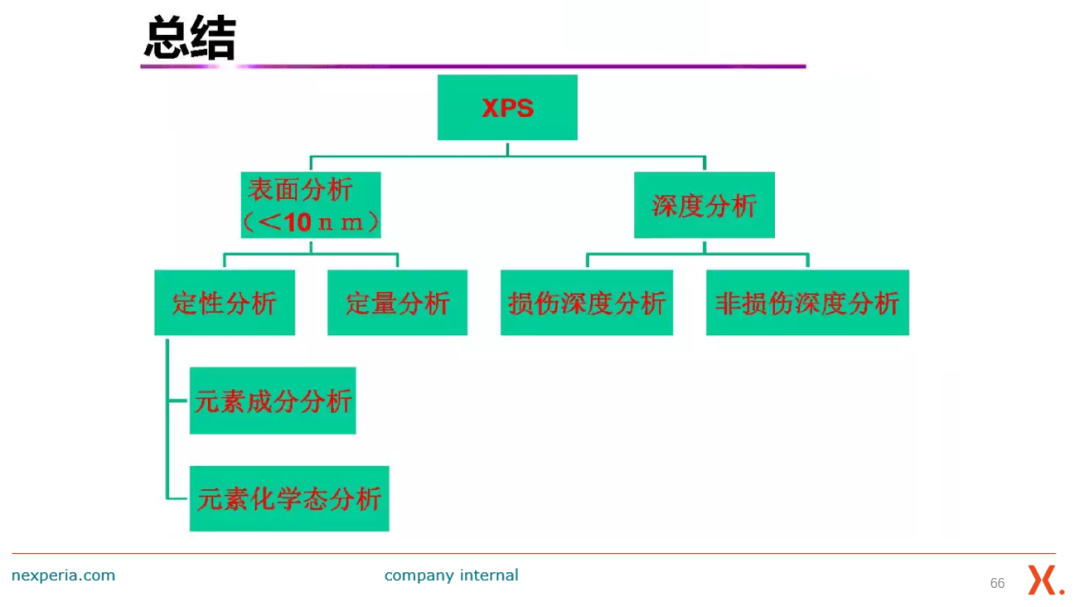

因為本PPT章節太多,剩下部分如有朋友有需要,可加入我“知識星球”免費下載PDF版本。注意:此資料只可供自己學習,不可傳閱,平臺有下載記錄,切記!文末有加入“星球”方式,歡迎加入后一起交流學習。

五、X射線光電子能譜(XPS)分析技術的特點
XPS是一種在材料表面分析中常用的先進分析技術,其對材料的分析過程中,不僅能得到總體的化學信息,還能獲取微區和深度分布等方面的信息,其具體特點如下:
1、測試范圍廣,可對表面存在的除H和He以外的所有元素進行定性和定量分析;
2、測試中能獲取豐富的化學信息,且能對樣品表面無損傷檢測;
3、相鄰元素的同種能級的譜線相隔較遠,相互干擾少,元素定性的標識性強;
4、能檢測元素的化學位移,從而用于材料中結構分析和化學鍵研究;
5、是一種高靈敏超微量表面分析技術,探測深度約3~10nm。

六、X射線光電子能譜(XPS)分析技圖譜的組成
XPS譜圖一般包括光電子譜線,衛星峰(伴峰),俄歇電子譜線,自旋-軌道分裂(SOS)等:
1、光電子譜線
每一種元素都有自己特征的光電子線,它是元素定性分析的主要依據,其中,譜圖中強度最大、峰寬最小、對稱性最好的譜峰,稱為XPS的主譜線。

如上圖所示,對于In元素而言,In 3d強度最大、峰寬最小,對稱性最好,是In元素的主譜線。而除了主譜線In 3d之外,其實還有In 4d, In 3p等其它譜線,這是因為In元素有多種內層電子,因而可以產生多種In XPS信號。
2、衛星峰(伴峰)
常規X射線源(Al/Mg Kα1,2)并非是單色的,而是還存在一些能量略高的小伴線(Kα3,4,5和Kβ等),所以導致XPS中,除Kα1,2所激發的主譜外,還有一些小的伴峰。
3、俄歇電子譜線
電子電離后,芯能級出現空位,弛豫過程中若使另一電子激發成為自由電子,該電子即為俄歇電子。俄歇電子譜線總是伴隨著XPS,但具有比XPS更寬更復雜的結構,多以譜線群的方式出現。特征:其動能與入射光hν無關。
4、自旋-軌道分裂(SOS)
由于電子的軌道運動和自旋運動發生耦合后使軌道能級發生分裂。對于l>0的內殼層來說,用內量子數j(j=|l±ms|)表示自旋軌道分裂。即若l=0 則j=1/2;若l=1則j=1/2或3/2。除s亞殼層不發生分裂外,其余亞殼層都將分裂成兩個峰。
5、鬼峰
有時,由于X射源的陽極可能不純或被污染,則產生的X射線不純。因非陽極材料X射線所激發出的光電子譜線被稱為“鬼峰”。

七、X射線光電子能譜(XPS)分析技術樣品荷電問題及解決辦法
在XPS測試過程中,如果樣品絕緣或導電性不好,經X射線輻照后,其表面會產生的正電荷不能得到電子的補充而導致電荷積累,使測得的結合能比正常值要偏高。
樣品荷電問題很難用某一種方法徹底消除,常用的解決方法有以下幾種:
1、在樣品表面蒸鍍導電性好的物質如金或碳等。但蒸鍍物質的厚度會對結合能的測定有影響, 而且蒸鍍物質可能會與樣品相互作用,從而影響測試結果。
2、測試過程中利用低能電子中和槍輻照出大量低能負電子到樣品表面,中和正電荷。但如何控制輻照電子流密度而不產生過中和現象仍是一大 難點,有待于解決。
3、在XPS分析中,一般會采用內標法對測試結果進行校準。常用的是碳內標法,用真空系統中最常見的有機污染碳的C 1s 結合能284. 8eV 進行校準,或者采用檢測材料中已知狀態穩定元素的結合能進行校準。
4、在XPS定量分析中,相關標準物質必不可少。目前我國在這方面還剛剛開始,需要根據產業需求,研制更多標準物質,以促進標準的執行。
XPS 技術被廣泛用于材料、化學、固體物理、催化、微電子技術及計量等諸多領域。利用XPS技術不僅可進行材料表面元素的定性分析( 如元素組成鑒別和化學態分析) 和定量分析,還可進行深度剖析研究樣品中元素的縱向分布,利用角分辨 XPS技術還可對超薄薄膜樣品的厚度進行測量。

八、X射線光電子能譜(XPS)分析技術的應用
XPS分析技術的應用主要分為定性分析和定量分析,以下分為兩個方面和四個大點分別對其應用進行介紹。
1、定性分析
XPS的定性分析就是根據所測得譜的位置和形狀來得到有關樣品的組分、化學態、表面吸附、表面態、表面價電子結構、原子和分子的化學結構、化學鍵合情況等信息,元素定性的主要依據是組成元素的光電子線的特征能量值。
(1)元素組成鑒別
每種元素都有唯一的一套能級,XPS技術通過測定譜中不同元素的結合能來進行元素組成的鑒別,對于化學組成不確定的樣品,應作全譜掃描以初步判定表面的全部或大部分化學元素。
一般情況下,首先鑒別普遍存在元素的譜線,特別是C和O的譜線;其次,鑒別樣品中主要元素的強譜線和有關的次強譜線;最后,鑒別剩余的弱譜線。
如果是未知元素的最強譜線,對p、d、f 譜線的鑒別應注意其一般為自旋雙線結構,它們之間應有一定的能量間隔和強度比。下圖為HfO2薄膜樣品的全譜掃描圖,由圖可知該樣品中含有Hf、O元素,其中C的結合能峰來自XPS測試過程中校準用的C元素。
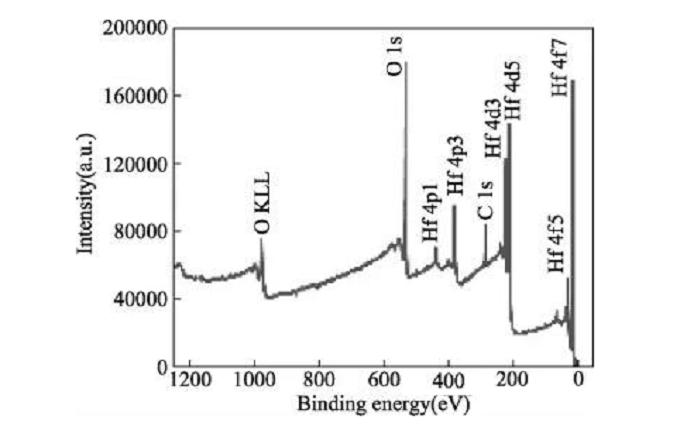
(2)化學態和分子結構分析
由于原子所處化學環境不同,其內殼層電子結合能會發生相應的變化,這種變化在譜圖上主要表現為譜峰的位移,即化學位移;同時,這種化學環境的不同可以是與原子相結合的元素種類或者數量不同,也可能是原子具有不同的化學價態。
分析化學態和分析結構具有以下一般規律:1)氧化作用使內層電子結合能上升,氧化中失電子愈多,上升幅度愈大;2)還原作用使內層電子結合能下降,還原中得電子愈多,下降幅度愈大;3)對于給定價殼層結構的原子,所有內層電子結合能的位移幾乎相同。
一般情況下,如果要研究樣品中已知元素的峰,可進行窄區域高分辨掃描,以獲取更加精確的信息,如結合能的準確位置、精準的線型、精確地計數等,通過扣除背底或峰的分解或退卷積等數據處理,來鑒定元素的化學狀態。例如要確定下圖中HfO2薄膜樣品全譜中Hf元素的詳細信息,可在Hf的最強峰附近進行窄譜掃描,窄譜掃描結果如下圖所示,兩個峰對應的結合能為17. 50 eV 和19. 18 eV,分別對應Hf 4f7和Hf 4f5,這與文獻中報道的HfO2中Hf4+的結合能接近,從而確定該樣品中Hf的化學態。

2、半定量分析
(1)基本原理
經X射線輻照后,從樣品表面出射的光電子的強度(I,指特征峰的峰面積)與樣品中該原子的濃度(n)有線性關系,因此可以利用它進行元素的半定量分析。
簡單的可以表示為:I = n*S, S稱為靈敏度因子(有經驗標準常數可查,但有時需校正)。
對于對某一固體試樣中兩個元素i和j, 如已知它們的靈敏度因子Si和Sj,并測出各自特定譜線強度Ii和Ij,則它們的原子濃度之比為:ni:nj=(Ii/Si):(Ij/Sj),因此可以求得相對含量。
鑒于光電子的強度不僅與原子的濃度有關,還與光電子的平均自由程、樣品的表面光潔度,元素所處的化學狀態,X射線源強度以及儀器的狀態有關。因此,XPS技術一般不能給出所分析元素的絕對含量,僅能提供各元素的相對含量。
(2)半定量分析方法的步驟
XPS的半定量分析通常是通過處理XPS譜圖完成的,主要有以下幾個處理步驟:(1)扣除背景;(2)測量峰面積(必要時進行峰擬合);(3)應用靈敏度因子;(4)計算原子濃度。
實例說明:下表為三種ZnO的Zn和O元素的相對含量,其中O 1s峰形如圖是不對稱的,說明是由不止一個峰組成的。根據譜峰形狀,結合文獻對O 1s進行峰擬合,分別是530 eV左右的ZnO晶格O的峰(OL)、531.7 eV左右的羥基O(Oα)的峰和533 eV的吸附O(Oβ)的峰,根據峰面積,結合各元素靈敏度因子,計算得到的元素比例如表所示。



3、深度剖析
由于樣品本身的層狀結構如鍍膜、氧化和鈍化等原因導致其在深度方向上化學狀態的差異。而前面提到的非破壞性方法僅限于檢測物體表面1~10nm內的組分變化,但為了獲得大于10nm深度的信息,必須在XPS設備的分析室用惰性氣體離子轟擊,對樣品表面進行刻蝕。
深度剖析主要是研究元素化學信息在樣品中的縱深分布,即通過利用氬離子槍對樣品表面進行氬離子濺射剝離,控制合適的濺射強度及濺射時間,將樣品表面刻蝕到一定深度,然后進行取譜分析。為了獲得準確的濺射深度,一般采用與被測樣品相近或相同的厚度標準物質校準濺射速率,從而根據濺射時間計算得到校準后對應元素分布的濺射深度。
為了避免刻蝕采用的離子束與被測樣品的相互作用,得到高質量的深度剖析測量結果,刻蝕必須在高真空下進行,利用刻蝕和取譜交替操作,便可得到樣品化學信息隨深度的變化規律,極大地擴展了 XPS的檢測范圍。
4、角分辨電子能譜分析
光電子從樣品表面逸出的深度與該電子的動能有關,當樣品表面垂直于分析器時,電子的逃逸深度為d,改變樣品表面與入射光束間的角度,即可改變入射光的檢測深度,使得檢測深度變淺,這樣來自最表層的光電子信號相對較深層的會大大增強。
利用這一特性,可以對超薄樣品膜表面的化學信息進行有效地檢測,從而研究超薄樣品化學成分的縱向分布。為了得到樣品的準確信息,測試前要根據ISO發布的XPS強度標的線性( ISO 21270: 2004) 對設備進行校準。
XPS可在無需對樣品進行機械、化學或離子刻蝕的情況下,以多種方式運用Beer-Lambert 方程提供覆蓋層的厚度信息,進行無損傷深度剖析。通過改變實驗裝置的幾何位置、入射電子的能量或刻蝕時間等,獲取樣品不同深度的信息。但需要注意的是,這種方法適用于襯底上覆蓋層連續均勻且厚度超薄(小于10nm) 的情況。

九、X射線光電子能譜(XPS)分析技術常見Q&A
1、Q:某些價態會掃不出來嗎?
A:不會,全譜能量很高。如果測不出來,要么就是污染碳很高,要么就是含量很少。一般是后者原因居多。
2、Q:激光導熱樣品厚度如何選擇?
A:不一樣。每種元素的主峰的靈敏度因子都不一樣。
3、Q:怎么判斷擬合是好是壞,是擬合了兩個峰算好還是擬合了三個峰算好?
A:看波動大小,越小越好;還要看對應的物理意義。波動如下圖所示。具體擬合幾個峰,要參考樣品本身的情況,以及擬合的貼合度,沒有嚴格的界定哪個更好。

十、總結一下
X射線光電子能譜(XPS)分析是一種表面分析方法,提供的是樣品表面的元素含量與形態,而不是樣品整體的成分。其信息深度約為3-5nm。如果利用離子作為剝離手段,利用XPS作為分析方法,則可以實現對樣品的深度分析。固體樣品中除氫,氦之外的所有元素都可以進行XPS分析。
1、俄歇電子能譜法(AES)的優點
在靠近表面5-20埃范圍內化學分析的靈敏度高;數據分析速度快;能探測周期表上He以后的所有元素。它可以用于許多領域,如半導體技術、冶金、催化、礦物加工和晶體生長等方面。
2、AES與XPS相同點
它們都是得到元素的價電子和內層電子的信息,從而對材料表面的元素進行定性或定量分析,也可以通過氦離子對表面的刻蝕來分析材料表面的元素,得到材料和分析物滲透方面的信息。
相比之下,XPS通過元素的結合能位移能更方便地對元素的價態進行分析,定量能力也更好,使用更為廣泛。但由于其不易聚焦,照射面積大,得到的是毫米級直徑范圍內的平均值,其檢測極限一般只有0.1%,因此要求材料表面的被測物比實際分析的量要大幾個數量級,AES有很高的微區分析能力和較強的深度剖面分析能力。另外,對于同時出現兩個以上價態的元素,或同時處于不同的化學環境中時,用電子能譜法進行價態分析是比較復雜的。

參考文獻:
1、張素偉, 姚雅萱, 高慧芳,等. X射線光電子能譜技術在材料表面分析中的應用[J]. 計量科學與技術(1):5.
免責聲明
我們尊重原創,也注重分享。文中的文字、圖片版權歸原作者所有,轉載目的在于分享更多信息,不代表本號立場,如有侵犯您的權益請及時聯系(一三七 二八三五 六二六五),我們將第一時間跟蹤核實并作處理,謝謝!
審核編輯 黃宇
-
X射線
+關注
關注
4文章
226瀏覽量
52970 -
XPS
+關注
關注
0文章
99瀏覽量
12558
發布評論請先 登錄
MAX30131/MAX30132/MAX30134:電化學傳感器AFE的卓越之選
AD5940/AD5941:高精度阻抗與電化學前端的卓越之選
鋁合金電化學處理的粗糙度表征與粘接性能優化

助力電池行業電化學阻抗測量邁向高精準新時代-IM89130電化學阻抗分析儀

億緯鋰能受邀出席2025全國電化學大會
電化學表征“傅里葉變換紅外光譜儀(FTIR)”分析技術的詳解;

電化學遷移(ECM):電子元件的“隱形殺手” ——失效機理、環境誘因與典型案例解析

求助,怎么提高電化學式CO傳感器的精度?
聚智姑蘇,共筑硅基光電子產業新篇 — “硅基光電子技術及應用”暑期學校圓滿落幕!

增長與挑戰并存:透視2025年一季度中國電化學儲能電站行業數據




 電化學表征“X射線光電子能譜(XPS)”分析技術的詳解;
電化學表征“X射線光電子能譜(XPS)”分析技術的詳解;





評論