1.卓越的可焊性和焊接可靠性(核心原因)
防止氧化:金(Au)是一種非常穩定的金屬,在空氣中不易氧化。而其他常用的焊盤表面處理方式,如鍍錫(HASL),在存放過程中容易氧化生成氧化錫膜,導致可焊性下降。
保證焊接強度:潔凈的金表面能提供極佳的潤濕性,使焊錫能夠輕松、均勻地鋪展,形成堅固、可靠的焊點。這對于自動化的SMT貼片生產至關重要,能大幅降低虛焊、假焊等缺陷率。
2.保證高頻電性能
優異的導電性:金是電的良導體,其表面電阻極低。對于晶振這種高頻元件(尤其是幾十MHz甚至上百MHz的),焊盤表面的微小電阻差異都可能引入不必要的損耗或信號完整性issues。
穩定的接觸:鍍金層表面平整光滑(稱為“平整化處理”),能與晶振的鍍金電極或錫球形成均勻、穩定的電接觸,減少信號傳輸中的損耗和反射,這對于保證時鐘信號的純凈度和穩定性非常重要。
3.適合金線鍵合( WireBonding )
一些高端或特殊封裝的晶振(如某些OCXO恒溫晶振)內部芯片與外部引腳之間需要通過極細的金線進行連接。這個過程需要在晶振外殼的焊盤上進行。
只有金層與金層之間才能實現最可靠、最穩定的鍵合。鍍金焊盤為這種工藝提供了必要條件。
4.延長保存期限( ShelfLife )
由于金不易氧化,鍍金PCB的可焊性可以保持很長時間(通常1年以上),方便物料管理
和庫存周轉。而鍍錫板在潮濕環境中幾個月后就可能出現可焊性問題。
5.適合多次回流焊( Reflow )
在復雜的PCBA組裝過程中,板子可能需要經過多次高溫回流焊。鍍金層在高溫下依然能保持穩定,不會像鍍錫那樣容易熔化或產生“錫須”Whiskers),從而保證每次過爐后焊盤依然具有良好的可焊性。
鍍金工藝的選擇:ENIG
貼片晶振焊盤最常用的鍍金工藝是 ENG( ElectrolessNickel lmmersion Gold,化學沉鎳浸金)。
底層鎳(Ni)層:這是關鍵。鎳層作為阻隔層,防止上層的金與底層的銅(Cu)在高溫下相互擴散形成脆性的金屬間化合物(IMC),這些化合物會嚴重影響焊點機械強度。
表層金(Au)層:金層很薄(通常0.05-0.1μm),僅用于保護鎳層不被氧化,并提供優良的可焊表面。在焊接的瞬間,金會迅速溶解到焊錫中,真正形成焊點的是下方的鎳層與焊錫(Sn)結合的Ni-Sn合金。
與其他表面處理方式的對比
表面處理方式的優點、缺點:(對于貼片晶振而言)
ENIG(化學沉金)平整度高、可焊性好、不易氧化、適合金線鍵合,成本較高。
HASL(噴錫)成本低,表面不平整,可能導致小尺寸元件焊接不良;易氧化。
OSP(防氧化助焊劑)成本低、非常平整,保護膜脆弱,不耐多次回流焊;保存期限短。Immersion Silver(沉銀)平整、可焊性好、成本適中,易氧化和硫化(發黃),長期可靠性不如ENIG。
ENEPIG(化學鎳鈀金)性能最優,非常適合金線鍵合,成本最高。
總結
給貼片晶振的焊盤鍍金(ENIG),核心目的是為了在高速、自動化的SMT生產中,確保這顆為系統提供“心跳”的關鍵元件能夠一次性焊接成功,并形成長期穩定、可靠的電連接和機械連接。
雖然鍍金成本更高,但為了避免因焊接不良導致的系統時鐘故障、批量返工甚至產品召回,這筆投資在絕大多數對可靠性有要求的電子產品(如通信設備、工業控制、汽車電子、醫療設備)中都是完全值得的。
-
電子元器件
+關注
關注
134文章
3833瀏覽量
113150 -
晶振
+關注
關注
35文章
3461瀏覽量
72837 -
晶體振蕩器
+關注
關注
9文章
734瀏覽量
32927 -
OCXO
+關注
關注
0文章
49瀏覽量
15332 -
TCXO
+關注
關注
0文章
221瀏覽量
13242
發布評論請先 登錄
元器件經驗分享-晶體與晶振對比分析
晶圓級CSP裝配工藝的印制電路板焊盤設計方式
PCB電路板表面處理工藝:沉金板與鍍金板的區別
單片機晶振的必要性_單片機晶振的作用_單片機晶振電路原理(51單片機)
分析Mini LED芯片焊盤表面電極結構各自的優缺點及適用性
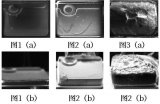
使用晶振時應注意哪些事項
HCI杭晶電子:強芯筑基,靈動隨行——杭晶晶振為飛騰D3000M精準賦能






 HCI杭晶電子——晶振焊盤表面處理:鍍金的必要性、工藝方式與對比分析
HCI杭晶電子——晶振焊盤表面處理:鍍金的必要性、工藝方式與對比分析



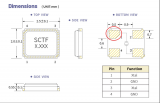











評論