隨著半導體行業的日益發展,半導體行業視覺檢測要求越來越高,半導體視覺檢測面臨著許多獨特的痛點和挑戰,如制程復雜、精度要求極高、環境苛刻等。
半導體視覺檢測在整個半導體制造流程中起著至關重要的作用,目前的檢測痛點與難點主要如下:
1. 微米/納米級的超高精度要求
尺寸微縮化:隨著半導體工藝從微米進入納米甚至亞納米時代,芯片上的線路和缺陷尺寸越來越小,傳統的機器視覺系統難以捕捉如此微小的瑕疵。這就要求檢測系統具備極高的分辨率和靈敏度,能夠識別小至幾十納米的顆粒、劃痕、斷線等缺陷。
缺陷多樣性和不確定性:半導體制造流程復雜,可能產生各種各樣、形態各異的缺陷,例如顆粒污染、晶體缺陷、劃痕、氣泡、腐蝕、以及各種形狀和位置的微小裂紋。這些缺陷往往不規則,且新工藝還會帶來新的缺陷類型,導致傳統基于規則的機器視覺算法難以應對。
2. 高速度與高效率
生產節拍快:半導體產線是24/7不間斷運行的,為了保證高產能和高良率,檢測系統必須在極短的時間內完成圖像采集、處理和分析,速度要比人工檢測快5-10倍,才能跟上生產節拍。
數據量龐大:一片晶圓上可能有成千上萬個芯片,每個芯片都需要進行多輪檢測,產生海量的圖像數據。如何快速處理和分析這些數據,并從中提取有價值的信息,對計算能力和算法效率提出了巨大的挑戰。
3. 復雜的光學環境與表面特性
多層結構與反射:半導體器件通常由多層薄膜和復雜的三維結構構成。在檢測過程中,光線會在不同材料層之間發生反射、折射和衍射,造成圖像對比度低、細節不清晰,難以有效區分缺陷與背景。
表面異構性:晶圓表面可能存在微粗糙度、薄膜不均勻性等問題,這些都會影響光的散射,降低信噪比(SNR),使得微小缺陷的識別變得更加困難。為了克服這些挑戰,需要使用特殊的照明技術(如明場、暗場、紫外、傾斜照明)和高級光學系統。
51camera 的半導體檢測方案已經多方驗證,在項目上廣泛應用。比如SWIR相機晶圓隱裂檢測系統,使用紅外相機發揮波段長穿透性強的特性進行材質透檢捕捉內部隱裂缺陷。搭配CCS紅外燈箱和茉莉特紅外鏡頭,強強聯合助力于晶圓檢測行業。
半導體視覺檢測的典型應用
· 晶圓外觀檢測:
· 鍵合封裝:
· 微裂紋檢測:
· 晶圓字符識別:
· 分類探針標記:
面向未來更高分辨率、更快速的光學成像系統是半導體檢測的核心競爭力。51camera通過持續技術創新和模塊化產品策略,提供高可靠性的定制化解決方案;
-
晶圓
+關注
關注
53文章
5408瀏覽量
132280 -
視覺檢測
+關注
關注
2文章
454瀏覽量
20517
發布評論請先 登錄
改善薄晶圓制造中的檢測挑戰
WD4000無圖晶圓檢測機:助力半導體行業高效生產的利器




 晶圓隱裂檢測系統助力半導體視覺檢測
晶圓隱裂檢測系統助力半導體視覺檢測

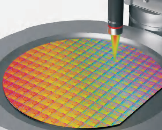
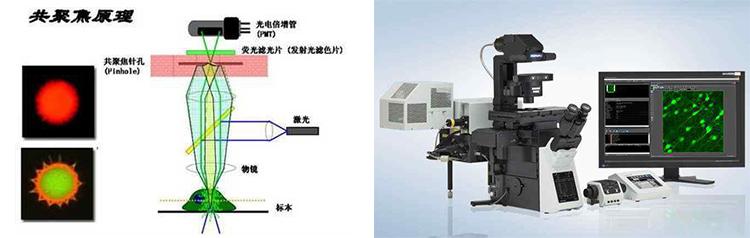




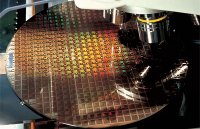




評論