電子發(fā)燒友網(wǎng)綜合報(bào)道,NEO Semiconductor宣布推出全球首款用于AI芯片的超高帶寬內(nèi)存 (X-HBM) 架構(gòu)。該架構(gòu)旨在滿足生成式AI和高性能計(jì)算日益增長(zhǎng)的需求,其32Kbit數(shù)據(jù)總線和單芯片高達(dá)512 Gbit的容量,帶寬提升16倍,密度提升10倍,顯著突破了傳統(tǒng)HBM的局限性。

關(guān)鍵特性和優(yōu)勢(shì)包括,可擴(kuò)展性,使GPU和內(nèi)存之間的數(shù)據(jù)傳輸更快,從而實(shí)現(xiàn)更高效的AI擴(kuò)展;高性能,解鎖未開發(fā)的GPU能力以提升AI工作負(fù)載;可持續(xù)性,通過整合AI基礎(chǔ)設(shè)施減少電力和硬件需求。
X-HBM 的兩大技術(shù)基礎(chǔ)是超高密度 I/O 通道和X-DRAM高容量 3D 內(nèi)存。該企業(yè)宣稱可通過 0.5μm(500nm)間距超精細(xì)混合鍵合在 HBM 所需 DRAM Die 上創(chuàng)造 32000-bit 超寬 I/O,而目前即將進(jìn)入商業(yè)化的 HBM4 內(nèi)存也僅有 2048-bit。
而在容量方面,NEO Semiconductor 稱其現(xiàn)有技術(shù)可通過 300 層堆疊技術(shù)在單層 DRAM Die 上實(shí)現(xiàn) 300Gb 容量,這已經(jīng)是當(dāng)下 HBM 領(lǐng)域所用 24Gb Die 的 12.5 倍。而未來 X-HBM 中的單 Die 將可實(shí)現(xiàn) 500+ 層陣列堆疊,單 Die 容量隨之提升到 512Gb (64GB)。
基于NEO的專有3D X-DRAM架構(gòu),X-HBM在內(nèi)存技術(shù)上實(shí)現(xiàn)了重大突破,消除了在帶寬和密度方面長(zhǎng)期存在的限制。相比之下,仍處于開發(fā)階段、預(yù)計(jì)于2030年左右面世的HBM5,預(yù)計(jì)僅能支持4K位數(shù)據(jù)總線和每芯片40 Gbit。
韓國(guó)高等科技學(xué)院(KAIST)最近的一項(xiàng)研究預(yù)測(cè),即便是預(yù)計(jì)于2040年左右問世的HBM8,也僅能提供16K位總線和每芯片80Gbit。相比之下,X-HBM則提供32K位總線和每芯片512 Gbit,使得AI芯片設(shè)計(jì)師能夠繞開與傳統(tǒng)的HBM技術(shù)相關(guān)的整整十年的漸進(jìn)式性能瓶頸。
NEO半導(dǎo)體研發(fā)的3D DRAM與水平放置存儲(chǔ)單元的傳統(tǒng)DRAM不同,3D DRAM垂直堆疊存儲(chǔ)單元大大增加單位面積的存儲(chǔ)容量并提高效率,成為下一代DRAM關(guān)鍵發(fā)展方向。
NEO表示,動(dòng)態(tài)隨機(jī)存取存儲(chǔ)器(DRAM)用于支持處理器,使DRAM在電子設(shè)備中的使用更加普遍。然而,處理器速度的增長(zhǎng)速度比多代內(nèi)存速度更快,由此產(chǎn)生的“性能差距”逐年擴(kuò)大。像云數(shù)據(jù)中心這樣的功耗敏感環(huán)境越來越依賴更高功率的處理器來滿足性能要求,但這會(huì)減少可用于內(nèi)存的功率。
采用X-DRAM架構(gòu)可以降低功耗,降低延遲,并增加吞吐量,以克服使用傳統(tǒng)DRAM時(shí)遇到的這些和其他挑戰(zhàn)。這為商業(yè)系統(tǒng)(例如服務(wù)器)提供了更高的性能,為移動(dòng)設(shè)備(例如智能手機(jī))提供了更長(zhǎng)的電池壽命,為邊緣計(jì)算設(shè)備(例如路由器)提供了更多的功能,并為物聯(lián)網(wǎng)對(duì)象(例如網(wǎng)關(guān))提供了新的部署選項(xiàng)。
3D X-DRAM的單元陣列結(jié)構(gòu)類似于3D NAND Flash,采用了FBC(無電容器浮體單元)技術(shù),它可以通過添加層掩模形成垂直結(jié)構(gòu),從而實(shí)現(xiàn)高良率、低成本和顯著的密度提升。NEO表示, 3D X-DRAM 技術(shù)可以生產(chǎn)230層的128Gbit DRAM 芯片,是當(dāng)前 DRAM 密度的八倍。
-
DRAM
+關(guān)注
關(guān)注
40文章
2375瀏覽量
188412 -
存儲(chǔ)
+關(guān)注
關(guān)注
13文章
4716瀏覽量
89671 -
HBM
+關(guān)注
關(guān)注
2文章
428瀏覽量
15740
發(fā)布評(píng)論請(qǐng)先 登錄
JEDEC制定全新內(nèi)存標(biāo)準(zhǔn),將取代HBM?
AI大算力的存儲(chǔ)技術(shù), HBM 4E轉(zhuǎn)向定制化

美光確認(rèn)HBM4將在2026年Q2量產(chǎn)
HBM技術(shù)在CowoS封裝中的應(yīng)用
全球首款HBM4量產(chǎn):2.5TB/s帶寬超越JEDEC標(biāo)準(zhǔn),AI存儲(chǔ)邁入新紀(jì)元
突破堆疊瓶頸:三星電子擬于16層HBM導(dǎo)入混合鍵合技術(shù)

Cadence推出HBM4 12.8Gbps IP內(nèi)存系統(tǒng)解決方案
HBM技術(shù)的優(yōu)勢(shì)和應(yīng)用場(chǎng)景

HBM新技術(shù),橫空出世:引領(lǐng)內(nèi)存芯片創(chuàng)新的新篇章
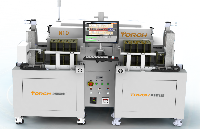
不再是HBM,AI推理流行,HBF存儲(chǔ)的機(jī)會(huì)來了?






 性能優(yōu)于HBM,超高帶寬內(nèi)存 (X-HBM) 架構(gòu)來了!
性能優(yōu)于HBM,超高帶寬內(nèi)存 (X-HBM) 架構(gòu)來了!











評(píng)論