文章來(lái)源:半導(dǎo)體全解
原文作者:圓圓De圓
本文主要講述什么是2.5D及3D封裝轉(zhuǎn)接板。
一、為什么需要2.5D及3D封裝
摩爾定律精準(zhǔn)預(yù)言了近幾十年集成電路的發(fā)展。然而,逐漸逼近的物理極限、更高的性能需求和不再經(jīng)濟(jì)的工藝制程,已引發(fā)整個(gè)半導(dǎo)體行業(yè)重新考慮集成工藝方法和系統(tǒng)縮放策略,意味著集成電路產(chǎn)業(yè)已經(jīng)步入后摩爾時(shí)代。
超越摩爾通過(guò)三維堆疊來(lái)實(shí)現(xiàn)多個(gè)芯片在平面和垂直方向的互連,用系統(tǒng)集成的策略來(lái)大幅度提升空間利用率。垂直互連技術(shù)從縱向維度進(jìn)一步擴(kuò)展,促進(jìn)了系統(tǒng)級(jí)集成的不斷進(jìn)步。轉(zhuǎn)接板形式的通孔技術(shù)是最有前景的互連方案之一,已成為全球先進(jìn)封裝的研究熱點(diǎn)。
二、2.5D及3D封裝的結(jié)構(gòu)組成
2.5D/3D先進(jìn)封裝技術(shù)是芯片系統(tǒng)關(guān)于延續(xù)摩爾定律的有效解決方案之一,該技術(shù)主要目的是通過(guò)在垂直方向上堆疊芯片以實(shí)現(xiàn)更高密度的集成。
其中,3D封裝技術(shù)與2.5D封裝技術(shù)的差別主要在于3D封裝技術(shù)是通過(guò)硅通孔(ThroughSiliconVia, TSV)或玻璃通孔(ThroughGlassVia, TGV)把所有芯片都垂直連接,而2.5D封裝技術(shù)指的是將多個(gè)芯片平鋪在中介層上,中介層上有再布線層,用于芯片間的水平互連,而中介層再通過(guò)通孔把芯片與封裝基板相連,進(jìn)而實(shí)現(xiàn)多個(gè)芯片的垂直互連,這種將多種不同材質(zhì)、尺寸、功能封裝到一個(gè)系統(tǒng)內(nèi)的技術(shù)也被稱作三維異質(zhì)集成技術(shù),其中實(shí)現(xiàn)中介層互連功能的關(guān)鍵工藝則是相應(yīng)的通孔制備及孔金屬化。
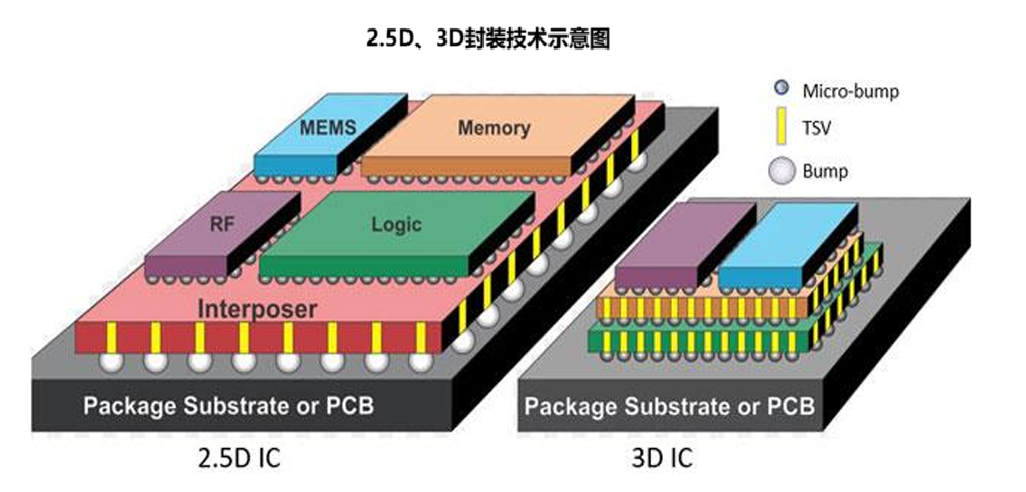
三、轉(zhuǎn)接板(中介層)的典型結(jié)構(gòu)
轉(zhuǎn)接板(中介層)主要包括基底和RDL。其上層RDL通過(guò)微凸塊與搭載的有源芯片相連,這些有源芯片可以是普通的二維芯片,也可以是三維的芯片堆疊。其下層RDL(或者是焊盤(pán))通過(guò)普通的凸塊或者焊球與封裝基底相連,實(shí)現(xiàn)轉(zhuǎn)接板與封裝管殼的電氣連接。轉(zhuǎn)接板的典型結(jié)構(gòu)如圖所示。
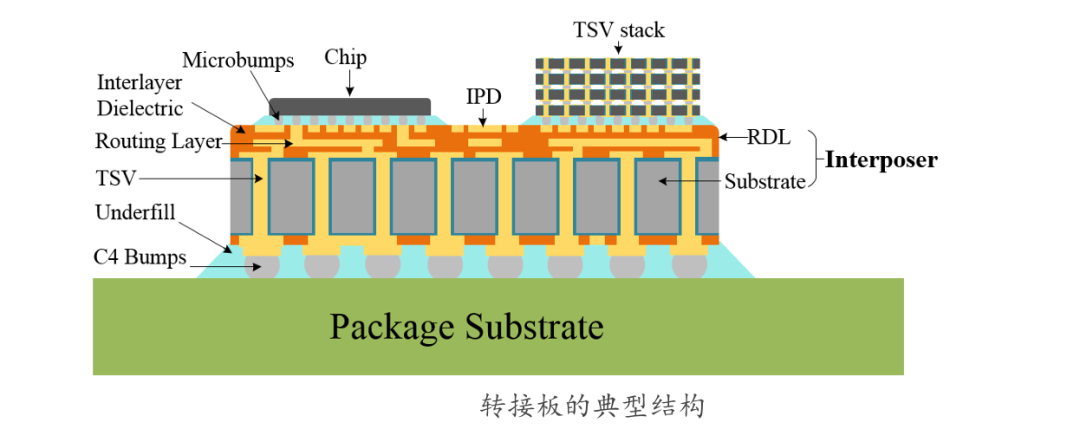
轉(zhuǎn)接板基板可以是硅、玻璃或者有機(jī)高分子材料,上面有貫穿基板的通孔,實(shí)現(xiàn)轉(zhuǎn)接板正面和背面的電氣連接。轉(zhuǎn)接板上的TSV采用導(dǎo)電材料填充,外側(cè)包覆有絕緣層,對(duì)TSV和基底進(jìn)行隔離。
TSV填充的導(dǎo)電材料通常是銅,也可以是鎢、多晶硅等。填充的方式有完全填充和不完全填充兩種。
轉(zhuǎn)接板的RDL包括金屬布線和絕緣介質(zhì)層,用來(lái)實(shí)現(xiàn)搭載的芯片與芯片之間、芯片與TSV之間的互連。金屬布線通常是通過(guò)電鍍銅來(lái)制備,而介質(zhì)層可以是無(wú)機(jī)介質(zhì)如SiO2、Si3N4等,也可以是有機(jī)聚合物如聚酰亞胺(PI,Polyimide)、苯并環(huán)丁烯(Benzocyclobutene,BCB)等。
在RDL層中,除了互連線以外,也可集成一些無(wú)源器件,包括電容、電感、電阻等。這些集成無(wú)源器件(IPD,Integrated Passive Device)可組成多種功能電路,起到如去耦合、濾波、抑制開(kāi)關(guān)噪聲等作用。
將IPD集成到轉(zhuǎn)接板中,不僅可以減小總體電路的體積,提升系統(tǒng)的集成度,也可以使轉(zhuǎn)接板的功能更豐富,適用面更廣。
目前絕大多數(shù)轉(zhuǎn)接板是無(wú)源的,即上面集成的只有布線和無(wú)源器件,也有少數(shù)研究機(jī)構(gòu)在轉(zhuǎn)接板上制備了CMOS晶體管來(lái)實(shí)現(xiàn)一些簡(jiǎn)單功能,這種轉(zhuǎn)接板被稱為有源轉(zhuǎn)接板(active interposer)。
比如法國(guó)的半導(dǎo)體研究機(jī)構(gòu)Leti在16年提出了一種2.5D封裝的片上網(wǎng)絡(luò)系統(tǒng)(NoC,Network on Chip),在有源硅轉(zhuǎn)接板上排布了6個(gè)通信芯片形成通信網(wǎng)絡(luò)系統(tǒng),如圖所示。轉(zhuǎn)接板本身也制備了CMOS結(jié)構(gòu),集成了一些簡(jiǎn)單的功能,包括功率變換和測(cè)試電路等。
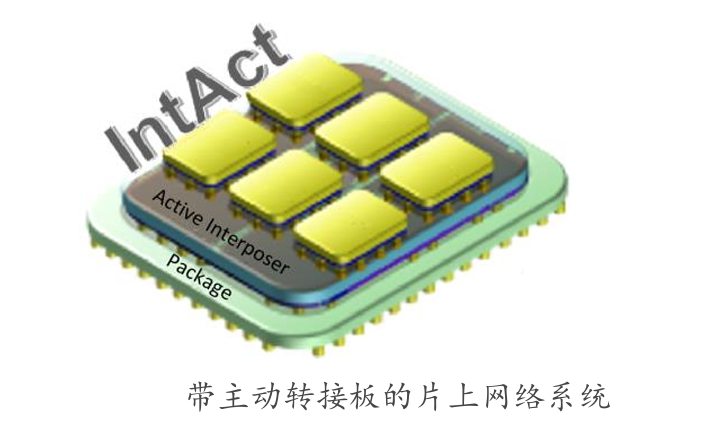
有源轉(zhuǎn)接板的好處在于,可以將承載芯片的一些簡(jiǎn)單功能轉(zhuǎn)移到轉(zhuǎn)接板上,或者在轉(zhuǎn)接板上配合相對(duì)應(yīng)的承載芯片增加一些新的功能,這樣,不僅可以充分利用轉(zhuǎn)接板上的空間,提高集成度,還能增加系統(tǒng)功能或者提升系統(tǒng)性能。有源轉(zhuǎn)接板的局限在于,在轉(zhuǎn)接板上制備CMOS結(jié)構(gòu),相當(dāng)于制備有源TSV芯片,工藝流程比無(wú)源轉(zhuǎn)接板復(fù)雜的多,成本也高;其集成結(jié)構(gòu)類似3D TSV封裝,也會(huì)面臨著3D TSV封裝類似的問(wèn)題。
四、轉(zhuǎn)接板的分類
按照轉(zhuǎn)接板基底材料的不同,轉(zhuǎn)接板可分為硅轉(zhuǎn)接板(silicon interposer)、玻璃轉(zhuǎn)接板(glass interposer)和有機(jī)轉(zhuǎn)接板(organic interposer)。
1、硅轉(zhuǎn)接板
硅轉(zhuǎn)接板是當(dāng)前最主流、最成熟的轉(zhuǎn)接板技術(shù),研究的最多,應(yīng)用也最廣泛。硅轉(zhuǎn)接板的迅速發(fā)展主要得益于成熟的硅加工工藝和布線工藝,使得硅轉(zhuǎn)接板可與集成電路工藝完美兼容。
硅轉(zhuǎn)接板上TSV孔徑可做到10 μm以下,深寬比達(dá)到20以上,而RDL線寬可以達(dá)到1μm以下。另外,硅轉(zhuǎn)接板還具有熱導(dǎo)率高、與搭載的芯片CTE匹配等優(yōu)點(diǎn)。
硅轉(zhuǎn)接板的最大不足之處在于其制作成本昂貴,目前只在少數(shù)高端產(chǎn)品中實(shí)現(xiàn)量產(chǎn)。目前,硅轉(zhuǎn)接板也面臨著一些工藝上的難題,比如TSV的絕緣、薄晶圓持拿等。另外,由于硅并非絕緣體,且介電常數(shù)較大(11.2),作為基底時(shí)會(huì)造成較大的損耗,尤其在高頻環(huán)境下會(huì)導(dǎo)致電路傳輸特性的下降。
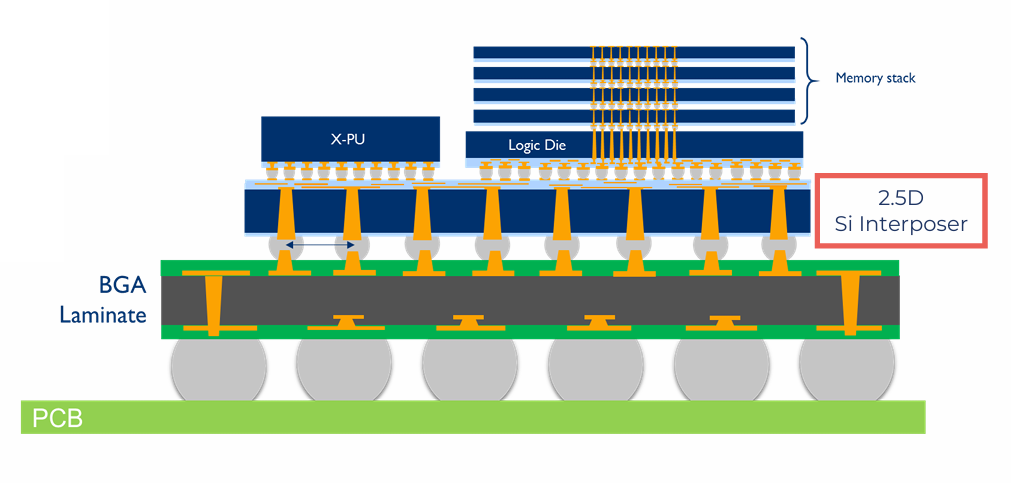
2、玻璃轉(zhuǎn)接板
玻璃轉(zhuǎn)接板和硅轉(zhuǎn)接板結(jié)構(gòu)類似,通過(guò)玻璃通孔(TGV,Through Glass Via)實(shí)現(xiàn)上下面的垂直互連。
玻璃轉(zhuǎn)接板的優(yōu)勢(shì)主要有以下兩點(diǎn):
1)玻璃轉(zhuǎn)接板的電學(xué)性能表現(xiàn)優(yōu)異,絕緣性好,具有較低的介電常數(shù)(5.3)及損耗角正切值(0.006);
2)玻璃轉(zhuǎn)接板不需要制備絕緣隔離層,使得制備工藝大大簡(jiǎn)化,具有較低的成本。
此外,玻璃轉(zhuǎn)接板與裸片也有較好的CTE匹配,且不會(huì)存在像TSV漏電這樣的絕緣缺陷。
而制約玻璃轉(zhuǎn)接板發(fā)展的主要因素是玻璃加工及相關(guān)配套工藝的不成熟。
例如,TGV打孔工藝,目前只能通過(guò)激光刻蝕、噴砂、微機(jī)械加工等實(shí)現(xiàn),存在加工效率低、精度低等缺點(diǎn),孔徑通常在幾十微米以上,深寬比在10以下。同時(shí),在玻璃上進(jìn)行細(xì)密布線比較困難,無(wú)法達(dá)到硅轉(zhuǎn)接板的集成密度。
另外,由于玻璃比較脆,會(huì)導(dǎo)致加工的良率降低。除了加工工藝不成熟外,散熱問(wèn)題對(duì)于熱導(dǎo)率低的玻璃轉(zhuǎn)接板來(lái)說(shuō)也是不小的挑戰(zhàn)。相對(duì)于硅轉(zhuǎn)接板和有機(jī)轉(zhuǎn)接板,玻璃轉(zhuǎn)接板最具潛在優(yōu)勢(shì)的應(yīng)用是在高頻領(lǐng)域。
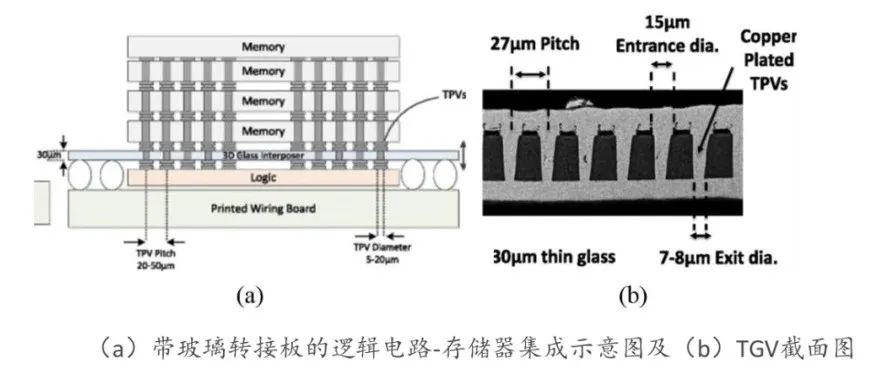
韓國(guó)科學(xué)技術(shù)院的Sumin Choi等人對(duì)硅轉(zhuǎn)接板、玻璃轉(zhuǎn)接板和有機(jī)轉(zhuǎn)接板的信號(hào)傳輸特性進(jìn)行了對(duì)比分析,仿真結(jié)果表明,在10GHz的應(yīng)用頻率下,玻璃轉(zhuǎn)接板具有最好的傳輸特性。
對(duì)于高帶寬、高傳輸速率的系統(tǒng)來(lái)說(shuō),玻璃轉(zhuǎn)接板是三種轉(zhuǎn)接板當(dāng)中的最佳選擇(如果其布線密度能滿足需求)。隨著高頻應(yīng)用尤其是5G通信的興起,玻璃轉(zhuǎn)接板在射頻領(lǐng)域越來(lái)越受業(yè)內(nèi)人士的青睞。
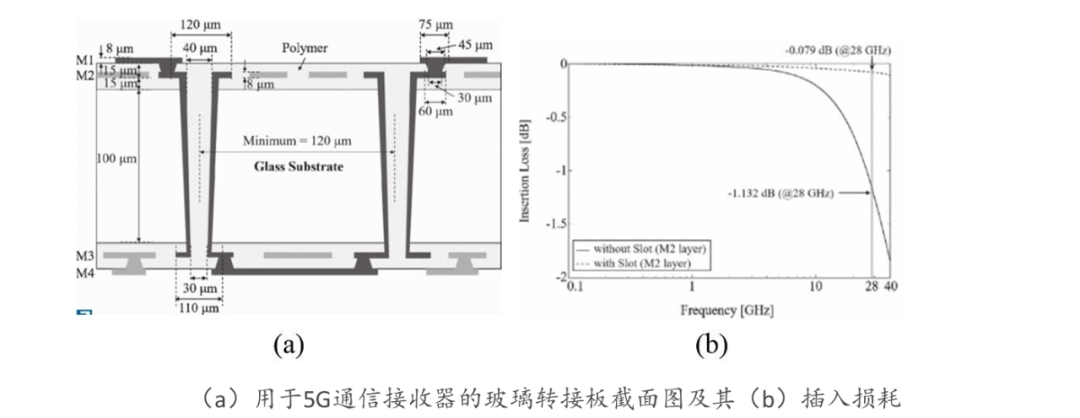
3、有機(jī)轉(zhuǎn)接板
有機(jī)轉(zhuǎn)接板的最大優(yōu)勢(shì)在于其成本低。
有機(jī)轉(zhuǎn)接板以有機(jī)高分子材料加增強(qiáng)相材料作為中間芯層(core),使用圖形化疊加工藝制作金屬布線,使用電鍍過(guò)孔(PTH,Plated Through Hole)實(shí)現(xiàn)上下的垂直互連。
這套工藝與倒裝焊封裝基底制備工藝類似,目前比較成熟,批量制造的成本也很低。
有機(jī)轉(zhuǎn)接板的缺點(diǎn)也非常明顯,首先,有機(jī)高分子材料熱膨脹系數(shù)比較大,有機(jī)轉(zhuǎn)接板與組件的CTE失配比較嚴(yán)重,容易引起熱應(yīng)力可靠性問(wèn)題,比如轉(zhuǎn)接板的翹曲、介質(zhì)材料斷裂等。
其次,有機(jī)轉(zhuǎn)接板的熱導(dǎo)率很低,不利于高密度集成的散熱。最后,受限于有機(jī)轉(zhuǎn)接板加工工藝的精度,其線寬和PTH的大小都無(wú)法與硅轉(zhuǎn)接板相媲美,嚴(yán)重阻礙了有機(jī)轉(zhuǎn)接板在高集成度、高I/O方面的應(yīng)用。
在集成密度要求不高和散熱問(wèn)題不嚴(yán)重時(shí),有機(jī)轉(zhuǎn)接板是硅轉(zhuǎn)接板的低成本替代方案之一。2016年,Cisco公司的Li Li等人提出了一種用于高性能交換機(jī)的3D SiP封裝,這是有機(jī)轉(zhuǎn)接板的典型應(yīng)用案例之一。
受光刻工藝的制約,目前主流半導(dǎo)體制造公司生產(chǎn)的硅轉(zhuǎn)接板的尺寸都限制26 mm×32 mm以內(nèi)。為了突破該尺寸限制并降低制造成本,Cisco公司選擇了有機(jī)轉(zhuǎn)接作為SiP集成方案。如圖所示,有機(jī)轉(zhuǎn)接板的尺寸為38 mm×30 mm×0.4 mm,其上集成了一個(gè)ASIC芯片和4個(gè)高帶寬存儲(chǔ)器(HBM,High Bandwidth Memory)。線寬為6μm,PTH直徑為57μm,高度為200μm。頻域仿真分析表明,在20 GHz以下時(shí),該SiP集成具有良好的性能,滿足使用的需求。作為有機(jī)轉(zhuǎn)接板,也有其局限性。由于布線密度不夠,為了實(shí)現(xiàn)互連的要求,該有機(jī)轉(zhuǎn)接板的布線層多達(dá)10層,大大增加了轉(zhuǎn)接板的厚度,造成了可靠性隱患。另外,該有機(jī)轉(zhuǎn)接板的翹曲高達(dá)100μm左右。
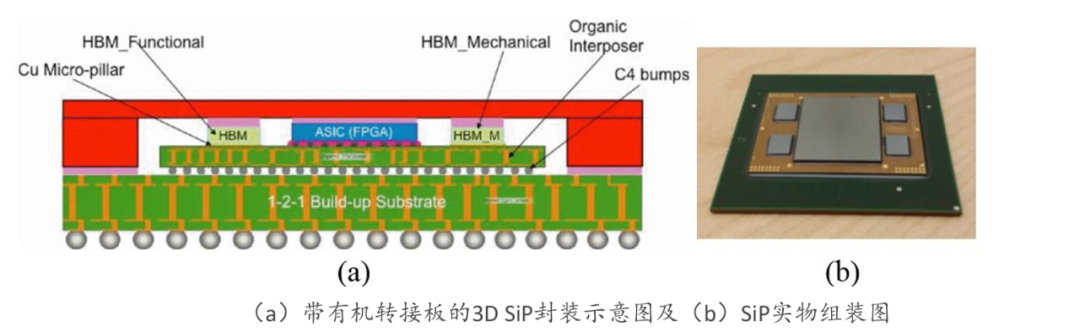
五、轉(zhuǎn)接板的應(yīng)用
為了降低轉(zhuǎn)接板集成的成本,提高轉(zhuǎn)接板性能,很多企業(yè)和研究機(jī)構(gòu)對(duì)此進(jìn)行了大量的研究。 在降低制造成本方面,早在1992年,IBM公司就提出了一種轉(zhuǎn)接板的制造方法,先在基板兩側(cè)布線,然后在基板上打通孔,在通孔內(nèi)濺射一層導(dǎo)電金屬,再通過(guò)絲網(wǎng)印刷的方法,將一種含有金和銀微顆粒的熱塑性導(dǎo)電聚合物填充通孔。
這種聚合物導(dǎo)電膠不僅用來(lái)填充通孔,還起著類似焊球的作用,用來(lái)連接上下多層轉(zhuǎn)接板或者芯片,該方法用低成本、耗時(shí)短的聚合物導(dǎo)電膠填充來(lái)代替高成本、耗時(shí)長(zhǎng)的TSV銅電鍍,可以降低轉(zhuǎn)接板成本,縮短轉(zhuǎn)接板開(kāi)發(fā)周期,但這種方法存在通孔填充不完全的問(wèn)題,通孔中的孔隙會(huì)導(dǎo)致可靠性方面的隱患。
2012年,佐治亞理工學(xué)院3D封裝研究中心的Sundaram等人提出了一種低成本、低電損耗的轉(zhuǎn)接板,用于邏輯-存儲(chǔ)芯片的集成,如下圖所示。
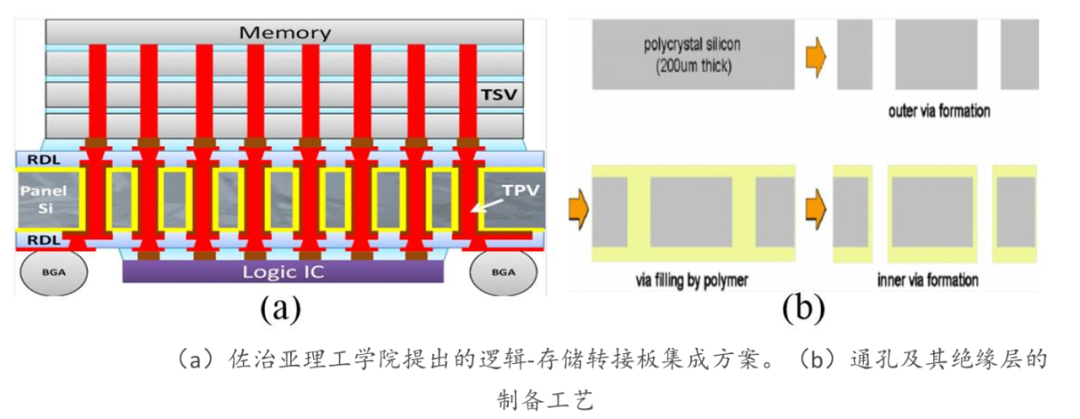
該轉(zhuǎn)接板采用多晶硅為基底,制備工藝如下:先使用激光在基底上燒蝕通孔,再使用熱壓工藝在通孔內(nèi)填充聚合物,在通孔的聚合物內(nèi)再打出孔,使用化學(xué)鍍或者電鍍來(lái)填充銅,最后再在雙面制備RDL。
由于轉(zhuǎn)接板上層及孔內(nèi)覆蓋有厚的聚合物,比起采用薄SiO2做絕緣的常規(guī)轉(zhuǎn)接板來(lái)說(shuō),損耗要低很多。
該轉(zhuǎn)接板的低成本主要來(lái)自三方面,一是低成本材料及工藝的運(yùn)用。大面積多晶硅薄片的成本大大低于單晶硅。多晶硅上用激光燒蝕的方法即可獲得小孔徑的通孔,比起單晶硅用深反應(yīng)離子刻蝕(DRIE,Deep Reactive Ion Etching)要簡(jiǎn)單快捷。
二是工藝步驟的簡(jiǎn)化。采用薄晶圓打通孔再涂覆聚合物絕緣層的方法,避免了轉(zhuǎn)接板的背面減薄和背面制備絕緣層的工藝。
三是便于批量化生產(chǎn)。超大面積的多晶硅面板使得每個(gè)面板上的轉(zhuǎn)接板數(shù)量大大增加,降低了單個(gè)轉(zhuǎn)接板的成本。
2017年,韓國(guó)電子技術(shù)研究院的Lee等人提出了一種低成本、低TSV插入損耗的新型TSV轉(zhuǎn)接板,應(yīng)用于高頻RF器件當(dāng)中。該轉(zhuǎn)接板使用了特殊的硅核心同軸通孔(S-COV,Silicon-Core Coaxial Via)替代傳統(tǒng)TSV,其結(jié)構(gòu)如圖(a)所示,通孔內(nèi)部有一個(gè)硅軸心,硅軸心外層和孔側(cè)壁層都包覆著一層金屬銅,分別作為信號(hào)通道和接地通道,在孔側(cè)壁與硅軸心之間填充有機(jī)聚合物,其制備工藝如圖(b)所示。
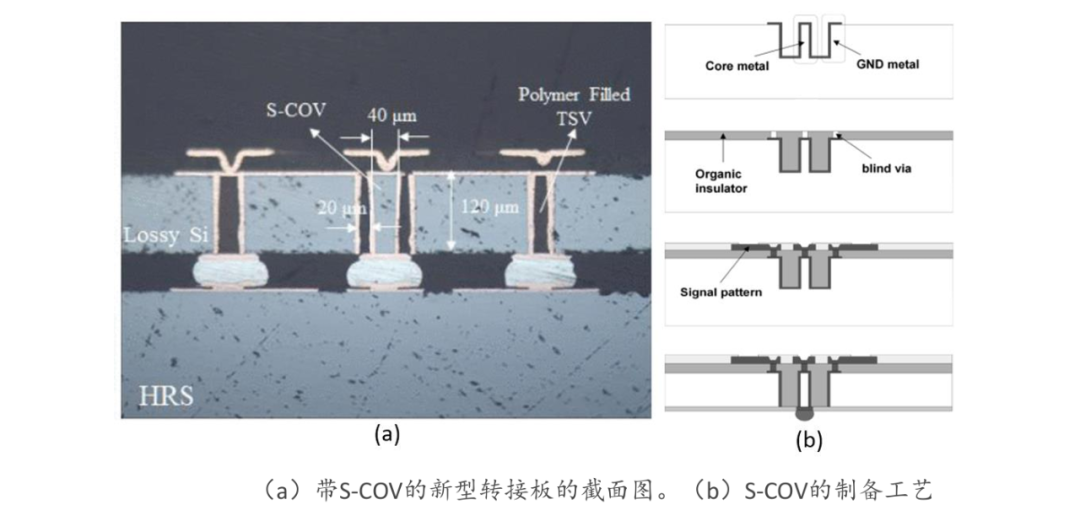
得益于厚的有機(jī)聚合物隔離層以及信號(hào)-接地的同軸結(jié)構(gòu),這種通孔的插入損耗要優(yōu)于傳統(tǒng)TSV。而且,該通孔不需要進(jìn)行完全銅填充的電鍍,只需要有銅導(dǎo)電層,節(jié)省了電鍍時(shí)間和成本。
硅轉(zhuǎn)接板集成技術(shù)兼容性好、可靠性高、設(shè)計(jì)靈活性強(qiáng),是目前先進(jìn)封裝技術(shù)中比較切實(shí)可行的方案之一,在工業(yè)界內(nèi)得到了大量的應(yīng)用。
這些應(yīng)用中既有同質(zhì)芯片集成以擴(kuò)充芯片容量/運(yùn)算能力,也有異質(zhì)芯片集成以形成SiP。
在硅轉(zhuǎn)接板的發(fā)展歷程中,第一個(gè)引人矚目的商業(yè)產(chǎn)品當(dāng)屬Xilinx公司2011年公布的FPGA芯片Virtex-7 2000T,如圖所示。
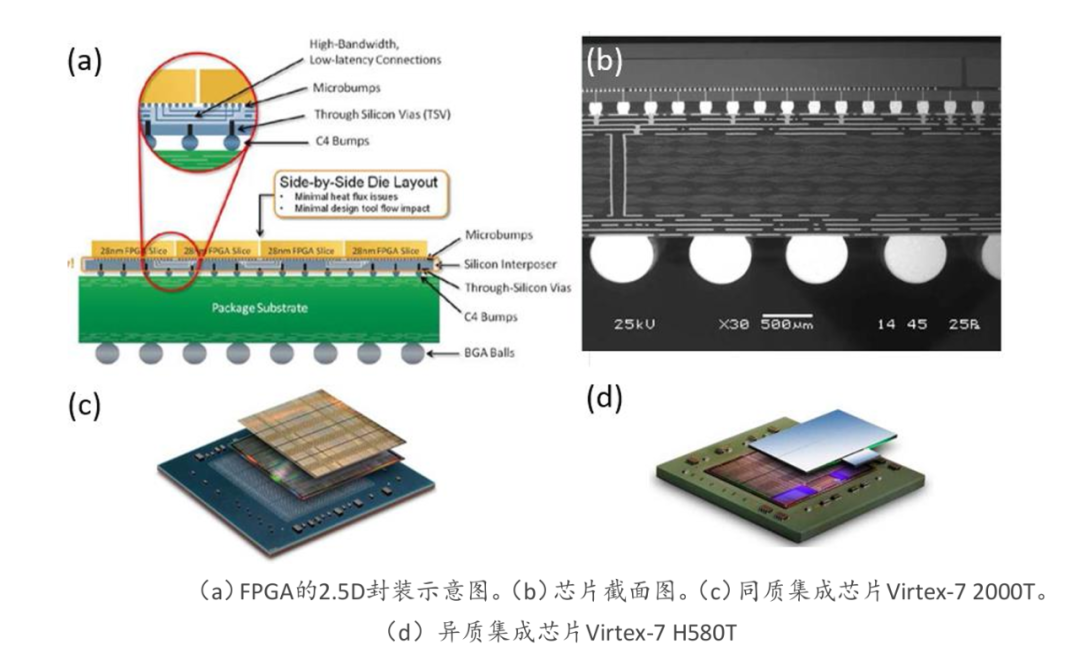
該FPGA芯片采用臺(tái)積電的CoWoS(Chip-on-Wafer-on-Substrate)28nm工藝,將4個(gè)FPGA裸片(die)排布在25 mm×31 mm大小的硅轉(zhuǎn)接板上,使得單片F(xiàn)PGA上邏輯單元的數(shù)量達(dá)到了200萬(wàn)個(gè),是非三維集成單片F(xiàn)PGA容量的2.8倍。
2012年,Xilinx公司又推出了一款FPGA產(chǎn)品Virtex-7 H580T,在硅轉(zhuǎn)接板上集成了2個(gè)FPGA裸片和一個(gè)收發(fā)器裸片,實(shí)現(xiàn)了轉(zhuǎn)接板上異質(zhì)芯片的集成。
高端顯卡也是硅轉(zhuǎn)接板應(yīng)用的一個(gè)主要領(lǐng)域。為了增強(qiáng)顯卡的性能、降低功耗,AMD公司于2015年發(fā)布了一款采用硅轉(zhuǎn)接板集成的顯卡Radeon R9 Fury X(Fiji),將顯卡核心(GPU/CPU/SoC)與顯存以及邏輯芯片集成在一個(gè)封裝中,如圖所示。
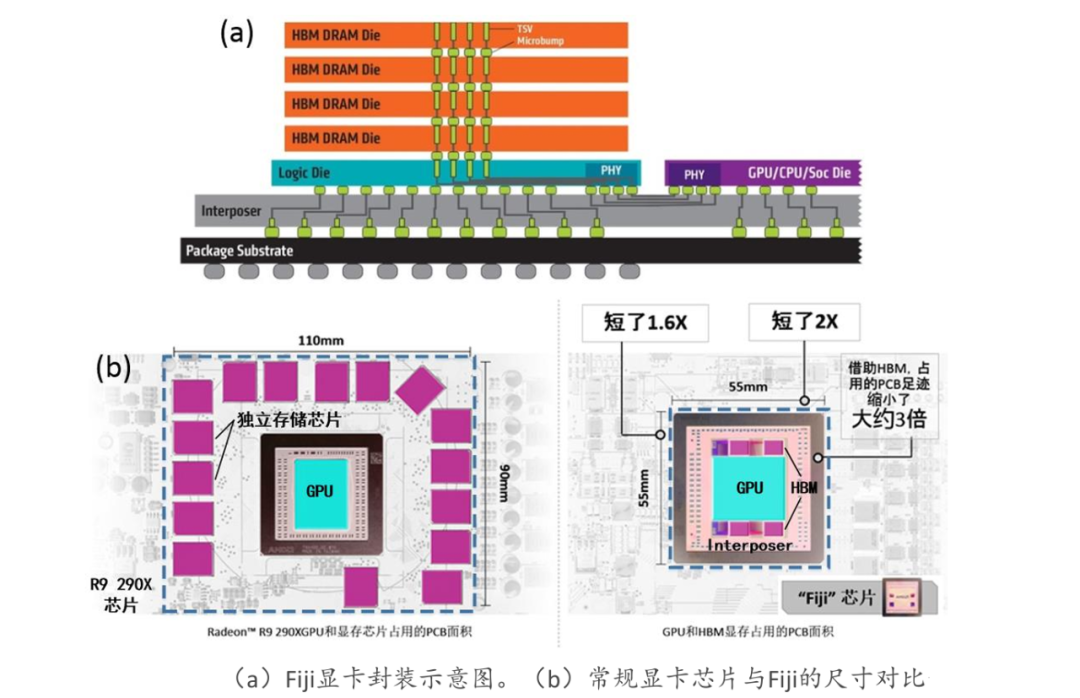
比起上一代非三維封裝顯卡Radeon R9 290X,該三維封裝顯卡的帶寬增加了60%,每瓦性能提高了兩倍多,芯片大小也縮減到原來(lái)的1/3以下。之后,ADM和NVIDIA公司又相繼推出了多款基于硅轉(zhuǎn)接板封裝的顯卡產(chǎn)品,比如NVIDIA于2016年推出的Tesla P100及AMD于2017年推出的Radeon Vega。這兩款顯卡產(chǎn)品比起Fiji來(lái)說(shuō),線寬更小,集成度更高,性能也有了進(jìn)一步的提升。
六 、硅轉(zhuǎn)接板技術(shù)面臨的挑戰(zhàn)
盡管硅轉(zhuǎn)接板技術(shù)擁有諸多優(yōu)勢(shì),擁有非常好的應(yīng)用前景,但目前仍面臨著一些產(chǎn)業(yè)和技術(shù)方面的挑戰(zhàn),制約著硅轉(zhuǎn)接板技術(shù)的應(yīng)用和進(jìn)一步發(fā)展。
(1)最主要的制約因素是工藝成本高。
首先,轉(zhuǎn)接板制造包括TSV電鍍、多余銅去除、減薄、臨時(shí)鍵合/解鍵合等一系列工藝,流程復(fù)雜,不僅工藝成本高,流片周期也長(zhǎng)。
其次,由于整個(gè)工藝步驟多,且不完全成熟,因此良率不高,這也導(dǎo)致硅轉(zhuǎn)接板的制造成本進(jìn)一步增加。
(2)硅轉(zhuǎn)接板制備工藝本身還不成熟,面臨一些技術(shù)方面的挑戰(zhàn)。
比如,轉(zhuǎn)接板的光刻(包括大尺寸的限制、TSV背面對(duì)準(zhǔn)以及翹曲對(duì)光刻精度的影響等)、晶圓減薄和持拿、TSV無(wú)孔隙電鍍等關(guān)鍵工藝還有待改進(jìn)。
另外,TSV漏電流、轉(zhuǎn)接板翹曲以及熱應(yīng)力等問(wèn)題也有待進(jìn)一步解決。
(3)TSV堆疊的方式突破了傳統(tǒng)芯片的二維結(jié)構(gòu),而與之相適應(yīng)的設(shè)計(jì)軟件及測(cè)試方法還很缺乏。
(4)產(chǎn)業(yè)環(huán)境還不完全成熟。
目前芯片設(shè)計(jì)、制造和封測(cè)各自分離的格局不利于轉(zhuǎn)接板集成技術(shù)的發(fā)展,還需要產(chǎn)業(yè)鏈的整合。此外,業(yè)內(nèi)對(duì)轉(zhuǎn)接板技術(shù)也未統(tǒng)一標(biāo)準(zhǔn)。
-
集成電路
+關(guān)注
關(guān)注
5452文章
12571瀏覽量
374517 -
3D封裝
+關(guān)注
關(guān)注
9文章
149瀏覽量
28307 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
533瀏覽量
1026
原文標(biāo)題:一文了解2.5D及3D封裝轉(zhuǎn)接板(RDL)研發(fā)技術(shù)
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
典型先進(jìn)封裝選型和設(shè)計(jì)要點(diǎn)
晶圓級(jí)封裝(WLP)及采用TSV的硅轉(zhuǎn)接板商機(jī)無(wú)限

微電網(wǎng)分類及其結(jié)構(gòu)特性分析與設(shè)計(jì)

51轉(zhuǎn)avr轉(zhuǎn)接板原理圖及使用說(shuō)明

DIY ATX電源轉(zhuǎn)接板

先進(jìn)封裝(Advanced Package)
什么是先進(jìn)封裝?先進(jìn)封裝和傳統(tǒng)封裝區(qū)別 先進(jìn)封裝工藝流程

什么是先進(jìn)封裝?和傳統(tǒng)封裝有什么區(qū)別?

甬矽電子“封裝結(jié)構(gòu)和封裝方法”專利獲授權(quán)
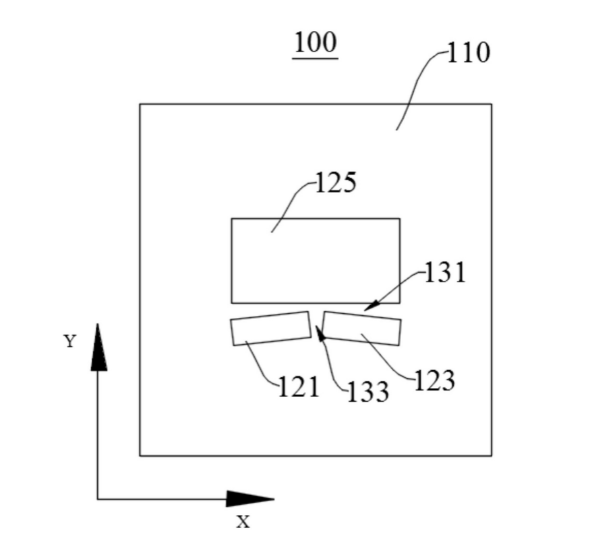
IC封裝產(chǎn)線分類詳解:金屬封裝、陶瓷封裝與先進(jìn)封裝




 先進(jìn)封裝轉(zhuǎn)接板的典型結(jié)構(gòu)和分類
先進(jìn)封裝轉(zhuǎn)接板的典型結(jié)構(gòu)和分類






評(píng)論