文章來源:半導體與物理
原文作者:jjfly686
本文主要講述半導體封裝的進化。
想象一下,你要為比沙粒還小的芯片建造“房屋”——既要保護其脆弱電路,又要連接外部世界,還要解決散熱、信號干擾等問題。這就是集成電路封裝(IC Packaging)的使命。從1950年代的金屬外殼到今日的3D堆疊,封裝技術已從簡單保護殼蛻變為決定芯片性能的核心環節。
封裝簡史:四階段技術革命
1. 1950-1970年代:直插式封裝時代
TO封裝:首款晶體管封裝,金屬外殼如“小禮帽”,三根引腳裸露在外,抗機械沖擊但笨重低效。
DIP封裝:1960年代雙列直插式封裝誕生,塑料取代金屬,引腳增至64根,成為早期CPU和存儲芯片的標準“住所”。
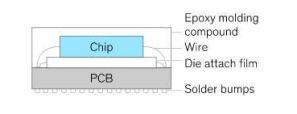
2. 1980年代:表面貼裝技術(SMT)革命
SOP/QFP:飛利浦開發的小外形封裝(SOP)和四邊扁平封裝(QFP),引腳細如發絲(間距0.4-1.27mm),可直接貼裝PCB,體積比DIP縮小70%。
核心突破:環氧樹脂模塑料(Epoxy Molding Compound)取代金屬外殼,實現高速自動化生產,成本大幅降低。
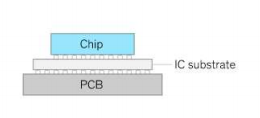
3. 1990年代:陣列封裝崛起
BGA封裝:球柵陣列封裝用焊球替代引腳,I/O數量突破1000+,散熱性能提升50%。英特爾奔騰處理器率先采用,引爆PC時代。
CSP封裝:芯片尺寸封裝(Chip Scale Package)實現“封裝不增大芯片面積”,內存條從此告別臃腫。
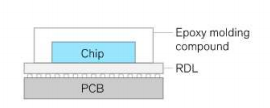
4. 21世紀:先進封裝(Advanced Packaging)紀元
技術目標:不再滿足于“保護”,而是通過封裝提升系統性能。
核心驅動力:摩爾定律放緩,晶體管微縮成本飆升,需通過封裝集成彌補算力缺口。
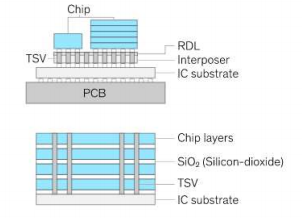 ? ? ?
? ? ?
先進封裝的核心技術
倒裝芯片(Flip Chip,1995年商用化)
原理:在芯片表面制作焊球(Solder Bumps),直接翻轉對接基板,取代金線鍵合。優勢:互聯距離縮短至微米級,電阻降低90%,蘋果A系列芯片、英偉達GPU全面采用。關鍵材料:高鉛焊料、無鉛焊料、銅柱凸塊。
晶圓級封裝(WLP,2000年普及)
工藝:直接在晶圓上完成布線(RDL層)、植球,切割后即成獨立芯片。
革命性意義:省去傳統封裝基板,厚度減薄80%,iPhone的RF芯片和傳感器依賴此技術。
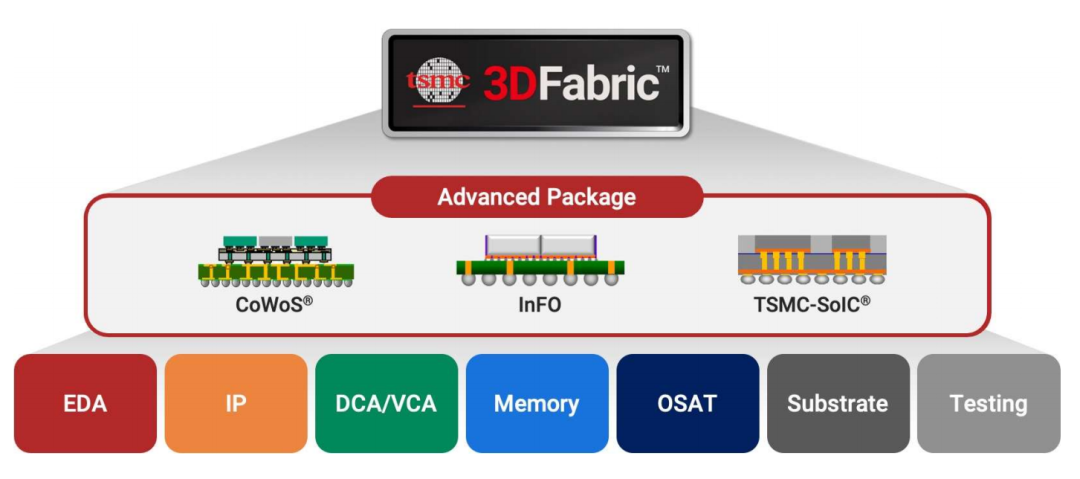
2.5D/3D堆疊(2010年后爆發)
| 技術 | 核心結構 | 應用場景 |
|---|---|---|
| 2.5D堆疊 | 硅中介層(Interposer)+TSV | 英偉達H100 GPU(CoWoS) |
| 3D堆疊 | 芯片直接堆疊+銅混合鍵合 | HBM3內存 |
TSV(硅通孔):在硅片上鉆孔填充銅,實現垂直導電,信號延遲降低至皮秒級。
-
集成電路
+關注
關注
5452文章
12571瀏覽量
374518 -
半導體
+關注
關注
339文章
30725瀏覽量
264026 -
封裝
+關注
關注
128文章
9248瀏覽量
148610
原文標題:從金屬殼到3D堆疊:半導體封裝的進化
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
buck電路原理圖講解 buck電路的演變過程

電機瞬變過程
數字式稱重傳感器的功能演變過程
【視頻分享】降壓電路的演變過程
定位技術的演變過程
升壓變換器二種結構的演變過程資料下載

半導體封裝的作用、工藝和演變
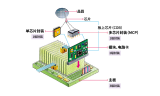
buck電路的演變過程

淺析can技術的演變過程




 半導體封裝技術的演變過程
半導體封裝技術的演變過程



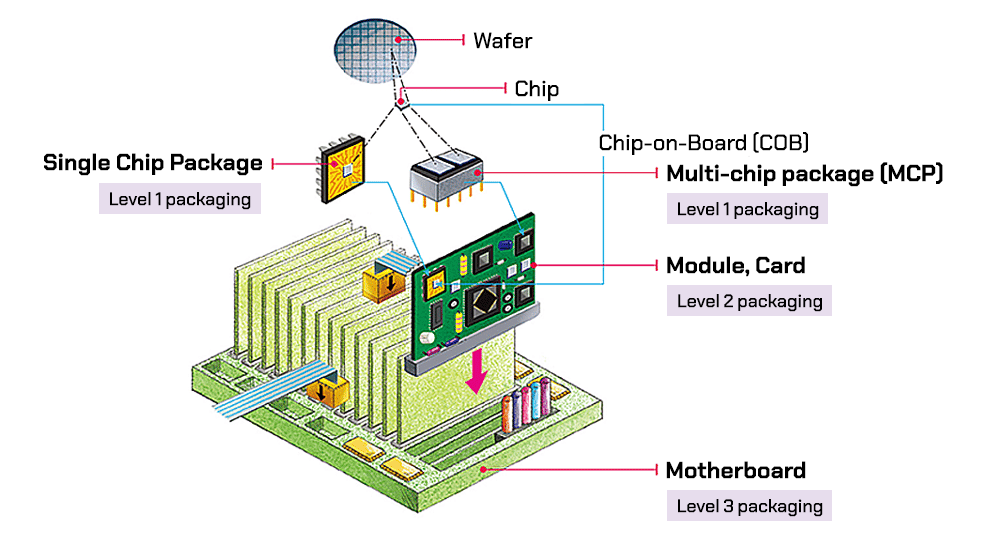



評論