技術(shù)原理
聚焦離子束顯微鏡(Focused Ion Beam, FIB)的核心在于其獨特的鎵(Ga)離子源。
鎵金屬因其較低的熔點(29.76°C)和在該溫度下極低的蒸氣壓(?10^-13 Torr),成為理想的離子源材料。在真空環(huán)境下,液態(tài)鎵沿著燈絲流動至針尖,在強外加電場作用下,針尖處的液態(tài)鎵被拉伸成曲率半徑極小的圓錐體(Taylor cone),鎵離子由此被游離并噴出,形成高度聚焦的鎵離子束。這種離子源尺寸極小(小于 10 nm),能量分散低(約 4.5 eV),亮度高(約 10^6 A/cm2.sr),使其成為納米結(jié)構(gòu)加工的利器,猶如一把精準的 “納米雕刻刀”。
系統(tǒng)構(gòu)成:多組件協(xié)同的精密平臺
聚焦離子束顯微鏡的系統(tǒng)由多個關(guān)鍵組件構(gòu)成。液態(tài)離子源是產(chǎn)生鎵離子束的源頭,為后續(xù)加工提供能量載體。
聚焦與掃描透鏡系統(tǒng)負責將離子束精確聚焦并引導至樣品表面,實現(xiàn)對樣品的精準加工。樣品移動平臺可實現(xiàn)樣品在三維空間內(nèi)的精確移動,確保離子束能夠作用于樣品的任意指定位置。反應(yīng)氣體噴嘴用于引入各種反應(yīng)氣體,如 Br?、XeF?、TEOS 等,這些氣體在離子束作用下與樣品發(fā)生化學反應(yīng),實現(xiàn)不同的加工效果,如金屬沉積、蝕刻等。信號偵測器則用于收集加工過程中產(chǎn)生的信號,如二次電子信號、二次離子信號等,為加工過程的監(jiān)控和分析提供依據(jù)。這些組件協(xié)同工作,使聚焦離子束顯微鏡能夠?qū)崿F(xiàn)選區(qū)濺射去除物質(zhì)、金屬沉積與蝕刻、絕緣層沉積與蝕刻等多種功能,成為微機電(MEMS)加工的重要工具平臺。
雙束系統(tǒng):納米級精準定位與切割
聚焦離子束顯微鏡還可配備電子束系統(tǒng),形成雙束聚焦離子顯微鏡(Dual Beam FIB)。這種雙束系統(tǒng)同時具備掃描式電子顯微鏡(Scanning Electron Microscope, SEM)和聚焦離子束顯微鏡的功能。
而離子束則用于精密切割目標區(qū)域,由于離子束加工過程中不會對樣品的其他結(jié)構(gòu)造成破壞,因此可以實現(xiàn)納米級精確的位置定位與切割,以及納米級的透射電子顯微鏡(TEM)試樣薄片制作。這種雙束系統(tǒng)的結(jié)合,極大地提高了樣品加工的精度和效率,為微觀結(jié)構(gòu)的研究和分析提供了更為強大的工具。
實際應(yīng)用:多領(lǐng)域中的關(guān)鍵角色
1.橫截面結(jié)構(gòu)觀察
在故障分析和制程監(jiān)控等領(lǐng)域,F(xiàn)IB 的橫截面結(jié)構(gòu)觀察功能發(fā)揮著重要作用。雙束 FIB 可以精確地在需要進行剖面切割的位置進行開挖。首先,利用電子束影像(即 SEM 影像)來搜尋欲切割的位置并進行定位,然后以 FIB 進行切割。剖面完成后,再以電子束來取得斷面的影像。
2.TEM 試片制備FIB 在透射電子顯微鏡(TEM)試片制備方面也有多種應(yīng)用方法,主要包括預(yù)先薄化法(Pre-Thin)、靜電吸取法(Lift-out)和探針取出法(Omni-probe)。
預(yù)先薄化法是先將試片通過研磨方式減薄到 5 - 10 um,然后再利用 FIB 進一步減薄至可供 TEM 觀察的 0.1 um 厚度。
這種方法的優(yōu)點是可以得到非常大面積(約 50 um)且厚度均勻的 TEM 試片,且由于薄區(qū)四周仍由相同材質(zhì)的材料固定,試片不會出現(xiàn)變形或卷曲。但其缺點是需要經(jīng)過研磨和 FIB 切割兩個步驟,較為費工、耗時,且存在研磨失敗的風險。
靜電吸取法則是先用 FIB 將取樣區(qū)減薄,再以 U 形切割將薄片與樣品分離,最后利用玻璃探針以靜電吸附方式將薄片取出并置于具碳膜的銅網(wǎng)上。
這是目前最快速省時的 TEM 試片制備法,每個試片的制作工時在 1 小時以下,適合大量 TEM 試片的制作。然而,這類試片一旦放置在碳膜上,就無法再進行任何加工或重工,試片的最終厚度需要依賴 FIB 工程師的經(jīng)驗來判斷,難以保證試片的最佳品質(zhì)。
探針取出法是將試片先用 FIB 粗切至 1 - 2 mm 左右脫離樣品,然后以 FIB 沉積 Pt 將探針與試片焊在一起,移動探針將試片移至試片座,并以 FIB 沉積 Pt 將試片焊在試片座上,之后再用 FIB 將探針切離試片,最后將試片細修至可供 TEM 觀察的薄度。
這種方法是最復(fù)雜、最耗時的 TEM 試片制備法,全部工時大約在 1.5 - 2 小時之間。但它的優(yōu)點在于,試片在 TEM 觀察后,若有任何需要局部修整的厚度問題,可以反復(fù)進出 FIB 進行再加工,從而保證 TEM 試片制備的零失誤與零風險,通常用于非常重要的試片分析。
總結(jié)
聚焦離子束顯微鏡憑借其獨特的鎵離子源、精密的系統(tǒng)構(gòu)成以及多種實際應(yīng)用功能,在微觀世界的加工和分析領(lǐng)域扮演著不可或缺的角色。
-
顯微鏡
+關(guān)注
關(guān)注
0文章
748瀏覽量
25453 -
fib
+關(guān)注
關(guān)注
1文章
128瀏覽量
11756 -
離子束
+關(guān)注
關(guān)注
0文章
113瀏覽量
8100
發(fā)布評論請先 登錄
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束顯微鏡(FIB-SEM)
聚焦離子束應(yīng)用介紹
聚焦離子束顯微鏡(FIB-SEM)材料分析

聚焦離子束掃描電鏡(FIB-SEM)技術(shù)原理、樣品制備要點及常見問題解答

聚焦離子束與掃描電鏡結(jié)合:雙束FIB-SEM切片應(yīng)用
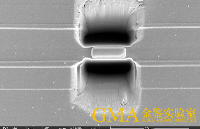
聚焦離子束(FIB)技術(shù)原理和應(yīng)用

聚焦離子束雙束系統(tǒng) FIB - SEM 的技術(shù)剖析與應(yīng)用拓展
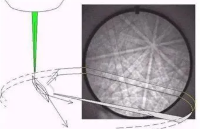



 聚焦離子束顯微鏡(FIB)的應(yīng)用
聚焦離子束顯微鏡(FIB)的應(yīng)用




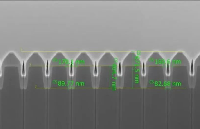
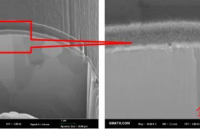




評論