在當今高速發(fā)展的微電子封裝和半導體制造領域,球形凸點(如焊球、導電膠凸點、銅柱凸點等)作為芯片與基板互連的關鍵結構,其機械可靠性直接影響產品的使用壽命和性能表現(xiàn)。隨著封裝技術向高密度、微型化方向發(fā)展,凸點尺寸不斷縮小(部分已降至50μm以下),這對剪切力測試技術提出了更高要求。
ASTM F1269標準作為國際通用的球形凸點機械測試規(guī)范,為行業(yè)提供了科學的測試方法。科準測控憑借多年材料力學測試經驗,結合推拉力測試機,開發(fā)了一套完整的球形凸點剪切力測試解決方案。本文將系統(tǒng)性地介紹測試原理、設備選型、標準解讀、操作技巧及典型應用案例,為工程師提供實用的技術參考。
一、測試原理
球形凸點剪切力測試通過施加平行于基板方向的力,直至凸點發(fā)生斷裂或脫落,記錄最大剪切力值。該測試可評估以下關鍵指標:
剪切強度:最大剪切力與凸點橫截面積的比值(單位:MPa)。
失效模式:界面斷裂(粘接失效)、凸點內聚斷裂或混合失效。
工藝一致性:多組凸點剪切力的離散性分析。
ASTM F1269標準規(guī)定了測試速度、刀具幾何形狀及數(shù)據(jù)采集要求,確保測試條件的一致性。
二、測試目的
1、球形凸點剪切力測試的意義
可靠性評估:量化凸點與基板/芯片的結合強度
工藝優(yōu)化:比較不同焊接/固化工藝的質量差異
失效分析:識別界面斷裂、內聚斷裂等失效模式
壽命預測:為熱循環(huán)可靠性提供基礎數(shù)據(jù)
2、剪切力測試的力學模型
根據(jù)彈性力學理論,球形凸點剪切過程可分為三個階段:
彈性變形階段:力-位移呈線性關系
塑性變形階段:材料發(fā)生屈服
斷裂階段:界面或凸點本體破壞

三、測試工具和儀器
1、Alpha W260推拉力測試機
A、設備介紹

Alpha W260推拉力測試機是專為微電子封裝設計的精密力學測試設備,常見的測試有晶片推力、金球推力、金線拉力等,采用高速力值采集系統(tǒng)。根據(jù)測試需要更換相對應的測試模組,系統(tǒng)自動識別模組,并自由切換量程。產品軟件操作簡單方便,適用于半導體IC封裝測試、LED 封裝測試、光電子器件封裝測試、PCBA電子組裝測試、汽車電子、航空航天、軍工等等。亦可用于各種電子分析及研究單位失效分析領域以及各類院校教學和研究。
2、推刀

3、常用工裝夾具

四、測試流程
步驟一、樣品準備
將帶有球形凸點的樣品(如BGA芯片)固定在測試平臺,確保基板水平。
使用光學系統(tǒng)定位目標凸點,調整刀具高度至凸點高度的50%~70%處(ASTM F1269推薦)。
步驟二、儀器設置
選擇ASTM F1269測試模板,設置參數(shù):
測試速度:50~500μm/s(依材料調整,默認100μm/s)。
剪切方向:平行于基板,刀具與凸點側壁接觸。
終止條件:力值下降80%(凸點完全剝離)。
步驟三、執(zhí)行測試
啟動測試機,刀具勻速推進,實時監(jiān)測力值變化。
記錄最大剪切力(F max )及失效位置(界面或凸點內部)。
步驟四、數(shù)據(jù)分析
計算剪切強度:

統(tǒng)計分析同一批次凸點的強度分布,評估工藝穩(wěn)定性。
步驟五、報告輸出
生成包含以下內容的測試報告:
最大剪切力、剪切強度、失效模式。
力-位移曲線及光學顯微鏡失效圖像。
五、應用案例
某半導體廠商采用Alpha W260測試錫銀焊球(直徑200μm),發(fā)現(xiàn)部分凸點剪切力低于標準值。經分析為回流焊溫度不足導致界面結合不良,優(yōu)化后剪切強度提升35%。
以上就是小編介紹的有關球形凸點剪切力測試相關內容了,希望可以給大家?guī)韼椭∪绻€想了解更多關于電阻推力圖片、測試標準、測試方法和測試原理,推拉力測試機怎么使用視頻和圖解,使用步驟及注意事項、作業(yè)指導書,原理、怎么校準和使用方法視頻,推拉力測試儀操作規(guī)范、使用方法和測試視頻,焊接強度測試儀使用方法和鍵合拉力測試儀等問題,歡迎您關注我們,也可以給我們私信和留言,【科準測控】小編將持續(xù)為大家分享推拉力測試機在鋰電池電阻、晶圓、硅晶片、IC半導體、BGA元件焊點、ALMP封裝、微電子封裝、LED封裝、TO封裝等領域應用中可能遇到的問題及解決方案。
審核編輯 黃宇
-
BGA
+關注
關注
5文章
585瀏覽量
51737 -
可靠性測試
+關注
關注
1文章
149瀏覽量
14763 -
焊球
+關注
關注
0文章
11瀏覽量
6210 -
推拉力測試機
+關注
關注
0文章
183瀏覽量
676
發(fā)布評論請先 登錄
光學組件推力測試怎么做?推拉力測試機操作使用

拉力測試過關,產品仍會失效?揭秘不可替代的半導體焊球-剪切測試
基于推拉力測試機的PCBA電路板元器件焊點可靠性評估與失效機理探討

推拉力測試機在CBGA焊點強度失效分析中的標準化流程與實踐

推拉力測試機詳解:硅基WLP封裝焊球剪切與拉脫測試全流程
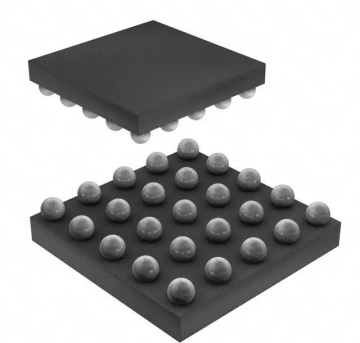
LTCC焊球可靠性提升方案:推拉力測試儀的測試標準與失效診斷

提升功率半導體可靠性:推拉力測試機在封裝工藝優(yōu)化中的應用

AEC-Q102之推拉力測試

提升QFN封裝可靠性的關鍵:附推拉力測試機檢測方案
基于推拉力測試機的化學鍍鎳鈀金電路板金絲鍵合可靠性驗證

實測案例:如何用推拉力測試機進行SMT元器件焊接強度測試?




 ASTM F1269標準解讀:推拉力測試機在BGA焊球可靠性測試中的應用
ASTM F1269標準解讀:推拉力測試機在BGA焊球可靠性測試中的應用





評論