概述
HMC-XDB112是一款單芯片無源倍頻器,采用GaAs異質結雙極性晶體管(HBT)技術,適用于低頻率倍頻比直接生成高頻率更加經濟的大規模應用。 所有焊盤和芯片背面都經過Ti/Au金屬化,HBT器件已完全鈍化以實現可靠操作。
HMC-XDB112無源倍頻器MMIC可兼容常規的芯片貼裝方法,以及熱壓縮和熱超聲線焊,非常適合MCM和混合微電路應用。 此處顯示的所有數據均是芯片在50 Ohm環境下使用RF探頭接觸測得。
數據表:*附件:HMC-XDB112 x2無源倍頻器芯片,20-30GHz輸出技術手冊.pdf
應用
特性
- 轉換損耗: 13 dB
- 無源: 無需直流偏置
- 輸入驅動: +13 dBm
- 高Fo隔離: 30 dB
- 裸片尺寸: 2.2 x 0.65 x 0.1 mm
框圖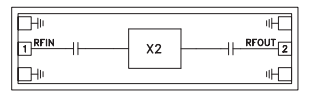
焊盤描述
毫米波砷化鎵單片微波集成電路(GaAs MMIC)的安裝與鍵合技術
芯片應使用導電環氧樹脂(參見HMC通用操作、安裝、鍵合說明)直接連接到接地層,或者與接地層實現電連接。建議使用0.127mm(5密耳)厚的氧化鋁薄膜微帶線傳輸線來傳輸50Ω射頻信號,并將其連接到芯片(圖1)。如果必須使用0.254mm(10密耳)厚的氧化鋁薄膜襯底,芯片應抬高0.150mm(6密耳),使芯片表面與襯底表面齊平。實現這一點的一種方法是將0.120mm(4密耳)厚的芯片連接到0.150mm(6密耳)厚的鉬墊片(熱沉片)上,然后將其連接到接地層(圖2)。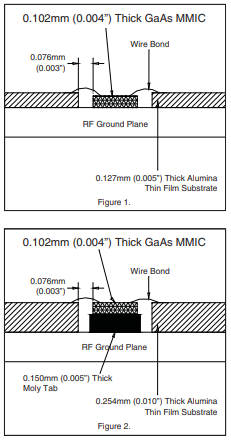
微帶線應盡可能靠近芯片放置,以盡量減少鍵合線長度。典型的芯片與襯底間距為0.076mm至0.152mm(3至6密耳)。
操作注意事項
遵循以下預防措施,避免造成永久性損壞。
- 存儲 :所有芯片均應放置在防靜電華夫盒或凝膠基防靜電容器中,然后密封在防靜電袋中運輸。防靜電袋一旦開封,所有芯片應存放在干燥的氮氣環境中。
- 清潔度 :在清潔環境中操作芯片。請勿嘗試使用液體清潔系統清潔芯片。
- 靜電敏感性 :遵循防靜電措施,防止靜電沖擊。
- 瞬態 :施加偏置時,抑制儀器和偏置電源的瞬態。使用屏蔽信號和偏置電纜,以盡量減少電感耦合。
- 一般操作 :使用真空吸筆或鋒利的彎頭鑷子夾持芯片邊緣。芯片表面可能有脆弱的空氣橋,請勿用真空吸筆、鑷子或手指觸碰。
安裝
芯片背面有金屬化層,可以使用金錫共晶預制件或導電環氧樹脂進行芯片安裝。安裝時芯片應保持清潔和平整。
- 共晶焊接 :建議使用80/20金錫預制件,工作表面溫度為255°C,工具溫度為265°C。使用90/10氮氣/氫氣混合氣體時,工具尖端溫度不得超過290°C。芯片溫度達到320°C以上時,請勿擦拭芯片。連接時間不應超過3秒。
- 環氧樹脂粘貼 :在安裝表面涂抹適量環氧樹脂,確保芯片放置到位后,其周邊出現一圈薄的環氧樹脂邊。按照制造商的固化時間表固化環氧樹脂。
引線鍵合
建議使用0.003英寸×0.0005英寸的帶狀射頻鍵合線。這些鍵合線應采用熱超聲鍵合,鍵合力為40 - 60克。建議使用DC鍵合線,直徑0.001英寸(0.025毫米),采用熱超聲鍵合。建議使用球鍵合,鍵合力為40 - 50克,楔形鍵合,鍵合力為18 - 22克。所有鍵合應在150°C的標稱階段溫度下進行。為實現可靠鍵合,應施加最小12微秒的能量,所有鍵合長度應盡可能短,小于12密耳(0.31毫米)。
-
GaAs
+關注
關注
3文章
893瀏覽量
25060 -
HBT
+關注
關注
0文章
156瀏覽量
16003 -
倍頻器
+關注
關注
8文章
124瀏覽量
37362
發布評論請先 登錄
HMC-XDB112 x2無源倍頻器芯片,20 - 30 GHz輸出

HMC448LC3B x2有源倍頻器SMT,20-25GHz技術手冊
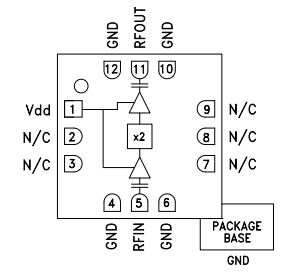
HMC573LC3B x2有源倍頻器,采用SMT封裝技術手冊
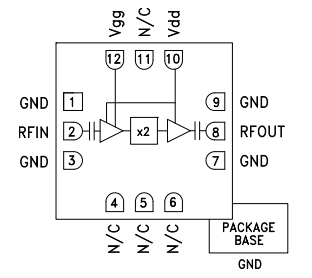
HMC577LC4B x2有源倍頻器,采用SMT封裝技術手冊

HMC942LP4E x2有源倍頻器,25-31GHz輸出技術手冊
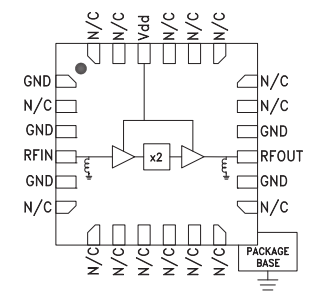



 HMC-XDB112 x2無源倍頻器芯片,20-30GHz輸出技術手冊
HMC-XDB112 x2無源倍頻器芯片,20-30GHz輸出技術手冊


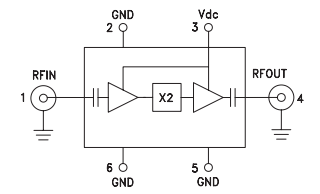
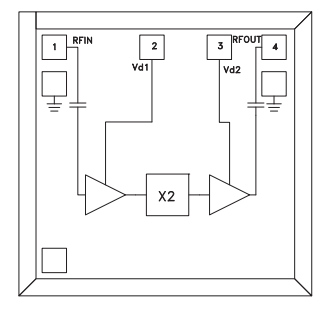
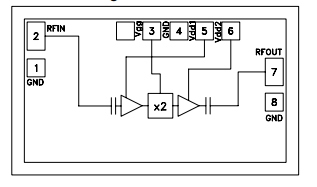
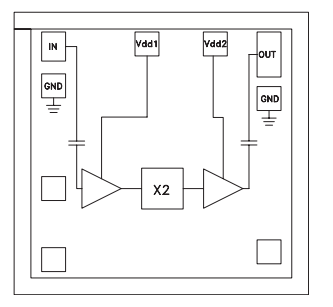
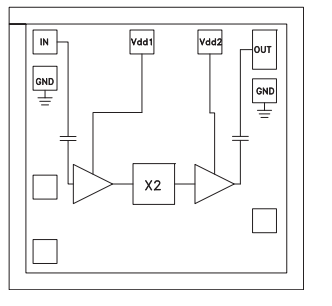
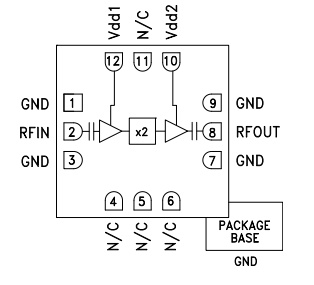
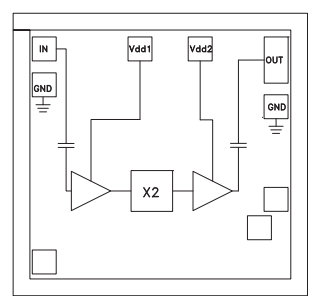




評論