----轉載自辛國鋒、瞿榮輝、陳高庭和方祖捷2005年的文章
摘 要
半導體激光器陣列的應用已基本覆蓋了整個光電子領域,成為當今光電子科學的重要技術。本文介紹了半導體激光器陣列的發展及其應用,著重闡述了半導體激光器陣列的封裝技術——熱沉材料的選擇及其結構優化、熱沉與半導體激光器陣列之間的焊接技術、半導體激光器陣列的冷卻技術、與光纖的耦合技術等。
1 引言
大功率半導體激光器具有一系列優點,如高電光轉化效率;可通過選用不同的有源區材料或改變多元化合物半導體的組分得到所需的激射波長,覆蓋的波段范圍寬廣;壽命長;具有直接調制能力;而且體積小、重量輕、價格便宜。在科學、遠程傳感和光譜方面的全激光系統中,常用大功率半導體激光器陣列抽運 Nd:YAG,Nd:YLF, Nd: Glass和各種各樣的固體激光器系統,其壽命和可靠性大約是閃光燈抽運系統的100倍,總體效率至少比閃光燈抽運高10倍。半導體激光器陣列技術在軍事、航空、空間激光通信系統中得到了廣泛應用,如:大功率固體激光器在航空和機載激光領域的應用,以及直接激光通信平臺和探測氣體濃度及污染的遠程傳感的應用。另一個重要的應用領域是大功率半導體激光器 陣列在生物醫學中的手術應用,生物醫學應用的波長范圍有近紅外抽運激光器(用作光切割);倍頻可見光和基波激光直接應用在光凝結 (photocoagulation)、光動力學(photodynamic)治療的波長范圍是680~980nm[1,2]。隨著實際工程的發展,要求大功率半導體激光器的輸出功率越來越高,目前大功率半導體激光器的電光轉化效率小于50%,即有50%的電功率將轉化成熱功率。而半導體激光器的光學特性、輸出功率以及可靠性等都與器件的工作溫度密切相關。要保證激光器有較高的效率,較好的光譜和較高的輸出功率,必須對大功率半導體激光器的封裝技術進行優化,諸如熱沉材料選擇和結構優化、焊接、冷卻及光束整形和光纖耦合等,從而減小熱阻,降低串聯電阻,提高光譜質量。本文詳細地介紹了大功率半導體激光器封裝的關鍵技術——熱沉材料選擇和結構優化、焊接技術、冷卻技術、光束整形和光纖耦合,展望了封裝技術的發展趨勢。
2 熱沉材料的選擇和結構優化
主要從兩個方面考慮熱沉材料的選擇,一是材料的熱導率要高,二是材料與芯片之間的熱膨脹系數盡可能匹配。目前5~50W的激光器芯片通常有19~25個尺寸為 100~150滋m的發光單元,裝配再CuW(或 BeO 或 Si)基座上,然后再將其焊接在銅熱沉上,熱沉用空氣流或熱電冷卻器模塊,甚至用水冷板被動冷卻。輸出功率為 50~75W 的大功率半導體激光器陣列,通常是 p 面朝下燒結在標準的鍍 Ni原Au 層的銅基座上。銅和芯片之間還常用 BeO、金剛石和 Si作中間載體,起到更好的散熱效果。輸出功率在 100W 以上的半導體激光器陣列,首先將芯片焊接在經過金屬化的載體或基座上,然后在微通道冷卻器上進行冷卻。在許多封裝中人們還常用 SiC、AlN 和 BeN 作為熱沉[1]。半導體激光器陣列熱沉的尺寸也在一定程度上影響著陣列的散熱。目前市場上,連續波工作半導體激光器陣列熱沉的尺寸大多采用 25mmX 25mmX 7mm。為了提高半導體激光器陣列的輸出功率可以將線陣列疊加組裝成二維陣列。對于二維半導體激光器陣列,根據不同的工作方式和要求,可以大致分為低密度封裝、中等密度封裝和高密度封裝。低密度封裝相對尺寸較大,每個單條需要一個制冷器,然后再疊成二維陣列,這種封裝通常適用于高占空比或連續波工作的半導體激光器陣列;對中等密度封裝的激光器陣列是先將激光器陣列焊接在次熱沉上,然后多個帶次熱沉的半導體激光器陣列共用一個制冷器,次熱沉的間距根據不同的電流占空比而改變,如對于占空比>3%的二維陣列其單條的間距通常為 0.4mm,>6%時的間距通常為 0.8mm,而>20%時的間距通常為 2.0mm;高密度封裝通常是將多條共用集成的次熱沉和制冷器。此種二維半導體激光器二維陣列通常工作在脈沖電流條件下。芯片溫度隨線陣列后腔面與水冷器之間距離增加而增加,并且激光器前后腔面的溫度差也將隨之增加,所以理論上此距離越小越好,但考慮實際的操作,此距離一般在 0.5~ 1mm 之間[3,4]。
3 焊接技術及焊料的選取
為了彌補芯片與熱沉之間由于熱膨脹系數不同而帶來的應力, 通常使用軟焊料即銦或鉛錫。但銦和鉛錫焊料可靠性有限,軟焊料的遷移(migration)與激光器芯片的災變性損壞成了一個突出的問題,雖然In和PbSn可以在一定程度上減小應力但會產生細絲。使用助焊劑可得到好的浸潤,避免界面出現空洞。如果使用 Au80原Sn20焊料可以得到更高的可靠性和無助焊劑焊接,增加了器件的壽命。在最近的工作中,用幾微米的 Au80原Sn20焊料將激光器陣列焊接在金剛石熱沉上。激光器結構是p面朝下裝配,它能在較高的熱應力和熱梯度下工作,因有較低的電光轉換效率(特別是在CW工作條件下)。用標準的金屬化工藝,激光器的輸出功率高達0.4W。如果優化金屬化過程,器件可以工作在1.6W。激光器陣列和熱沉材料之間包括金屬層 Ti-Pt-Au、一層 AuSn 焊料,然后淀積在熱沉上的金屬層Ti-Pt,其中Ti層起到粘附層的作用,而 Pt形成阻擋層防止擴散。Weiss等提出在激光器陣列一側淀積一薄層的 Au 浸潤層,當AuSn開始溶化時,焊料中的Au富相使其向激光器襯底遷移。Pittroff 將金屬化工藝改成在 3 微米的 AuSn 層下再有一層 2 微米厚的Au,用此方法制作的激光器可以減小光譜線寬。為了提高激光器管芯材料焊接的可靠性以及與熱沉焊接的可靠性,提出用InSn合金;由于對使用焊料的精確控制和回流行為,所以這個過程具有較好的可靠性。InSn 合金在激光器芯片焊接實驗中,在芯片材料和焊料之間以及焊料和熱沉界面之間具有較小的空洞范圍。51%In原49%Sn合金焊料的熔點溫度為 118°C。激光器芯片材料上一層In的存在可以防止在接近激光器陣列一側焊料出現空洞。在熱循環過程中將激光器芯片和 熱沉連接,熱沉表面的溫度上升到 In 的熔點157°C使其溶化,而在 Sn 的熔點232°C之前停止。降低了由于焊料的爬行和因短路而導致的器件損壞,因此激光器芯片的焊接 具有較高的可靠性。在到達 In 的熔點之前,In、Sn 相互擴散形成合金,此合金比 In 具有較低的熔點。擴散進行過程中大量的 In 沿激光器芯片表面移動,用壓力使激光器芯片和熱沉焊接在一起。目前人們常用的焊料是 Pb原 Sn,PbSn 中 Pb 有毒對環境造成污染,更重要的是助焊劑的使用會損壞光電器件的有源區,而傳統的清洗方法對光電器件的封裝不是很有效,因此以無助焊劑的焊料來焊接光電子器件是發展的必然趨勢。用In bump焊料的最優焊接條件是溫度150°C、壓力為500gf(gravi原ty force),但是在焊接過程中In焊料很容易被氧化。為了降低其熔點和防止其氧化,可在In表面蒸鍍一層銀。含97wt%In合金的熔點為144°C,外面包的銀可以增強熱沉與激光器芯片的焊接強度。在一些光電子封裝過程中,還常使用低溫焊料(<160°C)進行焊接,軟焊料中通常摻有Bi成分[5~9]。
4 冷卻技術
對于大功率半導體激光器來說,冷卻技術是重要技術之一。冷卻技術可以分為被動冷卻技術和主動冷卻技術。被動冷卻技術用熱容量大的散熱器釋放熱量。主動冷卻技術用流動冷卻液帶走熱功率。一般情況下,激光器采用半導體制冷器控制熱沉,保持恒定的溫度。平均功率密度高的激光器陣列如高占空比和連續激光器,主動冷卻是必需的。現在,各種水冷器結構多為多層片的微通道結構,采用的材料有硅、銅或金剛石。每層片上設計有流通冷卻液的圖形和微通道,可以采用常規的化學方法刻蝕出花樣,或用激光切割出花樣圖形。將層片組裝起來,便構成微通道制冷器[10~14],圖 1 給出的是一種微通道制冷器的示意圖。圖中的銅片花樣用激光切割出來,細槽進行冷卻液的熱交換。這種制冷器,可以有效的提高冷卻液的交換率和循環效率,減小熱阻。目前報道的用微通道熱沉封裝的大功率半導體激光器陣列的最高輸出功率為255 W,波長為 808 nm,填充因子為67%,腔長1.5mm,最高轉化效率為 49.1%。其微通道熱沉示意圖 見圖 2 [15]。
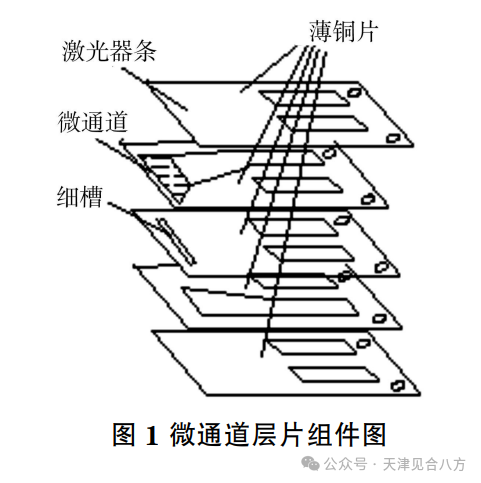
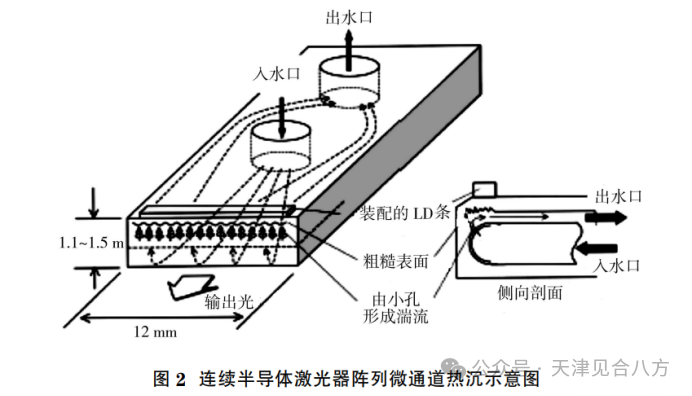
5 光束整形和光纖耦合
半導體激光器的光束質量與其它激光器如氣體、固體激光器相比相對較差。在半導體激光器的很多應用領域需要對其進行光束整形,有時需要光纖耦合輸出。光束整形(光束準直)常用的方法有柱透鏡、非球面透鏡及組合透鏡準直。柱透鏡可以用圓柱形的光纖芯來制作,雖然圓柱形透鏡準直效果不如非球面透鏡,但因成本低,并能夠達到一定的指標,所以在要求不高的場合下使用。而非球面透鏡的數值孔徑可以很大,并且在理論上準直后的光線是嚴格的平行光,所以它可以達到很好的準直效果,但是其制作難度大,成本高。最近還提出了用全息透鏡、雙臺階反射鏡等方法進行光束準直,但是其制作難度大,只適合在實驗室應用[16~20]。目前,單管激光器的耦合主要有直接耦合和間接耦合(先經光束整形再與光纖耦合),耦合形式如圖 3 所示。半導體激光器陣列的光纖耦合主要有微光學系統耦合和光纖陣列耦合兩種方式,用微光學系統可以將陣列的光耦合進單根光纖,從而得到高亮度和高功率密 度的激光輸出。但是微光學透鏡及其陣列的制作難度大,成本高。光纖陣列耦合是先將半導體激光器 陣列光束用一個柱透鏡進行準直,然后將經準直的光束耦合進光纖陣列中,此方法要求光纖陣列的周期與半導體激光器陣列發光單元周期嚴格匹配,對光纖陣列的固定提出了較高的要求,而且光纖束輸出的半徑較大,光束亮度和輸出功 率密度較低,但是此耦合系統較簡單、成本低,因此它在實用化的系統中得到廣泛應用。

6小結
本文從熱沉的材料選擇、結構優化,焊接技術及焊料選擇,水冷技術和光束整形與光纖耦合等方面分析了目前的發展現狀。封裝的關鍵技術是解決散熱問題、減小管芯應力以及半導體激光器光束的整形和光纖的耦合技術。
-
半導體
+關注
關注
339文章
30984瀏覽量
265448 -
激光器
+關注
關注
19文章
2988瀏覽量
64743 -
封裝技術
+關注
關注
12文章
602瀏覽量
69336
原文標題:大功率半導體激光器陣列的封裝技術
文章出處:【微信號:天津見合八方,微信公眾號:天津見合八方】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄



 大功率半導體激光器陣列的封裝技術
大功率半導體激光器陣列的封裝技術

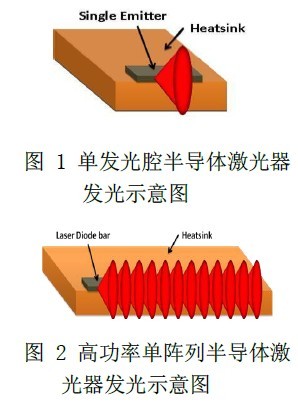



評論