一、前言
隨著電動汽車的發展,汽車功率器件芯片也正在尋求能夠有效處理更高工作電壓和溫度的組件。此時碳化硅 MOSFET 成為牽引逆變器等電動汽車構建模塊的首選技術。基于碳化硅的逆變器可使高達 800V 的電氣系統顯著延長 EV 續航里程并將充電時間減半。據行業研究公司IHS Markit 的數據,到 2025 年,全球高達 45% 的汽車生產將實現電氣化,每年將售出約 4600 萬輛電動汽車。據估計,到 2030 年,這些數字將上升到 57%,每年的電動汽車銷量約為 6200 萬輛。功率器件正從硅基 IGBT 發展至碳化硅 MOSFET 時代。碳化硅的材料特性對比硅有了顯著的提升:碳化硅材料的臨界擊穿場強為硅的近10倍,體遷移率與硅接近,帶隙寬度是硅的3倍,電子飽和漂移速度是硅的2倍,熱導率也為硅的3倍。碳化硅器件和相同電壓檔硅器件相比,厚度約為硅器件的1/10,理論上通態壓降可以大大降低,在開關速率和開關損耗上優勢則更加明顯。
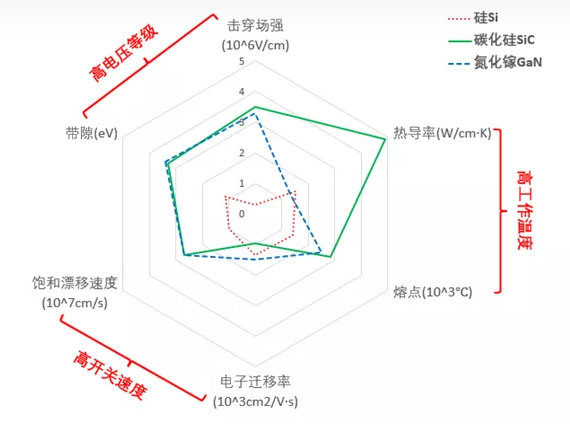
△ 圖1SiC、GaN與Si材料特性比較
目前為止,碳化硅 MOSFET 在通態壓降上并未對硅基 IGBT 表現出預期的優勢。碳化硅MOSFET 在襯底及外延層材料遷移率、SiC/SiO2界面表面遷移率方面的表現還有足夠的提升空間。圖2中顯示了碳化硅 Cool MOS與硅基 IGBT 導通損耗的對比。
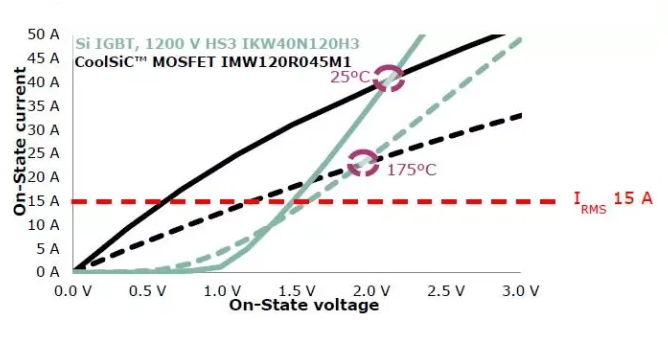
△ 圖2 SiC MOSFET與SiIGBT特性比較二、碳化硅MOSFET器件比導通電阻的優化降低碳化硅的比導通電阻,影響比導通電阻有以下幾個因素:
2.1碳化硅MOSFET的遷移率
根據在MOSFET中的位置可以分為溝道遷移率和體遷移率:當MOSFET導通時,柵極下方的溝道內的遷移率我們稱之為溝道遷移率;在遠離柵極和材料表面的區域,我們稱之為體遷移率。溝道遷移率可通過測量MOSFET的輸出特性來得到:這里又可以將其分為(1)有效遷移率;(2)場效應遷移率;3)飽和遷移率。溝道遷移率受到SiC/SiO2界面處的許多缺陷的限制,這導致器件的場效應遷移率比其霍爾遷移率低兩個數量級。一般認為:SiC中Si的選擇性氧化導致碳沉淀并在SiO2中形成碳團簇(C-cluster),從氧化動力學角度考慮界面的化學勢發現,界面的動態平衡性(dynamic equilibrium)限制了很高的碳化學勢,從而導致了界面C-cluster缺陷具有較低的形成能,解釋了高的界面態密度的成因,而其缺陷能級位置靠近SiC的導帶底,因此降低了載流子的遷移率。SiC MOSFET反型溝道電子主要散射機制包括:界面態電荷的庫倫散射、體晶格散射、離化雜質庫倫散射、表面粗糙散色以及表面聲子散射。下圖為SiC MOSFET溝道處的電子散射情況:
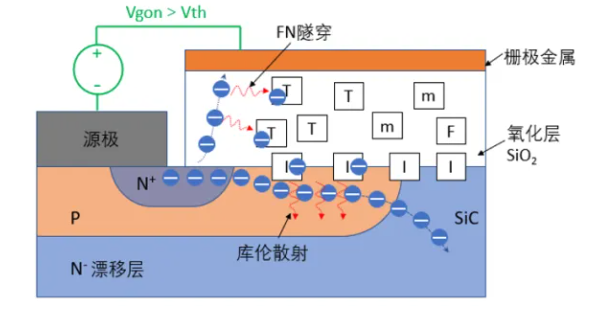
△ 圖3溝道處電子遷移率影響因素4H-SiC界面處主要由類受主缺陷對器件性能產生影響,庫倫遷移率決定于界面陷阱對溝道電子的散射。在降低比導通電阻方面,平面SiC MOSFET中JFET的電阻、MOSFET體電阻以及高濃度襯底電阻為總比導通電阻提供了相當大的貢獻。在降低JFET電阻方面,出現了從平面MOSFET向Trench MOSFET的過度。
2.2.器件結構設計優化降低比導通電阻其中溝道電阻:

其中 積累電阻:
積累電阻: JFET區電阻:
JFET區電阻: 漂移區電阻為:
漂移區電阻為: 以一顆pitch 5.0μm的SiC MOSFET為例,柵氧化層厚度約450A,Vth~3.0V,LCH=0.5μm,改變柵寬來調整a的數值,在a=1μm,1.5μm,2μm條件下 ,以JFET平均濃度,漂移區厚度約10μm時:
以一顆pitch 5.0μm的SiC MOSFET為例,柵氧化層厚度約450A,Vth~3.0V,LCH=0.5μm,改變柵寬來調整a的數值,在a=1μm,1.5μm,2μm條件下 ,以JFET平均濃度,漂移區厚度約10μm時:

△表1使用襯底1時比導通電阻構成

△ 表2 使用襯底2 時比導通電阻構成

△ 表3 漂移區濃度對Ronsp和Vth的影響
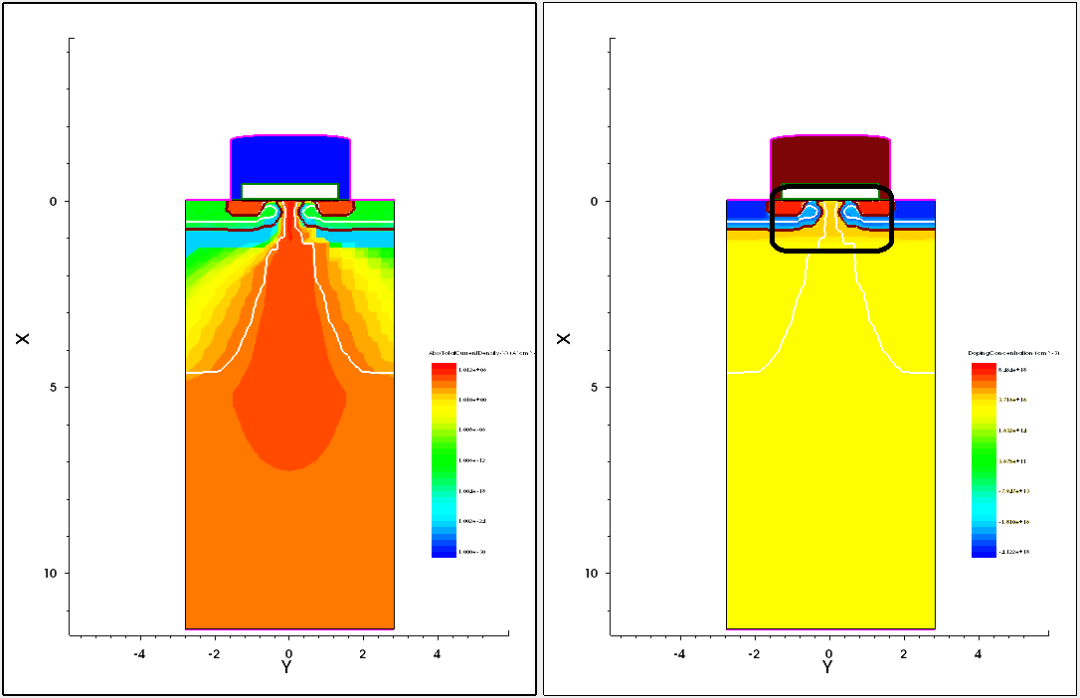
△ 圖4SiC MOSFET電流擴展圖及JFET區域
摻雜分布外延層厚度和摻雜濃度一定的情況下:降低JFET區電阻、并優化電流擴展區濃度對降低總比導通電阻貢獻較大,RDsp與器件襯底狀態相關性高,需達到外延摻雜濃度和厚度的折中設計。減薄襯底厚度:當減薄厚度由175μm降低到110μm時,對于常見的1200V/80mohm SiC Planar Mosfet,預計導通電阻降低3mohm左右,換算成比導通電阻降低約0.13mohm.cm2。2.3.Trench MOSFET取代Planar MOSFET降低比導通電阻
目前SiC MOSFET也正迎來從planar MOSFET向Trench MOS方向發展的趨勢,Planar MOSFET JFET區域電阻在總導通電阻中占比較大,而Trench MOS理論上不存在JFET區域。
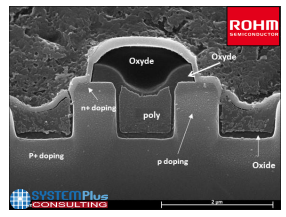
△ 圖5ROHM Trench MOSFET結構

△ 圖6英飛凌Trench MOSFET結構以ROHM代表的雙溝槽結構和infineon為代表的半包結構代表SiC Trench MOSFET獨立發展的兩種結構。下圖為ROHM公司從平面結構向Trench發展的Ron的表現。

△ 圖7ROHM 平面與溝槽MOSFET結構對比即比導通電阻比較
三、主流產品的性能比較下圖為目前市面上各主要大廠的MOSFET性能比較:
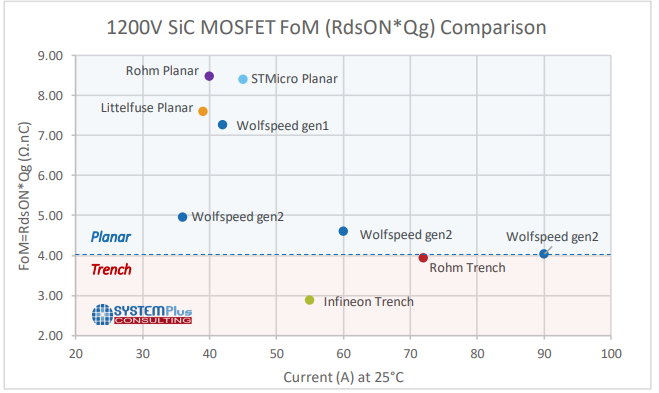
△ 圖8各主要廠商SiC MOSFET比導通電阻比較
四、結論
碳化硅MOSFET以低損耗,高阻斷,高溫工作,開關速度快等各優勢,不過在技術方面:SiC單晶材料雖然在導致SiC功率半導體性能和可靠性下降的致命缺陷微管密度降低和消除方面近年來取得很大進展,但位錯缺陷等其他缺陷對元件特性造成的影響仍未解決。碳化硅MOSFET器件目前存在兩個主要技術難點沒有完全突破:低反型層溝道遷移率和高溫、高電場下柵氧可靠性。在碳化硅MOSFET克服以上問題后,將迎來爆發式的增長。
-
MOSFET
+關注
關注
151文章
9678瀏覽量
233643 -
低功耗
+關注
關注
12文章
3466瀏覽量
106715 -
碳化硅
+關注
關注
26文章
3469瀏覽量
52369
發布評論請先 登錄
氮化硼墊片在第三代半導體功率器件SiC碳化硅IGBT單管內外絕緣應用方案

氮化硼散熱膜 | 解決手機射頻天線散熱透波問題

電機定子與線圈絕緣散熱的核心選擇 | 氮化硼PI散熱膜

第三代半導體碳化硅 IGBT/MOSFET導熱散熱絕緣材料 | 二維氮化硼導熱絕緣墊片

高功率密度碳化硅MOSFET軟開關三相逆變器損耗分析
基于氮化鎵的碳化硅功率MOSFET高頻諧振柵極驅動器

除了安森美CREE等還有哪些在美國境內流片的SiC碳化硅器件品牌
麥科信光隔離探頭在碳化硅(SiC)MOSFET動態測試中的應用
氮化硼納米管在芯片熱界面領域導熱性能可提升10-20%,成本僅增加1-2%
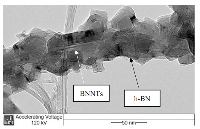
碳化硅(SiC)MOSFET替代硅基IGBT常見問題Q&A
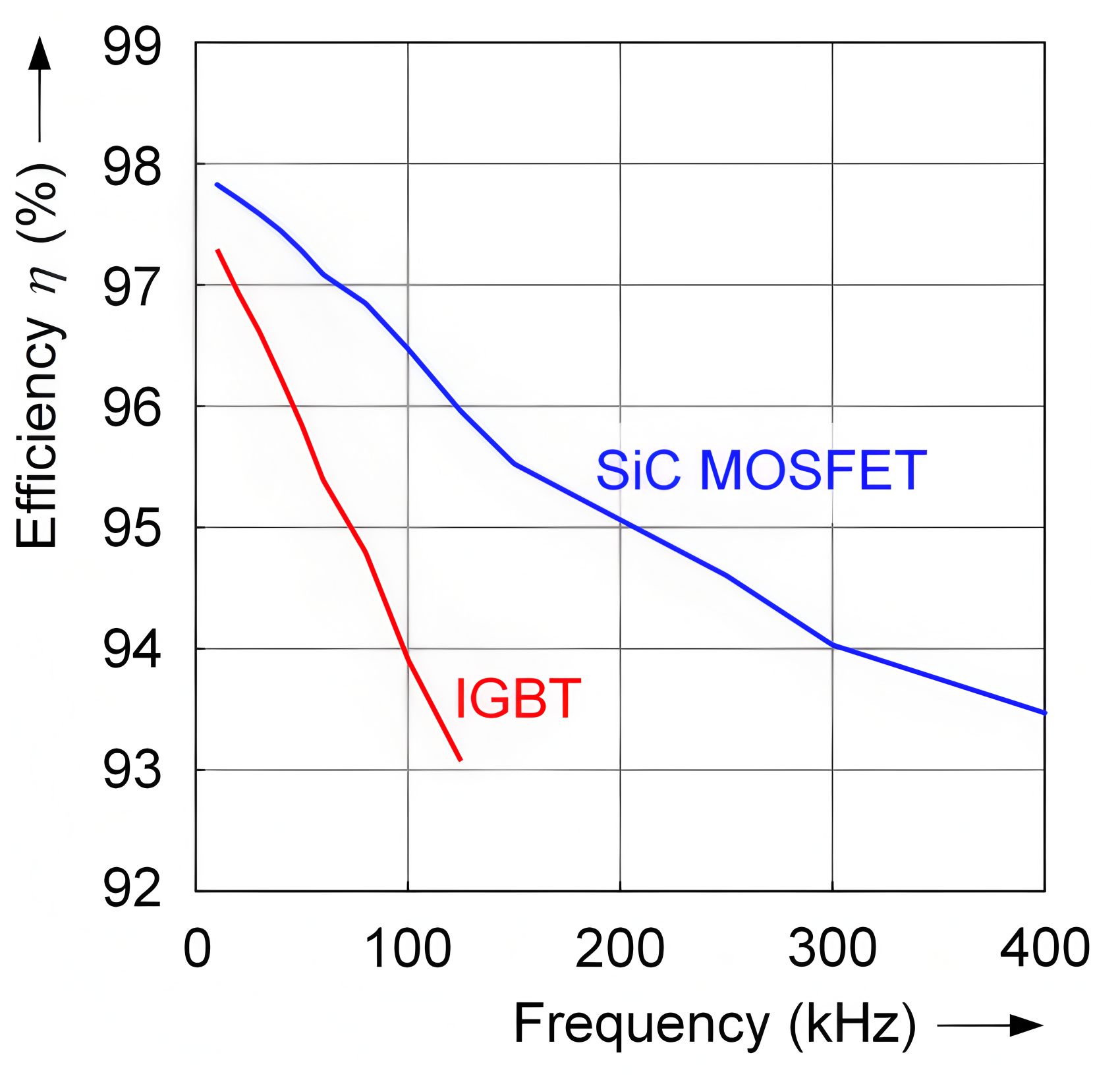



 低功耗碳化硅 MOSFET 的發展 | 氮化硼高導熱絕緣片
低功耗碳化硅 MOSFET 的發展 | 氮化硼高導熱絕緣片






評論