來源:IT之家
近日DigiTimes發布博文,表示在英偉達的不斷催促下,臺積電不僅開足馬力進軍半導體扇出面板級封裝(FOPLP),而且大力投資玻璃基板研發工藝,以期實現突破。
臺積電將會在 9 月召開的半導體會議上,公布 FOPLP 封裝技術細節,并公開玻璃基板尺寸規格。玻璃基板制程涵蓋玻璃金屬化(Glass Metallization)、后續的 ABF 壓合制程,及最終的玻璃基板切割。在玻璃金屬化完成后的玻璃又稱做“Glass Core”,制程涉及 TGV(Through-Glass Via)、濕蝕刻(Wet Etching)、AOI 光學檢測、鍍膜(Sputtering)及電鍍(Plating)。玻璃基板的尺寸為 515×510mm,在半導體和載板制程中均屬于全新制程,其關鍵在于第一道工序“TGV”。盡管這項技術早在 10 年前就已問世,但其速度未能滿足量產需求,僅能達到每秒 10~50 個孔,使得玻璃基板技術至今尚未能起飛。目前僅英特爾宣稱具備量產能力,尚未有其他廠商能提供完整且成熟的制程設備或服務,但業界則盛傳臺積電已重啟研發。關于玻璃基板何時投放市場,之前的一篇報道披露,主要制造商都把解決方案投放市場的時間窗口定在了 2025-2026 年,其中英特爾和臺積電走在了前列。
【近期會議】
10月30-31日,由寬禁帶半導體國家工程研究中心主辦的“化合物半導體先進技術及應用大會”將首次與大家在江蘇·常州相見,邀您齊聚常州新城希爾頓酒店,解耦產業鏈市場布局!https://w.lwc.cn/s/uueAru
11月28-29日,“第二屆半導體先進封測產業技術創新大會”將再次與各位相見于廈門,秉承“延續去年,創新今年”的思想,仍將由云天半導體與廈門大學聯合主辦,雅時國際商訊承辦,邀您齊聚廈門·海滄融信華邑酒店共探行業發展!誠邀您報名參會:https://w.lwc.cn/s/n6FFne
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。聯系郵箱:viviz@actintl.com.hk, 電話:0755-25988573
審核編輯 黃宇
-
芯片
+關注
關注
463文章
54020瀏覽量
466347 -
英特爾
+關注
關注
61文章
10302瀏覽量
180533 -
臺積電
+關注
關注
44文章
5803瀏覽量
176412 -
玻璃基板
+關注
關注
1文章
104瀏覽量
11072 -
三星
+關注
關注
1文章
1767瀏覽量
34229
發布評論請先 登錄
被指存散熱硬傷,英特爾代工iPhone芯片幾無可能?
超越臺積電?英特爾首個18A工藝芯片邁向大規模量產

五家大廠盯上,英特爾EMIB成了?
吉方工控亮相2025英特爾技術創新與產業生態大會
科通技術獲評英特爾首批尊享級合作伙伴

臺積電Q3凈利潤4523億元新臺幣 英偉達或取代蘋果成臺積電最大客戶
突發!臺積電南京廠的芯片設備出口管制豁免被美國正式撤銷
美國政府將入股英特爾?
特斯拉Dojo重塑供應鏈,三星和英特爾分別贏得芯片和封裝合同




 臺積電角力玻璃基板:和英特爾、三星競爭,首批芯片最快有望 2025 年投產
臺積電角力玻璃基板:和英特爾、三星競爭,首批芯片最快有望 2025 年投產




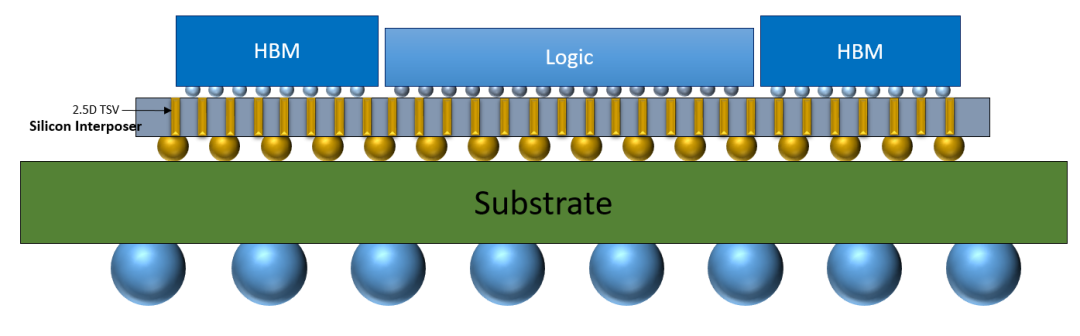




評論