去除表面鈍化層、金屬化層和層間介質(zhì)后有時(shí)依然無法觀察到失效點(diǎn),這時(shí)候就需要對(duì)芯片進(jìn)行進(jìn)一步處理,對(duì)于多層布線的芯片干法腐蝕或者濕法腐蝕來逐一去除,直至最后一層金屬化和介質(zhì)層。
去玩所有的金屬化層和介質(zhì)層后,有時(shí)候還需要去除多晶硅層、氧化層等直至露出硅本體。
芯片失效分析
由于層間介質(zhì)的材料與鈍化層材料種類基本相同,因此層間介質(zhì)的去除也是類似的,也是主要分為干法腐蝕和濕法腐蝕兩種。這里值得注意的是,F(xiàn)IB同樣可以運(yùn)用到失效分析的局部去層處理中。
聚焦離子束系統(tǒng)是利用電子透鏡將離子束聚焦成很小尺寸的纖維精細(xì)切割儀器,它由聚焦?fàn)顟B(tài)的離子探針對(duì)物體表面進(jìn)行點(diǎn)狀轟擊。由于FIB也具有成像功能,所以在進(jìn)行局部剝層之后也便于對(duì)失效點(diǎn)進(jìn)行觀察。
FIB技術(shù)的運(yùn)用
FIB技術(shù)如今十分活躍在半導(dǎo)體集成電路領(lǐng)域。因?yàn)樗诓牧系目涛g、沉積、注入、改變物化性能等方面具有顯著優(yōu)勢,所以被很多內(nèi)行人期待成為半導(dǎo)體集成電路領(lǐng)域最主要的加工手段。
FIB技術(shù)
現(xiàn)階段FIB技術(shù)主要應(yīng)用在以下方面:
1.光掩模的修補(bǔ);
2.集成電路的缺陷檢測分析與修整;
3.TEM和STEM的薄片試樣制備;
4.硬盤驅(qū)動(dòng)器薄膜頭的制作;
5.掃描離子束顯微鏡;
6.FIB的直接注入;
7.FIB曝光(掃描曝光和投影曝光)
8.多束技術(shù)和全真空聯(lián)機(jī)技術(shù);
9.FIB微結(jié)構(gòu)制造(材料刻蝕、沉積)
10.二次離子質(zhì)譜儀技術(shù)。
審核編輯:劉清
-
集成電路
+關(guān)注
關(guān)注
5452文章
12572瀏覽量
374561 -
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30737瀏覽量
264164 -
芯片失效分析
+關(guān)注
關(guān)注
0文章
14瀏覽量
285
原文標(biāo)題:聚焦離子束與芯片失效分析
文章出處:【微信號(hào):zhixinkeji2015,微信公眾號(hào):芯片逆向】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評(píng)論請先 登錄
FIB聚焦離子束電路修改服務(wù)
失效分析:離子束剖面研磨
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束顯微鏡(FIB-SEM)
聚焦離子束應(yīng)用介紹
聚焦離子束FIBSEM切片測試【博仕檢測】
聚焦離子束技術(shù)介紹
聚焦離子束(FIB)技術(shù)的特點(diǎn)、優(yōu)勢以及應(yīng)用

聚焦離子束雙束系統(tǒng)在微機(jī)電系統(tǒng)失效分析中的應(yīng)用
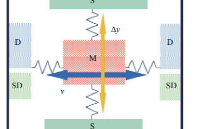
什么是聚焦離子束(FIB)?

FIB聚焦離子束切片分析

聚焦離子束技術(shù):納米加工與分析的利器

聚焦離子束技術(shù)的崛起與應(yīng)用拓展
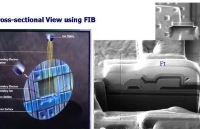
聚焦離子束(FIB)技術(shù)在芯片失效分析中的應(yīng)用詳解




 聚焦離子束與芯片失效分析與運(yùn)用
聚焦離子束與芯片失效分析與運(yùn)用

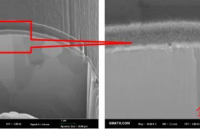



評(píng)論