隨著背面供電技術的完善和新型2D通道材料的采用,英特爾正致力于繼續推進摩爾定律,在2030年前實現在單個封裝內集成1萬億個晶體管。
包括PowerVia背面供電技術、用于先進封裝的玻璃基板和Foveros Direct技術預計將在2030年前投產。
12月9日,英特爾在IEDM 2023(2023 IEEE 國際電子器件會議)上展示了使用背面電源觸點將晶體管縮小到1納米及以上范圍的關鍵技術。英特爾表示將在2030年前實現在單個封裝內集成1萬億個晶體管。
PowerVia背面供電技術預計將于2024年隨Intel 20A制程節點推出。
英特爾表示,其將繼續推進摩爾定律的研究進展,包括背面供電和直接背面觸點(direct backside contacts)的3D堆疊CMOS晶體管,背面供電研發突破的擴展路徑(如背面觸點),并在同一塊300毫米晶圓上(而非封裝)中實現硅晶體管與氮化鎵(GaN)晶體管的大規模單片3D集成。
隨著遵循摩爾定律的半導體技術不斷推進,半導體芯片的集成度越來越高,目前衡量芯片的微觀集成密度的單位也從納米轉向埃米(1埃米等于一百億分之一米,是納米的十分之一)。
“我們正在進入制程技術的埃米時代,展望‘四年五個制程節點’計劃實現后的未來,持續創新比以往任何時候都更加重要。”英特爾公司高級副總裁兼組件研究總經理桑杰·納塔拉詹(Sanjay Natarajan)表示,“英特爾展示了繼續推進摩爾定律的研究進展,這顯示了我們有能力面向下一代移動計算需求,開發實現晶體管進一步微縮和高能效比供電的前沿技術。”
據國際數據公司(IDC)預計,全球人工智能硬件市場(服務器)規模將從2022年的195億美元增長到2026年的347億美元,五年復合增長率達17.3%。其中,用于運行生成式人工智能的服務器市場規模在整體人工智能服務器市場的占比將從2023年的11.9%增長至2026年的31.7%。
據英特爾透露,包括PowerVia背面供電技術、用于先進封裝的玻璃基板和Foveros Direct技術預計將在2030年前投產。
英特爾技術發展總監毛羅·科布林斯基(Mauro Kobrinsky)表示:“摩爾定律推動著更多晶體管的集成,這又推動著更多的層次和更小的導線,增加了復雜性和成本。每一層次都必須提供信號和電源導線,這通常會導致優化妥協和資源爭奪,形成互聯瓶頸,事情變得越來越具有挑戰性。”“背面電源從根本上改變了這種情況,通過在器件的兩側和垂直互連中使用電源過孔。我們明年將能夠在半導體Intel 20A(2nm)和18A(1.8nm)中部署這項技術,這意味著在前面減少導線,因此我們可以放寬間距,不再需要進行優化妥協。”
“在電源過孔之外,我們的研究還涉及背面接觸,這使我們首次能夠連接器件兩側的晶體管。我們已經能夠在研究中制造這些接觸,并且前后接觸無需使用電源過孔進行布線。這使我們能夠減小電池的電容,提高性能并降低功耗。”科布林斯基說。
英特爾認為,晶體管微縮和背面供電是滿足世界對更強大算力指數級增長需求的關鍵。隨著背面供電技術的完善和新型2D通道材料的采用,英特爾致力于繼續推進摩爾定律,在2030年前實現在單個封裝內集成1萬億個晶體管。
審核編輯:黃飛
-
英特爾
+關注
關注
61文章
10301瀏覽量
180454 -
摩爾定律
+關注
關注
4文章
640瀏覽量
80913 -
晶體管
+關注
關注
78文章
10396瀏覽量
147765 -
人工智能
+關注
關注
1817文章
50098瀏覽量
265389
原文標題:英特爾:2030年前實現在單個封裝內集成1萬億個晶體管
文章出處:【微信號:現代電子技術,微信公眾號:現代電子技術】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
英特爾前CEO基辛格:GPU將被取代!
突破供電瓶頸,英特爾代工實現功率傳輸的跨代際飛躍
智銳通科技亮相“英特爾技術創新與產業生態大會”,展示AI醫療內窺解決方案

NSBCMXW系列偏置電阻晶體管(BRT)技術解析與應用指南
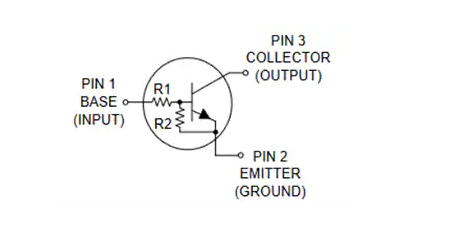
深入解析onsemi偏置電阻晶體管(BRT)NSBAMXW系列技術特性與應用
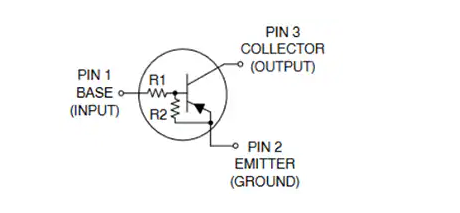
18A工藝大單!英特爾將代工微軟AI芯片Maia 2
多值電場型電壓選擇晶體管結構
下一代高速芯片晶體管解制造問題解決了!
英特爾先進封裝,新突破
英特爾持續推進核心制程和先進封裝技術創新,分享最新進展

多值電場型電壓選擇晶體管結構
英特爾先進封裝:助力AI芯片高效集成的技術力量




 英特爾:2030年前實現單個封裝內集成1萬億個晶體管
英特爾:2030年前實現單個封裝內集成1萬億個晶體管



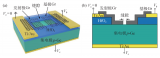



評論