近期,華為技術有限公司公布數項新的專利,其中一項名為“芯片封裝結構及制造方法”(公開號CN117256049A)的專利引起關注。
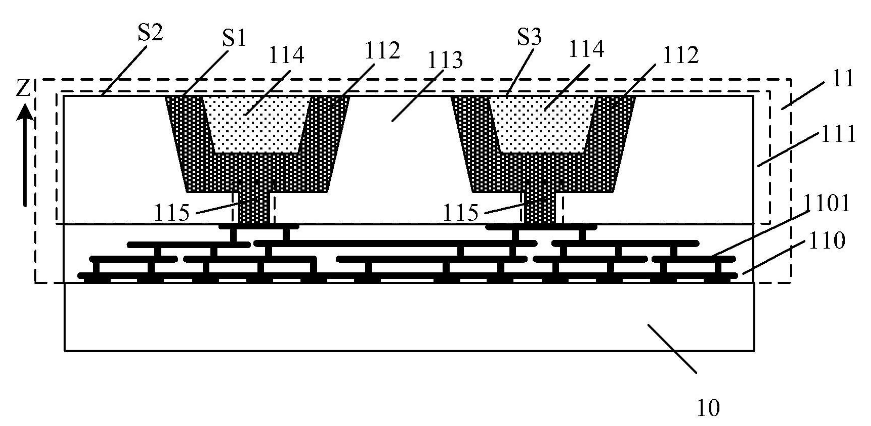
該專利提出了一種全新的封裝結構,由第一芯片搭配第一混合鍵合結構制成。這種結構能有效地連接不同芯片,提升芯片間信號傳輸性能。具體而言,混合鍵合結構包含第一鍵合層,它位于第一芯片襯底的邊緣,其材料是一種含有眾多第一金屬焊盤的絕緣物。這些金屬焊盤展現出槽型結構,其底部埋藏在絕緣材料里,而開口處則光滑平整地凸顯出來,且與芯底層的表面保持平行。值得注意的是,這些焊盤內部堆砌著第一絕緣介質,其表面跟第一絕緣材料完全貼合,使整個芯片封裝更為緊實。
截至2022年,華為共擁有超12萬項有效專利,覆蓋全球多個地區。特別是在中國和歐洲市場,這些專利占據了不小的比例,而它們在美國的專利數量更是高達22,000多項。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
463文章
54027瀏覽量
466398 -
封裝
+關注
關注
128文章
9259瀏覽量
148697 -
襯底
+關注
關注
0文章
39瀏覽量
9617
發布評論請先 登錄
相關推薦
熱點推薦
德州儀器TPS65176系列芯片封裝及設計指南
德州儀器TPS65176系列芯片封裝及設計指南 一、引言 在電子設計領域,芯片的封裝信息對于工程師來說至關重要,它不僅影響著
漢思新材料斬獲小間距芯片填充膠專利,破解高端封裝空洞難題
近日,東莞市漢思新材料科技有限公司(以下簡稱“漢思新材料”)成功斬獲“一種溫控晶振小間距芯片填充膠及其制備方法”發明專利(公開號:CN121343527A)。依托突破性創新配方設計,該產品可實現



漢思新材料取得一種系統級封裝用封裝膠及其制備方法的專利
漢思新材料(深圳市漢思新材料科技有限公司)于2023年公開了一項針對系統級封裝(SiP)的專用封裝膠及其制備方法的專利(申請號:202310155819.4),該技術旨在解決多芯片異構

智芯公司芯片核心技術專利入選2025年度北京市首批專利轉化運用優秀案例
例,標志著智芯公司在專利轉化運用和產業化方面的成效獲得業內高度認可。 該項目成功突破電力主控芯片設計、封裝設計、測試開發等關鍵技術難題,研發出高性能、低功耗等10余款電力主控系列芯片。
突破!華為先進封裝技術揭開神秘面紗
引發行業高度關注,為其在芯片領域的持續創新注入強大動力。 堆疊封裝,創新架構 華為公布的 “一種芯片堆疊封裝及終端設備”
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利2025年4月30日消息,國家知識產權局信息顯示,深圳市漢思新材料科技有限公司取得一項名為“

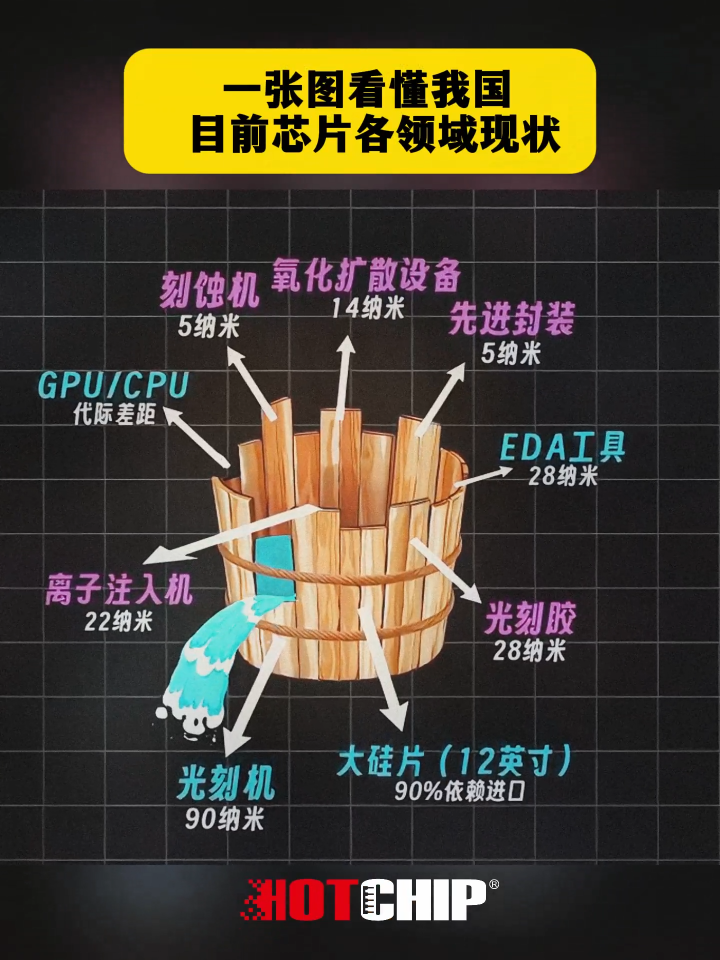


新能源汽車驅動電機專利信息分析
采用Thomson Innovation專利檢索分析平臺搜集整理驅動電機相關專利,通過分析國內外驅動電機專利的 申請時間趨勢、國別分布、申請人排名、技術熱點分布以及國內專利省市分布,了
發表于 03-21 13:39



 華為新增多條芯片封裝專利信息
華為新增多條芯片封裝專利信息




評論