低溫無壓燒結銀對鍍層的四點要求
對于AMB基板、DBC基板以及底板來說,銅或鋁表面在空氣中會發生氧化,形成的氧化物薄膜會阻礙與低溫燒結銀之間的原子擴散和金屬鍵的形成,降低連接強度。為避免基板表面的氧化,提升與互連材料之間的連接強度,需要對基板進行金屬鍍層處理。AS9376低溫無壓燒結銀對鍍層要求有以下四點
1、擴散層穩定
AMB基板、DBC基板以及散熱器表面的金屬鍍層通常具有基板與互連材料之間的熱導通、機械連接和電氣連接這三個功能。需要形成金屬鍍層與基板之間的原子擴散,形成原子結合。該連接需要在AS系列燒結銀互連過程中穩定,需要在可靠性測試:比如溫度循環測試,高低溫測試等測試中保持高剪切強度的連接,并且具有較低的界面熱阻。
2、潤濕性好
隨著第三代半導體器件向高溫、大功率方向的發展,AMB基板、DBC基板以及散熱器表面的金屬鍍層需要滿足高結溫可靠性的要求。需要對互連材料具有良好的潤濕性,來形成無空洞連接層。金屬鍍層表面需要避免產生氧化物或氮化物,避免底層的元素擴散到表面造成污染。
3、電阻和熱阻盡量低
導電和導熱性能需要具有盡量低的界面電阻和界面熱阻,來保證良好的導電和導熱性能;
4、金屬間化合物盡量少
需要盡量避免產生金屬間化合物。金屬間化合物一般為脆性,三元金屬間化合物比二元金屬間化合物更脆,易導致可靠性問題。如不能避免,需要盡量形成較薄的、不連續的金屬間化合物層。
低溫燒結銀焊膏AS系列,具有低溫燒結,高溫服役的特點,AS9376無壓燒結銀具有:低溫燒結,較高的熔點,熱導率高,導電率好和高可靠性等性能,可以應用于耐高溫芯片的互聯。
低溫無壓燒結銀可以實現高強度的低溫燒結銀的互連,可以無需額外的熱壓設備,大大降低生產成本,這對于拓展燒結銀互連材料和技術具有非常重要的理論和應用價值。
審核編輯 黃宇
-
半導體
+關注
關注
339文章
30734瀏覽量
264069 -
DBC
+關注
關注
2文章
65瀏覽量
8395 -
AMB
+關注
關注
0文章
27瀏覽量
6230
發布評論請先 登錄
燒結銀膏在硅光技術和EML技術的應用
再談低溫燒結銀的應用:從春晚四家機器人出鏡的幕后推手說起
低溫無壓燒結銀的前世今生:從發明到未來趨勢
銀膠vs銀漿:一字之差,卻是電子焊接的“兩種技術路線”!

為什么無壓燒結銀膏在銅基板容易有樹脂析出?
氮化鎵芯片無壓燒結銀膏的脫泡手段有哪些?
無壓燒結銀膏應該怎樣脫泡,手段有哪些?
從適配到突破:燒結銅工藝如何解決企業“改造成本焦慮”?

新能源汽車芯片焊接:錫膏與燒結銀的技術競速與場景分化

新能源汽車芯片焊接選材:為啥有的用錫膏,有的選燒結銀?




 低溫無壓燒結銀對鍍層的四點要求
低溫無壓燒結銀對鍍層的四點要求

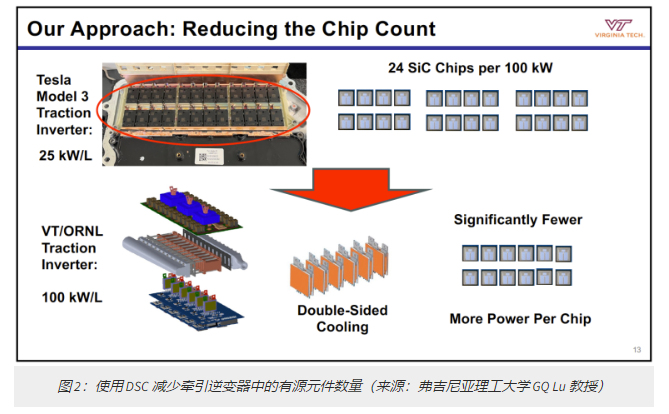
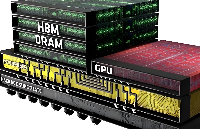



評論