當提到晶振(Crystal Oscillators)時,我們常常不太了解它們是如何制造的。晶振是電子設備中的關鍵組件,用于產生高精度的電子信號和時鐘頻率。下面,我們將深入了解晶振的制造過程,從原材料準備到最終產品的出貨,詳細描述每一個步驟。
第一步:原材料準備
制造晶振的第一步是選擇高純度的石英晶體作為原材料。這些晶體必須經過嚴格的質量控制,通常要求純度達到99.999%以上。原材料可以是石英粉末或石英石塊。
第二步:生長石英晶體
- 生長室設定:生長室內的溫度通常保持在1,700至2,000攝氏度,同時維持高壓環境,通常在數千大氣壓。
- 硅源氣體:硅源氣體,如三氯化硅(SiCl3),分解并釋放硅原子。
- 生長時間:控制生長時間,以達到所需的尺寸。
第三步:切割晶體
- 切割工具:使用高精度的金剛石切割刀片或線切割工具。
- 切割速度:控制切割速度,通常以毫米/分鐘為單位。
- 切割潤滑條件:確保切割過程中的潤滑條件以減少摩擦和熱量。
第四步:拋光
- 拋光工藝:使用化學機械拋光(CMP)或機械拋光設備。
- 拋光時間:控制拋光時間,通常以分鐘為單位。
- 拋光液:使用高質量的拋光液,通常是硅氧烷或氫氧化鋁。
第五步:清洗
- 清洗溶液:使用超純水和高純度的化學溶劑。
- 清洗時間和溫度:控制清洗時間和溫度以確保徹底清除表面污染。
第六步:植入金屬電極
- 植入條件:控制離子植入或物理沉積條件,包括能量、電流和金屬源。
- 植入深度:控制植入深度以確保金屬電極與石英晶片表面結合。
第七步:光刻和蝕刻
- 光刻掩膜設計:設計光刻掩膜以定義電路和引腳的圖案。
- 蝕刻條件:使用化學或物理腐蝕來去除不需要的材料,控制腐蝕時間和化學溶液。
第八步:金屬沉積
- 沉積工藝:控制金屬沉積過程,包括金屬源、溫度和氣氛。
- 沉積時間:控制沉積時間以形成所需的金屬層厚度。
第九步:終端制造
- 引腳和連接制造:使用工藝來制造引腳和連接,通常涉及蝕刻和金屬沉積。
第十步:測試和校準
- 測試設備:使用頻率測試設備和溫度控制設備。
- 校準條件:如果需要,進行校準以確保頻率和穩定性滿足規格。
第十一步:封裝
- 封裝材料和設計:選擇封裝材料和設計封裝以提供機械支撐和保護。
- 引腳連接:將晶片和引腳連接到封裝腔體。
第十二步:質檢和品控
- 質檢標準:根據性能和品質標準進行檢查,包括外觀、尺寸和性能測試。
第十三步:最終測試
- 測試條件:使用頻率測試設備進行最終測試以驗證性能和頻率穩定性。
第十四步:包裝和出貨
- 包裝材料:使用適合運輸和存儲的包裝材料。
- 出貨條件:準備晶片以供最終的電子設備制造商或應用領域使用。
這些步驟確保了晶振的高質量生產,每一步都是必不可少的,以確保性能和穩定性。晶振在電子設備中發揮著關鍵作用,提供了高精度的時鐘信號和頻率控制,使得現代電子設備能夠順利運行。這個看似簡單的小組件背后蘊含著精密的科學和工程。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
半導體
+關注
關注
339文章
30737瀏覽量
264156 -
振蕩器
+關注
關注
28文章
4172瀏覽量
142891 -
設備
+關注
關注
2文章
4835瀏覽量
73734
發布評論請先 登錄
相關推薦
熱點推薦
半導體精密劃片機:QFN封裝切割工序的核心支撐
中,切割工序作為銜接封裝與成品測試的關鍵環節,直接決定了芯片的良率、尺寸精度及可靠性,半導體精密劃片機則以其微米級的精準控制能力,成為該工序不可或缺的核心設備,為

氬離子的拋光與切割技術
氬離子拋光和切割技術是現代微觀分析領域中不可或缺的樣品制備手段。該技術通過利用寬離子束(約1毫米寬)對樣品進行切割或拋光,能夠精確地去除樣品表面的損傷層,并暴露出高質量的分析區域,為后
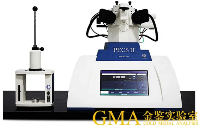
石英晶體頻率全指南:從基礎到選型
石英晶體的頻率與穩定度,直接決定系統的時間基準、相位噪聲與同步能力。本文從工程視角梳理頻率穩定度、溫度特性、相位噪聲/抖動與老化等核心概念,并結合 GNSS/5G/工業控制等典型應用,

金剛石線鋸切割技術對藍寶石晶體切面表面形貌優化研究
隨著LED技術的迅速發展,藍寶石晶體作為GaN芯片的主要襯底材料,其市場需求不斷增加。金剛石線鋸技術在藍寶石晶體切割中得到了廣泛應用,藍寶石晶體的高硬度也給加工帶來了挑戰,

晶振生產工藝:從石英晶體到高精度振蕩器
石英晶體:晶振的核心基石 晶振的核心是石英晶體,其主要成分是二氧化硅(SiO?),這種在自然界廣泛存在于巖漿巖、變質巖、沉積巖和熱液脈體中的氧化物礦物,是重要造巖礦物和巖石圈的重要組成
碳化硅晶圓特性及切割要點
01襯底碳化硅襯底是第三代半導體材料中氮化鎵、碳化硅應用的基石。碳化硅襯底以碳化硅粉末為主要原材料,經過晶體生長、晶錠加工、切割、研磨、拋光、清洗等制造過程后形成的單片材料。按照電學性

半導體哪些工序需要清洗
半導體制造過程中,清洗工序貫穿多個關鍵步驟,以確保芯片表面的潔凈度、良率和性能。以下是需要清洗的主要工序及其目的: 1. 硅片準備階段 硅片切割后清洗 目的:去除切割過程中殘留的金屬碎
晶片機械切割設備的原理和發展
通過單晶生長工藝獲得的單晶硅錠,因硅材質硬脆特性,無法直接用于半導體芯片制造,需經過機械加工、化學處理、表面拋光及質量檢測等一系列處理流程,才能制成具有特定厚度和精度要求的硅片。其中,針對硅錠的晶片




 石英晶體的生長切割拋光等工序
石英晶體的生長切割拋光等工序



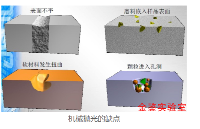






評論