電遷移是金屬線在電流和溫度作用下產(chǎn)生的金屬遷移現(xiàn)象——運(yùn)動(dòng)中的電子和主體金屬晶格之間相互交換動(dòng)量,金屬原子沿電子流方向遷移時(shí),就會(huì)在原有位置上形成空洞,同時(shí)在金屬原子遷移堆積形成丘狀突起。
前者將引線開路或斷裂,而后者會(huì)造成光刻困難和多層布線之間的短路,從而影響芯片的正常工作。
為更好地滿足客戶EM測(cè)試需求,季豐電子提供EM測(cè)試樣品制備服務(wù),樣品外形涵蓋DIP8、DIP16、DIP24、DIP28等。
工藝可靠性電遷移(EM)測(cè)試
芯片經(jīng)過長時(shí)間高溫、大電流(密度),容易引起金屬線metal-line或連接通孔Via失效,測(cè)試環(huán)境250~300°。
測(cè)試流程是通過在施加溫度和電流時(shí)測(cè)量電阻,直至該顆測(cè)試樣品達(dá)到設(shè)定電阻變化,被判定失效發(fā)生,測(cè)試實(shí)驗(yàn)終止。
樣品制備流程:晶圓減薄劃片-陶瓷管殼打線
陶瓷管殼焊線材質(zhì)一般用金線和鋁線,以下將2種材質(zhì)的樣品進(jìn)行對(duì)比:
1. 陶瓷管殼封裝-Au wire 實(shí)驗(yàn)溫度條件 250°C

(FApictureofAubond)
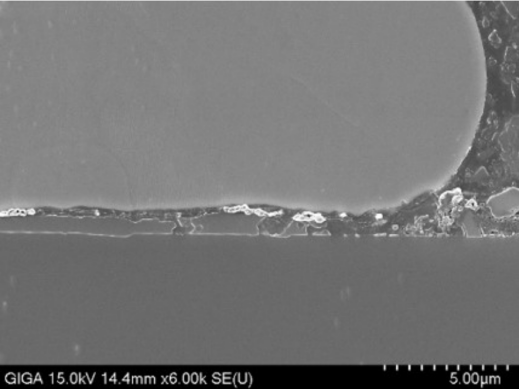
2. 陶瓷管殼封裝-Alwire實(shí)驗(yàn)溫度條件250°C
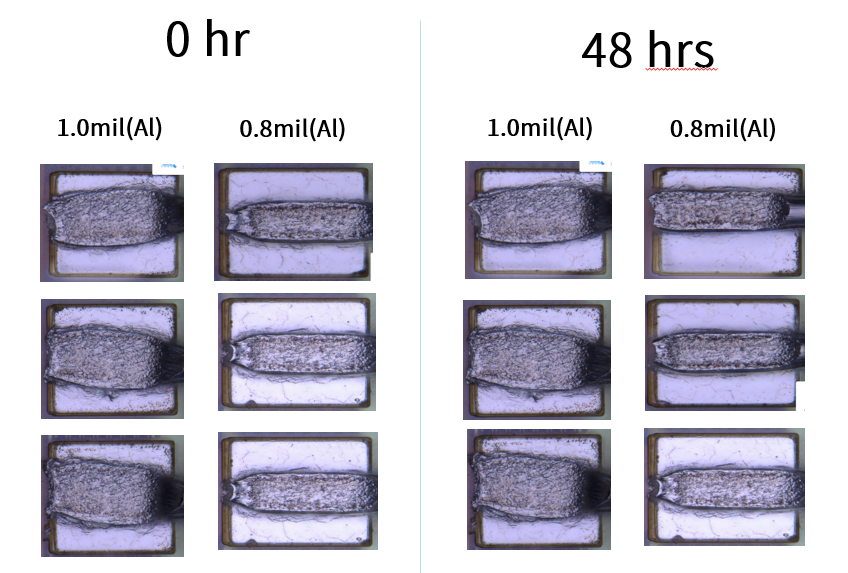
當(dāng)溫度處于250°C,時(shí)間達(dá)到48小時(shí),頂部金屬擴(kuò)散到Au和Al襯底,會(huì)引起測(cè)試結(jié)構(gòu)Open。
EM測(cè)試時(shí)需要250°以上高溫,使用鋁線制備EM樣品最佳。
審核編輯:劉清
-
電阻器
+關(guān)注
關(guān)注
22文章
4239瀏覽量
65408 -
連接器
+關(guān)注
關(guān)注
104文章
16138瀏覽量
147015 -
DIP封裝
+關(guān)注
關(guān)注
1文章
42瀏覽量
14047
原文標(biāo)題:工藝可靠性電遷移EM測(cè)試-樣品制備
文章出處:【微信號(hào):zzz9970814,微信公眾號(hào):上海季豐電子】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
什么是高可靠性?
芯片可靠性(RE)性能測(cè)試與失效機(jī)理分析

如何測(cè)試單片機(jī)MCU系統(tǒng)的可靠性
如何測(cè)試時(shí)間同步硬件的性能和可靠性?
可靠性設(shè)計(jì)的十個(gè)重點(diǎn)

太誘MLCC電容的可靠性如何?
AR 眼鏡硬件可靠性測(cè)試方法

關(guān)于LED燈具的9種可靠性測(cè)試方案

可靠性測(cè)試包括哪些測(cè)試和設(shè)備?

ePTFE防水透氣膜的可靠性測(cè)試哪些項(xiàng)目?

半導(dǎo)體測(cè)試可靠性測(cè)試設(shè)備

提供半導(dǎo)體工藝可靠性測(cè)試-WLR晶圓可靠性測(cè)試
詳解晶圓級(jí)可靠性評(píng)價(jià)技術(shù)




 工藝可靠性電遷移EM測(cè)試
工藝可靠性電遷移EM測(cè)試


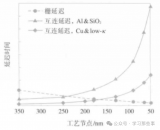



評(píng)論