芯片封裝的發展歷程可以總結為七種類型:TO→DIP→SOP→QFP→PLCC→BGA→CSP。
TO:最早的封裝類型,代表了晶體管外殼,現在仍然有晶體管采用這種封裝。
DIP:雙列直插式封裝,初學電子時常用于面包板和學習51單片機等。
SOP:小外形封裝,是目前最常見的貼片式封裝,具有方便操作和較高可靠性的特點。
QFP:小型方塊平面封裝,引腳從四個側面引出呈海鷗翼型,適用于大規模集成電路。
PLCC:塑封J引線芯片封裝,外形呈正方形,適合SMT表面安裝技術,具有小尺寸和高可靠性。
BGA:球柵陣列封裝,具有更小的體積、更好的散熱性和電性能,廣泛應用于高集成度、高功耗芯片。
CSP:面積最小、厚度最小的封裝,適用于內存芯片等領域,擁有更多的輸入/輸出端數。
隨著集成電路的發展,封裝類型不斷演進,從較大的直插式封裝(DIP)到高集成度的BGA和CSP封裝,為芯片提供了更好的性能、散熱和可靠性。正確選擇合適的封裝類型對于芯片設計和應用至關重要。
一些封裝廠商的封裝類型和封裝技術也越來越多,例如宇凡微支持ssop、sot23、msop、qfn等多達十幾種封裝方式,有需求歡迎聯系宇凡微電子。
審核編輯:湯梓紅
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
封裝
+關注
關注
128文章
9248瀏覽量
148606 -
芯片封裝
+關注
關注
13文章
614瀏覽量
32261 -
SOP
+關注
關注
0文章
99瀏覽量
28689
發布評論請先 登錄
相關推薦
熱點推薦


聊聊倒裝芯片凸點(Bump)制作的發展史
凸點(Bump)是倒裝芯片的“神經末梢”,其從金凸點到Cu-Cu鍵合的演變,推動了芯片從平面互連向3D集成的跨越。未來,隨著間距縮小至亞微米級、材料與工藝的深度創新,凸點將成為支撐異構

詳解CSP封裝的類型與工藝
1997年,富士通公司研發出一種名為芯片上引線(Lead On Chip,LOC)的封裝形式,稱作LOC型CSP。為契合CSP的設計需求,LOC封裝相較于傳統引線框架CSP做出了一系列

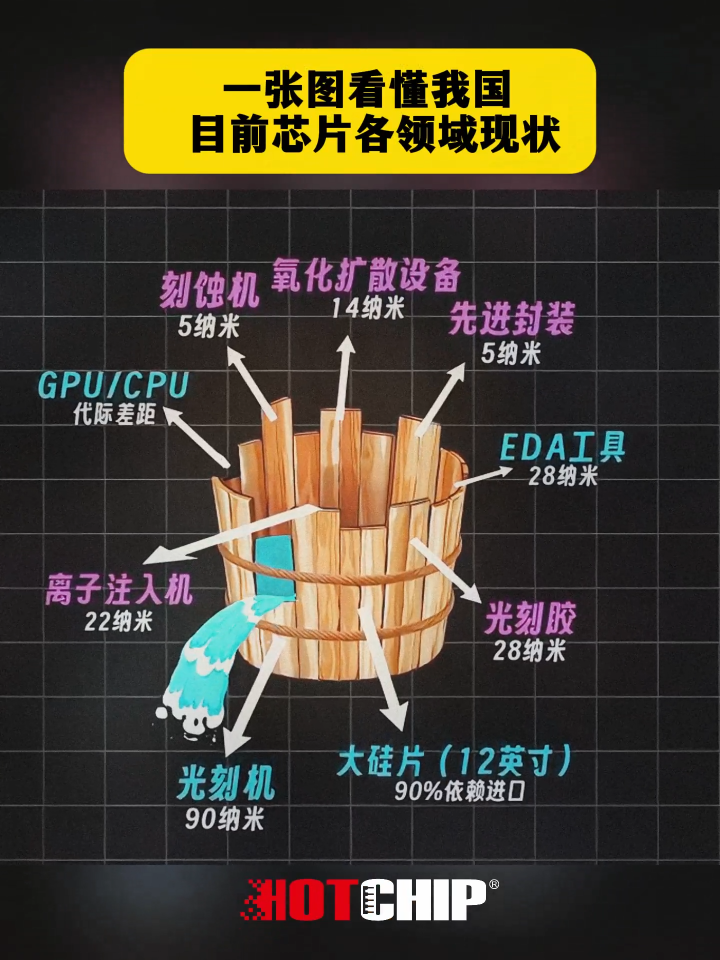


半導體材料發展史:從硅基到超寬禁帶半導體的跨越
半導體材料是現代信息技術的基石,其發展史不僅是科技進步的縮影,更是人類對材料性能極限不斷突破的見證。從第一代硅基材料到第四代超寬禁帶半導體,每一代材料的迭代都推動了電子器件性能的飛躍。 1 第一代
如何制定芯片封裝方案
封裝方案制定是集成電路(IC)封裝設計中的關鍵環節,涉及從芯片設計需求出發,制定出滿足功能、電氣性能、可靠性及成本要求的封裝方案。這個過程的
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】圖文并茂,全面詳實,值得閱讀的芯片科普書
產業基礎技術是安全保障,一定要有,同時又要積極產于國際產業合作, 另外附錄中介紹的芯片發展史介乎貢獻人員,中國相關行業奠基人,重大事件等也可以翻翻,可以用這些名人大事激勵自己,作為從業人員做好自己的工作也是一種貢獻,保持不斷學
發表于 03-27 16:07
IC封裝產線分類詳解:金屬封裝、陶瓷封裝與先進封裝
在集成電路(IC)產業中,封裝是不可或缺的一環。它不僅保護著脆弱的芯片,還提供了與外部電路的連接接口。隨著電子技術的不斷發展,IC封裝技術也在不斷創新和進步。本文將詳細探討IC

芯片封裝中的焊點圖案設計
Bump Pattern Design(焊點圖案設計) 是集成電路封裝設計中的關鍵部分,尤其在BGA(Ball Grid Array)和Flip Chip等封裝類型中,焊點設計決定了芯片



 從七種封裝類型,看芯片封裝發展史
從七種封裝類型,看芯片封裝發展史


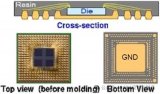




評論