問題描述
AMB陶瓷覆銅基板是一個(gè)復(fù)合結(jié)構(gòu):銅箔/焊料/陶瓷/焊料/銅箔,不同材料之間的CTE、楊氏模量、導(dǎo)熱性能也存在差異。

在IGBT/SiC功率模塊的封裝制程中,尤其芯片燒結(jié)、散熱器焊接或塑封,同時(shí)有熱參數(shù)、壓力參數(shù)及其他材料CTE的條件影響, 會(huì)導(dǎo)致AMB覆銅陶瓷基板產(chǎn)生翹曲,進(jìn)而產(chǎn)生一些通用問題,例如焊接空洞、塑封分層,嚴(yán)重情況下甚至產(chǎn)生陶瓷開裂等問題。
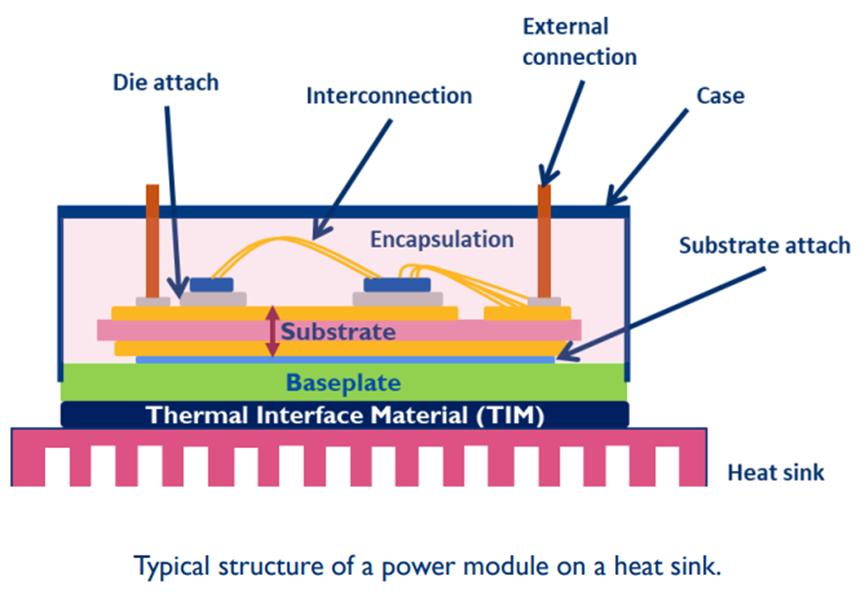
AMB通用技術(shù)問題-翹曲
翹曲機(jī)理?
復(fù)合材料結(jié)構(gòu)的翹曲機(jī)理:不同材料屬性各異,其模量、強(qiáng)度、熱膨脹系數(shù)差異很大,復(fù)合之后會(huì)存在明顯的各向異性。復(fù)合材料結(jié)構(gòu)的翹曲變形主要是由燒結(jié)反應(yīng)過程中的殘余應(yīng)力引起,而殘余應(yīng)力又是由組分材料的熱膨脹不匹配、多層結(jié)構(gòu)線性收縮不一致引起的。

AMB翹曲示意圖
AMB翹曲T0狀態(tài)主要受三大因素影響——線路排布、材料組合、AMB單片尺寸。在客戶端焊接、燒結(jié)及塑封制程中,圖形面與非圖形面的銅材不論是體積還是Layout上必然存在差異,導(dǎo)致在受熱過程中釋放差異性應(yīng)力,進(jìn)而導(dǎo)致AMB翹曲。
威斯派爾解決方案?
1.圖形設(shè)計(jì)優(yōu)化或者反饋
2.燒結(jié)工藝保證(燒結(jié)工藝參數(shù)、特制燒結(jié)治具等);成品翹曲度保證(樣品初制承諾0.65%,具體以客戶圖紙為準(zhǔn))
3.Winspower實(shí)驗(yàn)室實(shí)驗(yàn)模擬(以客戶溫度曲線為基礎(chǔ),平臺(tái)模擬翹曲)
威斯派爾實(shí)驗(yàn)室目前擁有由研發(fā)團(tuán)隊(duì)搭建的測(cè)試平臺(tái),參考客戶端封裝的工藝參數(shù),可以模擬分析AMB的翹曲形態(tài)及翹曲數(shù)據(jù),將內(nèi)部的測(cè)試數(shù)據(jù)與客戶端測(cè)試數(shù)據(jù)相結(jié)合后,技術(shù)團(tuán)隊(duì)分享最優(yōu)的解決方案:銅減薄、調(diào)整銅面積、調(diào)整材料組合、Dimpling設(shè)計(jì)等,并快速提供樣品給客戶。
撰文:Stefan
來源 :威斯派爾
審核編輯:劉清
-
散熱器
+關(guān)注
關(guān)注
2文章
1137瀏覽量
39647 -
IGBT
+關(guān)注
關(guān)注
1288文章
4331瀏覽量
262984 -
SiC
+關(guān)注
關(guān)注
32文章
3721瀏覽量
69390 -
AMB
+關(guān)注
關(guān)注
0文章
27瀏覽量
6230
原文標(biāo)題:技術(shù)文章 | AMB通用技術(shù)問題——翹曲及其解決方案
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
預(yù)防翹曲的方法
PCB元器件焊接翹曲問題研究
如何防止線路板曲翹
針對(duì)PCB板翹曲如何解決?
針對(duì)PCB板翹曲如何解決?
防止印制板翹曲的方法
如何預(yù)防PCB板翹曲?
SMT異常的原因和翹曲有關(guān)系嗎?
常見PCB弓曲扭曲翹曲撓曲分析改善方案
什么是PoP層疊封裝? 基板薄化對(duì)翹曲有什么影響?




 AMB通用技術(shù)問題—翹曲及其解決方案
AMB通用技術(shù)問題—翹曲及其解決方案





評(píng)論