No.1 案例背景
當芯片底部出現焊接不良的問題時,我們可以怎么進行失效分析呢?
本篇案例運用X-ray檢測——斷面檢測——焊錫高度檢測——SEM檢測的方法,推斷出芯片底部出現焊接不良的失效原因,并據此給出改善建議。
No.2 分析過程
X-ray檢測
說明
對樣品進行X-ray檢測,存在錫少、疑似虛焊不良的現象。
斷面檢測
#樣品斷面檢測研磨示意圖
位置1
位置2
位置3
說明
樣品進行斷面檢測,底部存在錫少,虛焊的現象。且芯片底部焊錫與PCB焊錫未完全融合。
焊錫高度檢測
引腳焊錫高度0.014mm
芯片底部焊錫高度0.106mm
說明
芯片引腳位置焊錫高度0.014mm,芯片未浮起,芯片底部高度為0.106mm,錫膏高度要大于芯片底部高度才能保證焊接完好。
SEM檢測
說明
對底部焊接的位置進行SEM檢測,芯片與PCB之間焊錫有縫隙,焊錫未完全融合,IMC致密性差,高度5μm左右。
No.3 分析結果
通過X-ray、斷面分析以及SEM分析,判斷引起芯片底部焊接失效的原因主要有——
① 芯片底部存在錫少及疑似虛焊不良的現象;
② 芯片底部焊錫與PCB焊錫未完全融合的現象。而且,芯片焊接未浮起,芯片底部高度僅為0.106mm。只有當錫膏高度大于芯片底部高度時,才能保證焊接完好;
③ 芯片與PCB之間焊錫有縫隙,焊錫未完全融合,IMC致密性差,高度4-5μm左右;
根據以上綜合分析,造成芯片底部焊接虛焊的原因推測為:
1. 錫膏厚度不足導致底部焊接虛焊;
2.焊接時熱量不足導致焊錫液相時間不足。
No.4 改善方案
1. 建議實際測量錫膏高度(L)與芯片底部高度(A1)后進行調整;
2. 建議根據實際測量情況,適當調整芯片底部焊錫液相時間。
新陽檢測中心有話說:
本篇文章介紹了芯片底部焊接失效分析。如需轉載本篇文章,后臺私信獲取授權即可。若未經授權轉載,我們將依法維護法定權利。原創不易,感謝支持!
新陽檢測中心將繼續分享關于PCB/PCBA、汽車電子及相關電子元器件失效分析、可靠性評價、真偽鑒別等方面的專業知識,點擊關注獲取更多知識分享與資訊信息。
審核編輯黃宇
-
芯片
+關注
關注
463文章
54007瀏覽量
465949 -
失效分析
+關注
關注
18文章
250瀏覽量
67736
發布評論請先 登錄
芯片失效故障定位技術中的EMMI和OBIRCH是什么?
聚焦離子束(FIB)技術在芯片失效分析中的應用詳解

熱發射顯微鏡下芯片失效分析案例:IGBT 模組在 55V 就暴露的問題!

漢思新材料:底部填充膠可靠性不足如開裂脫落原因分析及解決方案

LED失效的典型機理分析
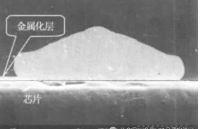
LED芯片失效和封裝失效的原因分析

聚徽解碼工業觸控一體機I/O端口接觸不良:焊接修復與防護策略
離子研磨在芯片失效分析中的應用

如何降低焊接不良對PCBA項目的影響?
芯片底部填充膠填充不飽滿或滲透困難原因分析及解決方案




 芯片底部焊接不良失效分析
芯片底部焊接不良失效分析

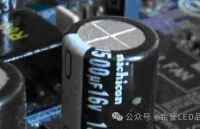

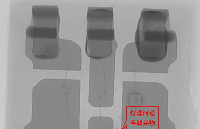





評論