ICP的設計在半導體工業中相當普遍,這種系統包括高密度等離子體(HDP)電介質CVD系統;硅、金屬和電介質HDP刻蝕系統;原生氧化物濺鍍清潔系統;離子化金屬等離子體PVD系統。
在ICP反應室中加入射頻偏壓系統就可以產生自偏壓并控制離子的轟擊能量。由于在高密度等離子體中的離子轟擊會產生大量的熱能,因此必須有一個背面気氣冷卻系統和靜電夾盤控制晶圓的溫度。下圖(b)顯示了一個ICP反應室腔。ICP系統中,由等離子體密度決定的離子束流通過射頻功率源控制,而離子轟擊能量由偏壓射頻功率控制。
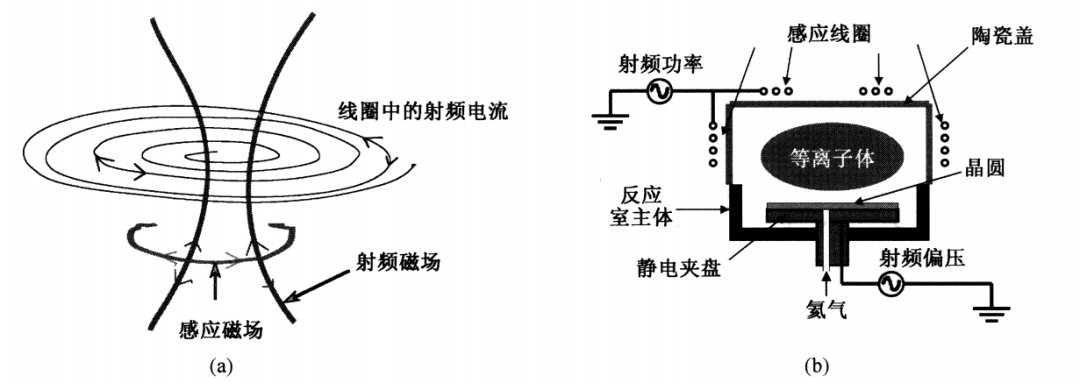
電子回旋共振
帶電粒子在磁場中將形成回旋轉動,而轉動的頻率稱為螺旋轉動頻率或回旋頻率,它由磁場的強度決定。由公式可以得出,電子螺旋轉動頻率為:
ΩeMHz)=2.8B(高斯)
在磁場中,當所用的微波頻率等于電子的螺旋轉動頻率,即ωMW=Ωe,電子就發生回旋共振。電子將通過微波使能量增加,進而電子和原子或分子產生碰撞,而離子化碰撞將產生更多的電子,這些電子也會和微波形成共振獲得能量,且通過離子化碰撞產生更多的電子。由于電子將沿磁場線進行螺旋轉動,如下圖(a)所示,因此即使平均自由程比反應室的距離長,也一定會先和氣體分子產生多次碰撞后才會與反應室墻壁或電極碰撞。這就是ECR系統能在低壓狀態下產生高密度等離子體的原因。
ECR系統和ICP系統一樣都具有射頻偏壓系統控制離子的轟擊能量,并具有靜電夾盤背面氮氣冷卻系統以控制晶圓的溫度,如下圖(b)所示。離子轟擊的流量主要由微波功率控制。ECR系統的優點之一在于通過改變磁場線圈中的電流就能調整共振的位置,所以可以通過調整磁場線圈的電流來控制等離子體的位置,提高工藝的均勻性。

等離子體工藝回顧
1.等離子體由離子、電子和中性分子組成。
2.等離子體中三種主要的碰撞為離子化、激發-松弛和分解碰撞。
3.平均自由程是指粒子與其他粒子碰撞前所能移動的平均距離,平均自由程和壓力成反比。
4.分解碰撞中產生的自由基能夠增強CVD、刻蝕和干法清洗工藝的化學反應。
5.等離子體電位必須高于電極的電位,高電位的等離子體才能產生離子轟擊。
6.電容耦合式等離子體系統中,增加射頻功率可以增加離子轟擊的能量和流量。
7.低頻功率將使離子有更多的能量,說明有更劇烈的離子轟擊。
8.刻蝕工藝比PECVD工藝需要更多的離子轟擊,刻蝕反應室通常使用磁場增加低壓條件下的等離子體密度。
9.電容耦合式等離子體源不能產生高密度等離子體。
10.刻蝕和CVD工藝需要低壓條件下的高密度等離子體。
H.ICP和ECR是最常使用的兩種高密度等離子體源。
12.ICP和ECR等離子體源都可以單獨控制離子轟擊的流量和能量。
審核編輯 :李倩
-
磁場
+關注
關注
3文章
908瀏覽量
25395 -
半導體
+關注
關注
339文章
31009瀏覽量
265499 -
等離子
+關注
關注
2文章
275瀏覽量
31541
原文標題:等離子工藝(十三)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
北方華創發布全新一代12英寸高端電感耦合等離子體刻蝕設備NMC612H
Pearson皮爾森電流探頭:半導體等離子體測試精準測量優選方案

射頻功率放大器在等離子體激勵及發射光譜診斷系統中的應用
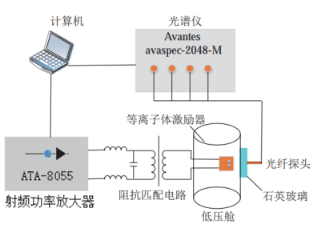
中達瑞和定制內推式高光譜相機助力等離子體運動軌跡監測
TDK PiezoBrush PZ3 - c評估套件:探索冷等離子體解決方案的利器
SPS-5T-2000℃型智能型放電等離子體燒結爐

使用簡儀科技產品的等離子體診斷高速采集系統解決方案

探索微觀世界的“神奇火焰”:射頻等離子體技術淺談
如何遠程采集監控等離子清洗機PLC數據

高端芯片制造裝備的“中國方案”:等離子體相似定律與尺度網絡突破

安泰高壓放大器在等離子體發生裝置研究中的應用

上海光機所在多等離子體通道中實現可控Betatron輻射
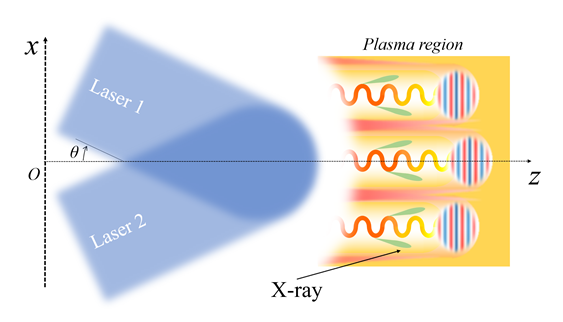



 等離子體工藝回顧
等離子體工藝回顧






評論